Volume 26, No.2 Pages 92 - 97
1. 最近の研究から/FROM LATEST RESEARCH
(JASRI理事長ファンド採択研究課題)
大気非曝露下での電圧印加硬X線光電子分光法による有機薄膜トランジスタ動作中の電位分布の解明
Analysis of Electric Potential Distributions of an Organic Thin Film Transistor upon Controlled Exposure to Air Investigated by Bias-Applied Hard X-ray Photoelectron Spectroscopy
(公財)高輝度光科学研究センター 放射光利用研究基盤センター 産業利用・産学連携推進室 Industrial Application and Partnership Division, Center for Synchrotron Radiation Research, JASRI
- Abstract
- 有機薄膜トランジスタ(OTFT:Organic Thin-Film Transistor)は大気曝露することでデバイス特性の劣化が著しく進行することが知られている。従って大気曝露がOTFT動作時の電子状態に及ぼす効果を解明することは重要である。本研究では、OTFT作製、電気特性の評価および電圧印加硬X線光電子分光(HAXPES:Hard X-ray Photoelectron Spectroscopy)測定を大気非曝露で実施できるシステムを開発した。このシステムを用いて、大気曝露がOTFT動作中の電位分布形成に及ぼす効果を調べた。
1. はじめに
次世代エレクトロニクス材料として注目される有機デバイスでは、物質内部での電荷移動のしやすさを示す物理量である移動度の向上や、高い再現性のあるデバイス動作の実現が求められている。代表的な有機デバイスの一種であるOTFTの概略を図1に示す。一般的にOTFTは、有機半導体材料だけでなくゲート電極、ソース電極、ドレイン電極や絶縁膜といった無機材料が組み合わされた有機/無機複合材料で構成されている。このOTFTに対して、図1のように2方向から電圧(ゲート・ソース電圧:Vgsとドレイン・ソース電圧:Vds)を印加すると、①ソース電極から電荷が注入され、②絶縁膜上に形成された有機半導体薄膜に電荷が蓄積し、さらに③ソース−ドレイン間で電荷移動が生じることでトランジスタの機能が発現すると考えられている[1-3][1] G. Horowitz, X. Peng, D. Fichou and F. Garnier: J. Appl. Phys. 67 (1990) 528.
[2] M. A. Alam, A. Dodabalapur and M. R. Pinto: IEEE Trans. Electron Devices 44 (1997) 1332-1337.
[3] A. R. Brown, C. P. Jarret, D. M. de Leeuw and M. Matters: Synth. Metals 88 (1997) 37-55.。従ってOTFTの電荷輸送特性を向上させるためには、OTFT動作(Vgs、Vds印加)中の電子状態を解明し電荷移動を制御する必要がある。特にOTFTは大気(特に大気中に含まれる水や酸素)曝露することで移動度の低下や、トランジスタをOn状態にするために必要な電圧(しきい電圧:Vth)の増大といったデバイス劣化が著しく進行することが報告されている[4-6][4] D. Knipp, A. Benor, V. Wanger and T. Muck: J. Appl. Phys. 101 (2007) 044504.
[5] H. Yang, L. Yang, M.-M. Ling, S. Lastella, D. D. Gandhi, G. Ramanath, Z. Bao and C. Y. Ryu: J. Phys. Chem. C 112 (2008) 16161-16165.
[6] T. Watanabe, T. Koganezawa, M. Kikuchi, C. Videlot-Ackermann, J. Ackermann, H. Brisset, N. Yoshimoto and I. Hirosawa: J. Cryst. Growth 468 (2017) 816-820.。このため大気曝露がOTFT動作時の電子状態に及ぼす効果を解明することは、実用の観点から重要な課題となっている。
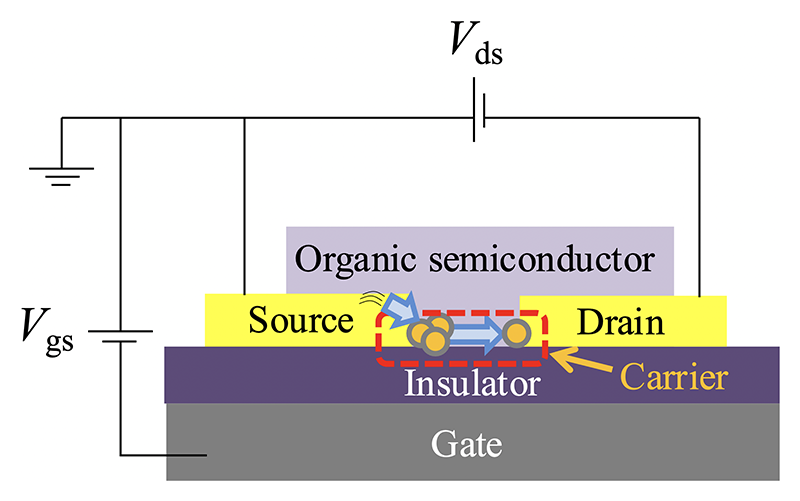
図1 ボトムコンタクト型OTFTの概略図。p型OTFTではVgs-Vthを超えた負の電圧を印加することで、有機半導体内部にキャリアが注入し始める。
上記の効果を検討する手段として、OTFT動作中の電位分布を検討することは有効である。これはOTFT内部に形成される電位分布を調べることで、OTFTの劣化要因とされる捕獲準位などの発生箇所やエネルギー値を推定できるためである。従って大気曝露前後におけるOTFT動作中の電位分布を調べることで、これら劣化要因の起源を定量的に解明することが期待できる。これまでOTFT動作中の電位分布を調べる手法には、ケルビンフォースプローブ顕微鏡(KFM:Kelvin probe Force Microscopy)測定や真空紫外から軟X線領域(数十eVから1.5 keV程度)の光を励起光とする光電子分光測定が提案されてきた[7-13][7] L. Bürgi, H. Sirringhaus and R. H. Friend: Appl. Phys. Lett. 80 (2002) 2913.
[8] J. A. Nichols, D. J. Gundlach and T. N. Jackson: Appl. Phys. Lett. 83 (2003) 2366.
[9] N. J. Watkins and Y. Gao: J. Appl. Phys. 94 (2003) 5782.
[10] M. Nakamura, N. Goto, N. Ohashi, M. Sakai and K. Kudo: Appl. Phys. Lett. 86 (2005) 122112.
[11] L. Chen, R. Ludeke, X. Cui, A. G. Schrott, C. R. Kagan and L. E. Brus: J. Phys. Chem. B 109 (2005) 1834-1838.
[12] S. Ikeda, T. Shimada, M. Kiguchi and K. Saiki: J. Appl. Phys. 101 (2007) 094509.
[13] N. Nagamura, Y. Kitada, J. Tsurumi, H. Matsui, K. Horiba, I. Honma, J. Takeya and M. Oshima: Appl. Phys. Lett. 106 (2015) 251604.。とりわけKFM測定では、金属/有機半導体界面における接触抵抗の定量化や、デバイス構造の違いが電位分布形成に及ぼす効果といった素過程の解明に貢献をしてきた[14][14] K. P. Puntambekar, P. V. Pesavento and C. D. Frisbie: Appl. Phys. Lett. 83 (2003) 5539.。しかし、従来の手法によって得られる知見は最表面から数nm以内の情報に限られていた。実用的なOTFTでは、数十nmを超える有機半導体薄膜を形成させる場合が多い。このため実用OTFTでは、①電荷注入が行われている金属膜下の有機半導体薄膜や、②電荷輸送を担う有機半導体薄膜/絶縁膜界面近傍といったトランジスタの性能を決定付ける「有機薄膜深部」の電位分布を調べることは困難とされてきた。
そこで我々はHAXPES法に着目した。HAXPES法は数keV~十数keVの硬X線を励起光として用いる。このためHAXPES測定で検出される光電子の運動エネルギーは従来の光電子分光法より数倍以上大きくなり、薄膜深部の光電子を検出することが可能である。従ってHAXPES測定をOTFTに適用すれば、「有機薄膜深部」の電位分布を調べることが期待できる。
また、HAXPES測定を含む電圧印加光電子分光測定では、束縛エネルギーだけでなく電圧印加によって変化した静電ポテンシャルを反映した光電子スペクトルを観察することができる[15-17][15] Y. Yamashita, K. Ohmori, S. Ueda, H. Yoshikawa, T. Chikyow and K. Kobayashi: e-J. Surf. Sci. Nanotech. 8 (2010) 81-83.
[16] J. Ikeuchi, H. Hamamatsu, T. Miyamoto, S. Tanaka, Y. Yamashita, H. Yoshikawa and S. Ueda: J. Appl. Phys. 118 (2015) 085308.
[17] K. Kobayashi, M. Yabashi, Y. Tanaka, T. Tokushima, S. Shin, K. Tamasaku, D. Miwa, T. Ishikawa, H. Nohira, T. Hattori, Y. Sugita, O. Nakatsuka, A. Sakai and S. Zaima: Appl. Phys. Lett. 83 (2003) 1005.。これまでに我々は、電圧印加HAXPES測定を用いたTFT動作中の半導体薄膜内部の電位観察技術の開発に取り組んできた[18-20][18] T. Watanabe, K. Tada, S. Yasuno, H. Oji, N. Yoshimoto and I. Hirosawa: Jpn. J. Appl. Phys. 55 (2016) 03DD12.
[19] I. Hirosawa, T. Watanabe, H. Oji, S. Yasuno, T. Koganezawa, K. Tada and N. Yoshimoto: Jpn. J. Appl. Phys. 55 (2016) 03DD09.
[20] S. Yasuno, T. Watanabe and S. Ishimaru: J. Surf. Anal. 24 (2017) 136-140.。さらに本研究では、試料作製から電圧印加HAXPES測定までの試料環境を大気非曝露に制御できるシステムの開発を行った。また開発したシステムを利用して大気曝露前後におけるOTFT動作中の電位分布を観察することで、大気曝露がOTFTの電位分布形成に及ぼす効果を検討した。
2. 実験
本実験はSPring-8 BL46XUで行った。蓄積リングで発生した放射光をHAXPES測定チャンバーへ導入するための光学機器の装置構成や調整条件の詳細は、参考文献[21,22]に示したとおりである。図2には、本実験で用いた試料準備室を含んだHAXPES測定装置の概略を示す。本研究では既存のHAXPESチャンバーに取り付け可能な有機薄膜真空蒸着チャンバー、試料環境制御に必要な機器である試料ホルダーおよび電流導入端子付き試料移送ロッドを新規に導入した。以下では本研究で導入した各機器を紹介した後に、詳細な実験条件について説明する。

図2 HAXPES測定装置の概略図。
2-1. 新規導入した実験機器
大気非曝露環境下でのOTFT作製、電気特性評価と電圧印加HAXPES測定を実施するにあたり、試料ホルダーと試料移送ロッド開発は特に重要な開発項目であった。図3には、開発した試料ホルダーと試料移送ロッド先端部の概略図を示す。作製した試料ホルダーは、‘top part’と‘bottom part’に大別される。top partは主にゲート電極、ソース電極、ドレイン電極および絶縁膜が形成された基板を固定する箇所として使用される。top partに基板を固定する際は、基板側から銅板とアルミナ板を挟んで固定する。この銅板にはゲート電極が接しており、銅板を通じてVgsが印加される。Vgsを印加する際にはアルミナ板の設置によって試料ホルダー全体に電圧が印加されない仕様としている。一方のbottom partは、マニピュレータに取り付けられている電流導入端子付き試料移送ロッドとドッキングする箇所として使用される。
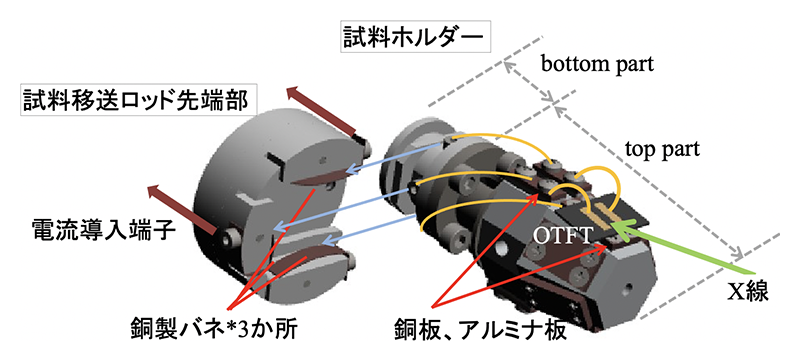
図3 作製した試料ホルダー(右)と電流導入端子付き試料移送ロッド(左)の概略図。これらがドッキングすることでOTFTに電圧印加することができる。
電流導入端子付きHAXPES測定試料移送ロッドに関しては図3に示すように、先端部がテフロンと3つの銅製バネで構成されている。この銅製のバネは電流導入端子と接続されており、ドッキングすると銅製バネと試料ホルダーbottom partに設置された3個のネジ(図3青矢印)が接触する。これら3個のネジは試料ホルダーtop part部のゲート、ソース、ドレインの電極と各々が接続されている。このため試料ホルダーと試料移送ロッドをドッキングさせることで、電流導入端子を通じた外部からのOTFTへのVds、Vgs印加が可能となる。この開発でOTFT作製、電気特性評価と電圧印加HAXPES測定を大気非曝露環境下で連続的に実施することが可能となった。
2-2. 実験条件
本実験ではボトムコンタクト型OTFTを作製した。基板には、パターニングAu膜および300 nmの熱酸化SiO2絶縁膜付きSi基板を用いた。Si基板はホウ素をヘビードープしたp型基板を使用し、ゲート電極として用いた。ソース、ドレイン電極に用いたパターニングAu膜は真空蒸着法により作製した。チャネル幅(W)とチャネル長(L)はそれぞれ5 mm、0.5 mmである。また有機半導体薄膜には、過去に表面電位分布を含む様々な物性が明らかにされている低分子材料のペンタセン(化学式:C22H14)を使用した[23-27][23] R. B. Campbell, J. M. Robertson and J. Trotter: Acta Cryst. 14 (1961) 705-711.
[24] A. R. Völkel, R. A. Street and D. Knipp: Phys. Rev. B 66 (2002) 195336.
[25] H. Fukagawa, H. Yamane, T. Kataoka, S. Kera, M. Nakamura, M. Kudo and N. Ueno: Phys. Rev. B 73 (2006) 245310.
[26] T. Kakudate, N. Yoshimoto and Y. Saito: Appl. Phys. Lett. 90 (2007) 081903.
[27] T. Watanabe, T. Hosokai, T. Koganezawa and N. Yoshimto: Mol. Cryst. Liq. Cryst. 566 (2012) 18-21.。ペンタセン薄膜は、蒸着速度と膜厚の条件を各々0.01 nm/s、30 nmで作製した。
OTFT作製後に試料ホルダーとともにHAXPES測定チャンバーへ搬送し、電圧印加HAXPES測定を行った。励起X線エネルギーは7.94 keVとした。X線は試料表面に対して約10°の条件で入射し、光電子の取り出し角度は80°とした。使用したX線のビームサイズは縦0.02 mm横0.2 mmで、OTFTに対するフットプリントはチャネル長方向、チャネル幅方向でそれぞれに0.02 mm、1 mmとなっている。またパスエネルギーは200 eVとし、Au 4f、C 1s、Si 1sのスペクトルを取得した。
光電子分光器はScienta Omicron社製のR4000L1-10kVを使用した。本実験のHAXPES測定では、図4で示すようにソース電極、ドレイン電極、チャネルを7分割したHAXPESマッピング測定を実施した。Vds、Vgsの印加には、2台のKeithley 6517Aを使用した。印加電圧は、Vds = 0 V、Vgs = 0 V(ゼロバイアス)および、Vds = -20 V、Vgs = -30 V(OTFTオン)とし、それぞれの印加条件下でHAXPESのマッピング測定を実施した。また、電圧印加HAXPES測定前後においてOTFTの電気特性として伝達特性(ドレイン・ソース電流のVgs依存性)を評価した。
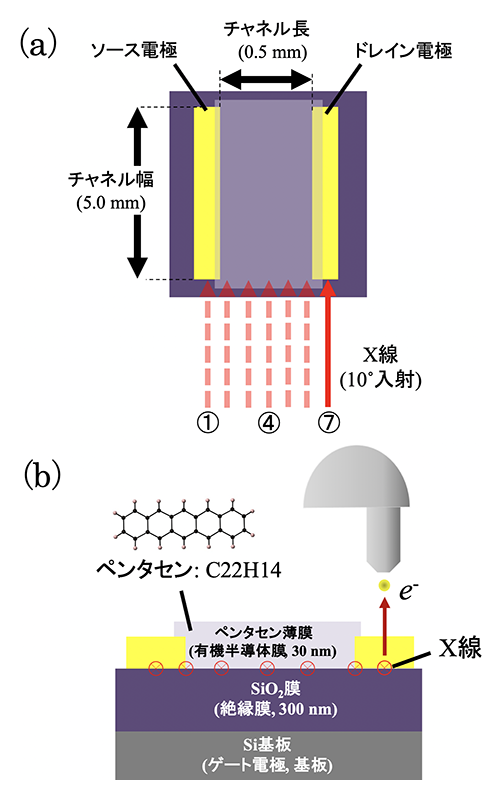
図4 HAXPESのマッピング測定の概要。(a) 上面図、(b) 断面図。図ではチャネル長方向とチャネル幅方向の長さの比率を変えている。
3. 実験結果
3-1. OTFT大気非曝露
図5(a)には、ゼロバイアス時のHAXPESマッピング測定で得られたC 1s、Si 1sスペクトルを示す。各スペクトルの縦軸は光電子強度、横軸は光電子の運動エネルギーである。各チャネルおよび電極位置においても、C 1sは7654.5 eV、Si 1sは6095.5 eV近傍に各々ピークが観察されていることが分かる。今回の測定では、有機半導体層だけでなく各薄膜下に存在する絶縁膜からのスペクトルが得られている。HAXPES測定では、従来の手法では困難であった深部や界面領域の知見も獲得できていることを改めて強調したい。本実験で観察されたC 1s、Si 1sのスペクトルは各々ペンタセン薄膜、SiO2膜に由来すると考えられる[19][19] I. Hirosawa, T. Watanabe, H. Oji, S. Yasuno, T. Koganezawa, K. Tada and N. Yoshimoto: Jpn. J. Appl. Phys. 55 (2016) 03DD09.。これらの結果より、観察されたC 1sスペクトルは絶縁膜界面近傍に形成されているペンタセン薄膜深部の状態も反映していると考えられる。さらに疑フォークト関数による当てはめを行うことで、得られた光電子スペクトルのピークとなる光電子運動エネルギーを見積もった。当てはめによって見積もられたC 1s、Si 1sのピークエネルギーとソース電極からの距離との関係をプロットしたものを図5(b)に示す。ここで、ソース電極からの距離とは、ソース電極下(図4(a)①に対応)を原点とするドレイン電極下(図4(a)⑦に対応)までの距離を示す。ソース電極下とドレイン電極下のピークエネルギーを比較すると0.10 eV以下のわずかな差異であったのに対し、チャネルと電極下を比べるとチャネルで高エネルギー側に0.15−0.20 eV程度の有意なシフトが観察された。これはゼロバイアスの印加によって、電極下の有機薄膜とチャネル部分の有機薄膜との間に電位差が発生したことを示している。このときSi 1s側は、ソース・ドレイン電極に比べ低エネルギー側に0.15−0.20 eV程度シフトしており、ゼロバイアス印加によって有機半導体内部と同程度の電位差が絶縁膜側でも発生していた。これはペンタセンと絶縁膜界面に形成された電気二重層を反映したものであると考えられる。
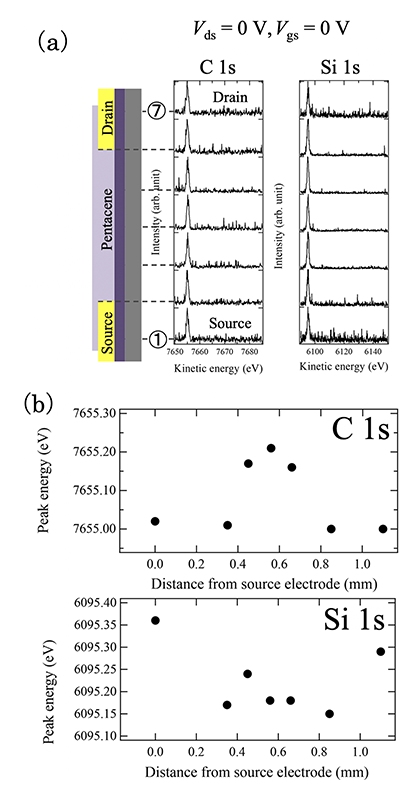
図5 (a) ゼロバイアス時のHAXPESマッピング測定で得られたC 1s、Si 1sスペクトル。(b) 見積もられたC 1s、Si 1sピークエネルギーとソース電極からの距離との関係。
図6には、OTFTオン時のHAXPESマッピング測定で得られたC 1sスペクトルを示す。OTFTを動作状態にすると、ソース電極からの距離の増大に伴って高エネルギー側にピークエネルギーがシフトしていることが明らかとなった。このことから、ペンタセン薄膜ではソース電極からの距離に対して電位が連続的に変化したと示唆される。このように我々は開発したシステムを用いることで、大気非曝露環境下OTFT動作中における有機薄膜深部の情報を含むソース、ドレイン間の電位分布を観察することに成功した。ボトムコンタクト型OTFTは、表面近傍でもソース電極からの距離に依存した電位分布を形成することが報告されている[7,8,14][7] L. Bürgi, H. Sirringhaus and R. H. Friend: Appl. Phys. Lett. 80 (2002) 2913.
[8] J. A. Nichols, D. J. Gundlach and T. N. Jackson: Appl. Phys. Lett. 83 (2003) 2366.
[14] K. P. Puntambekar, P. V. Pesavento and C. D. Frisbie: Appl. Phys. Lett. 83 (2003) 5539.。今回の結果は、これらの報告と比較しても矛盾のない結果が得られた。一方で、本実験により我々が取得した各々のC 1sスペクトルは、ソース電極からの距離と平行な水平方向だけでなく、深さ方向の電位の情報が反映されている。今後は水平方向のマッピング測定だけでなく、深さ分析を併せて実施することで、深さ方向と水平方向に発生する電位を切り分けた検討を行っていきたい。

図6 大気非曝露下OTFTオン時のHAXPESマッピング測定で得られたC 1sスペクトル。
3-2. OTFT大気曝露
図7には、大気曝露前後におけるOTFTの伝達特性を示す。電気特性の評価は、大気曝露後60分大気圧で放置した後に真空環境(1.0 × 10-5 Pa)へ戻して実施した。作製したOTFTは、大気曝露に関係なくp型トランジスタとして動作することを確認した。また大気曝露することでVthは-5.93 Vから0.46 Vへとプラス側にシフトしていた。このVthの変化は、有機半導体層への酸素のドーピングによって形成されたアクセプタ準位が主要因として考えられる[4][4] D. Knipp, A. Benor, V. Wanger and T. Muck: J. Appl. Phys. 101 (2007) 044504.。さらに得られた伝達特性から、移動度(μh)に及ぼす大気曝露の効果を確認するため大気曝露前後におけるμhを比較した。μhは、
Ids = μh (WCOX / 2L) (Vgs − Vth)2 … (1)
と記述される。Ids、COXはそれぞれ、ドレイン電流とSiO2の静電容量を示している。μhは大気曝露前の1.9 × 10-3 cm2V-1s-1から1.6 × 10-3 cm2V-1s-1と80%程度低下しており、Knippらの報告と矛盾のない結果が得られた[4][4] D. Knipp, A. Benor, V. Wanger and T. Muck: J. Appl. Phys. 101 (2007) 044504.。
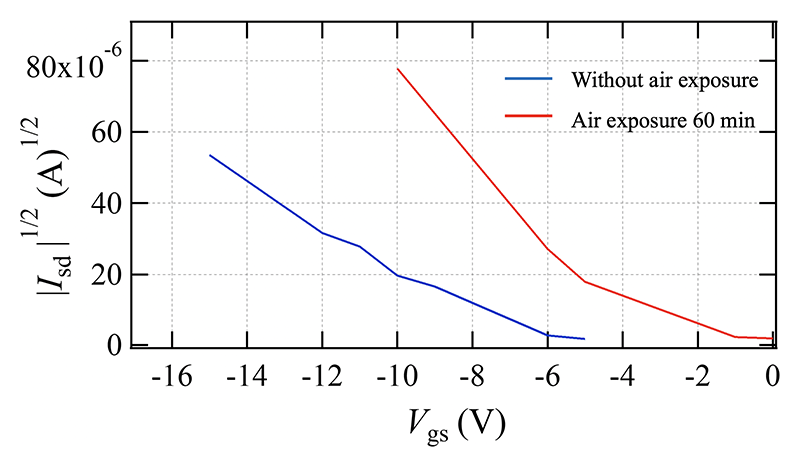
図7 大気曝露前後におけるOTFTの伝達特性。
3-3. OTFT大気曝露後のHAXPES測定
電気特性の評価に続いてOTFT動作中のHAXPESマッピング測定を行った。大気曝露後OTFTオン時のC 1sスペクトル、大気曝露前後におけるC 1sスペクトルのピークエネルギーとソース電極からの距離との関係をプロットしたものを図8(a),(b)にそれぞれ示す。大気曝露前後のピークエネルギーを比較すると、チャネル内部でピークエネルギーが低エネルギー側に0.50−2.40 eV程度シフトしたことが分かった。このことは大気曝露前後でチャネル内部に形成される電位分布が変化することを示している。大気曝露前後のHAXPES測定と電気特性の結果を併せると、この理由は以下のように考察できる。大気曝露することで、ソース・ドレイン電極/ペンタセン薄膜界面近傍のペンタセン薄膜内部に酸素がドーピングされアクセプタ準位が形成される。このアクセプタ準位の存在によって電位降下が発生した結果、ピークシフトが観察されたと考えられる。Knippらの報告でも、アクセプタ準位密度は、結晶粒界密度が高くなる電極/ペンタセン薄膜界面近傍で形成されやすいという結果が示されている[4][4] D. Knipp, A. Benor, V. Wanger and T. Muck: J. Appl. Phys. 101 (2007) 044504.。今後は走査型原子間力顕微鏡や薄膜X線回折法による結晶評価を組み合わせて、電子状態と結晶状態の観点から大気曝露の効果を詳細に検討したい。

図8 (a) 大気曝露後OTFTオン時のHAXPESマッピング測定で得られたC 1sスペクトル。(b) 大気曝露前後におけるC 1sピークエネルギーとソース電極からの距離との関係。
4. まとめ
本研究では、大気非曝露でOTFT作製、電気特性評価および電圧印加HAXPES測定を可能とする計測システムを開発した。さらに開発した計測システムを用いて大気曝露前後のOTFT電位分布を調べることで、大気曝露がOTFT膜内の電位分布に及ぼす効果を検討した。この結果、ペンタセン薄膜内部への酸素ドーピング由来と推定されるアクセプタ準位の形成に起因する電圧降下を観察することができた。
しかしながら、本手法は未だ開発途上の技術であり、多くの課題を残している。特に今後は深さ分析とマッピング測定を組み合わせた、OTFT動作中の二次元電位分布の検討が必須である。現在、我々は励起エネルギー依存性を調べることでOTFTの電位分布の深さ分析に取り組む計画である。一方でOTFT動作中の絶縁膜の電位分布を検討する試みは、HAXPES測定にしかできない。今後は有機半導体薄膜、絶縁膜を含めた電位分布の検討を進めることで、大気曝露の効果をより定量的に検討していきたいと考えている。
謝辞
本研究は、公益財団法人高輝度光科学研究センター理事長ファンドの支援を受けて実施した。また実験はBL46XU(課題番号:2017A1608および2020A1892)で実施した。研究の遂行にあたっては、高輝度光科学研究センターの安野聡氏、陰地宏氏(現:名古屋大学)、大麻隆彦氏、廣沢一郎氏(現:九州シンクロトロン光研究センター)、岩手大学の吉本則之氏から多くの助言をいただいた。ここに深く感謝する。
参考文献
[1] G. Horowitz, X. Peng, D. Fichou and F. Garnier: J. Appl. Phys. 67 (1990) 528.
[2] M. A. Alam, A. Dodabalapur and M. R. Pinto: IEEE Trans. Electron Devices 44 (1997) 1332-1337.
[3] A. R. Brown, C. P. Jarret, D. M. de Leeuw and M. Matters: Synth. Metals 88 (1997) 37-55.
[4] D. Knipp, A. Benor, V. Wanger and T. Muck: J. Appl. Phys. 101 (2007) 044504.
[5] H. Yang, L. Yang, M.-M. Ling, S. Lastella, D. D. Gandhi, G. Ramanath, Z. Bao and C. Y. Ryu: J. Phys. Chem. C 112 (2008) 16161-16165.
[6] T. Watanabe, T. Koganezawa, M. Kikuchi, C. Videlot-Ackermann, J. Ackermann, H. Brisset, N. Yoshimoto and I. Hirosawa: J. Cryst. Growth 468 (2017) 816-820.
[7] L. Bürgi, H. Sirringhaus and R. H. Friend: Appl. Phys. Lett. 80 (2002) 2913.
[8] J. A. Nichols, D. J. Gundlach and T. N. Jackson: Appl. Phys. Lett. 83 (2003) 2366.
[9] N. J. Watkins and Y. Gao: J. Appl. Phys. 94 (2003) 5782.
[10] M. Nakamura, N. Goto, N. Ohashi, M. Sakai and K. Kudo: Appl. Phys. Lett. 86 (2005) 122112.
[11] L. Chen, R. Ludeke, X. Cui, A. G. Schrott, C. R. Kagan and L. E. Brus: J. Phys. Chem. B 109 (2005) 1834-1838.
[12] S. Ikeda, T. Shimada, M. Kiguchi and K. Saiki: J. Appl. Phys. 101 (2007) 094509.
[13] N. Nagamura, Y. Kitada, J. Tsurumi, H. Matsui, K. Horiba, I. Honma, J. Takeya and M. Oshima: Appl. Phys. Lett. 106 (2015) 251604.
[14] K. P. Puntambekar, P. V. Pesavento and C. D. Frisbie: Appl. Phys. Lett. 83 (2003) 5539.
[15] Y. Yamashita, K. Ohmori, S. Ueda, H. Yoshikawa, T. Chikyow and K. Kobayashi: e-J. Surf. Sci. Nanotech. 8 (2010) 81-83.
[16] J. Ikeuchi, H. Hamamatsu, T. Miyamoto, S. Tanaka, Y. Yamashita, H. Yoshikawa and S. Ueda: J. Appl. Phys. 118 (2015) 085308.
[17] K. Kobayashi, M. Yabashi, Y. Tanaka, T. Tokushima, S. Shin, K. Tamasaku, D. Miwa, T. Ishikawa, H. Nohira, T. Hattori, Y. Sugita, O. Nakatsuka, A. Sakai and S. Zaima: Appl. Phys. Lett. 83 (2003) 1005.
[18] T. Watanabe, K. Tada, S. Yasuno, H. Oji, N. Yoshimoto and I. Hirosawa: Jpn. J. Appl. Phys. 55 (2016) 03DD12.
[19] I. Hirosawa, T. Watanabe, H. Oji, S. Yasuno, T. Koganezawa, K. Tada and N. Yoshimoto: Jpn. J. Appl. Phys. 55 (2016) 03DD09.
[20] S. Yasuno, T. Watanabe and S. Ishimaru: J. Surf. Anal. 24 (2017) 136-140.
[21] H. Oji, Y.-T. Cui, J.-Y. Son, T. Matsumoto, T. Koganezawa and S. Yasuno: J. Surf. Anal. 21 (2015) 121-129.
[22] S. Yasuno, H. Oji, T. Koganezawa and T.Watanabe: AIP Conf. Proc. 1741 (2016) 030020.
[23] R. B. Campbell, J. M. Robertson and J. Trotter: Acta Cryst. 14 (1961) 705-711.
[24] A. R. Völkel, R. A. Street and D. Knipp: Phys. Rev. B 66 (2002) 195336.
[25] H. Fukagawa, H. Yamane, T. Kataoka, S. Kera, M. Nakamura, M. Kudo and N. Ueno: Phys. Rev. B 73 (2006) 245310.
[26] T. Kakudate, N. Yoshimoto and Y. Saito: Appl. Phys. Lett. 90 (2007) 081903.
[27] T. Watanabe, T. Hosokai, T. Koganezawa and N. Yoshimto: Mol. Cryst. Liq. Cryst. 566 (2012) 18-21.
(公財)高輝度光科学研究センター
放射光利用研究基盤センター 産業利用・産学連携推進室
〒679-5198 兵庫県佐用郡佐用町光都1-1-1
TEL : 0791-58-0924
e-mail : t5511001@spring8.or.jp








