Volume 22, No.4 Pages 306 - 309
1. 最近の研究から/FROM LATEST RESEARCH
専用ビームラインの研究から ~BL11XU(量子科学技術研究開発機構)~
その場X線回折による窒化物半導体薄膜の結晶成長観察
Observation of Crystal Growth Dynamics in Nitride Semiconductors by in situ X-ray Diffraction
(国)量子科学技術研究開発機構 放射光科学研究センター Synchrotron Radiation Research Center, National Institutes for Quantum and Radiological Science and Technology
- Abstract
- 窒化ガリウム(GaN)薄膜の成長初期にのみ発現する特異な格子変形現象を報告する。SPring-8、量研(QST)専用ビームラインBL11XUでは、結晶成長装置とX線回折計が一体化した独自のその場測定装置を有している。本研究は、GaN薄膜成長中のその場X線回折を原子層オーダーの膜厚分解能で測定し、GaNの面内および面内垂直方向の格子間隔の変化を詳細に調べた。その結果、膜厚数ナノメートルの成長初期にのみ、従来の弾性変形とは異なる特異な格子変形を見出した。この現象を理解するため、従来の弾性ひずみに加えて、点欠陥の混入による単位格子の膨張効果を取り入れた格子変形モデルを構築し、実験結果を良く再現することができた。このことから、GaN薄膜は基板との格子不整合によって生じる弾性ひずみがきっかけとなり、置換型の点欠陥(アンチサイト欠陥)が形成されやすいことを示唆した。これまで見過ごされていた成長初期の点欠陥の混入は、GaNベースの発光および電子デバイスの構造設計において重要な知見を与えるものと考える。
1. はじめに
窒化ガリウム(GaN)に代表される窒化物半導体はLEDやレーザといった発光デバイスだけでなく、高周波・パワーデバイスとしても研究開発が盛んであり、応用範囲の拡大がなお一層期待されている。さらに、GaNは絶縁破壊電界および飽和電子速度が高く、従来のシリコン(Si)やガリウムヒ素(GaAs)では成し得なかった消費電力の大幅な削減が期待でき、省エネルギー社会の実現に向けてもさらなる普及が求められている。
GaNは1994年の高輝度青色LED[1][1] S. Nakamura, T. Mukai and M. Senoh: Appl. Phys. Lett. 64 (1994) 1687.が発表されて以降、比較的短期間で普及に至ったという経緯がある。それはこれまでのSiやGaAsで培ってきたデバイスプロセスを踏襲したことによる要因が大きい。しかし、ここにきて、GaN本来の優れた物性値をデバイス性能として最大限引き出すには、欠陥やひずみといった結晶成長の基礎を十分に理解し、上手く制御することの重要性が再認識されている。GaNの薄膜を例にとると、基板材料の選定や極性面の相性に応じて、SiやGaAsには現れない特異な欠陥構造[2-4][2] C. Kisielowski, J. Krüger, S. Ruvimov, T. Suski, J. W. Ager III, E. Jones, Z. Liliental-Weber, M. Rubin, E. R. Weber, M. D. Bremser and R. F. Davis: Phys. Rev. B 54 (1996) 17745.
[3] K. Shojiki, T. Hanada, T. Tanikawa, Y. Imai, S. Kimura, R. Nonoda, S. Kuboya, R. Katayama and T. Matsuoka: Jpn. J. Appl. Phys. 55 (2016) 05FA09.
[4] H. Miyake, G. Nishio, S. Suzuki, K. Hiramatsu, H. Fukuyama, J. Kaur and N. Kuwano: Appl. Phys. Express 9 (2016) 025501.が存在するなど明らかにすべき課題は多い。さらに、評価手法が極めて限定されることから、膜厚数ナノメートルという成長初期の欠陥やひずみの状態は明らかになっていない。
我々は実験室クラスのX線では検出が困難とされてきた薄膜成長初期の状態を、高輝度の放射光X線を用いることで評価できると考えた。さらに、放射光X線を用いた評価を、薄膜成長中に行うことができれば、成長初期の欠陥やひずみが成長の進行とともにどのように変化し、最終状態に至るのか、つまり、結晶成長のダイナミクスが解明できると考えた。これら知見は、GaN薄膜の欠陥やひずみの制御に極めて有用であることから、我々はSPring-8、量研(QST)専用ビームラインBL11XUに結晶成長その場X線回折装置を独自に開発した[5][5] T. Sasaki, F. Ishikawa, T. Yamaguchi and M. Takahasi: Jpn. J. Appl. Phys. 55 (2016) 05FB05.。その場X線回折は、同じその場測定である反射高速電子線回折(RHEED)[6,7][6] G. Koblmüller, R. Averbeck, H. Riechert, Y.-J. Hyun and P. Pongratz: Appl. Phys. Lett. 93 (2008) 243105.
[7] E. Bellet-Amalric, C. Adelmann, E. Sarigiannidou, J. L. Rouvière, G. Feuillet, E. Monroy and B. Daudin: J. Appl. Phys. 95 (2004) 1127.と比較して、GaN結晶の面内および面内垂直方向の格子間隔を抽出できるため、成長初期の薄膜の状態の解明に極めて有用である。本稿では、結晶成長その場X線回折装置を用いて新たに見出されたGaN薄膜の成長初期にのみ発現する、点欠陥を含んだ特異な格子変形現象を報告する[8][8] T. Sasaki, F. Ishikawa and M. Takahasi: Appl. Phys. Lett. 108 (2016) 012102.。
2. 結晶成長その場X線回折装置
BL11XU実験ハッチ3では、分子線エピタキシー(MBE)装置とX線回折計(XRD)が一体化したMBE-XRDシステムを有しており、これまでにGaAs系半導体のその場X線回折を行ってきた[9][9] M. Takahasi: J. Phys. Soc. Jpn. 82 (2013) 021011.。そして、欠陥やストレス、表面・界面の挙動を多角的に明らかにしてきた。これまでは、GaAs系半導体に特化していたが、今回、文部科学省ナノテクノロジープラットフォームの研究支援の一環として、窒化物半導体用のMBE装置を導入した。そして、2014年にはX線回折計と接続し(図1)、2015年から本格稼働している。装置構成の詳細は参考文献[5]を参照していただきたい。

図1 SPring-8/BL11XU実験ハッチ3に設置した結晶成長その場X線回折装置。
3. 実験
実験は図2に示す測定配置で、6H-SiC(0001)基板上にGaN薄膜を結晶成長しながら、X線回折測定を実施した。成長温度は675°C、GaとNの原料供給比(Ga/N)は1.5である。X線のエネルギーは20 keV、ビームサイズは0.1 × 0.1 mm2である。測定はSiC-103ブラッグ反射付近の逆格子マップ(H-L面)を測定した。1測定あたりの時間は7秒で、これはGaNの膜厚に換算すると約0.25 nmに対応する。GaNは1原子層あたり約0.5 nmであるため、今回の測定では、およそ半原子層成長するたびに、データを取得しており、原子層オーダーでの結晶成長ダイナミクスを評価していることになる。回折X線はピクセルアレイ検出器(PILATUS 100K)を用いた。HおよびL方向における角度分解能は0.014°である。
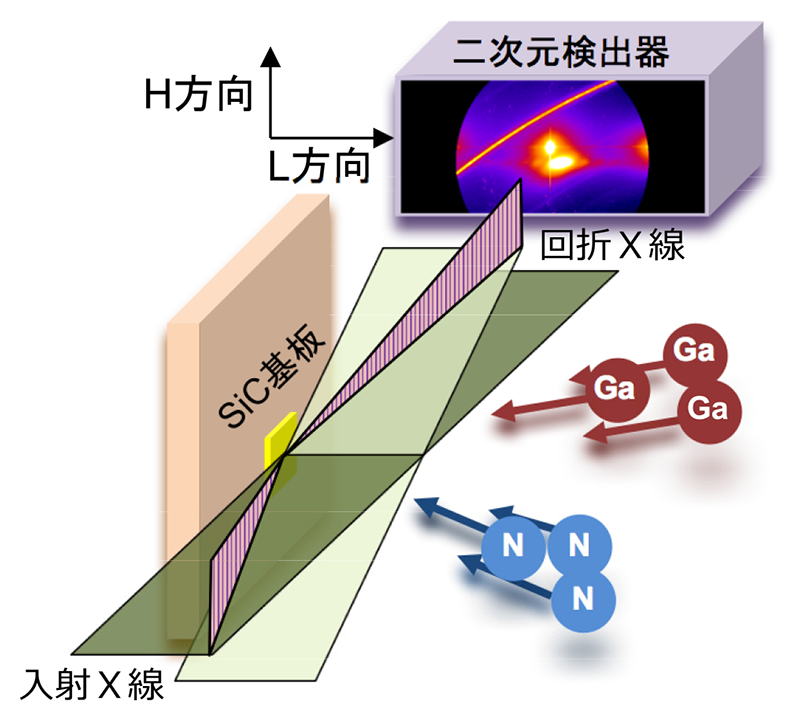
図2 その場X線回折の測定配置。炭化ケイ素(SiC)基板上にGaN薄膜を結晶成長し、同時にX線回折を測定した。
4. 結果
図3にGaN薄膜の成長初期10 nmまでの逆格子マップを示す。横軸は面内方向[100]に対応するH方向、縦軸は面内垂直方向[001]に対応するL方向である。GaN成長前は基板のSiC-103回折ピークのみが観測されるが、膜厚が0.8 nmを超えると、GaN-101回折ピークが現れた。このことは、放射光X線を用いることで、わずか2原子層程度の薄膜でも格子変形の様子を定量的に捉えられることを意味する。

図3 GaN薄膜成長中の逆格子マップの変化。GaNの膜厚の増加とともに、GaN-101回折ピークの出現やピーク位置が変化していることがわかる。
図4はGaNの格子間隔を反映する回折ピークの位置をL方向とH方向でそれぞれプロットしたものである。基板であるSiCに対して、GaNの格子定数は大きいため、従来の常識とされている弾性変形の場合は、L方向の格子間隔が小さくなる分だけ、H方向の格子間隔が大きくなるように、両方向が連動して完全ひずみから完全緩和の状態に格子変形すると考えられてきた。しかし、実験結果を見てみると、H方向はほとんど変化しないのに対して、L方向では著しく格子間隔が小さくなり、従来の弾性変形とは明らかに異なる挙動を示すことがわかった。ただし、膜厚が10 nm程度にまで達すると、H方向、L方向ともに完全緩和に対応するところに回折ピークが移動することから、この特異な格子変形は膜厚数ナノメートルの成長初期にのみ発現することがわかった。
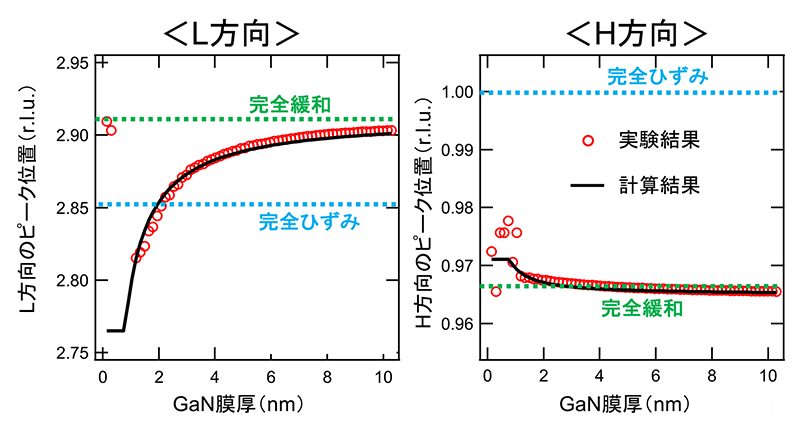
図4 GaN薄膜成長中の回折ピーク位置の変化。単位r.l.u.は、reciprocal lattice unitsの略で逆格子の単位である。値が大きい(小さい)ほど、GaNの格子間隔は小さい(大きい)ことに対応する。
この格子変形を理解するため、従来の弾性ひずみ(格子不整合GaN/SiCの場合は圧縮ひずみ)に加えて、NサイトにGa原子が置き換わる置換型の点欠陥(Gaアンチサイト)による単位格子の膨張効果を考慮した(図5)。その理由として、GaNはGaとNの原子半径の差が大きいため、圧縮ひずみによってアンチサイト欠陥ができやすいという報告がある[2][2] C. Kisielowski, J. Krüger, S. Ruvimov, T. Suski, J. W. Ager III, E. Jones, Z. Liliental-Weber, M. Rubin, E. R. Weber, M. D. Bremser and R. F. Davis: Phys. Rev. B 54 (1996) 17745.。さらに、今回のGaN薄膜の成長条件は、Ga/N供給比が1よりも大きいGa過剰条件であるため、Gaアンチサイトができやすいと考えた。そして、従来の圧縮ひずみとGaアンチサイトによる体積膨張の2種類の格子変形を考慮することで、図4の計算結果に示すように実験結果を良く再現できた。その際にパラメータとして用いたGaアンチサイトの密度は成長開始時には1020 cm−3オーダーと非常に高く、膜厚の増加とともに減少することがわかった[8][8] T. Sasaki, F. Ishikawa and M. Takahasi: Appl. Phys. Lett. 108 (2016) 012102.。つまり、膜厚の増加とともに、ひずみ緩和によって圧縮ひずみも減少していくが、それに伴ってGaアンチサイトによる体積膨張の効果も弱まっていくことが予想される。そして、結晶成長が進行し、膜厚が10 nm程度まで達すると、Gaアンチサイトによる体積膨張の効果は消滅し、従来の弾性的な格子変形を示すと考えられる。
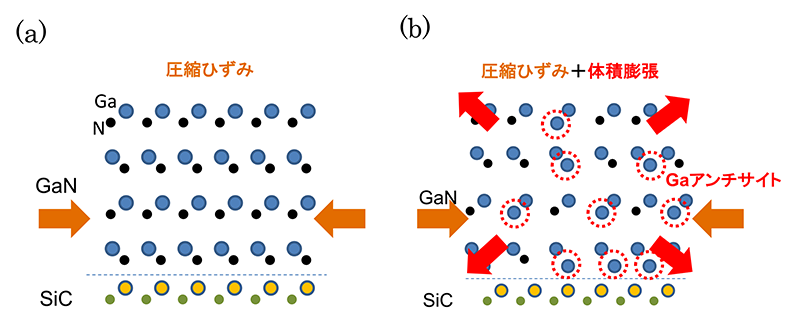
図5 SiC基板上のGaN薄膜の格子変形の様子。従来の常識は、弾性的な圧縮ひずみによる格子変形(a)であるが、本研究では圧縮ひずみとGaアンチサイトによる体積膨張の複合的な格子変形(b)を提案した。
5. まとめ
結晶成長その場X線回折装置を用いて、GaN薄膜成長中の格子変形の様子をリアルタイム観察した。その結果、GaN薄膜は成長初期にかぎって、アンチサイト欠陥を含んだ特異な格子変形を示すことがわかった。さらに、本研究で提案する格子変形モデルから、アンチサイト欠陥の密度を定量評価することができた。将来的には、これらの知見をもとにGaN薄膜の成長条件を最適化し、点欠陥の混入を抑制した高品質薄膜を作製することが可能になると期待する。
謝辞
本研究は愛媛大学の石川史太郎准教授との共同研究で実施したもので、実験データは、SPring-8の量研(QST)専用ビームラインBL11XUにて測定した。課題番号は、2014B3503、2015A3503である。
参考文献
[1] S. Nakamura, T. Mukai and M. Senoh: Appl. Phys. Lett. 64 (1994) 1687.
[2] C. Kisielowski, J. Krüger, S. Ruvimov, T. Suski, J. W. Ager III, E. Jones, Z. Liliental-Weber, M. Rubin, E. R. Weber, M. D. Bremser and R. F. Davis: Phys. Rev. B 54 (1996) 17745.
[3] K. Shojiki, T. Hanada, T. Tanikawa, Y. Imai, S. Kimura, R. Nonoda, S. Kuboya, R. Katayama and T. Matsuoka: Jpn. J. Appl. Phys. 55 (2016) 05FA09.
[4] H. Miyake, G. Nishio, S. Suzuki, K. Hiramatsu, H. Fukuyama, J. Kaur and N. Kuwano: Appl. Phys. Express 9 (2016) 025501.
[5] T. Sasaki, F. Ishikawa, T. Yamaguchi and M. Takahasi: Jpn. J. Appl. Phys. 55 (2016) 05FB05.
[6] G. Koblmüller, R. Averbeck, H. Riechert, Y.-J. Hyun and P. Pongratz: Appl. Phys. Lett. 93 (2008) 243105.
[7] E. Bellet-Amalric, C. Adelmann, E. Sarigiannidou, J. L. Rouvière, G. Feuillet, E. Monroy and B. Daudin: J. Appl. Phys. 95 (2004) 1127.
[8] T. Sasaki, F. Ishikawa and M. Takahasi: Appl. Phys. Lett. 108 (2016) 012102.
[9] M. Takahasi: J. Phys. Soc. Jpn. 82 (2013) 021011.
(国)量子科学技術研究開発機構 放射光科学研究センター
〒679-5198 兵庫県佐用郡佐用町光都1-1-1
TEL : 0791-58-1047
e-mail : sasaki.takuo@qst.go.jp
(国)量子科学技術研究開発機構 放射光科学研究センター
〒679-5198 兵庫県佐用郡佐用町光都1-1-1
TEL : 0791-58-0821
e-mail : takahashi.masamitsu@qst.go.jp
BL11XU、BL14B1、BL22XUに設置のQST放射光実験装置のご利用を希望される方は、QST微細構造解析プラットフォーム事務局(ml-qst-nanoinfo[at]qst.go.jp)に御相談ください。
利用相談は随時無料で受け付けています。
装置の概要や利用方法については、JAEA・QST微細構造解析プラットフォームの専用ウェブサイトをご覧ください。
http://www.kansai.qst.go.jp/nano/








