Volume 13, No.1 Pages 50 - 55
4. 利用者懇談会研究会報告/RESEARCH GROUP REPORT (SPring-8 USERS SOCIETY)
X線トポグラフィ研究会の現状報告
Current Activities of the X-ray Diffraction Topography Group
[1]富山大学 理学部 Faculty of Science, University of Toyama、[2]大阪大学 大学院工学研究科 Graduate School of Engineering, Osaka University、[3](財)高輝度光科学研究センター 産業利用推進室 Industrial Application Division, JASRI
1. 設立趣旨と活動方針
結晶性物質内には単位胞から結晶の外形に至るまでの種々の階層レベルの空間スケールにおいて種々の高次構造が存在することが知られており、それらがその物質の示す特性・機能と深く係っていることが知られている。X線トポグラフィは結晶中の高次構造、構造不均一の実空間分布をX線の回折・散乱によってコントラストをつけて可視化しようとするイメージング手法である。高次構造の中でも特に、電子密度分布の差が小さく、X線に大きな位相変化をもたらすような構造変化(例えば転位や積層欠陥のようなもの)を高いコントラスト比で、非破壊で可視化するときに威力を発揮する。
X線トポグラフィ研究会はX線トポグラフィビームラインサブグループを引き継いだ形で2006年4月に設立された研究会である[1][1] X線トポグラフィ研究会のHPが開設されています。URLはhttp://www-asf.mls.eng.osaka-u.ac.jp/Xtopo/。現在の会員数は24名である。本研究会の活動目的はX線トポグラフィ技術の開発・改良とその利活用に関する科学・関連工学を探求することである。先端的X線トポグラフィ技術の開発においてはSPring-8シンクロトロン放射光の大強度、高輝度、高エネルギー、高干渉性などの特徴を十分に生かし、空間分解能、実時間観察の時間分解能、コントラスト比の飛躍的向上を目指す。開発された技術・手法の適用範囲を従来観察評価が困難であったようなものへと格段に広げる。新たに開発された回折イメージング技法の適用範囲拡大においては、各種無機および有機人工結晶、人工多層膜、人工不均一構造の評価だけではなく、電子デバイスなどの内部に存在する格子欠陥や格子ひずみを非破壊的に観測し、デバイス特性の最適化・高性能化に資することなどを通して、産業利用を志向するグループとの連携・共同を強化する。研究会の具体的な活動としては、X線トポグラフィおよび関連技術に関する最新情報の交換と新規アイデアの醸成を目的とした研究会会合を企画立案・開催する。
SPring-8におけるX線トポグラフィ実験は、主としてBL20B2とBL28B2で実施されている[2,3][2] Y. Chikaura et al.: J. Phys. D: Appl. Phys. 34 (2001) A158-A162.
[3] 近浦ほか:応用物理 71 (2002) 1386-1390.。BL28B2では白色X線が利用できる。X線の画像検出器としては、X線フィルム、原子核乾板、イメージングプレート、CCDを基とする可視光変換型の二次元検出器、CMOSセンサーを基とするフラットパネル検出器などが利用できる。また、低温用クライオスタットや高温電気炉なども準備されている。これらの装置を用いて、ラウエ法トポグラフィが種々の結晶に適用されている。ラウエ法トポグラフィは完全性の高い結晶から完全性の低い結晶まで、広い適用範囲を持つ。試料結晶の温度などの外的条件を変えても常に回折スポットがあるので、実時間観察などで威力を発揮する。また、白色マイクロX線とX線半導体検出器とを組み合わせて走査型のイメージングも行われている。BL20B2は単色X線が利用できる200 m長のビームラインである。大きなビームサイズ、高い平行度、などの特徴を生かした単色X線トポグラフィが実施されている。これら2つのビームライン以外でも、BL20XU、BL16B2、BL24XUなどで本研究会会員による回折イメージングの研究が実施されている。
2. 研究会開催、活動等の報告
平成18年度
2007年1月13日に放射光学会年会にあわせて、研究会を広島国際会議場内において開催した。10名の参加を得て、X線回折トポグラフィに関する最近の情報の会員相互による共有と意見交換を行った。議事内容は、旧トポグラフィビームラインサブグループからX線トポグラフィ研究会への移行の経過報告(富山大学、飯田敏)、BL28B2の課題採択状況や実験ハッチ改造計画(JASRI、梶原堅太郎)、GaNの逆格子マッピング法による研究紹介(九州工業大学、鈴木芳文)、国際会議XTOP2006における話題紹介(九州工業大学、鈴木芳文)、白色X線トポ・トモグラフィ的手法による単結晶評価(ZnTeや有機強磁性結晶)に関する研究紹介(島根大学、水野薫)であった。参加者全員によるX線トポグラフィ研究会の今後の活動計画についての意見交換も行った。
平成19年度
2007年8月3日に大阪大学、吹田キャンパスにおいて開催した。17名の参加を得て、X線回折トポグラフィに関する最近の情報の会員相互による共有と意見交換を行った。議事内容は次の通りである。(1)新規会員の紹介、研究会の目的、今回のプログラムの注目点(X線トポグラフィの三次元化、SiCのX線トポグラフィ)(富山大学、飯田敏)、(2)出席者全員による自己紹介、(3)気相法有機単結晶の構造評価に関する研究紹介(山口東京理科大学、城貞晴)、(4)伝導性チタン酸ストロンチウムの自発歪に関する研究紹介(広島工業大学、尾崎徹)、(5)共鳴散乱を利用するトポグラフィに関する研究紹介(埼玉工業大学、根岸利一郎)、(6)ステップスキャニングセクショントポグラフィによるSi転位の三次元分布に関する研究紹介(JASRI、梶原堅太郎)、(7)硬X線マイクロビーム回折イメージングによるSiの微小欠陥観察に関する研究紹介(九州シンクロトロン光研究センター、川戸清爾)、(8)マイクロビームX線3Dトポグラフィに関する研究紹介(富士電機アドバンストテクノロジー㈱、田沼良平)、(9)SiCのトポグラフィに関する研究紹介(豊田中央研究所、山口聡)、(10)材料/デバイス研究者のツールとしてのX線トポグラフィ考と題する話題提供と提案(産業技術総合研究所、山口博隆)
これらの議事内容からこの分野の研究者が対象とする物質は、たんぱく質結晶、有機結晶から無機天然物結晶、産業利用を目指した人工半導体結晶やそれらを用いたデバイスまで、非常に多岐に亘ることがわかる。結晶中の転位や析出物などの格子欠陥の特性評価だけでなく、格子欠陥の発生、伝播、終端の様子の観察からより良い結晶成長条件やデバイスのプロセス条件探索のために知見を得ることを目指している。X線トポグラフは結晶中の三次元高次構造の二次元投影図であったが、X線トポグラフィの三次元化に関する研究紹介があり、その有用性が改めて認識された。従来の二次元検出器を用いたX線トポグラフィとマイクロビームを用いた走査型の回折イメージングの相補的利用が有効であろうことも分かった。
3. 研究例の報告
3-1. 白色X線を用いたステップスキャニングセクショントポグラフィによるシリコン結晶中の転位像の特徴(BL28B2)
転位線の三次元の位置情報は、転位線の発生や伝播のメカニズムを理解するうえで重要な情報である。格子欠陥の三次元分布を観察する手法はトポ・トモグラフィ[4][4] W. Ludwig et al.: J. Appl. Cryst. 34 (2001) 602-607.があるが、BL28B2ではステップスキャニングセクショントポグラフィを用いた格子欠陥の三次元分布観察法が開発された[5][5] T. Mukaide et al.: J. Synchrotron Rad. 13 (2006) 484-488.。ステップスキャニングセクショントポグラフィはトポ・トモグラフィと比較して、実験のセッティングが簡単なことや断面像の再構成に特別な画像処理が必要ないことが特徴である。ステップスキャニングセクショントポグラフィの開発に関する報告では結晶粒の三次元分布が紹介されているが、ここではこの手法の基礎的なデータを取得することを目的に、CZシリコンインゴットのネック部における転位の三次元分布を観察した結果を報告する。
実験の原理を簡単に説明する。完全に近い結晶とシート状に成形した球面波X線とを用いてラウエケースのトポグラフを観察すると、結晶中の格子歪みの分布を示した擬似的な断面像(セクショントポグラフ像)が得られる。試料を走査しながらいくつかの部分の断面像を撮影し、これらの像をコンピュータ上で積み重ねることによって、結晶中の格子歪みの三次元分布を推測することができる。
実験はBL28B2のトポグラフィ実験ステーションで行った。図1に試料写真と実験配置図を示す。
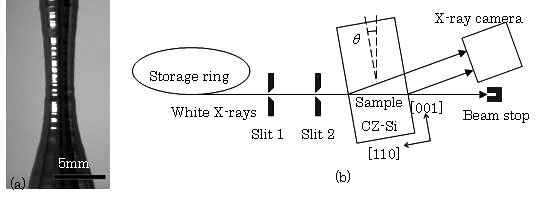
図1 試料写真(a)と実験配置図(b)
偏向電磁石光源から発生した白色X線をスリットで上下方向のサイズを0.03mmに成形し、試料に照射した。<001>方向に引き上げられたCZシリコンインゴットのネック部からの004反射のセクショントポグラフ像を可視光変換型のX線CCDカメラで測定した。段階的に試料を走査し、それに同期して画像を測定した。
20 keVのX線により撮影された代表的なセクショントポグラフ像と再構成した正面からと側面からの断面像を図2に示す。

図2 20 keVのX線による、シリコン単結晶の代表的なセクショントポグラフ像(a)および、再構成した断面像A-A(b)と断面像B-B(c)。
セクショントポグラフ像中に観察された代表的な5つのコントラストを矢印で示した。コントラストi1、i2とi3はそれぞれ転位線のdirect image、intermediary imageおよび dynamical imageである。コントラストi4はペンデル縞である。コントラストi5の起源や発生のメカニズムは不明である。試料表面の凹凸に起因すると推測している。これらの像は再構成像中にも観察されており、再構成像中に矢印で示されたものがそれである。異なるX線エネルギーでも観察を行い、これらのコントラストがエネルギー依存性を有することが分かった。コントラストi1の位置は転位線の位置を示しており、また、強度が強いため、強度の閾値でこのコントラストのみ抽出し、三次元表示することで、転位線の三次元分布を直感的にかつ精度良く理解することが可能である。図3に、この方法で抽出した転位線の三次元分布図を示す。

図3 転位線の三次元分布像
いくつかの転位線について、すべり面や転位線の形状などを調べた結果はトポ・トモグラフィの結果と一致しており、転位線の三次元分布観察が可能であることが分かった[6][6] K. Kajiwara et al.: physica status solidi (a) 204 (2007) 2682-2687.。
3-2. 広領域X線トポグラフィによる歪みSiウェーハの結晶性評価(BL20B2)
シリコンLSIの高性能化は主にデバイスの微細化によってなされてきた。しかしながら、微細化による高性能化は物理的限界を迎えており、微細化に頼らない手法が求められるようになっている。その手法の一つとして、MOSFETs(Metal-oxide-semiconductor field effect transistors)のチャネル領域に歪みSiを導入し、キャリア移動度の向上を図る手法が検討されている。
歪みSiデバイスの作製法のひとつとして、歪みSiウェーハを用いる手法が提案されている。この手法の利点は、比較的大きな歪みを印加することが可能であり、かつ、従来のデバイス作製プロセスに適用が容易であるという点である。しかしながら、歪みSiウェーハの結晶性が悪いという問題があり、実用化に向けてその改善のための努力が勢力的に行われている。 放射光を用いたX線回折法は、非破壊による薄膜の結晶性評価法として非常に有効な方法である。近年の各種分析機器の発達により、試料の局所領域における構造情報を得ることは比較的容易になってきている。しかし、ウェーハサイズでの原子レベルでの結晶性評価は容易ではない。ウェーハよりも大きなビームサイズを用いたX線トポグラフィを適用することにより、ウェーハ全体における結晶不均一性の可視化が可能となる。歪みSiウェーハの実用化のためには、ウェーハ全体での結晶性評価が不可欠であり、本研究では、広領域X線トポグラフィを歪みSiウェーハの評価に適用した。
ここでは、sSOI(strained Si on Insulator)ウェーハと呼ばれる歪みSiウェーハの結果について紹介する。完全に緩和したSiGe基板上にSiをエピタキシャル成長すると、その格子定数の違いのため、面内に伸びた歪みSi層が形成される。sSOIウェーハは水素イオン注入を用いたLayer transfer技術を用いて、この歪みSi層を別のウェーハに酸化膜を介して貼り合わせたものである。歪みSi層の厚さが70 nm、直径300 mmのsSOIウェーハの測定結果について示す。
トポグラフ測定は全長200 mの中尺ビームラインBL20B2にて行った。試料位置での水平方向のビームサイズは最大300 mmであり、12インチのsSOIウェーハ全面について試料を走査することなく一括測定することが可能である。測定のときの配置を図4に示す。ω回転で試料表面へのX線の入射角を決定し、Φ回転でブラッグ条件を満たすように調整を行った。そのときの強度プロファイルを図5に示す。

図4 測定配置図。(a) 上面図、(b) 側面図。
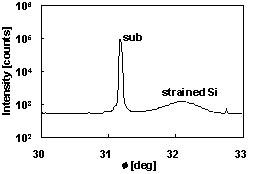
図5 Φスキャンによる強度分布
歪みSi層からの反射が基板からの反射とはっきりと分離して測定されていることがわかる。この反射を用いて測定したトポグラフ像を図6に示す。

図6 歪みSi層のトポグラフ像
[110]方向に走る格子状のコントラストが観測されており、また、ウェーハ全体の均一性も非常に悪いことがわかる。現在は一連のこれらのトポグラフ像から歪みや格子面傾斜分布を抽出するための解析を行っている。
3-3. 平面波X線を用いた回折トポグラフィと局所ゴニオメトリィ(BL20B2 & BL20XU)
完全に近い結晶と平面波X線とを用いてラウエケースの回折強度曲線を測定すると、回折強度曲線に特徴的な強度の振動が観察される。この強度振動は試料結晶中の格子歪みに敏感に応答して変化することが知られている[7,8][7] 石川哲也:応用物理 57(1988)1496-1504.
[8] 木村滋、石川哲也、松井純爾:日本結晶成長学会誌 21(1994)76-87.。従来、平面波X線を用いた回折強度曲線測定は比較的広がった平面波X線と点状X線検出器とを用いて測定されることが通例であった。今回我々は二次元X線検出器と平面波X線を用いて、高い空間分解能(数ミクロンの画素サイズ)で空間分解された局所的回折強度曲線を測定することに成功した。
実験はBL20B2およびBL20XUの医学利用棟実験ステーションで行った。リング棟光学ハッチのSi311あるいは111二結晶モノクロメーターで30keV X線を取り出した。医学利用棟の実験ハッチ2にSi220非対称反射コリメーターを設置し、X線の平行度を高めると共にビームの上下方向の幅を拡大した。
図7に実験配置の模式図を示す。
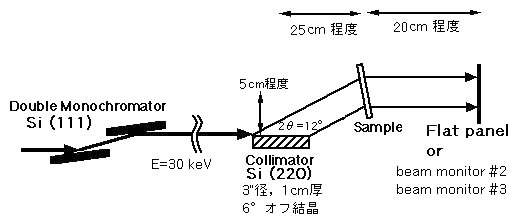
図7 実験配置の模式図
低速引き上げas-grown CZ-Si結晶の220反射平面波X線トポグラフのX線入射角依存性を可視光変換型のX線CCDカメラで測定した。得られた代表的平面波X線トポグラフを図8に示す。

図8 CZシリコン結晶中微小欠陥の平面波X線トポグラフの入射角依存性。ブラッグからのずれを秒角で示してある。
平面波X線トポグラフのX線入射角依存性を再構成することによって、空間分解された回折強度曲線(ロッキングカーブ)を数ミクロンの画素サイズ毎に得ることができる(図9、10参照)。

図9 デジタルトポグラフの組から画像データを再構成することにより回折強度曲線を得る。

図10 空間分解された回折強度曲線の例。微小欠陥近傍の歪んだ領域の回折強度曲線と欠陥から離れた領域の回折強度曲線とを比較した。
この手法は局所的格子歪みの精密測定が重要になる分野で特に有効である。今後この手法を、より空間分解の高い方向へ、より測定時間を短縮し実時間観察へとつなげる方向へ、より多様な物質の構造評価へと発展させる必要がある。
4. 終わりに
X線トポグラフィは比較的古い(歴史と伝統のある)X線イメージング手法の一つであるが、シンクロトロン放射光の高度な利用とデジタル二次元検出器の高性能化で今後ますます進展するものと期待される。X線トポグラフィの特徴である広い観察領域の確保と、高い空間分解能と実時間分解能との両立を目指したい。実験技術的には重なる部分もある他のX線イメージング手法の研究グループとの交流、連携を進めてゆきたい。X線トポグラフィ実験手法の高度化だけでなくその手法の適用範囲も、これまでの比較的結晶完全性の高い試料からより完全性が高くない現実結晶へ、試験片から実デバイスへ、と広がるであろう。さらには、実材料を実環境でその場観察・評価する方向に進展するのではないかと期待している。そのために、産業利用を志向する研究グループとの連携・共同を今後もさらに進めるとともに、X線トポグラフ像の解析・解釈のための環境・ソフトウェアの整備を図ることによって、本実験手法の利用拡大につなげたい。
参考文献
[1] X線トポグラフィ研究会のHPが開設されています。URLはhttp://www-asf.mls.eng.osaka-u.ac.jp/Xtopo/
[2] Y. Chikaura et al.: J. Phys. D: Appl. Phys. 34 (2001) A158-A162.
[3] 近浦ほか:応用物理 71 (2002) 1386-1390.
[4] W. Ludwig et al.: J. Appl. Cryst. 34 (2001) 602-607.
[5] T. Mukaide et al.: J. Synchrotron Rad. 13 (2006) 484-488.
[6] K. Kajiwara et al.: physica status solidi (a) 204 (2007) 2682-2687.
[7] 石川哲也:応用物理 57(1988)1496-1504.
[8] 木村滋、石川哲也、松井純爾:日本結晶成長学会誌 21(1994)76-87.
飯田 敏 IIDA Satoshi
富山大学 理学部
〒530-8555 富山市五福3190
TEL:076-445-6585 FAX:076-445-6549
e-mail : sxiida@sci.u-toyama.ac.jp
志村 考功 SHIMURA Takayoshi
大阪大学 大学院工学研究科
〒565-0871 吹田市山田丘2-1
TEL & FAX:06-6879-7281
e-mail : shimura@mls.eng.osaka-u.ac.jp
梶原 堅太郎 KAJIWARA Kentaro
(財)高輝度光科学研究センター 産業利用推進室
〒679-5198 兵庫県佐用郡佐用町光都1-1-1
TEL:0791-58-0802 FAX:0791-58-0830
e-mail : kajiwara@spring8.or.jp








