Volume 05, No.2 Pages 108 - 111
4. 最近の研究から/FROM LATEST RESEARCH
ニュースバルでの極端紫外線リソグラフィ研究(EUVL)の現状
The Status of EUV Lithography at New SUBARU
姫路工業大学 高度産業科学技術研究所 Laboratory of Advanced Science and Technology (LASTI), Himeji Institute of Technology
1.はじめに
電子メールから始まった新しい技術革新の流れはデスクトップ型計算機からノートパソコンへ、そしていまでは個人の所有する携帯電話がその役割を担い、それを結ぶネットがすでに構築されてきています。携帯は本来の電話の機能に、文字や画像の送信の機能を加え、ますますその便利さを増しています。文字だけならばさほどのメモリも必要としないが、画像を扱い、そこそこの解像度にまで高めるには、いままで以上の高速演算素子や大容量の記憶素子が必要になります。しかも、携帯サイズでそれを実現せねばならない訳ですから、さらに細い線を描画する技術開発が必要になってきます。
半導体デバイスを製造するための加工技術(リソグラフィ)はこれまで紫外線を用いて行われてきました。しかしながら、大容量化とともにチップサイズへの高集積化が要求され、2009年の実用化に向け線幅70nmの微細パタン形成が必要となります。これまでは露光波長の短波長化、ならびに位相効果を導入したマスク技術や、一次の回折光によって露光する照明方式等の導入により、露光波長の1/2程までの微細化が可能になってきています。現在主流のKrFエキシマ光源(波長248nm)では、0.13µmまでのデバイス製作が可能であり、さらにArFエキシマ(193nm)光源リソグラフィによって0.1µmまでのび微細化が明らかになってきています。
極端紫外線露光技術は光源波長を10〜14nmとし、これまでのレンズによる屈折型縮小光学系に代えて反射ミラーからなる反射縮小光学系を用いることを特徴とします。最近ではNA0.25の光学設計も可能なことからこの露光方式で30nmのパタン形成、すなわちSiによるデバイス製作の限界まで適用可能な技術となってきています。
現在米国Intelを中心としたチームとCarl Zeissを中心とする欧州チーム、および我々のチーム(姫路工業大学と超先端電子技術開発機構とニコン)とが競って技術開発を進めています。
本稿ではニュースバルビームラインに建設した極端紫外線露光装置の概要と最近の成果を示します。
2.露光装置の概要
図1にビームラインの全体構成を図2に今回開発した露光装置概要を示します。また表1に装置仕様を示します。EUVL用のビームラインは図1に示すように2枚の集光光学系、2枚の照明光学系、そして露光装置からなります。集光光学系の1枚目はトロイダルミラーで横方向40mrad、縦方向4mradの光を集光し、2枚目のトロイダルミラーによりほぼ縦横ともに発散角1mrad以下の丸いビームに整形します。ビームサイズはおよそ直径20mmです。このビームを2枚のトロイダルミラーからなる明光学系によってマスク面上に60mm×10mmの大きさのビームに整形します。マスク面上では光の強度の一様性が重要であり、理想的には1%以下が望ましいが、現状の方式ではおよそ10%の強度ばらつきがみられます。マスク面上のパタンを照射した光は縮小光学系を通してウェハ面上に1/5に縮小結像されます。
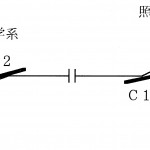
図1 ニュースバル極端紫外線露光専用ビームライン概要
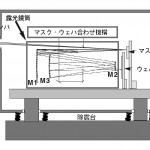
図2 露光装置の概要
表1 開発したEUVL実験装置仕様
| 開口数 | 0.1 |
| 縮小率 | 1/5 |
| 解像度 | 0.06 um(λ=13.5nm) |
| 焦点深度 | 1.9 um(0.1- um-linewidth) |
| 露光フィールド | 30mm×28mm(走査時) |
| 総合合わせ精度 | 30nm(3σ) |
| マスクサイズ | 6inch |
| ウェハサイズ | 8inch |
| 露光雰囲気 | 真空中 |
図2に示す露光装置は3枚の非球面からなる縮小光学系、マスクステージ、ウェハステージ、マスクとウェハの合せ光学系、ウェハの焦点検出光学系とからなります。
図3に装置の概観写真を示します。露光装置は0.1℃以下の温度制御を施したサーマルクリーンブース内に設置され、光学鏡筒とステージは位置フィードバックサーボを持つ除振台に搭載され、外部振動を除去しています。マスクとウェハは5対1の速度比で移動し露光領域を拡大させることが出来、設計上は30mm×28mmにまで露光できます。
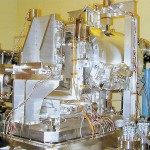
図3 露光装置主要部写真
光学系には3枚の非球面からなるミラーを用いており、図4(a)に示すようにm1ミラーは直径272mmの凹面ミラー、(b)のM2は直径116mmの凸面ミラー、(c)のM3は直径224mmの凹面ミラーであり、一部光のパスのため切り欠いた形状となっています。これらの各ミラーに要求される形状精度は許容される波面収差量から(Marechalの式)によって与えられ、およそ0.3nm以下となります。また表面粗さは測定領域が数µm以下での粗さと、1mm以下の粗さともに0.3nm以下であることが望まれます。前者は多層膜の反射率に影響し、後者はEUVL光の散乱によるコントラストの低下に影響します。形状精度の測定は検出分解能0.5nm以下をもつCGHを参照面とする干渉計により測定し、各ミラーともに0.58nmであり、粗さはAFMおよびMAXIM-3Dでの測定領域ともに0.3nmほどでありました。
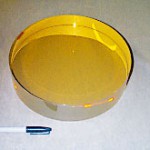
(a) M1ミラー

(b) M2ミラー

(c) M3ミラー
図4 製作したミラー概観
また、これらのミラーへの多層膜形成は、M1とM2ミラーへの光の入射角は場所により4〜7度と変化するため、これらのミラーには膜厚分布をもつGradedな膜としました。M3ミラーへの入射角はほぼ2度であるため、一様膜厚をもつ多層膜を形成しました。
図5に反射率を示します。65%以上の高い反射率が得られており、また3枚のミラー間のマッチングも0.05nmであることが確認されています。
3枚のミラーの合せは市販のフィゾー干渉系を用いて透過波面の測定により行いました。検出されたフィゾー面をゼルニケの多項式で展開し、その量をもとに光線追跡プログラムにより、各ミラーの収差量を求めます。一番影響度の大きなミラーの収差を小さくする方向で再調整します。このシーケンスを繰り返すことによりミラーの合せが可能となります。今回の合せでは3nmの透過波面が得られています。

図5 ミラーに形成した多層膜の反射率特性
3.露光実験
昨年10月よりニュースバル調整中のビーム評価の一環として露光実験を進めました。波長13.5nmの光のレジストへの吸収は強いため、10mAでも300秒程で露光が可能であります。露光用マスクは多層膜の基板の上に金属薄膜の吸収体を形成したものを用います。図6(a)はNiを電解鍍金で作成したマスクのパタン例であり、図(b)はその露光パタンの一例を示します。これまでに光学系の回折限界性能である56nmの微細パタン形成を確認できました。レジストにはポジ型の化学増幅系のものを用いています。レジストの厚さは0.1µmほどであります。
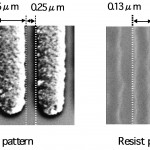
(a) Mask pattern (b) Resist pattern
図6 露光パタン例
4.おわりに
ニュースバルの産業応用の1テーマとして将来のリソグラフィ技術である極端紫外線リソグラフィの装置開発を進め、露光実験により光学系の回折限界性能である56nmのパタン形成を確認しました。これはメモリにすれば64Gbitメモリが可能となり、現在の1000倍性能向上が図れます。露光装置としてはさらに大面積化、8インチウェハ全面での均一なパタン形成、およびデバイス製作のためのマスクウェハのアライメント技術等の開発を進めていかねばなりません。
また、ミラー光学系の合せ精度の向上を図るため、11mの長尺アンジュレータ部に設置するAt-wavelength干渉系によって光学系の透過波面の高精度計測技術を開発し、サブオングストロームのアライメント精度の検討等も進めていきます。
最後にニュースバルも光科学技術の世界のCOEであるSPring-8でようやっと芽を出すことができました。立ち上げ時に惜しみない協力をいただいたSPring-8関係者に感謝するとともに今後は産業利用の面でその一翼を担えるよう努めて行きたく感じております。
木下 博雄 KINOSHITA Hiroo
姫路工業大学 高度産業科学技術研究所
〒678-1205 兵庫県赤穂郡上郡町光都3-1-2
TEL:0791-58-0447 FAX:0791-58-0242
e-mail:kinosita@lasti.himeji-tech.ac.jp
渡邊 健夫 WATANABE Takeo
姫路工業大学 高度産業科学技術研究所
〒678-1205 兵庫県赤穂郡上郡町光都3-1-2
TEL:0791-58-0470 FAX:0791-58-0242
e-mail:takeo@lasti.himeji-tech.ac.jp








