Volume 26, No.3 Pages 251 - 255
1. 最近の研究から/FROM LATEST RESEARCH
高運動エネルギーO2分子に対するグラフェンのガスバリア性
Gas Barrier Properties of Graphene Against O2 Molecules with High Kinetic Energy
[1]東北大学 国際放射光イノベーション・スマート研究センター International Center for Synchrotron Radiation Innovation Smart, Tohoku University、[2]Sigma Division, Los Alamos National Labolatory、[3](国)産業技術総合研究所 ナノ材料研究部門 Nanomaterials Research Institute, National Institute of Advanced Industrial Science and Technology、[4](国)日本原子力研究開発機構 物質科学研究センター Materials Sciences Research Center, Japan Atomic Energy Agency、[5]東北大学 マイクロシステム融合研究開発センター Micro System Integration Center, Tohoku University
- Abstract
- グラフェンは優れたガスバリア性能を持っており、この性質は科学的にも産業的にも大変興味深い。本研究では、Cu基板上にCVD成長させた単層グラフェンに対し、大きな並進運動エネルギーを持つO2分子は単層グラフェンを非破壊で透過するが、小さな並進運動エネルギーを持つO2分子は透過できないことをX線光電子分光法で実証した。分子動力学に基づくシミュレーションにより透過現象の物理的描像の解明を試みた。その結果、グラフェンの原子空孔欠陥にて高エネルギーO2分子の解離が発生し、解離したO原子が非破壊で単層グラフェンを透過することが示唆された。この解離はグラフェンに対して非破壊であり、低エネルギーO2分子に対しては引き続きガスバリア性能を維持していることも分かった。
1. はじめに
グラフェンは単原子の厚さでありながら気体分子をほとんど透過しないため、優れたガスバリア膜の候補の1つである[1][1] S. Chen, L. Brown, M. Levendorf, W. Cai, S.-Y. Ju et al.: ACS Nano 5 (2011) 1321-1327.。グラフェンのガスバリア性については欠陥のないグラフェンはヘリウム原子でさえほとんど透過しないことが理論研究で示され[2][2] O. Leenaerts, B. Partoens, F. M. Peeters: Appl. Phys. Lett. 93 (2008) 193107.、近年実験でも証明された[3][3] P. Z. Sun, Q. Yang, W. J. Kuang, Y. V. Stebunov, W. Q. Xiong et al.: Nature 579 (2020) 229-232.。具体的には、直径数μmのグラフェン膜を1時間にわずか数個のヘリウム原子のみが透過することが定量的に示された。ただし、このグラフェンは黒鉛を剥離して作製した高品質なものである。その一方、実用を考えた場合、大面積成膜可能な化学気相堆積法(CVD)にて成膜したグラフェンのガスバリア性を評価することが重要になる。特にCu(111)基板を触媒としたCVD法では欠陥の少ない高品質な単層グラフェンを成膜できるものの、それでも黒鉛剥離によって作製したグラフェンより原子空孔欠陥などは多い。しかしながら、Cu基板上に成膜されたグラフェンは下地Cu基板の酸化を保護することが報告されている[1][1] S. Chen, L. Brown, M. Levendorf, W. Cai, S.-Y. Ju et al.: ACS Nano 5 (2011) 1321-1327.。このことは多少の欠陥が存在してもグラフェンはガスバリア膜として活用可能であることを示している。
以上のように、グラフェンのガスバリア性能、特に耐酸化性能については多くの研究が進められている。その一方、グラフェンのガスバリア膜としての寿命についてはほとんど知見がなかった。腐食保護膜としての利用を想定する場合、数年単位の寿命が必要とされ、このような長期間にわたる寿命を評価する研究はこれまで行われていなかった。ここで、我々はグラフェンガスバリア膜の寿命を決定づける因子の1つとして、高運動エネルギー分子の存在を考慮した。大気中にはマクスウェル−ボルツマン分布に従って様々な速度の分子が存在する。室温300 Kの気体中で最も高頻度なのは0.026 eVの並進運動エネルギー(Et)を持つ分子であるが、分子照射時間、すなわちバリア膜の利用時間が長くなると高速分子とグラフェンの衝突も無視できない回数となる。そのため、グラフェンの酸素に対するガスバリア性能の寿命評価には、高速O2分子のグラフェン衝突による影響(グラフェンの破壊や欠陥生成など)を明らかにすることが重要であるが、このような研究はほとんど報告されていない。
そこで本研究ではリアルタイム光電子分光法を用いて、Cu(111)基板上に合成したCVD単層グラフェンのO2分子ガスバリア特性を調べた[4][4] S. Ogawa, H. Yamaguchi, E. Holby, T. Yamada, A. Yoshigoe et al.: J. Phys. Chem. Lett. 11 (2020) 9159-9164.。まず、高速O2分子によるグラフェン破壊現象を調べるため、グラフェンの下地であるCu基板の酸化速度を求めた。ここからグラフェン透過過程におけるO2分子のEt依存を測定した。
2. 実験方法
本実験の模式図を図1(a)に示す。単層グラフェン/Cu(111)基板に一様のEtを持つO2分子ビームを照射した。グラフェンがガスバリア膜としての性質を保っているのであれば、下地Cu(111)基板は酸化されない。しかし、高EtのO2ビーム照射によるグラフェンの破壊が生じた場合は下地のCu(111)基板が酸化されるので、Cu(111)基板の酸化速度からグラフェンの破壊を推定できる。
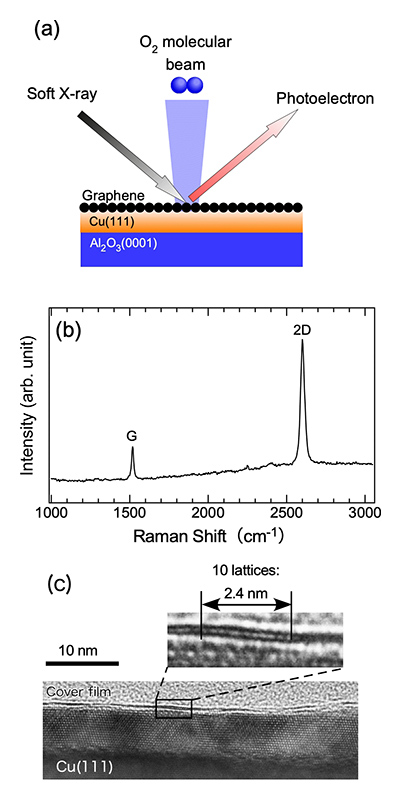
図1 (a) 本研究の実験模式図、(b) 本研究で使用したグラフェン/Cu基板のラマンスペクトルおよび、(c) 断面TEM像。
試料はサファイアC面(Al2O3(0001)面)にエピタキシャル成長させたCu(111)基板を触媒として熱CVD成長させ、Cu基板上にグラフェンを合成したものである。本試料のラマンスペクトルと断面TEM像を図1(b)、(c)に示す。ラマンスペクトルでは1350 cm-1付近にDバンドピークが観察されず、2D/Gバンドピーク強度比は4以上で、欠陥の極めて少ない高品質単層グラフェンがCu(111)上に形成されていることが分かる[5][5] J. Čermák, T. Yamada, M. Ledinský, M. Hasegawa, B. Rezek: J. Mater. Chem. C 2 (2014) 8939-8948.。
O2分子照射実験およびCu基板酸化速度の測定はSPring-8のBL23SUにて実施した。本ビームラインに設置されている表面化学実験ステーションにはEtが0.06~2.3 eVの分子ビームが発生可能な「超音速分子線発生装置」が備え付けられている。本研究ではO2/He/Arの流量比およびノズル温度によりEtを制御した。なお、O2だけでなくHeやArも同じEtで試料表面に照射される。しかし、Etの最大値である2.3 eVとグラフェンのC=C結合エネルギー7.4 eVとの間に大きなエネルギー差があるため、HeやArによるグラフェンへの物理的ダメージは無視できる程度と考えられる。これは、数eVのエネルギーを持つHe+イオンやAr+イオンがグラフェンにダメージを与えないという報告と一致する[6][6] P. Ahlberg, F. O. L. Johansson, Z.-B. Zhang, U. Jansson, S.-L. Zhang et al.: APL Mater. 4 (2016) 046104.。また、本装置は軟X線による光電子分光測定位置を見込むように取り付けられており、超音速分子線照射中に光電子スペクトルを測定できる。SPring-8の特徴である高輝度放射光のメリットを活かし、時間分解測定から酸化速度を求めた[7][7] S. Ogawa, J. Tang, A. Yoshigoe, S. Ishidzuka, Y. Teraoka et al.: Jpn. J. Appl. Phys. 52 (2013) 110128.。
具体的な実験手順は以下の通りである。単層グラフェン/Cu(111)基板を光電子分光測定槽内に導入し、10-4 PaのH2雰囲気にて300°Cの加熱を行い、グラフェン/Cu界面に存在するCu酸化物を除去した。その後、O2分子ビームを試料に照射し、ビーム照射中にO 1sスペクトルを16秒ごとに繰り返し測定してスペクトルの時間変化を得た。O2分子ビーム照射実験終了後は再びH2雰囲気中での加熱・還元を行い、1つの試料で繰り返しO2分子ビーム照射/還元実験を実施した。
3. 実験結果と考察
Et = 0.07 eVおよび0.83 eVのO2分子ビームをグラフェン/Cu基板に照射したときのO 1sスペクトルの変化を図2(a)、(b)に示す。図2(a)のEt = 0.07 eVのO2ビーム照射では、O 1sピーク強度はほとんど変化していない。もしO2分子がグラフェンを透過すれば、O2分子とCu基板が反応しCu-O結合由来のピークが増加するはずである。従って、この結果はCVD成長させた単層グラフェンがO2分子に対して不透過性であり、室温ガス中の大部分を占める低速O2分子に対して良好なバリアであることを示している。一方で、Et = 0.83 eVのO2分子線を照射した場合、O 1sのピーク強度が急激に増加し早い段階で飽和に達している。
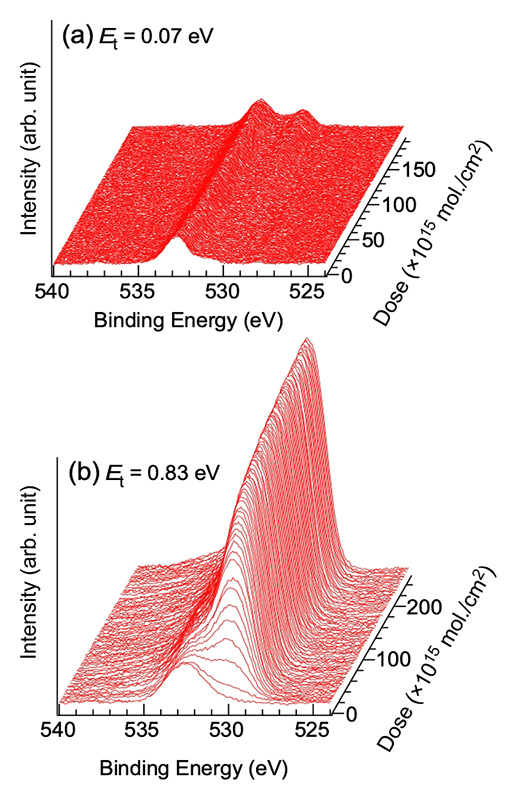
図2 O 1s光電子スペクトルのO2分子暴露量依存。(a) Et = 0.07 eV、(b) Et = 0.83 eV。
このO 1sピークの急増について考察するため、O 1s光電子スペクトルにおけるO-Cu結合ピークの面積強度を求めた。清浄化後のグラフェン/Cu基板およびO2分子ビーム照射後の基板のO 1s光電子スペクトルを図3(a)、(b)に示す。O 1sスペクトルは過去の文献[8]から、Cu酸化物由来、吸着有機物由来、および吸着水由来のピークに分離することができる。特に清浄化後でも残存しているピークはC-O-C結合のエネルギーと近いことから[8][8] L. Torrisia, L. Silipigni, M. Cutroneo, A. Torrisi: Vacuum 173 (2020) 109175.、グラフェンのエッジなどに結合している残留酸素と考えた。実際、清浄化工程を数回繰り返しても、このO 1sピークは消失しなかった。これ以降、O 1sスペクトルのピークのうち、O-Cu由来のピークのみに着目する。
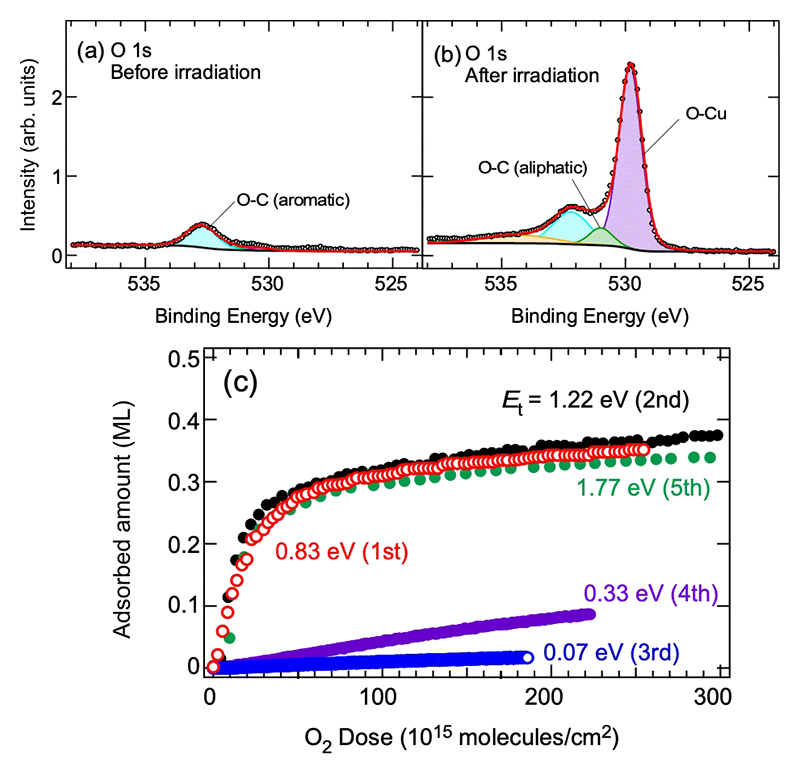
図3 (a) O2分子ビーム照射前および、(b) Et = 1.22 eVのO2分子ビーム照射後のO 1s光電子スペクトル。(c) O 1sスペクトル中のO-Cu結合成分強度のO2分子ビーム暴露量依存。
O 1sスペクトルにおけるO-Cuピーク面積強度のO2分子照射量依存を図3(c)に示す。ここではEt = 0.07、0.33、0.83、1.22、1.77 eVについてプロットした。Cu(111)表面におけるCu原子密度を1 MLとして、O-Cu強度から吸着したO原子の密度を求めた。この図から分かる通り、Etが0.33 eV以下と0.83 eV以上で、酸素吸着曲線が大きく異なっている。過去の報告の類推から[9][9] K. Moritani, M. Okada, S. Sato, S. Goto, T. Kasai et al.: J. Vac. Sci. Technol. A 22 (2004) 1625-1630.、Cu(111)表面におけるO2分子の吸着反応が2次反応モデルで進行すると仮定する。2次反応による酸素吸着曲線の傾きから、Cu基板へのO2分子初期吸着確率を求めたところ、Et = 0.07 eVおよび0.83 eVの場合、それぞれ1.08 × 10-4、1.58 × 10-2であった。これは、グラフェンを透過した全ての酸素分子がO-Cu結合生成に寄与し、Cuに対する酸素の付着係数が同じであると仮定すると、Et = 0.83 eVのO2のグラフェン透過率は、0.07 eVのそれよりも2桁大きいことになる。2つのエネルギー間のCuへの吸着確率の違いの可能性を考慮しても[9][9] K. Moritani, M. Okada, S. Sato, S. Goto, T. Kasai et al.: J. Vac. Sci. Technol. A 22 (2004) 1625-1630.、Etに依存してグラフェンの透過率は50倍以上異なることが示唆される。
ここで、Et = 0.83 eV以上でグラフェンのO2透過率が大きくなった原因として、高エネルギーO2分子によるグラフェンの破壊が考えられる。これを検証するため、我々は図3(c)中に示す順番の通り、すなわち0.83、1.22、0.07、0.33、1.77 eVの順に同一試料を用いてO2分子ビーム照射実験を行った。もし0.83 eV以上の高速O2分子ビームでグラフェンが破壊されているのならば、その後に実験を行ったEt = 0.07 eVにおいてCuの酸化が進行するはずである。しかしながら、0.07 eVではCu基板の酸化がほとんど進行しなかった。この結果は、Et = 0.83 eV以上でのO2分子透過プロセスが非破壊的であり、高エネルギーO2分子照射後もグラフェンはガスバリア性を保持していることを示す。その一方、Et = 0.83 eV以上の酸素吸着曲線は清浄Cu(111)単結晶表面の吸着曲線[9][9] K. Moritani, M. Okada, S. Sato, S. Goto, T. Kasai et al.: J. Vac. Sci. Technol. A 22 (2004) 1625-1630.によく一致しており、O2分子が単層グラフェンを自由に透過していることが明らかとなった。
照射後に原子レベルの構造欠陥が増加する可能性について明らかにするため、C 1s光電子スペクトルの解析を行った。その結果、図4に示すように、本研究の最大Etである1.77 eVと最低Etである0.07 eVの両方において、0.1原子%を大きく下回る検出限界内で、グラフェンシート内の空孔欠陥に起因するピーク強度の増加は見られなかった。そのため、超音速分子線照射によってグラフェンの破壊が進行した可能性は限りなく低い。
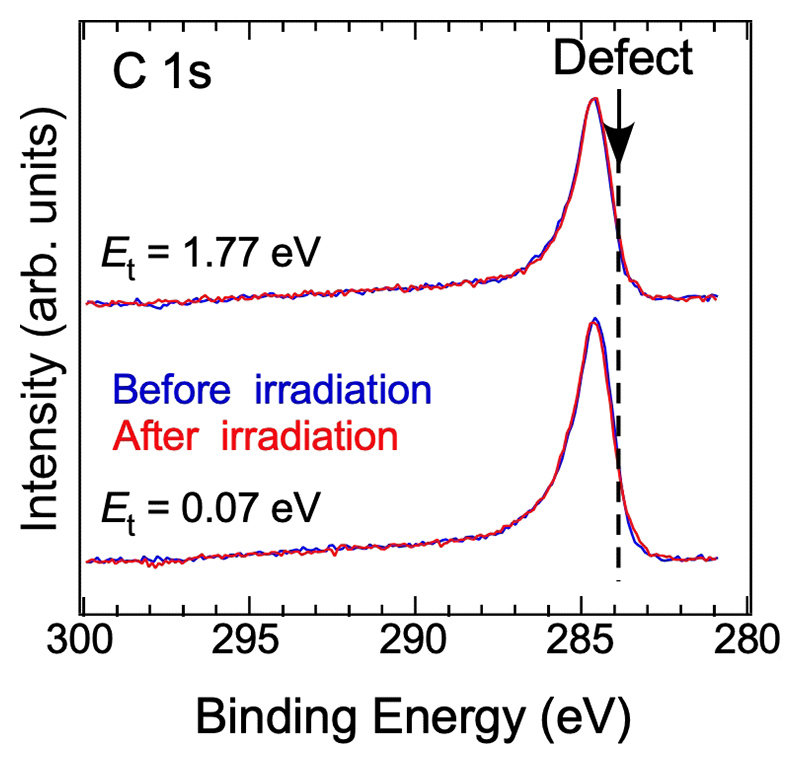
図4 O2分子ビーム照射前後のC 1s光電子スペクトルの比較。
また、Cu基板の酸化がO2分子のグラフェン透過ではなく、基板端から侵入した酸素のグラフェン/Cu基板間を介した拡散の可能性も考えられる。本研究におけるO2分子照射実験は室温で実施している。しかし、この温度は、グラフェンエッジからグラフェン/Cu基板間でO2分子が拡散する温度(~1000 K)[10][10] E. Grånäs, J. Knudsen, U. A. Schröder, T. Gerber, C. Busse et al.: ACS Nano 6 (2012) 9951-9963.よりもはるかに低いため、グラフェン/Cu基板間拡散の可能性も極めて低い。
以上のような高エネルギーO2分子のグラフェン透過メカニズムを解明するため、分子動力学(MD)シミュレーションを行った。Et = 0.5、1.0、1.5 eVと異なるO2分子を、原子構造欠陥の異なるグラフェンに垂直に照射した。特に図5(a)の2原子欠陥はグラフェンで最もよく見られる安定した欠陥であり[11][11] K.-G. Zhou, K. S. Vasu, C. T. Cherian, M. Neek-Amal, J. C. Zhang et al.: Nature 559 (2018) 236-240.、今回の試料にも含まれている可能性が高い。シミュレーションの結果、Et = 0.5 eVのO2分子は欠陥のないグラフェン表面(図5(b))で反跳した。より高い運動エネルギー(Et = 1.0および1.5 eV)では、C-O結合が短時間形成されたが、O2分子のO-O結合の切断は観察されなかった。C原子の未結合手が存在する2原子欠陥ではEt = 1.0および1.5 eVでO2分子の解離が起こり、O原子は欠陥周囲のC原子に結合したままグラフェンシート上面から下面に移動した。さらに大きな欠陥である17原子欠陥(図5(c))では、全てのEtのO2分子がC原子と反応・解離することなく通り抜けた。このO原子の移動現象は重要な結果である。なぜなら、移動したO原子が下地のCu(111)基板と反応してCu-O結合を形成する可能性があるからである。2原子欠陥の場合、Et = 0.5 eVではO2分子の解離が起こらず、無欠陥の場合と同様に分子が反跳したことから、欠陥におけるO2分子の解離反応には運動エネルギーの閾値があると考えられる。

図5 分子動力学計算に用いたグラフェンシート欠陥の模式図。(a) 2原子欠陥、(b) 無欠陥、(c) 17原子欠陥。
分子動力学シミュレーションで明らかとなった解離メカニズムは、以下の2点において実験結果とよく一致している。1つ目は、光電子スペクトルで観測された解離のエネルギー閾値と酸素吸着曲線増加の閾値が定量的に重なっていることである。シミュレーションでは0.5~1.0 eV、実験では0.33~0.83 eVであった。2つ目の一致点は、実験でもシミュレーションでも、原子構造欠陥の増加は観察されなかったことである。従って、この解離メカニズムは実験結果と一致しており、グラフェン層を介した酸素の輸送を説明できる。
4. まとめ
本研究の結論として、CVD成長した単層グラフェンにEtが2 eV未満の酸素分子を照射してそのガスバリア性を放射光XPSで評価したところ、Et = 0.83 eV以上のO2分子はグラフェンを透過したが、0.07 eVの酸素分子はほとんど透過しなかった。グラフェンは、Etが0.83 eV以上のO2分子を透過させた後も、低EtのO2分子に対する不透過性を維持しており、この透過プロセスは非破壊的であることが分かった。分子動力学法に基づくシミュレーションにより、グラフェンの欠陥が触媒のように作用し、運動エネルギーを介したO2分子解離過程とC-O結合生成およびその後のC-O結合切断が高エネルギーO2分子のグラフェン透過現象のメカニズムとして考えられることが分かった。一方で、キャリアガスとして使用されたヘリウムとアルゴンは、解離した酸素分子の場合とは異なり、ダングリングボンドを持たないため、グラフェンを「触媒的に」透過しないと考えられる。
また本報告では詳しく触れなかったが、実験開始前にH2雰囲気中でアニールすることで、グラフェン/Cu界面に存在するCu酸化物を還元することができる。この結果は、同様のグラフェン欠陥がH2やOHなどを透過する可能性を示しており、今後の研究が期待される。
参考文献
[1] S. Chen, L. Brown, M. Levendorf, W. Cai, S.-Y. Ju et al.: ACS Nano 5 (2011) 1321-1327.
[2] O. Leenaerts, B. Partoens, F. M. Peeters: Appl. Phys. Lett. 93 (2008) 193107.
[3] P. Z. Sun, Q. Yang, W. J. Kuang, Y. V. Stebunov, W. Q. Xiong et al.: Nature 579 (2020) 229-232.
[4] S. Ogawa, H. Yamaguchi, E. Holby, T. Yamada, A. Yoshigoe et al.: J. Phys. Chem. Lett. 11 (2020) 9159-9164.
[5] J. Čermák, T. Yamada, M. Ledinský, M. Hasegawa, B. Rezek: J. Mater. Chem. C 2 (2014) 8939-8948.
[6] P. Ahlberg, F. O. L. Johansson, Z.-B. Zhang, U. Jansson, S.-L. Zhang et al.: APL Mater. 4 (2016) 046104.
[7] S. Ogawa, J. Tang, A. Yoshigoe, S. Ishidzuka, Y. Teraoka et al.: Jpn. J. Appl. Phys. 52 (2013) 110128.
[8] L. Torrisia, L. Silipigni, M. Cutroneo, A. Torrisi: Vacuum 173 (2020) 109175.
[9] K. Moritani, M. Okada, S. Sato, S. Goto, T. Kasai et al.: J. Vac. Sci. Technol. A 22 (2004) 1625-1630.
[10] E. Grånäs, J. Knudsen, U. A. Schröder, T. Gerber, C. Busse et al.: ACS Nano 6 (2012) 9951-9963.
[11] K.-G. Zhou, K. S. Vasu, C. T. Cherian, M. Neek-Amal, J. C. Zhang et al.: Nature 559 (2018) 236-240.
東北大学 国際放射光イノベーション・スマート研究センター
〒980-8577 宮城県仙台市青葉区片平2-1-1
TEL : 022-217-5367
e-mail : ogasyu@tohoku.ac.jp
Sigma Division, Los Alamos National Labolatory
e-mail : hyamaguchi@lanl.gov
Sigma Division, Los Alamos National Labolatory
e-mail : holby@lanl.gov
(国)産業技術総合研究所 ナノ材料研究部門
e-mail : takatoshi-yamada@aist.go.jp
(国)日本原子力研究開発機構 物質科学研究センター
e-mail : yoshigoe@spring8.or.jp
東北大学 マイクロシステム融合研究開発センター
e-mail : yuji.takakuwa.b7@tohoku.ac.jp








