Volume 26, No.1 Pages 22 - 28
1. 最近の研究から/FROM LATEST RESEARCH
(JASRI理事長ファンド採択研究課題)
硬X線光電子分光法によるバンドギャップ光励起下の電子状態評価技術の開発
Study of Electronic Structure for Various Semiconductor Materials using Hard X-ray Photoelectron Spectroscopy with Band-Gap Excitation
(公財)高輝度光科学研究センター 放射光利用研究基盤センター 産業利用・産学連携推進室 Industrial Application and Partnership Division, Center for Synchrotron Radiation Research, JASRI
- Abstract
- 半導体デバイスにおいて、バンドベンディングやバンドオフセットなどの電子状態を精密に評価して正確なバンド構造を把握することは電気特性の要因解析や特性改善の指標を得る上で重要である。本研究では多層膜構造など実際のデバイスに近い構造におけるバンド構造の定量的評価を可能とすることを目的として、BL46XUの硬X線光電子分光(HAXPES, Hard X-ray Photoelectron Spectroscopy)装置をベースにバンドギャップ光励起による表面光起電力(SPV, Surface photo-voltage)を応用した電子状態評価技術を開発した。本評価技術は半導体デバイスの他、材料の光化学的な反応や光による劣化の評価、太陽電池や光触媒における光照射下の電子状態評価など、様々な材料に応用することもできる。本稿では、本評価技術を用いた半導体デバイスのバンド構造評価や波長依存性を応用したバンドギャップ評価、酸化物半導体や太陽電池材料におけるバンドギャップ光照射下の電子状態、光劣化評価への応用事例を紹介する。
1. はじめに
硬X線光電子分光(HAXPES)は、6~14 keVの硬X線を励起光として用いることから、一般に普及している軟X線(~1.5 keV)光電子分光(XPS, X-ray Photoelectron Spectroscopy)に比べて、検出される光電子の運動エネルギーが数倍大きく、検出深さが大きくなる[1][1] K. Kobayashi: Nucl. Instrum. Methods Phys. Res. 601 (2009) 32-47.。このため試料深部の電子状態や結合状態を非破壊で調べることが可能であり、これまでに半導体デバイスや太陽電池などのバンド構造、電子状態の評価に利用されている[2,3][2] N. Ikeno, Y. Yamashita, H. Oji, S. Miki, K. Arafune et al.: Jpn. J. Appl. Phys. 54 (2015) 08KD19.
[3] D. Gerlach, R. G. Wilks, D. Wippler, M. Wimmer, M. Lozac'h et al.: Appl. Phys. Lett. 103 (2013) 023903.。一方で、HAXPESによるバンド構造の評価は有用であるものの、多くの半導体表面や界面では蓄積層もしくは空乏層などのバンドベンディングが生じていることが一般的であり、その幅は半導体のキャリア密度やデバイス構造に依存して変化する(数nm~数十μm)。HAXPESにおける検出深さは数十nm程度であり、バンドベンディングの幅がそれよりも大きい場合は、基準となる半導体中のポテンシャル位置(バンドがフラットな位置)が不明なため、バンドベンディング量を求めるためには、半導体層自体が持つキャリア密度などから計算によって求めたフェルミ準位を仮定する必要がある。HAXPESは分析深さが大きく多層膜構造など実デバイスに近い構造での分析が可能であるものの、重要な半導体層中のバンド構造に仮定を伴ってしまうことは、正確な評価が行えているとは言い難い状況であった。近年、パワーデバイス用半導体として研究開発が盛んなSiCやGaNではリーク電流への影響の大きいバンド構造を正確に評価することが求められており、実際にユーザーからもこのような評価技術への要望があった。このため、半導体デバイスにおいて正確なバンド構造を導き出すことを目的として、HAXPESと表面光起電力(SPV)を組み合わせた電子状態評価技術の開発に取り組んできた。これは、対象の半導体のバンドギャップ(Eg)に相当する光を照射することによって生じるフラットバンド状態(表面光起電力)を基準にしてバンド構造を評価するものである[4-8][4] J. E. Demuth, W. J. Thompson, N. J. DiNardo and R. Imbihl: Phys. Rev. Lett. 56 (1986) 1408-1411.
[5] B. F. Spencer, D. M. Graham, S. J. O. Hardman, E. A. Seddon, M. J. Cliffe et al.: Phys. Rev. B 88 (2013) 195301.
[6] J. P. Long and V. M. Bermudez: Phys. Rev. B 66 (2002) 121308(R).
[7] H. Sezen and S. Suzer: Surf. Sci. 604 (2010) L59-L62.
[8] H. Sezen, E. Ozbay and S. Suzer: Appl. Surf. Sci. 323 (2014) 25-30.。
これにより通常は検出することが難しい深部のフラットバンド状態を表面・界面近傍で再現することができ、正確なバンド構造の評価に繋げることができる(図1)。さらに検出深さの大きなHAXPESと組み合わせることで、XPSでは実現できなかった実際のデバイス構造や多層膜試料での評価が可能となる。その他、本技術はバンドギャップ励起に付随したデバイス・材料の電子状態を直接理解できることに繋がるため、バンドギャップ励起により特性を発現する材料、例えば、太陽電池や光触媒の励起時の電位分布やフォトクロミック材料の励起時における化学結合状態、近年研究開発の盛んな有機−無機ハイブリッド材料(ペロブスカイト太陽電池)への応用など、適用範囲が広範に亘ることも期待される。本稿では、本評価技術を用いた半導体デバイスのバンド構造評価の他、波長依存性を応用したバンドギャップ評価、酸化物半導体やペロブスカイト太陽電池材料における光照射下での電子状態、光劣化評価の応用事例について紹介する。
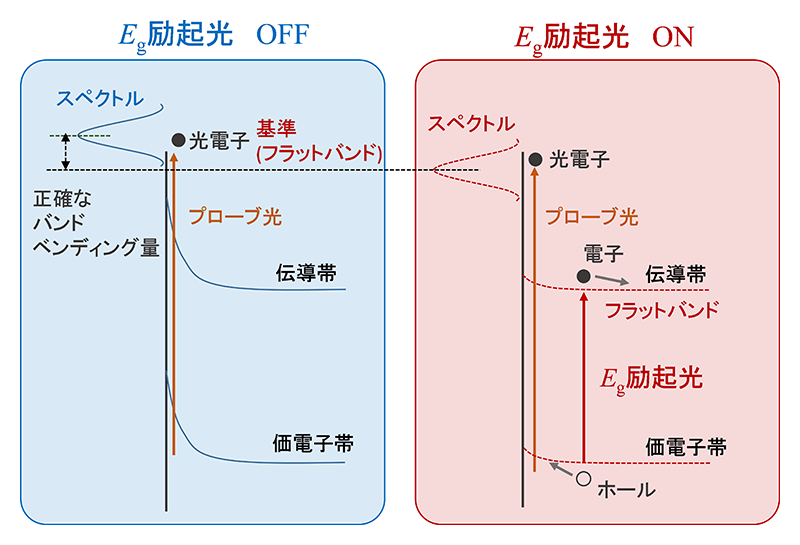
図1 表面光起電力(SPV)発生の概念
2. HAXPESによるバンドギャップ光励起下の電子状態評価技術
BL46XU第二実験ハッチでは、HAXPES装置を運用しており[9,10][9] H. Oji, Y-T. Cui, J-Y. Son, T. Matsumoto, T. Koganezawa and S. Yasuno: J. Surf. Anal. 21 (2015) 121-129.
[10] S. Yasuno, H. Oji, T. Koganezawa and T. Watanabe: AIP Conf. Proceedings of SRI 2015 1741 (2016) 030020.、高輝度光科学研究センター 理事長ファンド及びJSPS科研費の助成を受け、バンドギャップ光励起用のキセノン光源(朝日分光社製MAX-303 300W Xenon lamp)及びHAXPES装置の測定槽へバンドギャップ光を照射するためのライトガイドと集光レンズを2019年に導入した。今回は様々な半導体材料への適用を考え、広い波長域(250~1200 nm程度)を持つキセノン光源を選択した。また、2020年には、波長選択の自由度の向上とバンドギャップ光の励起波長依存性評価を行うための回折格子型の分光器を導入した。図2には本装置外観と測定槽内部の写真を示している。ライトガイド及び測定槽内へ導入した集光レンズによって試料のHAXPES測定位置でΦ 4.5 mmとなるように集光している。
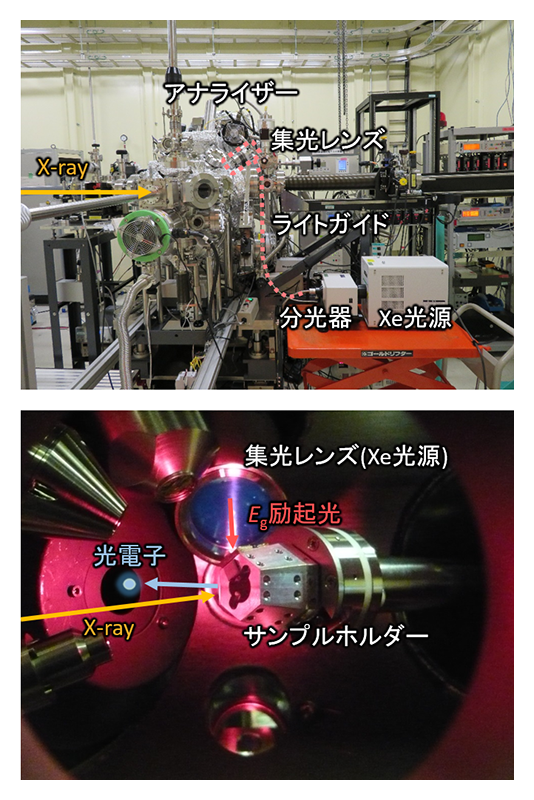
図2 SPring-8 BL46XU 第二実験ハッチに設置したバンドギャップ光励起HAXPES装置の外観及び測定槽内部の写真。
3. 実験方法
本装置を用いた実験は、Scienta Omicron社製R4000L1-10kVアナライザーを有する硬X線光電子分光装置で実施した。励起X線エネルギーは7.94 keV、測定位置におけるビームサイズは半値幅で、水平方向で250 μm程度、鉛直方向で20 μm程度である。入射角度は試料表面から10°、出射角15~80°にてパスエネルギー200 eVで測定を行い、各試料におけるHAXPESスペクトルを取得した。バンドギャップ光には先に述べたキセノン光源から発生させた光を用い、バンドパスフィルターや回折格子による分光もしくはフィルター無し(300~600 nm)の条件で照射を行った。
4. 実験結果
4.1、4.2、4.3では励起光照射によるバンド構造評価の検討結果、4.4、4.5では光照射による試料劣化の検討について報告する。
4.1 p型GaNの表面バンドベンディング評価
はじめに、モデルケースとしてp型GaNにおけるバンドギャップ光照射下の評価事例を紹介する。GaNは高耐圧、高周波、高温動作などの優れた特性のデバイスが実現可能なことからSiに代わる次世代半導体材料の一つとして注目されている材料である。一方で、p型化については、低い活性化率を要因としたp型GaN層の抵抗率やコンタクト抵抗が高いといった課題があり[11,12][11] G. Greco, F. Iucolano and F. Roccaforte: Appl. Surf. Sci. 383 (2016) 324-345.
[12] J.-K. Ho, C.-S. Jong, C. C. Chiu, C.-N. Huang and K.-K. Shih: J. Appl. Phys. 86 (1999) 4491-4497.、同材料のバンド構造を正確に評価することは重要である。本評価にはSi基板上にp型GaN(200 nm)/AlGaN/undoped GaN/buffer layerをMOCVDにより成膜したものを用いた[13,14][13] T. Kondo, Y. Akazawa and N. Iwata: Jpn. J. Appl. Phys. 59 (2020) SAAD02.
[14] N. Iwata and T. Kondo: Jpn. J. Appl. Phys. 60 (2021) SAAD01.。p型GaN(Mg doped)層のキャリア密度は3 × 1017 cm-3である。バンドパスフィルターによって分光した350 nmのUV光をバンドギャップ励起光として照射した。
UV光の照射有無におけるGa 2p3/2スペクトルの測定結果を図3(a)に示す。UV光照射によって低結合エネルギー側へピークがシフトすることが確認できる。光電子分光におけるピークシフトは化学結合状態の変化やチャージアップの影響が一般的であるが、SPV評価のためには、上記のような要因を注意深く切り分けなければならない。今回の実験では、他の元素のスペクトル(N 1s)や価電子帯端も同様にシフトしていること、またチャージアップが発生しないX線強度域(アッテネータ(厚さの異なるAl箔)によりX線強度を変化させてピークシフト(チャージアップ)の有無を確認)で測定していることから、観測されたピークシフトはUV光照射によってバンドベンディングが緩和した結果を表していると考えられる。また、別途測定した脱出角度依存評価で得られたバンドベンディングの傾向と矛盾の無いことも確認できている。以上の結果より、今回測定したp型GaNの表面は、図3(b)に示すように下向き(高結合エネルギー側)のバンドベンディングが生じた空乏層が形成された状態であることがわかった。

図3 (a) UV光照射有無におけるp型GaNのGa 2p3/2スペクトル。(b) p型GaNのバンド構造の模式図。図中のVBは価電子帯(Valence Band)、CBは伝導帯(Conduction Band)、Efはフェルミ準位を表している。
4.2 SiO2/Si基板構造のバンド構造評価
次に多層構造(酸化物/半導体基板)のバンド構造を評価した事例を紹介する。試料は熱酸化により膜厚10 nmのSiO2を形成したSiO2(10 nm)/p型Si基を評価対象とした。図4(a)には、バンドギャップ光照射(バンドパスフィルター無し)前後におけるSi 1sスペクトルの結果を示す。光照射により低結合エネルギー側へのピークシフトが観測され、SiO2/Si基板界面で0.2 eV程度下向き(高結合エネルギー側)にバンドベンディングが生じていることがわかった。さらにSiO2とp型Si基板におけるSi 1s、価電子帯スペクトルの測定結果を併せてまとめたものを図4(b)に示す。これよりSiO2/p型Si基板の価電子帯オフセット(ΔEv)を以下の式(1)から見積もったところ[15][15] R. W. Grant, E. A. Kraut, S. P. Kowalczyk and J. R. Waldrop: J. Vac. Sci. Technol. B 1 (1983) 320-327.、ΔEvは4.9 eVと見積もられた。また、文献値を参照した各層のバンドギャップ[16,17][16] S. Miyazaki: J. Vac. Sci. Technol. B 19 (2001) 2212-2216.
[17] S. M. Sze and K. K. Ng: Physics of Semiconductor Devices, 3rd ed. (Wiley, New York, 1981) 790.を勘案して得られたSiO2/p型Siのバンド構造全体(伝導体オフセット(ΔEc)を含む)の結果を図4(c)に示す。分析深さの大きなHAXPESとSPVを組み合わせることで、本試料のような多層構造のバンド構造が評価できることがわかる。
 |
… (1) |
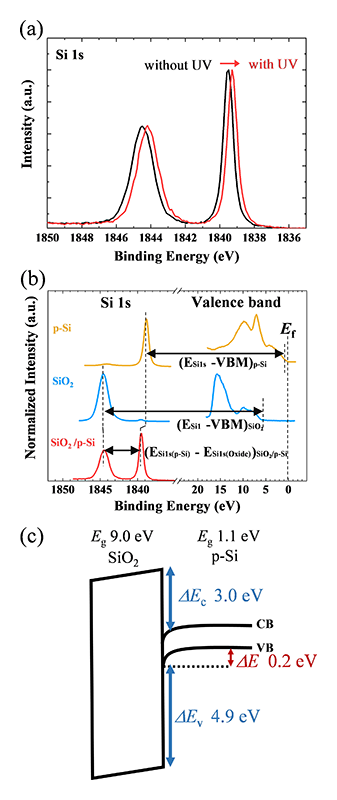
図4 (a) UV光照射有無におけるSiO2(10 nm)/p型Si基板のSi 1sスペクトル。(b) SiO2/p型Si基板、p型Si基板、SiO2のSi 1sスペクトル及び価電子帯スペクトル。図中のVBMは価電子帯端(Valence Band Maximum)を表している。(c) SiO2/p型Si基板のバンド構造の模式図。
4.3 励起波長依存性によるバンドギャップ評価
これまでの事例で見られたように、半導体が持つバンドギャップエネルギー以上の光を照射することで、半導体内部のポテンシャルに変化が生じた結果が光電子スペクトルのピークシフトによって直接反映される。これを利用することで、材料のバンドギャップ評価への応用が期待できる。ここでは測定対象に4H-SiC基板(p型、キャリア密度:6.0 × 1017/cm3)を使用し、キセノン光源からのUV光を回折格子型の分光器により波長域330~430 nm間を5 nm毎に分光させた波長依存性の評価結果を紹介する。
図5(a)に各波長照射下におけるSi 1sスペクトルの結果を示す。励起波長に依存してピーク位置がシフトする傾向が認められる。各励起波長の結果に対してUV光照射をしていないSi 1sを基準としたピーク位置の差分をプロットしたものを図5(b)に示す。これより390~380 nm(3.18~3.26 eV)付近よりピークシフトが観測されることから、本試料のバンドギャップ値は文献値の4H-SiCのバンドギャップ(3.26 eV)[18][18] T. Kimoto and J. A. Cooper: Fundamentals of Silicon Carbide Technology: growth, characterization, devices and applications (John Wiley & Sons Singapore Pte. Ltd, 2014).に近い3.18~3.26 eV程度と見積もられた。現状では光電子エネルギー変化の励起波長依存性からバンドギャップ値を正確に求めるための解析方法の確立など今後に課題はあるが、本技術を用いたバンドギャップ評価の可能性を示すことができたと考えている。今回は一般的な半導体基板による評価を実施したが、薄膜構造や局所的な領域、さらにX線を集光すれば微小領域でのバンドギャップ評価へ応用できることも期待される。
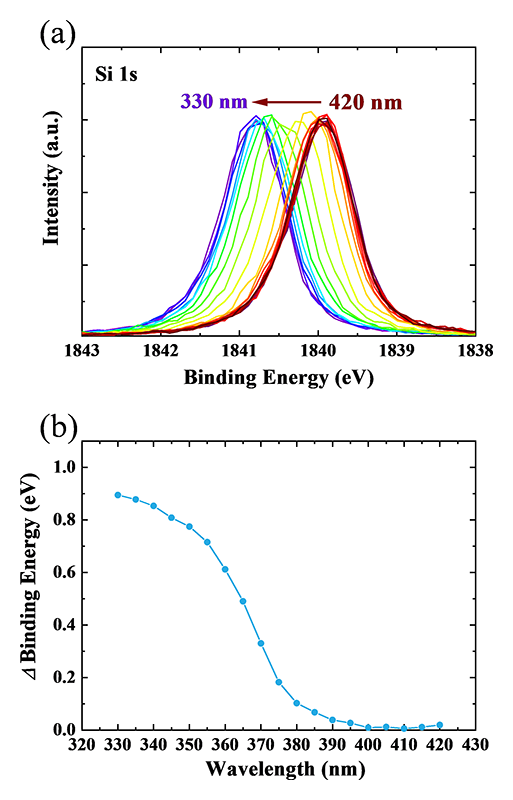
図5 4H-SiC基板のUV光波長依存性評価結果。(a) Si 1sスペクトル、(b) Si 1sピークシフトの差分結果。
4.4 アモルファス酸化物半導体における光照射劣化の検討
InGaZnO4をはじめとするアモルファス酸化物半導体は、低温での成膜・熱処理でも良好なデバイス特性を示すなど優れた特質が認められ、液晶、有機ELディスプレイのスイッチング素子などへの応用が進められている材料である[19][19] K. Nomura, H. Ohta, A. Takagi, T, Kamiya, M. Hirano and H. Hosono: Nature 432 (2004) 488-492.。一方で、光照射によって起こる光劣化(103秒以上の長い光応答特性)に見られるように、安定性、信頼性で改善していくべき課題もある[20,21][20] T. Aoi, N. Oka, Y. Sato, R. Hayashi, H. kumomi and Y. Shigesato: Thin Solid Films 518 (2010) 3004-3007.
[21] D. P. Gosain and T. Tanaka: Jpn. J. Appl. Phys. 48 (2009) 03B018.。こうしたデバイス特性は、価電子帯端やサブギャップ準位による影響が大きいと考えられており、これまでにHAXPESによる評価が有効であることが報告されている[22,23][22] K. Nomura, T. Kamiya, H. Yanagi, E. Ikenaga, K. Yang, K. Kobayashi, M. Hirano and H. Hosono: Appl. Phys. Lett. 92 (2008) 202117.
[23] K. Nomura, T. Kamiya, E. Ikenaga, H. Yanagi, K. Kobayashi and H. Hosono: J. Appl. Phys. 109 (2011) 073726.。ここではUV光照射によるアモルファス酸化物半導体の価電子帯近傍の電子状態への影響を評価した結果を紹介する。InGaZnO4膜(200 nm)はInGaZnO4(In:Ga:Zn = 1:1:1)ターゲットをDCスパッタによりSi基板上に成膜し、大気雰囲気(350°C、1h)で熱処理を実施したものを測定に用いた。
図6にUV光照射有無におけるInGaZnO4薄膜の価電子帯スペクトルの結果を示す。UV光照射によって2~4 eV近傍の価電子帯端近傍の準位密度が増加していることが認められる。また双方ともにフェルミ準位近傍にサブギャップ準位が確認されるが、これも同様にUV光照射によって準位密度がわずかに増加することが認められた。UV光照射によって、こうした価電子帯端近傍の裾部やサブギャップ準位密度が増加する傾向は電気特性の結果から同様の報告があり、酸素欠損が関連したメカニズムが提案されている[24,25][24] J. H. Kim, U. K. Kim, Y. J. Chung and C. S. Hwang: Appl. Phys. Lett. 98 (2011) 232102.
[25] P. Migliorato, M. D. H. Chowdhury, J. G. Um, M. Seok and J. Jang: Appl. Phys. Lett. 101 (2012) 123502.。

図6 UV光照射有無におけるInGaZnO4薄膜の価電子帯スペクトル。図中の挿入図は価電子帯端近傍を拡大したものを示している。
4.5 ペロブスカイト太陽電池の光劣化評価
最後に、次世代の新規太陽電池材料として注目の大きいペロブスカイト太陽電池についてUV光照射によるダメージ評価を行った事例を紹介する。ヨウ化鉛メチルアンモニウム(CH3NH3PbI3)に代表されるペロブスカイト太陽電池は、シリコン系太陽電池にも匹敵する高い変換効率を達成し、かつ塗布(スピンコート)技術で容易に作製できるといった特徴がある。一方で、大気や湿度、光などに対する安定性の課題があり、特性向上を目指した研究開発が行われている[26][26] X. Liu, Q. Han, Y. Liu, C. Xie, C. Yang et al.: Appl. Phys. Lett. 116 (2020) 253303.。FTO基板上にCH3NH3PbI3を塗布法により成膜したものを対象として、UV光照射による光劣化評価を行った。実験はUV光を2分間照射→HAXPES測定を繰り返し、UV光照射合計10分までの測定を実施した。
図7にPb 4f及びI 3d5/2スペクトルのUV光照射の時間依存性結果を示す。図7(a)のPb 4fスペクトルからは、UV光照射時間の増加に伴ってCH3NH3PbI3由来のPb2+成分のピーク強度が減少し、新たに出現したPb0と推測されるピーク強度が増加することが確認された。一方、図7(b)のI3 d5/2スペクトルでは、UV光照射時間の増加によってピーク強度が減少する傾向が認められた。光照射によるCH3NH3PbI3の分解で、揮発性の高いHIやメタルPbが生成される可能性が報告されており[26][26] X. Liu, Q. Han, Y. Liu, C. Xie, C. Yang et al.: Appl. Phys. Lett. 116 (2020) 253303.、これらと矛盾しない結果が得られていると考えられる。

図7 ペロブスカイト太陽電池薄膜試料のUV光照射時間依存性結果。(a) Pb 4fスペクトル、(b) I 3d5/2スペクトル。
5. まとめ
本稿では、HAXPESをベースとしたバンドギャップ光励起下の電子状態評価技術を用いた様々な半導体材料についての評価事例を紹介した。多層構造における半導体デバイスのバンド構造の評価や、波長依存性によるバンドギャップ評価、光が関与する劣化現象を観測することに成功した。本評価技術がバンド構造評価のみならず、光が関係する広範な材料、現象へ応用展開できるものと期待される。一方で、表面や界面に存在する欠陥密度によっては現在のキセノン光源では光量が不足する課題が一部の試料で確認されている。また、最表層に金属電極が存在するケースでは、バンドギャップ光を半導体層へ到達させるためには、表面(金属電極)側からではなく、試料の断面から照射するなどの工夫が必要になる。今後、材料や試料構造に最適な条件で評価が行えるよう光源や光の導入位置、集光などについて最適化の検討を進め、HAXPESのさらなる利用者と適用分野の拡大に繋げていきたいと考えている。
謝辞
本研究は、(公財)高輝度光科学研究センター 理事長ファンド及び日本学術振興会 科学研究費助成事業 若手研究(課題番号20K15184)の支援を受けて実施した。本稿におけるHAXPES(BL46XU)を使用した実験は、SPring-8の利用研究課題(課題番号2019A1754、2019B1701)により実施した成果である。本研究で測定に用いたp型GaN試料は豊田工業大学 岩田直高教授、4H-SiC試料は広島大学 黒木伸一郎教授、ペロブスカイト太陽電池薄膜試料は東京大学 柴山直之様に提供頂いた。ここに感謝の意を表する。
参考文献
[1] K. Kobayashi: Nucl. Instrum. Methods Phys. Res. 601 (2009) 32-47.
[2] N. Ikeno, Y. Yamashita, H. Oji, S. Miki, K. Arafune et al.: Jpn. J. Appl. Phys. 54 (2015) 08KD19.
[3] D. Gerlach, R. G. Wilks, D. Wippler, M. Wimmer, M. Lozac'h et al.: Appl. Phys. Lett. 103 (2013) 023903.
[4] J. E. Demuth, W. J. Thompson, N. J. DiNardo and R. Imbihl: Phys. Rev. Lett. 56 (1986) 1408-1411.
[5] B. F. Spencer, D. M. Graham, S. J. O. Hardman, E. A. Seddon, M. J. Cliffe et al.: Phys. Rev. B 88 (2013) 195301.
[6] J. P. Long and V. M. Bermudez: Phys. Rev. B 66 (2002) 121308(R).
[7] H. Sezen and S. Suzer: Surf. Sci. 604 (2010) L59-L62.
[8] H. Sezen, E. Ozbay and S. Suzer: Appl. Surf. Sci. 323 (2014) 25-30.
[9] H. Oji, Y-T. Cui, J-Y. Son, T. Matsumoto, T. Koganezawa and S. Yasuno: J. Surf. Anal. 21 (2015) 121-129.
[10] S. Yasuno, H. Oji, T. Koganezawa and T. Watanabe: AIP Conf. Proceedings of SRI 2015 1741 (2016) 030020.
[11] G. Greco, F. Iucolano and F. Roccaforte: Appl. Surf. Sci. 383 (2016) 324-345.
[12] J.-K. Ho, C.-S. Jong, C. C. Chiu, C.-N. Huang and K.-K. Shih: J. Appl. Phys. 86 (1999) 4491-4497.
[13] T. Kondo, Y. Akazawa and N. Iwata: Jpn. J. Appl. Phys. 59 (2020) SAAD02.
[14] N. Iwata and T. Kondo: Jpn. J. Appl. Phys. 60 (2021) SAAD01.
[15] R. W. Grant, E. A. Kraut, S. P. Kowalczyk and J. R. Waldrop: J. Vac. Sci. Technol. B 1 (1983) 320-327.
[16] S. Miyazaki: J. Vac. Sci. Technol. B 19 (2001) 2212-2216.
[17] S. M. Sze and K. K. Ng: Physics of Semiconductor Devices, 3rd ed. (Wiley, New York, 1981) 790.
[18] T. Kimoto and J. A. Cooper: Fundamentals of Silicon Carbide Technology: growth, characterization, devices and applications (John Wiley & Sons Singapore Pte. Ltd, 2014).
[19] K. Nomura, H. Ohta, A. Takagi, T, Kamiya, M. Hirano and H. Hosono: Nature 432 (2004) 488-492.
[20] T. Aoi, N. Oka, Y. Sato, R. Hayashi, H. kumomi and Y. Shigesato: Thin Solid Films 518 (2010) 3004-3007.
[21] D. P. Gosain and T. Tanaka: Jpn. J. Appl. Phys. 48 (2009) 03B018.
[22] K. Nomura, T. Kamiya, H. Yanagi, E. Ikenaga, K. Yang, K. Kobayashi, M. Hirano and H. Hosono: Appl. Phys. Lett. 92 (2008) 202117.
[23] K. Nomura, T. Kamiya, E. Ikenaga, H. Yanagi, K. Kobayashi and H. Hosono: J. Appl. Phys. 109 (2011) 073726.
[24] J. H. Kim, U. K. Kim, Y. J. Chung and C. S. Hwang: Appl. Phys. Lett. 98 (2011) 232102.
[25] P. Migliorato, M. D. H. Chowdhury, J. G. Um, M. Seok and J. Jang: Appl. Phys. Lett. 101 (2012) 123502.
[26] X. Liu, Q. Han, Y. Liu, C. Xie, C. Yang et al.: Appl. Phys. Lett. 116 (2020) 253303.
(公財)高輝度光科学研究センター
放射光利用研究基盤センター 産業利用・産学連携推進室
〒679-5198 兵庫県佐用郡佐用町光都1-1-1
TEL : 0791-58-0924
e-mail : yasuno@spring8.or.jp








