Volume 23, No.1 Pages 2 - 7
1. 最近の研究から/FROM LATEST RESEARCH
専用ビームラインの研究から ~BL16B2/16XU(産業用専用ビームライン建設利用共同体)~
IoT市場向け強誘電体メモリにおけるPLZT薄膜の結晶化メカニズム
Crystallization Mechanism of PLZT Thin Film in Ferroelectric Memory for IoT Market
[1](株)富士通研究所 デバイス&マテリアル研究所 Devices & Materials Laboratory, Fujitsu Laboratories Ltd.、[2]富士通セミコンダクター(株) システムメモリカンパニー System Memory Company, Fujitsu Semiconductor Ltd.
- Abstract
- 強誘電体La-doped Pb(Zr,Ti)O3薄膜を用いたIoTエッジデバイス用メモリ技術を確立することに成功した。その開発において、我々は、La-doped Pb(Zr,Ti)O3の結晶化アニール時に、Arに2%のO2を含ませた雰囲気とすることで、分極特性の向上を通じて強誘電体メモリの製造歩留りが大きく向上することを見出した。結晶構造解析を行った結果、最適なO2; 2%では膜表面のランダム配向結晶が消失していることが明らかになった。その消失理由を明らかにするために、Ar/O2濃度比による結晶成長過程の違いを調べた結果、準安定パイロクロア相から安定ペロブスカイト相への相転移速度が、Ar雰囲気では速くO2雰囲気では遅いことが明らかになった。最適なO2; 2%では、膜表面から供給されたO2により、膜厚方向にO2濃度分布が生じた結果、膜表面のランダム配向結晶の形成が抑制され、下部電極から成長する配向成分のみが優先的に形成されたと考えられる。
1. はじめに
1.1 背景
低消費電力、高速書き換え、多書き換え回数等の優れた特徴を備えた強誘電体メモリ(FRAM: Ferroelectric Random Access Memory)[1][1] J. F. Scott: Ferroelectric Memories, Advanced Microelectronics Series Vol.3 (Springer, Berlin, 2000).は、スマートカードや認証デバイスに加えて、近年注目されているモノのインターネット(IoT: Internet of Things)市場向けへの利用拡大が進んでいる。富士通グループでは、1999年に世界に先駆けてFRAMの量産を開始し、現在、設計寸法0.18 µm、動作電圧1.8 V、集積度8 Mbの製品化に成功している[2][2] T. Eshita, W. Wang, K. Nakamura, S. Ozawa, Y. Okita et al.: J. Phys. Sci. Appl. 5 (2015) 29-32.。
FRAMに用いられる強誘電体材料には、チタン酸ジルコン酸鉛(PZT: Pb(Zr,Ti)O3)系、タンタル酸ビスマスストロンチウム(SBT: SrBi2Ta2O9)系、ビスマスフェライト(BFO: BiFeO3)系、酸化ハフニウム(HfO2)系等の各種材料が提案されている。一方、製品化されているFRAMにおいては、ほとんどの場合、大きな分極と低い動作電圧を兼ね備えたPZT系の材料が採用されている。図1に、強誘電体としてPZT系材料を使用したFRAMの構造及び動作原理を示す。本材料を用いたFRAMでは、Zr/Tiイオンが結晶の中心位置からシフトすることで分極が発生する。Zr/Tiイオンは2つの安定点を持ち、外部電界によってその位置を変えることが可能となっている。一度どちらかの安定点に位置すると電界を取り去っても位置は変化しないため、2つの安定点、即ち、+分極と-分極を「0」「1」データとして記憶させることで、不揮発性メモリとして用いることができる。

図1 強誘電体としてPZT系材料を用いたFRAMの構造及び動作原理。
1.2 研究目的
今回、強誘電体材料としてランタン添加チタン酸ジルコン酸鉛(PLZT: La-doped Pb(Zr,Ti)O3)を用いたFRAMの開発を行った。その開発において、我々は、PLZTの結晶化アニール時にアルゴン(Ar)に2%の酸素(O2)を含ませた雰囲気(O2; 2%)とすることで、分極特性の向上(図2)を通じて、FRAMの製造歩留りが大きく向上することを見出した[3][3] W. Wang, K. Nomura, H. Yamaguchi, K. Nakamura, T. Eshita et al.: Jpn. J. Appl. Phys. 56 (2017) 10PF14.。その理由を明らかにし、高歩留り安定量産化及び、さらなる高性能化を図ることを目的として、X線回折(XRD: X-ray diffraction)及び、走査型電子顕微鏡(SEM: Scanning Electron Microscope)を用いて、結晶構造解析及び結晶成長過程の観測を行った。本稿においては、製造歩留りが向上する理由並びに、PLZTの結晶成長メカニズムについて述べる。

図2 結晶化アニール時のO2濃度と分極値の関係。
2. 実験
2.1 サンプル
本実験で使用したサンプルの膜構造を図3に示す。SiO2/Si基板上に、下部電極としてPt/Tiを成膜し、さらに、スパッタリング法でPLZTを成膜した。PLZTの組成は、Zr/Ti比が0.4/0.6で、Laの添加量は2.0 mol%である。
アモルファスPLZT膜を結晶化するために、表1に示した条件で、高速加熱処理(RTA: Rapid Thermal Annealing)法により結晶化アニールを行い、測定に用いた。
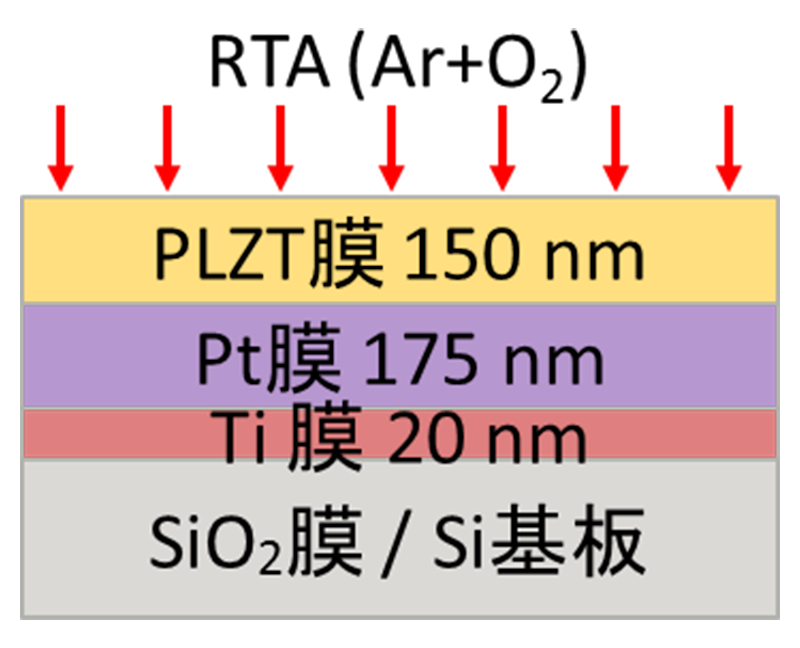
図3 サンプルの膜構造。
表1 結晶化アニール条件
| O2/(Ar+O2) (%) | PLZT結晶化アニール時間(秒) | |||
| 0 | − | 90 | ||
| 0.25 | 10 | 30 | 60 | |
| 2 | ||||
| 50 | ||||
| 100 | − | |||
2.2 測定
XRD測定では、主にHuber社製8軸X線回折装置を使用した(使用ビームライン:BL16XU、課題番号:2016A5110、2016B5110)。X線のエネルギーは20 keVを選択し、検出器には2次元検出器PILATUS 100kを用いた。また、逆格子マッピング測定では、Huber社製6軸X線回折装置を使用した(使用ビームライン:BL16B2、課題番号:2016A5410、2016B5410)。X線のエネルギーは15 keVを選択し、検出器には同じ2次元検出器を用いた。上記2測定のX線波長が異なるため、見やすいように全てCuKα線に波長を換算してグラフ化した。
3. 結果及び考察
3.1 製造歩留り向上の理由
図4に、2θ/ω–χ法で測定した逆格子マッピングの測定結果を示す。表1に示した90秒の結晶化アニールを行った3サンプルを用いた。図4(a)はAr条件(O2; 0%)、図4(b)は最適条件(O2; 2%)、図4(c)はO2条件(O2; 100%)の結果である。
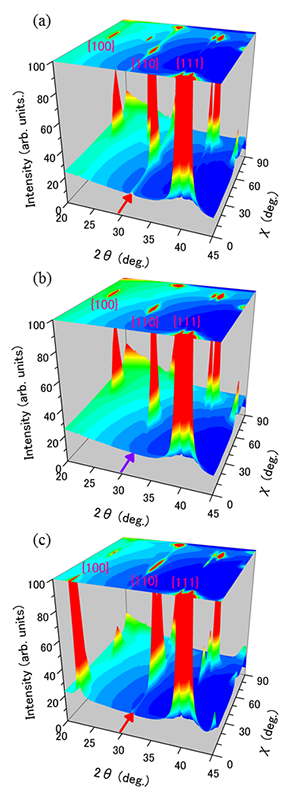
図4 2θ/ω–χ法で得られた逆格子マッピング。
(a) O2; 0%、(b) O2; 2%、(c) O2; 100%。
Ar条件(O2; 0%)では、PLZT{111}配向成分に加えて、ランダム成分(矢印で示したPLZT{110}は配向成分ではなくランダム成分)が観測されている。O2条件(O2; 100%)では、それらに加えて、PLZT{100}配向成分も観測されている。一方、最適条件(O2; 2%)では、PLZT{111}配向成分のみが観測されており、Ar条件(O2; 0%)やO2条件(O2; 100%)で観測されたランダム成分は消失している。
表1に示した90秒の結晶化アニールを実施した5サンプルについて、2θ/ω法で測定を行い、PLZT{100}、PLZT{110}、PLZT{111}の回折強度とAr/O2濃度比の関係を求めた。結果を図5に示す。最適条件(O2; 2%)では、特異的にランダム成分が消失している。
ランダム成分の存在箇所を特定するために、図6に示したSEM観察を行った。図6(a)はAr条件(O2; 0%)、図6(b)は最適条件(O2; 2%)の結果である。
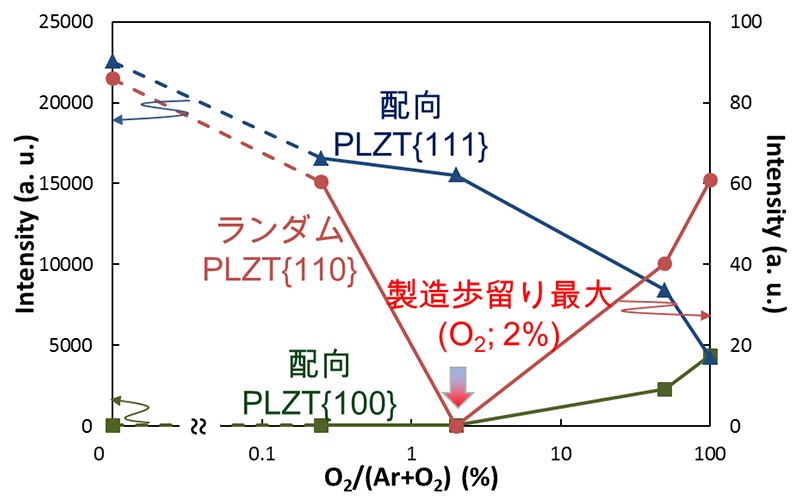
図5 結晶化アニール時のO2濃度とX線回折強度の関係。
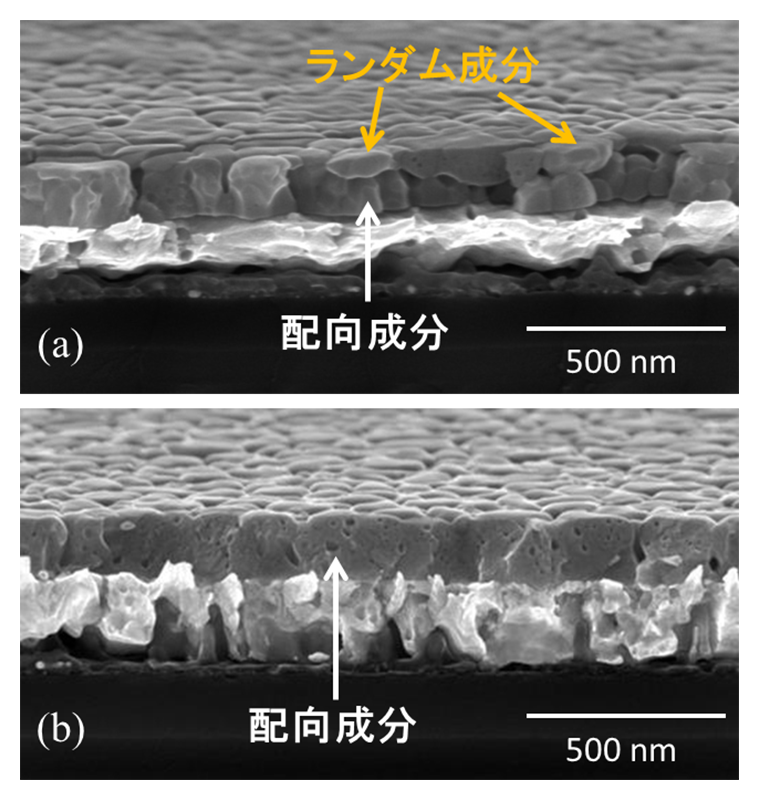
図6 SEM観察結果。(a) O2; 0%、(b) O2; 2%。
Ar条件(O2; 0%)では、下部電極から結晶成長したと考えられる配向成分に加えて、PLZT表面にランダム成分が形成されている。一方、最適条件(O2; 2%)では、図4及び図5のXRDの結果と同様に、配向成分のみが観測されている。本結果は、最適条件(O2; 2%)において製造歩留りが向上した理由は、PLZT表面におけるランダム成分の消失であることを示唆する。
3.2 結晶成長メカニズム及びランダム成分消失理由
最適条件(O2; 2%)において、PLZT表面のランダム成分が特異的に消失する理由を明らかにするために、結晶化アニール時の結晶成長過程の観測を行った。図7は結晶化アニールの温度履歴を示している。成膜時はアモルファス相であり、昇温過程において準安定相であるパイロクロア相に相転移している[4][4] E. S. Lee, H. W. Chung, S. H. Lim and S. Y. Lee: J. Vac. Sci. Technol. A23 (2005) 773.ことは、別途XRD測定及び、X線吸収微細構造(XAFS: X-ray Absorption Fine Structure)測定により確認した。
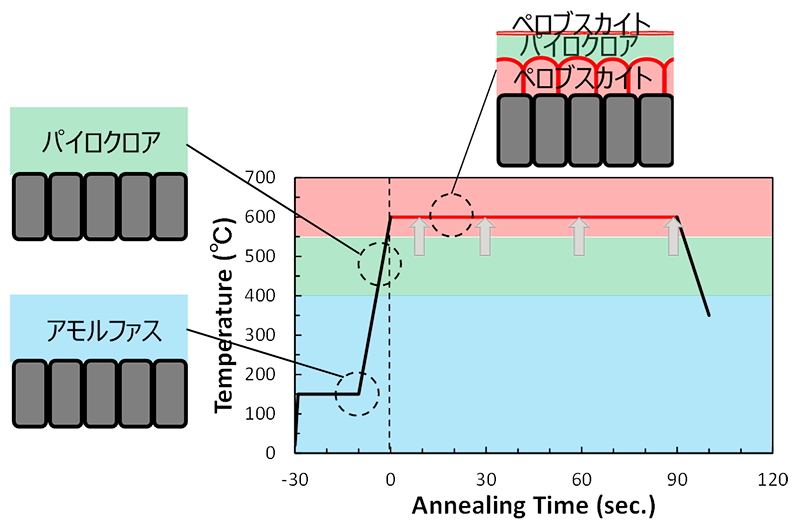
図7 結晶化アニールの温度履歴。
表1に示した、Ar条件(O2; 0.25%)、最適条件(O2; 2%)、O2条件(O2; 50%)の3種類のAr/O2条件の其々に対して、結晶化アニール時間が10、30、60、90秒のサンプルを用いて結晶成長過程の観測を行った。結果を図8に示す。図8(a)はAr条件(O2; 0.25%)、図8(b)は最適条件(O2; 2%)、図8(c)はO2条件(O2; 50%)の結果である。O2; 0.25%では、10秒で既に配向成分もランダム成分も、ペロブスカイトへの相転移が進んでいる。O2; 50%では、10秒時点でペロブスカイトへの相転移は、配向成分、ランダム成分共に全く起こっていない。即ち、アニール中の雰囲気によって、ペロブスカイトへの相転移速度が異なっており、O2雰囲気ではAr雰囲気よりも遅い。一方、O2; 2%では、10秒時点において、配向成分に関してはO2; 0.25%と同程度のペロブスカイト化が進んでいるのに対して、ランダム成分に関してはO2; 50%と同様にペロブスカイト化は全く起こっていない。即ち、O2; 0.25%やO2; 50%とは異なり、下部電極近傍とPLZT表面において、ペロブスカイト化の速度に違いが観測されている。

図8 PLZTの結晶成長過程の観測結果。
(a) O2; 0.25%、(b) O2; 2%、(c) O2; 50%。
図8の結晶成長過程の観測結果を図9に模式図として示す。図8(a)及び図9(a)に示したO2; 0.25%では、下部電極からの配向成分もPLZT表面のランダム成分もどちらもペロブスカイト化が同程度に非常に速く、最終的に表面にランダム成分が形成されている。図8(c)及び図9(c)に示したO2; 50%では、配向成分もランダム成分もどちらもペロブスカイト化が同程度に非常に遅いために、最終的に表面にランダム成分が形成されている。それに対して、図8(b)及び図9(b)に示したO2; 2%では、配向成分は速く、ランダム成分は遅いために、配向成分のみが優先的に形成され、最終的にはPLZT表面のランダム成分が消失している。
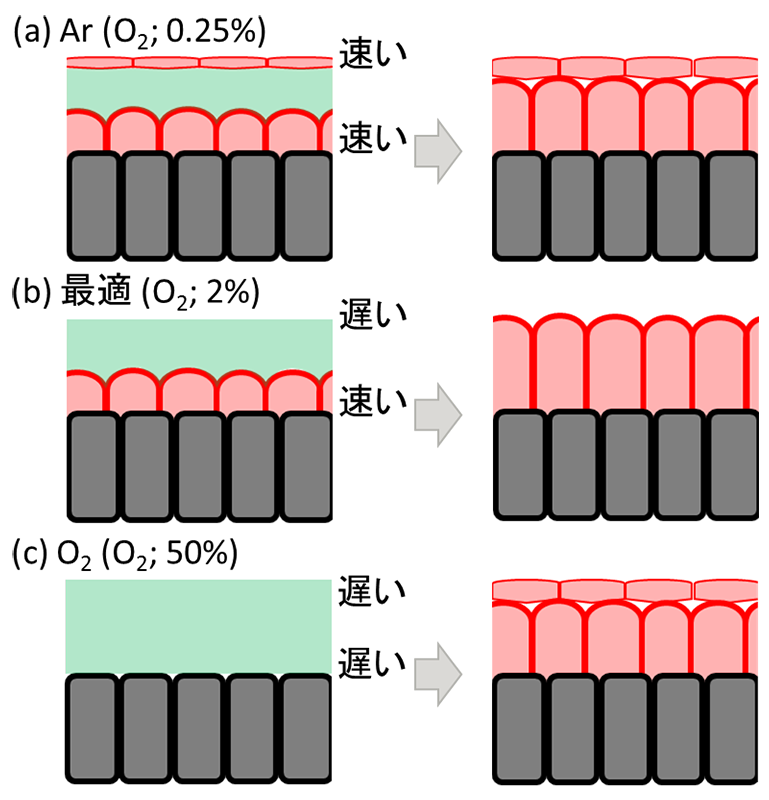
図9 パイロクロアからペロブスカイトへの相転移。
(a) O2; 0.25%、(b) O2; 2%、(c) O2; 50%。
Ar条件(O2; 0.25%)とO2条件(O2; 50%)におけるペロブスカイト化の速度の違いが何に起因するかを明らかにするために、準安定相であるパイロクロア相に着目し、結晶化アニール時の消失過程の観測を行った。結果を図10に示す。O2条件(O2; 50%)では、90秒後においても残留パイロクロア相が観測されている。本結果は、パイロクロア相はAr雰囲気よりもO2雰囲気でより安定的であることを示唆する[5][5] G. R. Fox and S. B. Krupanidhi: J. Mater. Res. 9 (1994) 699-711.。
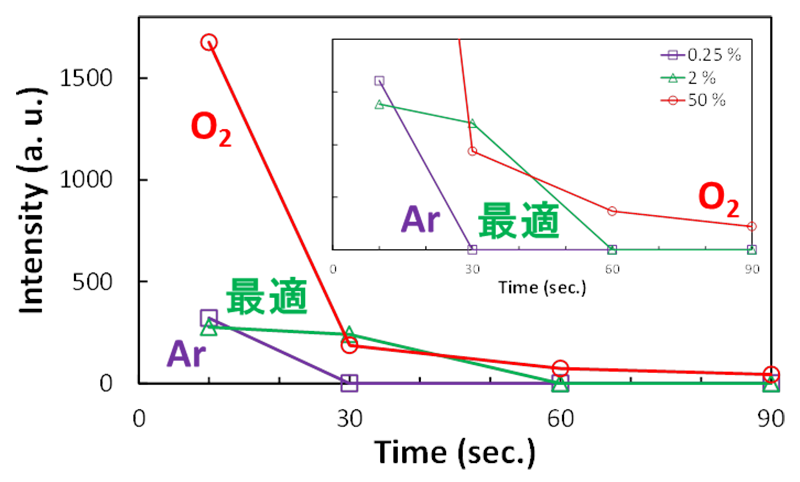
図10 O2; 0.25%、O2; 2%、O2; 50%における、準安定パイロクロア相の消失過程の観測。
以上の結果を基に、図11及び図12を用いて、PLZTの結晶成長メカニズムを説明する。図11は、パイロクロア相からペロブスカイト相への相転移におけるO2の役割を模式図として示したものである。結晶化アニール時のO2は、準安定相であるパイロクロア相から安定相であるペロブスカイト相への相転移の障壁を上げる役割を担っており、その結果、障壁が低いAr条件ではペロブスカイト化が速く(図11紫線)、障壁が高いO2条件ではペロブスカイト化が遅くなり(図11赤線)、両者のペロブスカイト化の速度に違いが生じたと考えられる。

図11 パイロクロアからペロブスカイトへの相転移におけるO2の役割。
Ar条件:紫線、O2条件:赤線。
図12は、結晶化アニール時のPLZTの膜厚方向のO2濃度分布を模式図として表したものである。Ar条件では、膜厚方向に一様にO2濃度が低く、従って、下部電極近傍もPLZT表面も一様に障壁が低くペロブスカイト化が速い。それとは反対に、O2条件では、膜厚方向に一様にO2濃度が高く、従って、下部電極近傍もPLZT表面も一様に障壁が高くペロブスカイト化が遅い。一方、最適条件(O2; 2%)において、下部電極から成長する配向成分とPLZT表面のランダム成分でペロブスカイト化の速度に違いが生じた理由は、結晶化アニール時にPLZT表面から供給したO2により、PLZTの膜厚方向にO2濃度分布が発生したためであると考えられる[6][6] R. Wang and P. C. Mclntyre: J. Appl. Phys. 97 (2005) 023508.。即ち、PLZT表面から供給したわずかなO2(O2; 2%)は、PLZT表面の障壁を上げてペロブスカイト化を抑制し、障壁が低い下部電極近傍のペロブスカイト化のみを促進したと考えられる。

図12 結晶化アニール時の膜厚方向のO2濃度分布。
ここで、図8(b)に示した最適条件(O2; 2%)のペロブスカイト化の過程では、10秒から30秒まではペロブスカイト化の速度の鈍化が観測されている。また、同様に、図10に示した最適条件(O2; 2%)のパイロクロア消失過程においても、10秒から30秒まではパイロクロア相の消失速度の鈍化が観測されている。このように、今回我々が見出した最適条件(O2; 2%)では、2段階結晶成長という特徴的な挙動を示している。この理由は、最適条件(O2; 2%)においては、下部電極近傍は障壁が低いためにAr条件のようにペロブスカイト化が促進されるが、ある程度ペロブスカイト化が進むと、必ずPLZT表面近傍に存在する障壁が高い領域に突入し、その結果、O2条件のようにペロブスカイト化が抑制されるためであると考えられる。即ち、最適条件(O2; 2%)で観測された2段階結晶成長は、我々が示したPLZTの結晶成長メカニズムを強く支持する。
4. まとめ
本研究により、強誘電体膜PLZTの結晶化アニール時の雰囲気を最適なO2; 2%にした場合にFRAMの製造歩留りが大きく向上する理由が、PLZT表面のランダム配向PLZTの形成を抑制したためであることが明らかになった。また、最適なO2; 2%でランダム配向PLZTが消失した理由は、PLZT表面から供給したわずかなO2が、表面近傍のみにおいてパイロクロア相からペロブスカイト相への相転移の障壁を上げる役割を担うことにより、下部電極からの配向PLZTを優先的にペロブスカイト化させたためであることが明らかになった。本課題で得られた成果を、今後のFRAMの高歩留り安定量産及び、さらなる高性能FRAMの開発の指針として活用することを予定している。
参考文献
[1] J. F. Scott: Ferroelectric Memories, Advanced Microelectronics Series Vol.3 (Springer, Berlin, 2000).
[2] T. Eshita, W. Wang, K. Nakamura, S. Ozawa, Y. Okita et al.: J. Phys. Sci. Appl. 5 (2015) 29-32.
[3] W. Wang, K. Nomura, H. Yamaguchi, K. Nakamura, T. Eshita et al.: Jpn. J. Appl. Phys. 56 (2017) 10PF14.
[4] E. S. Lee, H. W. Chung, S. H. Lim and S. Y. Lee: J. Vac. Sci. Technol. A23 (2005) 773.
[5] G. R. Fox and S. B. Krupanidhi: J. Mater. Res. 9 (1994) 699-711.
[6] R. Wang and P. C. Mclntyre: J. Appl. Phys. 97 (2005) 023508.
(株)富士通研究所 デバイス&マテリアル研究所
〒243-0197 神奈川県厚木市森の里若宮10-1
TEL : 046-250-8266
e-mail : nomura.kenji@jp.fujitsu.com
富士通セミコンダクター(株) システムメモリカンパニー
〒965-8502 福島県会津若松市門田町工業団地6番
TEL : 0242-38-2722
e-mail : wangws@jp.fujitsu.com
(株)富士通研究所 デバイス&マテリアル研究所
〒243-0197 神奈川県厚木市森の里若宮10-1
TEL : 046-250-8266
e-mail : yamagu@jp.fujitsu.com
富士通セミコンダクター(株) システムメモリカンパニー
〒965-8502 福島県会津若松市門田町工業団地6番
TEL : 0242-38-2722
e-mail : kou@jp.fujitsu.com
富士通セミコンダクター(株) システムメモリカンパニー
〒222-0033 神奈川県横浜市港北区新横浜3-9-18
TEL : 045-755-7042
e-mail : eshita@jp.fujitsu.com
富士通セミコンダクター(株) システムメモリカンパニー
〒965-8502 福島県会津若松市門田町工業団地6番
TEL : 0242-38-2722
e-mail : hikosaka.yukino@jp.fujitsu.com
(株)富士通研究所 デバイス&マテリアル研究所
〒243-0197 神奈川県厚木市森の里若宮10-1
TEL : 046-250-8266
e-mail : y.kataoka@jp.fujitsu.com
産業用専用ビームライン建設利用共同体(サンビーム共同体)及びビームライン(BL16XU、BL16B2)に関する詳細は、サンビーム公式ウェブサイトをご覧下さい。
https://sunbeam.spring8.or.jp/
お問い合わせはサンビーム共同体事務局までお願い致します。
sunbeam@spring8.or.jp








