Volume 22, No.4 Pages 321 - 326
1. 最近の研究から/FROM LATEST RESEARCH
長期利用課題報告2
グリーンナノエレクトロニクスのための材料・プロセスインテグレーション -超低消費電力次世代トランジスタ開発-
Materials and Process Integration for Advanced Low-Power-Consumption Transistors – Development of Advanced Low-Power-Consumption Transistors –
名古屋大学大学院 工学研究科 Graduate School of Engineering, Nagoya University
- Abstract
- 大規模集積回路の基本素子である金属−絶縁膜−半導体電界効果トランジスタの低消費電力化・高性能化の要となるIV族系半導体材料を中心に、次世代の材料プロセス技術の開発に指針を与える各種物性発現メカニズムの解明や評価技術の構築を目的とし、BL47XUに設置されている硬X線光電子分光(HAXPES: Hard X-ray Photoemission Spectroscopy)を活用し、薄膜多層構造や微細構造における化学結合および電子状態の精密評価を推進した。各材料の物性を最大限に引き出すためには、電気的特性と密接に関連する絶縁膜/半導体の界面物性などの理解は必須であり、実デバイス内の様々な材料で構成されるナノメートルスケールの多層構造や埋もれた界面を高感度に非破壊で分析可能なHAXPESは極めて強力な分析技術である。本稿では、長期利用課題を通して得られた成果の一部を紹介する。
1. はじめに
スマートフォンやタブレットなどの携帯情報端末の普及、クラウドコンピューティングやソーシャルメディアに代表される新たなICT技術の浸透・高度化に伴って、より安全で快適なネットワーク社会への進化が強く求められている。その一方で、ICT機器・インフラの拡充による消費電力の激増が大きな社会問題となっている。これを抜本的に打開するには、ICT機器の主要構成部品である大規模集積回路(LSI: Large Scale Integrated circuit)の消費電力および発熱量を低減する技術の確立が急務である。とりわけ、LSIの基本素子である金属−絶縁膜−半導体電界効果トランジスタ(MISFET: Metal Insulator Semiconductor Field Effect Transistor)の開発では、現在、新材料・新構造導入による低省電力化と高性能化の両立が強く求められている。そこで、卓越した電子物性をデバイスレベルで引き出すためには、MISFETを構成する電子材料固有の物性の本質的な理解と、異種材料界面で生じる化学反応の精密制御技術を確立する必要がある。
そこで、我々は、長期利用課題「グリーンナノエレクトロニクスのための材料・プロセスインテグレーション -超低消費電力次世代トランジスタ開発-」を通して、MISFETの低消費電力化・高性能化の要となる新規チャネル候補であるGe系半導体を中心に、次世代の材料プロセス技術の開発に指針を与える各種物性メカニズムの解明や評価技術の構築を目的とし、硬X線光電子分光(HAXPES: Hard X-ray Photoemission Spectroscopy)による精密評価を推進した。具体的な成果として、(I)Ge-MIS構造への界面反応制御層導入による低誘電率GeO2層の抑制技術の開発[1,2][1] A. Ohta et al.: Electrochemical Society (ECS) Transaction 64 (2014) 241-248.
[2] S. Miyazaki et al.: Electrochemical Society (ECS) Transaction 69 (2015) 165-170.、(II)MIS構造の内部電位および界面ダイポール評価[3,4][3] N. Fujimura et al.: Jpn. J. Appl. Phys. 56 (2017) 04CB04.
[4] A. Ohta et al.: Microelectro. Eng. 178 (2017) 80-84.、(III)金属/Ge構造で生じるフェルミレベルピニング現象の深耕とその緩和・抑制技術の構築[5,6][5] A. Suzuki et al.: Ext. abstr. of 2015 Int. Conf. on Solid State Devices and Materials (SSDM 2015).
[6] A. Suzuki et al.: Ext. abstr. of 2016 Int. Conf. on Solid State Devices and Materials (SSDM 2016).、(IV)GeやGeSnなどに対するn型不純物の高効率活性化技術[7][7] K. Takahashi et al.: Ext. abstr. of The Fifteenth Int. Workshop on Junction Technology (IWJT2015).、(V)新奇二次元物質の合成方法の構築[8,9][8] M. Kurosawa et al.: Jpn. J. Appl. Phys. 55 (2016) 08NB07.
[9] 黒澤昌志 他:表面科学 37 (2016) 374-379.、(VI)一軸歪Geの化学構造分析[10][10] S. Yamahori et al.: Electrochemical Society (ECS) Transaction 64 (2014) 431-439.、(VII)格子定数とエネルギーバンドオフセットを独立に制御できるGe系IV族混晶の設計指針の構築[11][11] T. Yamaha et al.: Appl. Phys. Lett. 108 (2016) 061909.、など次世代の材料プロセス技術にフィードバックできる貴重な情報が得られた。成果の詳細は、参考文献を参照して頂きたい。本稿では、得られた成果の中でも、金属−絶縁膜−半導体(MIS)構造の埋もれた界面の化学組成・結合状態評価や、新奇二次元物質の合成方法についてのHAXPES分析結果を紹介する。
2. HAXPES測定
ビームラインBL47XUに設置された光電子脱出角度が可変な光電子分光ステーションを利用した。蓄積リングからアンジュレータを通して得られた放射光を、Si単結晶を用いたモノクロメータ、スリット、集光ミラーを通すことで、単色化された7,939 eVの励起エネルギーを持つ硬X線をプローブとして試料に照射した[12][12] E. Ikenaga et al.: J. Electron Spectrosc. and Relat. Phenom. 190 (2013) 180-187.。このとき、GeもしくはSi基板の場合では、励起されるGe 2p3/2およびSi 1s内殻光電子の平均自由工程は、~9 nmおよび~11 nmであり[13][13] S. Tanuma et al.: Surf. Interface Anal. 43 (2011) 689-713.、深さ方向の分析限界は表面から~30 nmに相当する。加えて、多元素から構成された試料では、結合エネルギー数百eVの測定領域で、内殻光電子信号同士が重畳し、解析を困難にする場合があるが、HAXPESでは測定可能なエネルギー範囲が幅広いため、このような問題を回避し分析精度を向上できる。また、高輝度X線を使用することから、高いエネルギー分解能で極微量存在する構成元素が検出でき、かつ従来にない高いスループットで測定を進めることが可能となる。
3. Ge-MIS構造への界面反応制御層導入による低誘電率GeO2層の抑制[1,2][1] A. Ohta et al.: Electrochemical Society (ECS) Transaction 64 (2014) 241-248.
[2] S. Miyazaki et al.: Electrochemical Society (ECS) Transaction 69 (2015) 165-170.
高移動度チャネルGe-MISデバイスの実現には、電気的なSiO2等価換算膜厚を1 nm以下に薄くし、低界面準位密度、かつ高誘電率な酸化物薄膜の積層構造実現が必要不可欠である。そのため、電気的等価膜厚はより薄く設定できる高誘電率(high-k)絶縁膜の導入・実用化が必須であり、high-k/Ge界面遷移領域における化学結合状態の解明と制御技術構築が必要不可欠である。そこで、high-k/Ge界面において、低誘電率層のGeO2形成を抑制し、高誘電率を維持しながら良好な界面特性を得るため、界面制御層の導入を検討した。これまでに、GeO2が還元し易いことを利用し、Ta-TTT有機錯体を用いた化学気層堆積(CVD)において、酸化剤を用いずに錯体の熱分解を利用することで、high-k絶縁膜をGe基板表面に直接形成可能なプロセスを見出している[14][14] K. Mishima et al.: J. Physics: Conference Series 417 (2013) 012013.。そこで、HAXPESの深い分析深度を活用して、TiNを電極に用いたHfO2/TaGexOy/Ge(100)のMIS構造の熱的安定性を、Ge 2p3/2内殻光電子信号よりを評価した(図1)。Ge基板に相当するGe-Ge結合の高結合エネルギー側に観測されるGe酸化成分に着目すると、300°CのN2雰囲気中熱処理(PMA: Post Metallization Annealing)により界面制御層として形成したTaGexOyにGeがわずかに混入することが認められるものの、電気特性評価では界面準位やリーク電流の低減に効果があることを明らかにした。また、500°C以上の熱処理では、Geの拡散に伴う顕著な組成ミキシングにより、ゲートリーク電流が増大し、電気特性が劣化することが分かった。TaOx界面層およびHfO2層の膜厚とプロセス温度を精密制御した結果、SiO2容量換算膜厚1.0 nm、ゲートリーク電流10-3 A/cm2@-0.77 Vを実現できた。
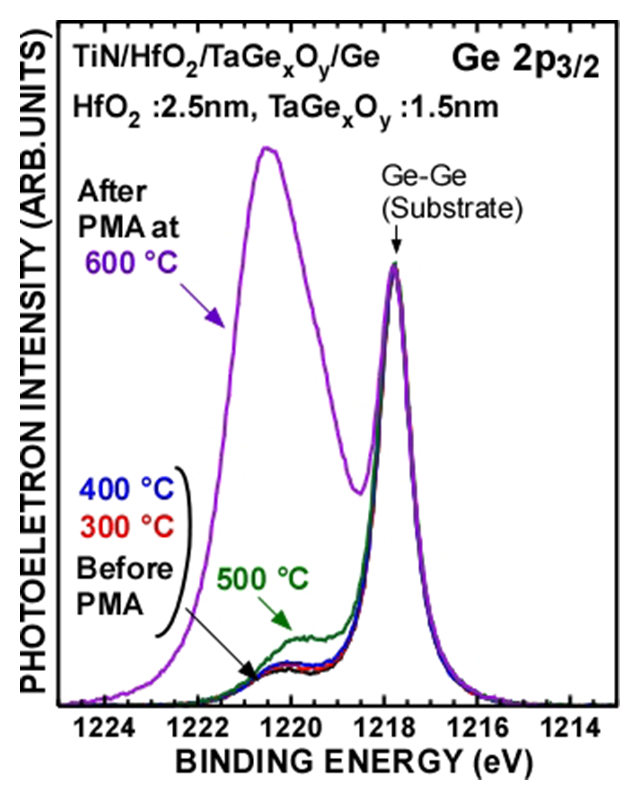
図1 TiN/HfO2/TaGexOy/Ge構造のN2雰囲気中熱処理前後のGe 2p3/2スペクトル。
4. MIS構造の内部電位評価・オペランド計測[4][4] A. Ohta et al.: Microelectro. Eng. 178 (2017) 80-84.
半導体デバイスの動作を理解するには、エネルギーバンド構造や電圧印加による絶縁膜および半導体表面の電位変化を理解することが不可欠である。特に、最先端のMISデバイスでは、そのしきい値電圧を精密に制御するために、各界面での化学結合状態やダイポールなどの電位変化の理解が強く望まれている。そこで、多層構造や埋もれた界面の化学結合状態の分析が可能であるHAXPESを活用し、MIS構造に電圧を印加した状態で測定を行い、単純なAu/SiO2/Si構造を解析することで、光電子スペクトルと内部電位分布との相関を調べた。
MIS構造は、次の手順で作成した。p型Si(100)基板を化学溶液洗浄により水素終端した後、1,000°Cの熱酸化を行い、厚さ5.3 nmのSiO2を成長させた。最後に、厚さ10 nmのAu電極を形成した。
図2に示すAu 4fおよびSi 1sスペクトルは、Au上部電極を接地電位にし、Si基板側より電圧を印加した。Au電極に相当するAu 4fスペクトルでは、電圧印加によるエネルギーシフトおよびその形状に変化が認められず一定であることから、Au電極が電気的に接地されていることが確認できる。一方、Si 1sスペクトルでは、電圧印加に伴い、Si基板に相当するSi-Si結合成分が、印加した電圧に相当したシフトが認められるのに対して、熱酸化SiO2に相当するSi-O結合成分は、電圧印加により形状が変化し、Si基板に比べてエネルギーシフト量も小さい。図3(a)に、Au-Au、Si-OおよびSi-Si結合のエネルギー位置を、印加電圧の関数に対してまとめた。図3(b)に示す理想的なSi-MOSダイオードの電位変化を計算した結果に比べて、負の低バイアス印加領域(-1 V以下)において、Si基板成分のエネルギーシフトが抑えられ、熱酸化SiO2成分のエネルギーシフト量が顕著であることが分かる。この結果は、基板側の光励起において、負バイアス印加時に反転層が形成される結果として解釈することができる。容量−電圧特性との比較から、熱酸化SiO2中の電荷トラップ密度・分布を含めたより深い考察が可能と言える。

図2 電圧印加したAu/SiO2/Siの、(a) Au 4fおよび、(b) Si 1sスペクトル。各スペクトルは、光電子脱出角度87ºで測定し、Au電極を接地電位にし、Si(100)基板側に、-1.0 V、0 V、1.0 Vを印加した。

図3 (a) 電圧印加したAu/SiO2/SiのAu 4fおよびSi 1s信号のピーク位置と、(b) 理想的MOSダイオードの場合での酸化膜電圧とSi表面電位の計算結果。計算では、Au電極の仕事関数を5.10 eVとし、Si基板の不純物濃度は、3 × 1015 cm-3とした。
さらに、広角電子レンズを用いて異なる光電子脱出角度のSi 1s信号を測定することで、試料の化学結合状態の深さ方向分布と印加電圧によるピークシフトを区別し評価を行った(図4)。各スペクトルの光電子強度は、Si基板からのSi-Si結合により規格した。光電子脱出角度を浅くし表面敏感にすることで、SiO2に相当するSi 1s信号に加えて、サブオキサイドと呼ばれる界面遷移層に相当する信号が増大する。さらに、光電子脱出角度を10ºまで小さくすると、この信号はSiO2よりも明らかに大きい。この結果は、サブオキサイド成分が、SiO2/Si界面だけでなくAu/SiO2界面にも存在することを示唆する。これらのことより、電圧印加HAXPES測定により、内部電位変化を評価するだけでなく、化学結合状態に起因するケミカルシフトと電位変化によるエネルギーシフトを切り分けて詳細な化学分析ができることを示した。

図4 電圧印加したAu/SiO2/SiのSi 1sスペクトルの光電子脱出角度依存性。各スぺクトルは、広角対物電子レンズを用いて一括で測定し、測定中はSi基板側に+2.0 V(Au電極は接地電位)を印可した。
5. IV族系新奇二次元物質の合成[8,9][8] M. Kurosawa et al.: Jpn. J. Appl. Phys. 55 (2016) 08NB07.
[9] 黒澤昌志 他:表面科学 37 (2016) 374-379.
新世代の省エネ・超高速デバイスへのパラダイムシフトを実現する新材料として、原子1層分の厚みしか持たない二次元結晶が期待されている。様々な二次元結晶の中でも、ハニカム構造状の炭素原子の二次元配列を持つグラフェンは、その構造に起因する特殊な電子状態によって優れたキャリア輸送特性を示すことが知られている。その一方、バンドギャップが小さいことから、スイッチング素子として活用する際にはOFF状態時の電流を抑制できず、消費電力が増大することが懸念されている。グラフェンよりも重いIV族元素から構成されるシリセンやゲルマネンなどの二次元結晶もまた、ハニカム構造状の原子配列に起因する特殊な電子状態を有することが知られており、これらの結晶は、完全にフラットな構造とはならず、この構造的特徴のおかげで、垂直電場によりバンドギャップ幅の制御が可能であることが理論予測されている。また、グラフェンに比べ30~800倍強いスピン軌道相互作用を有することが予測されており、トポロジカル絶縁体として振舞うことも期待されている。これまでに、単結晶Ag基板およびエピタキシャルZrB2上でのシリセン合成に成功しているが、準安定なシリセンが合成し得る明確な理由は明らかでない。
そこで、HAXPESの特徴である高輝度による微量元素の定量と深い分析深度を活かした積層構造の化学結合状態分析を行った。具体的には、化学溶液洗浄したSi(111)およびGe(111)基板上にAg層をエピタキシャル成長し、熱処理によるAg表面へのSiやGe極薄膜の析出や形成を系統的に調べた。
図5に、Ag/Ge(111)構造および400°C熱処理前後のAl2O3/Ag/Ge(111)構造におけるGe 2p3/2およびAg 3d5/2スペクトルを示す。Al2O3堆積後および熱処理後において、Ge-Ge結合に相当するGe 2p3/2信号が明瞭に観測される。HAXPESの分析深度がおよそ30 nmであることを考慮すると、このことはAl2O3堆積および熱処理中にGe基板よりGe原子がAg表面に拡散したことを示唆する。ここで、Ge-O結合の形成は、熱処理炉内に残留する酸素や試料搬送中に酸化したと考えられる。このとき、Ag 3d信号に変化がないことより、エピタキシャル成長したAg膜中へのGe原子の混入はHAXPES分析の検出限界以下(< 0.1 at.%)である。このことはAg-Ge系の相図で表されるAg中のGeの固溶限が非常に小さいこととも一致する。さらに興味深いことに、Al2O3/Ag/Si(111)構造にでも同様の結果が得られた。そこで、Al2O3/Ag/Ge(111)およびAl2O3/Ag/Si(111)構造において、HAXPESにより観測したSi 1sおよびGe 2p3/2信号の積分強度を熱処理時間に対してまとめた(図6)。注目すべきは、400°C以上の熱処理でGeおよびSi原子はAg表面に析出することである。また、Geの析出量がSiよりも大きいことは、Ag中のGeの固溶限がSiよりも高いことに起因すると考えられる。図6に示す積分強度より、析出したSiおよびGeの平均膜厚を見積もった。その結果、400°Cで1時間熱処理した試料のSiおよびGeの平均膜厚は、それぞれ、~0.9 nmおよび~1.6 nmと見積もられる。また、Ag(111)/Ge(111)構造において、450°Cで2時間熱処理した試料において、原子レベルで平坦化したAg(111)表面上に、厚さ二原子層の二次元Ge結晶が形成できることを、原子間力顕微鏡(AFM)および断面透過電子顕微鏡(TEM)より明らかにした。この現象には、Ag(111)表面上へのエピタキシャル的なGe層析出と、自然酸化における自己停止効果が深く関与していると考えている。以上の成果より、高移動度チャネル材料として期待される新奇二次元物質合成方法の指針を構築することができた。

図5 ヘテロエピタキシャル成長した厚さ60 nmのAg(111)/Ge(111)構造およびN2雰囲気中熱処理(400°C、1時間)前後で測定したAl2O3/Ag/Ge(111)構造の、(a) Ge 2p3/2と、(b) Ag 3d5/2スペクトル。各スペクトルは、光電子脱出角87ºで測定し、光電子強度はAg 3d5/2信号のピーク強度で規格化した。

図6 N2雰囲気中熱処理前後のAl2O3/Ag/Ge(111)およびAl2O3/Ag/Si(111)構造のSi 1sおよびGe 2p3/2光電子信号強度。各信号強度は、Ag(111)に相当するAg 3d5/2信号ピーク強度で規格化した。
謝辞
本報告の成果は、長期利用課題(課題番号2014A0109~2016B0109)を通してビームラインBL47XUで得られた。本課題の推進に関して多数の支援、御協力を頂いた大田晃生特任助教(名古屋大学)、村上秀樹准教授(熊本高専)、財満鎭明教授、中塚理教授、黒澤昌志講師、坂下満男助教、竹内和歌奈助教(名古屋大学)、野平博司教授(東京都市大学)、各大学の関連諸氏、および学生諸君に厚く御礼申し上げます。また、課題期間にわたり様々な技術支援を頂いた池永英司博士、JASRI職員の皆様に感謝致します。
参考文献
[1] A. Ohta et al.: Electrochemical Society (ECS) Transaction 64 (2014) 241-248.
[2] S. Miyazaki et al.: Electrochemical Society (ECS) Transaction 69 (2015) 165-170.
[3] N. Fujimura et al.: Jpn. J. Appl. Phys. 56 (2017) 04CB04.
[4] A. Ohta et al.: Microelectro. Eng. 178 (2017) 80-84.
[5] A. Suzuki et al.: Ext. abstr. of 2015 Int. Conf. on Solid State Devices and Materials (SSDM 2015).
[6] A. Suzuki et al.: Ext. abstr. of 2016 Int. Conf. on Solid State Devices and Materials (SSDM 2016).
[7] K. Takahashi et al.: Ext. abstr. of The Fifteenth Int. Workshop on Junction Technology (IWJT2015).
[8] M. Kurosawa et al.: Jpn. J. Appl. Phys. 55 (2016) 08NB07.
[9] 黒澤昌志 他:表面科学 37 (2016) 374-379.
[10] S. Yamahori et al.: Electrochemical Society (ECS) Transaction 64 (2014) 431-439.
[11] T. Yamaha et al.: Appl. Phys. Lett. 108 (2016) 061909.
[12] E. Ikenaga et al.: J. Electron Spectrosc. and Relat. Phenom. 190 (2013) 180-187.
[13] S. Tanuma et al.: Surf. Interface Anal. 43 (2011) 689-713.
[14] K. Mishima et al.: J. Physics: Conference Series 417 (2013) 012013.
名古屋大学大学院 工学研究科
〒464-8603 愛知県名古屋市千種区不老町
TEL : 052-789-3588
e-mail : miyazaki@nuee.nagoya-u.ac.jp








