Volume 14, No.2 Pages 143 - 148
2. 最近の研究から/FROM LATEST RESEARCH
長期利用課題報告1 硬X線光電子分光法による次世代シリコン系ナノデバイスの評価
Long-term Proposal Report 1: Investigation of Next Generation Silicon Nano-Electronic Devices by using Hard X-ray Photoelectron Spectroscopy
名古屋大学大学院 工学研究科 Department of Applied Chemistry, Graduate School of Engineering, Nagoya University
- Abstract
- High performance Si ultra-large scale integrated circuits (ULSI) are constantly advancing with scaling-down of metal-oxide-semiconductor field effect transistors (MOSFETs). However, for conventional scaling-down of MOSFETs, we are facing serious issues that are caused by specific physical limits of materials traditionally used. It is required to actively introduce new materials, new process technologies and new device structures, in order to overcome these problems that cannot be solved only with scaling technology of ULSI. We can investigate the chemical bonding structure and the electronic state at the interface buried in the complex multilayered structures of recent MOS devices by using a hard X-ray photoelectron spectroscopy (HAXPES), whose features are a long mean free path of photoelectrons, a large spectrum intensity, a high energy resolution, a high throughput, and a non-destructive measurement. In this study, we investigated the chemical bonding characteristics and the energy band structures of various multilayered samples by using HAXPES and aimed to establish the accurate analysis method for Si nanoelectronics.
1. はじめに
インターネットに代表される現代の高度情報化社会は、シリコン(Si)を中心とする半導体超々大規模集積回路(ULSI)による高速、大容量の情報処理技術によって支えられている。ULSIの指数関数的な性能向上の原動力は、これを構成する基本素子である金属−絶縁膜−半導体電界効果トランジスタ(MOSFET)の微細化(スケーリング)によるところが大きかった。スケーリング技術の追求によって、最先端MOSFETの素子寸法はナノメートルで記述されるスケールにまでその微細化が進んできた。
しかし、現在、MOSFETの微細化が原子尺度の極限に至った結果、Siエレクトロニクスの高集積化技術は、従来用いられてきた材料固有の物性限界に起因する大きな障壁に直面している。例えば、以前からゲート絶縁膜に用いられてきたシリコン酸化物(SiO2)薄膜に対して、将来、1 nm以下の極薄膜厚が要求される結果、量子力学的トンネル効果によるリーク電流増大が本質的に不可避となり、絶縁膜を流れるリーク電流が回路消費電力の激増を招きつつある。そのため、SiO2よりも誘電率が高く、物理膜厚の確保が容易な次世代の高誘電率絶縁膜(high-k膜)として、新たにHfSiONや希土類系金属酸化物であるLa2O3、Pr2O3等が活発に研究されている。また、従来のゲート電極材料である多結晶Siで生じる空乏層形成を避けるためのNiSi、TiN等の金属材料の導入や、Siよりも大きな電子、正孔移動度を有する歪Si、Ge、III-V族化合物半導体を用いた高速チャネルの実現なども、近年、活発に議論されている。今後は、これら様々な新規材料の物性を本質的に理解した上で、個々の材料特性を極限まで引き出し、微細化だけに頼らない革新的な材料・プロセス技術、デバイス構造が要求される。我々は、これら一連の技術を“ポストスケーリング技術”と位置づけて、近年積極的な研究展開を進めてきた。
多様な材料を用いて、究極的な電子デバイス性能を引き出し、また、新しい機能を実現するためには、その電気的特性と密接に関連する材料および界面物性の理解は必要不可欠である。例えば、high-k膜と半導体基板材料あるいは金属ゲート電極材料との間に生じる界面反応は、元素の相互拡散や欠陥準位の形成を伴い、絶縁膜の誘電率やリーク電流に大きな影響を与える。また、MOSFET動作に重要なゲート電圧のしきい値は、電極/絶縁膜界面の元素組成分布、結晶相、欠陥形成等と、これらの物性に依存するゲート電極材料の仕事関数に強い影響を受けることが報告されている。しかし、様々な新規材料から構成される多層構造およびその界面遷移領域における、界面反応、化学結合に関わる物性は未解明な点も多い研究領域である。超高密度集積に耐える高信頼性を持つナノスケール極微細ULSIを実現するために、その精密な分析評価技術が希求されている。
放射光を用いた硬X線光電子分光(HAXPES)法は、光電子の大きな脱出深さ、高いエネルギー分解能、広い内殻準位測定範囲、高輝度を活かした大きなS/N比と高いスループットなどの特徴から、次世代MOSFETにおける複雑なナノスケール多元素多層構造、およびその界面遷移領域の評価に極めて強力な分析技術となる。本長期利用課題“ポストスケーリング技術に向けた硬X線光電子分光法による次世代ナノスケールデバイスの精密評価”(2005B〜2008A)においては、超高性能・超高機能ULSI実現へのブレークスルーに向けたポストスケーリング技術確立のための分析技術として、HAXPES法による界面遷移領域の深さ方向分析手法の構築、およびこれを活用した金属電極/高誘電率絶縁膜/半導体ゲートスタック構造などの多層構造に埋もれた界面の化学結合状態と電子物性解明を研究目的とした。また、最新のMOS構造だけにとどまらず、ナノドット構造、有機系半導体基板など次世代デバイスとしての新規ナノ構造に対するHAXPES法の応用可能性についても評価、検討した。本稿に関連する内容は、第12回SPring-8シンポジウム(2008年10月30日〜11月1日)・長期利用課題報告においても報告しているので、合わせてご参照いただきたい。
2. 硬X線光電子分光法
本課題におけるHAXPES測定は、アンジュレータビームラインBL47XUにおいて設置された光電子分光ステーションを利用して行われた。図1に典型的なHAXPES光学系の模式図を示す。蓄積リングからアンジュレータを通して得られたX線は、Si単結晶モノクロメータによって6〜8 keVの任意の励起エネルギーを有するX線として単色化され、さらにスリット、集光ミラーを用いることで試料上において、およそ35 µm程度の微細スポットに集光される。X線が照射された領域において、試料を構成する元素からの光電子が発生する。試料を傾けることで、任意の角度に脱出してくる光電子をアナライザーによって検出した。
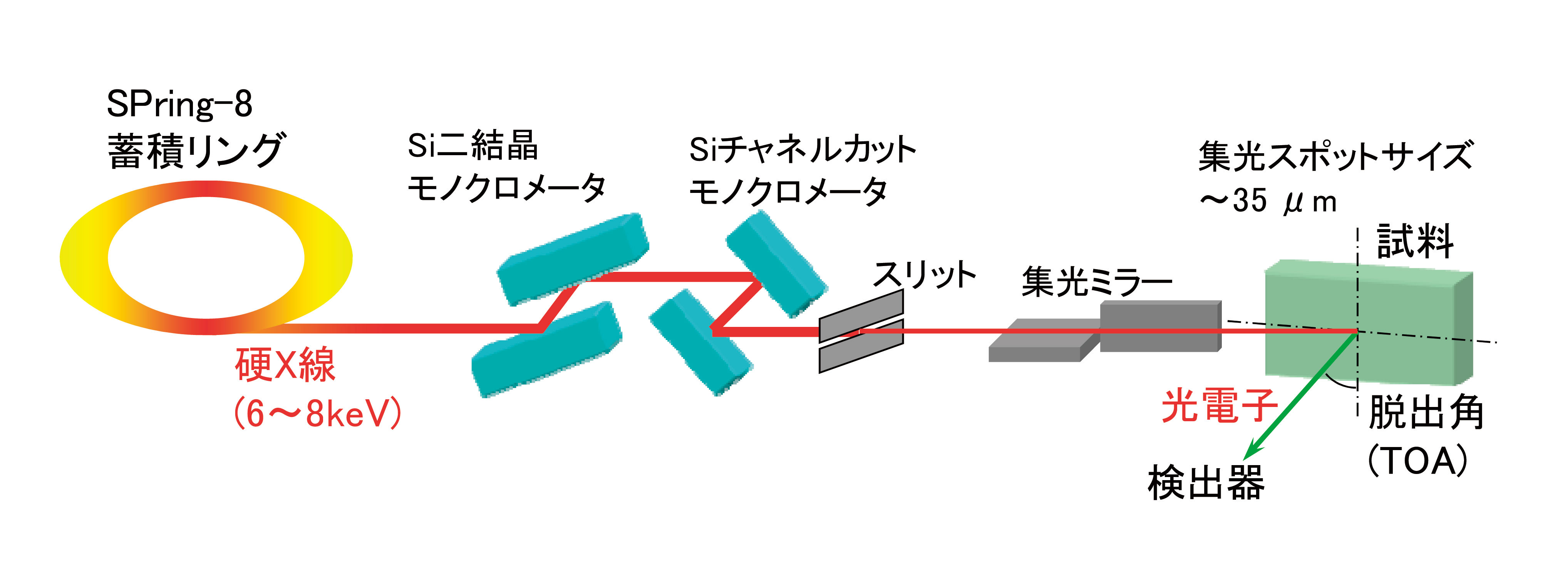
図1 BL47XUにおけるHAXPES測定光学系の模式図。
MgKα線(1253.6 eV)やAlKα線(1486.6 eV)などの軟X線を用いる従来のX線光電子分光(XPS)法では励起エネルギーの制限から、試料表面から2 nm程度の深さまでの化学結合状態の検出が限界であったため、現在のMOS型構造において膜厚3〜4 nm程度であるhigh-k膜と半導体基板との界面や、10 nm程度の金属ゲート電極と絶縁膜との界面など、多層構造の界面化学結合状態を、デバイス構造そのままの状態で観察することは不可能だった。一方、HAXPES法においては、比較的大きな6〜8 keVの励起エネルギーを持つ硬X線をプローブに用いるため、内殻準位あるいは価電子帯から発生する光電子は、大きな運動エネルギーを持つ。その結果、例えば、SiO2中のSi1s光電子の脱出深さは8.5 nmに達するため、多層構造を通した深い領域からの光電子をも検出可能となる。図2に、NiGe(7〜15 nm)/SiO2(12 nm)/Si基板構造を持つ試料を、励起エネルギー7.943 keVの硬X線により測定したSi1s内殻準位スペクトルを示す。厚い金属ゲート電極/絶縁膜構造を通しても、基板のSiに起因するSi-Si結合のスペクトルが十分な強度を持って検出できることがわかる。すなわち、HAXPES法によって、実際のデバイス構造に対して、非破壊でリアルな状態の化学結合状態評価が可能となる。
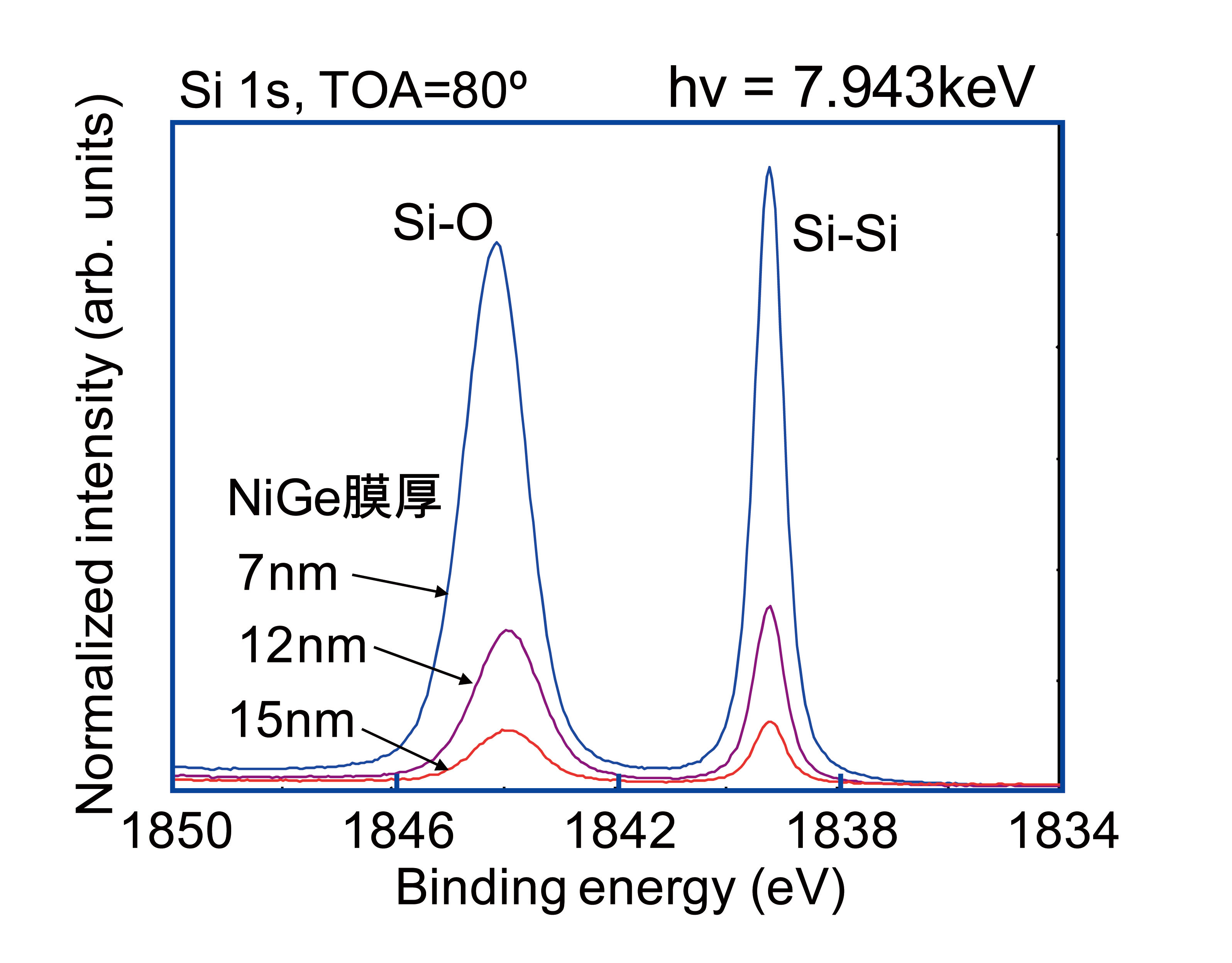
図2 NiGe(7〜15 nm)/SiO2(12 nm)/Si基板試料におけるHAXPES法により測定したSi1s内殻準位スペクトル。Si-O結合に加えて、基板Siを示すSi-Si結合に関連する信号を、厚いNiGe/SiO2層を通しても観測できる。励起エネルギーは7.943 keV。光電子脱出角は80°。
3. ゲートスタック構造内部の界面遷移領域の化学結合状態評価
本研究課題では、SiあるいはGe基板上にHfシリケート膜、およびPr、La、Gdなどの希土類系金属酸化物膜を形成した種々の試料を作製し、次世代MOSFETのゲートスタック構造に埋もれた界面遷移領域における化学結合状態評価を行った。以下にいくつかの事例を紹介する。
近年、ULSIへの導入が進められているHf系酸化物膜とSi基板界面における界面反応、化学結合構造の詳細な評価を行った[1][1] T. Hattori, H. Nohira, K. Azuma, K. W. Sakai, K. Nakajima, M. Suzuki, K. Kimura, Y. Sugita, E. Ikenaga, K. Kobayashi, Y. Takata, H. Kondo and S. Zaima: Int. J. High Speed Electron. Sys. 16 (2006) p.353-364.。HfO2(4.4 nm)/SiO2(0.8 nm)/Si(001)試料をHfO2堆積後熱処理(PDA)前後で測定したSi1sおよびHf3d内殻準位スペクトルを、図3(a)および(b)にそれぞれ示す。PDA前後において、Si基板からのSi1sスペクトルには大きな違いが見られないが、光電子脱出角80°の測定において、Hf3dスペクトルのピークが低結合エネルギー側にシフトしていることがわかる。これは、熱処理によってHfO2とSiとの界面SiO2層内にHf-Si結合が生じたことを示唆している。さらに、高分解能ラザフォード後方散乱(RBS)法により評価したSi、Hf、Oの深さ方向組成分布を基準として、角度分解HAXPES測定から得られた化学結合状態に関するデータを最大エントロピー法を用いて解析した結果、図4に示すようなスタック構造内部におけるSi-Hf結合の深さ方向分布が得られた。その結果、PDA処理後の試料においては、HfO2とSiとの界面遷移領域にSi-Hf結合が偏在することが明らかになった。
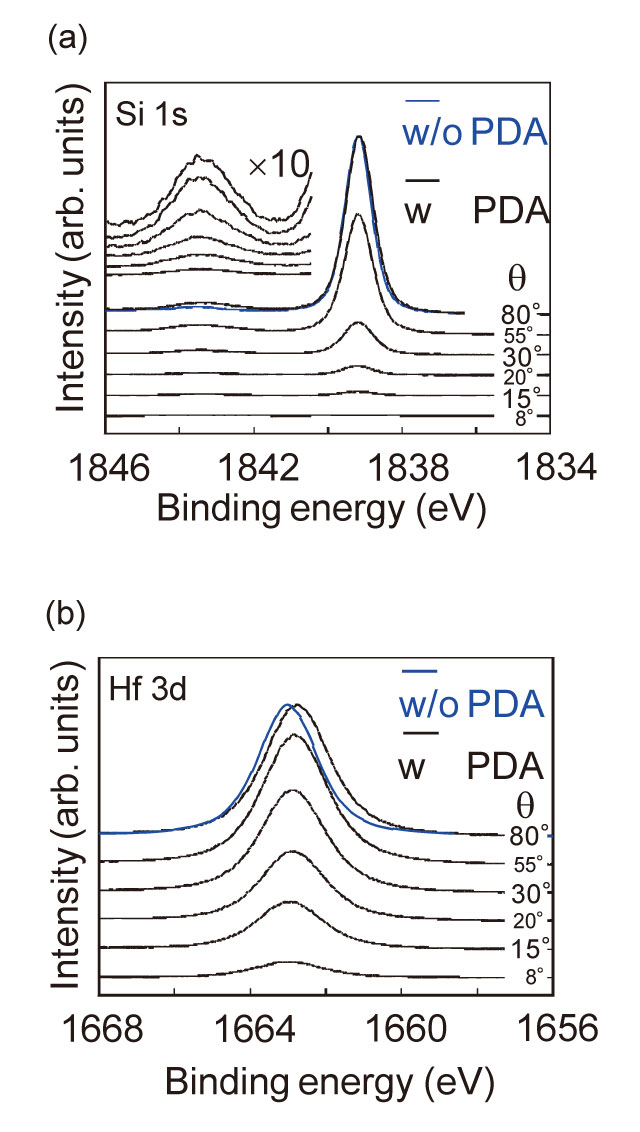
図3 HfO2(4.4 nm)/SiO2(0.8 nm)/Si(001)試料のHfO2堆積後熱処理(PDA)前後におけるHAXPES測定結果。(a) Si1sおよび(b) Hf3d内殻準位スペクトル。励起エネルギーは5.950 eV。θは光電子脱出角。
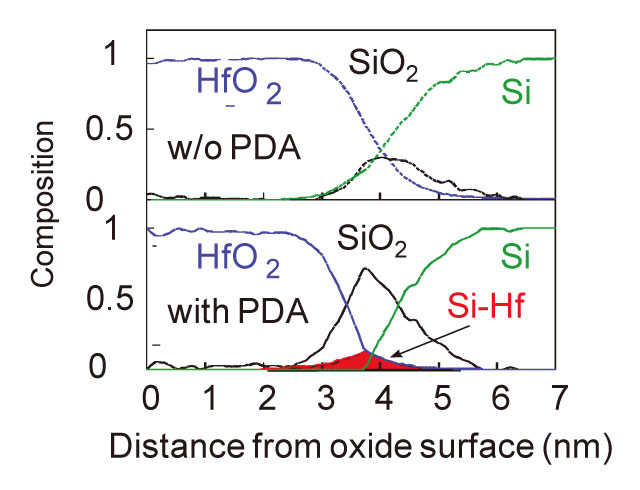
図4 HAXPESおよびRBS測定を用いて評価されたHfO2/SiO2/Si多層構造における組成および化学結合状態の深さ方向分布。上段、下段はそれぞれPDA処理前後を示す。
次に、高キャリア移動度材料であるGe基板上にhigh-k膜として希土類Pr酸化物膜を形成した試料を準備し、PrOx/Ge界面におけるGeの分布を詳細に評価した結果について示す[2,3][2] M. Sakashita, N. Kito, A. Sakai, H. Kondo, O. Nakatsuka, M. Ogawa and S. Zaima: in Ext. Abstra. of 2007 International Conference on Solid State Devices and Materials, p.330-331, Tsukuba, Japan, Sept. 18-21, 2007.
[3] 鬼頭伸幸、坂下満男、酒井朗、中塚理、近藤博基、小川正毅、財満鎭明:ゲートスタック研究会−材料・プロセス・評価の物理−(第12回研究会)研究報告 p.251-256.。同じPrOx(5.2 nm)/Ge(001)試料をHAXPES法およびMgKα線によるXPS法により評価し、Ge2pおよびPr3d内殻準位スペクトルより得られたGe酸化物成分信号とPr信号の強度比を光電子脱出角の関数でプロットしたものを図5に示す。先述のように、励起光に硬X線を用いた場合、試料中における光電子の平均自由行程はおよそ10 nm前後とMgKα線を用いた場合の2〜3 nmよりも相当大きくなる。(GeOx/Pr3d)光電子強度比の脱出角依存性が励起光によって大きく異なるのは、各成分の多層構造内部における分布の違いを反映している。数値計算を行うことで、分布の詳細を評価したところ、Pr酸化物膜とGe基板との間にGe酸化物層が存在する、GeO2(0.01 nm)/PrOx(3.9 nm)/GeO2(0.1 nm)/Geで表わされるような表面・界面構造が形成されていることが推測された。さらに本研究を通して、このようなhigh-k/Ge界面における界面反応やGeのhigh-k膜中への拡散が、high-k膜の誘電率を著しく低下させること、Pr酸化物/Ge界面に挿入した極薄Ge窒化物膜がGe拡散の阻止と誘電率低下の抑制に有効であることも明らかになった。
以上のようにHAXPES法を用いることで、MOSFETの多層構造深くに埋もれた界面遷移領域の化学結合状態を非破壊かつ詳細に分析可能となり、界面の化学的安定性や電子物性に与える固相反応の影響などに関する知見が得られることを実証できた。
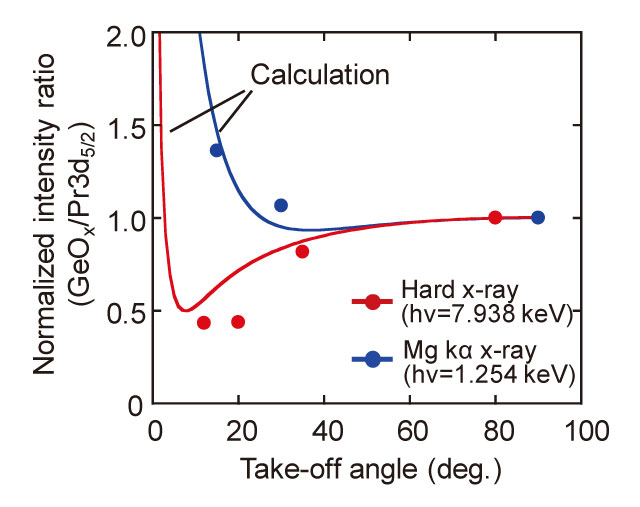
図5 PrOx(5.2 nm)/Ge(001)試料におけるGe酸化物成分信号とPr信号の強度比の光電子脱出角依存性。それぞれの信号は、HAXPES法およびXPS法(MgKα線)を用いてGe2pおよびPr3d内殻準位スペクトルから評価した。図中の曲線は、GeO2(0.01 nm)/PrOx(3.9 nm)/GeO2(0.1 nm)/Ge構造を仮定した場合の計算結果。
4. ゲートスタック構造におけるエネルギーバンド構造の評価
高い絶縁性、信頼性を実現するMOS構造の形成には、エネルギーバンドギャップ、界面バンドオフセットなどのエネルギーバンド構造の詳細な理解が必要不可欠である。大きな励起エネルギーを有するHAXPES法を用いることで、発生する光電子の運動エネルギーを幅広い範囲から選択可能となり、従来のXPSでは評価が困難であったような領域のエネルギースペクトル構造を分析できる。例えば、図6(a)に示すように、従来のAlKα線を用いたXPS測定では、Ge基板上に形成した酸化物膜におけるO1s内殻準位スペクトルの高結合エネルギー側に現れる損失スペクトル評価の際、GeLMM遷移のオージェ電子に起因する信号が重畳するため、その分析が困難であった[4][4] A. Ohta, H. Nakagawa, H. Murakami, S. Higashiand S. Miyazaki: J. Surf. Sci. Nanotech. 4 (2006) p.174-179.。しかし、硬X線を用いれば、励起エネルギーの適切な選択により、オージェ電子に起因する信号が重なることなく損失スペクトルが得られる。図6(b)に示すように十分な分解能を持って測定されたスペクトルから、Ge基板上に形成したLaAlO3膜のエネルギーバンドギャップを6.1 eVと決定できた。
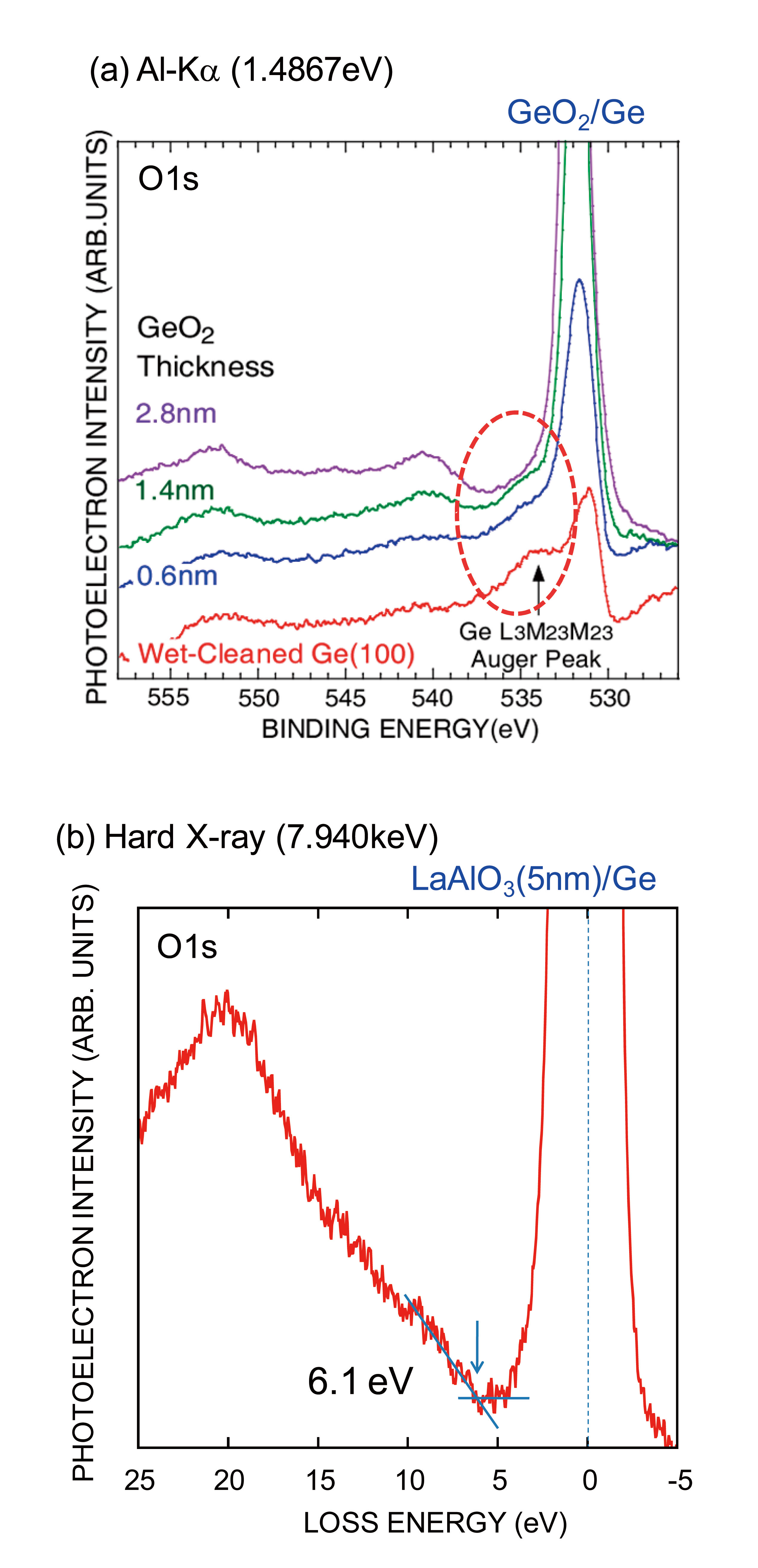
図6 (a) AlKα線源を用いたXPSにより得られたGeO2/Ge試料のO1s損失スペクトル。O1s内殻準位スペクトルの高エネルギー側にGeLMMオージェ電子に起因する信号が重畳している。(b) HAXPESにより得られたLaAlO3/Ge試料のO1s損失スペクトル。GeLMMオージェ電子の影響を除いて、損失スペクトルよりエネルギーバンド構造を評価可能となる。
5. 次世代メモリデバイスに向けたナノドット構造の分析
メモリデバイスなどへの応用が期待されるSiやNiSiナノドットの多層構造に埋もれた状態における電子状態、微量不純物元素の化学結合状態の分析評価を行った。一例として、Siナノドットの電子状態に関する結果を述べる。
我々は、SiO2/Si上に形成した膜厚0.3 nm程度の極薄アモルファス層を570°C〜630°C程度で熱処理することで、図7(a)に示すような粒径4.9 nm、数密度3 × 1012cm-2の超高密度Siナノドット構造を形成できることを報告してきた。しかし、そのSiナノドットは、構造が極めて微細であるため、その電子状態や結晶構造を従来のXPSやX線回折、電子顕微鏡で評価することは困難であった。そこで、高輝度、高分解能の特徴を持つHAXPESを用いて、これらSiナノドット構造の詳細評価を行った[5][5] H. Kondo, T. Ueyama, E. Ikenaga, K. Kobayashi, A. Sakai, M. Ogawa and S. Zaima: Thin Solid Films 517 (2008) p.297-299.。
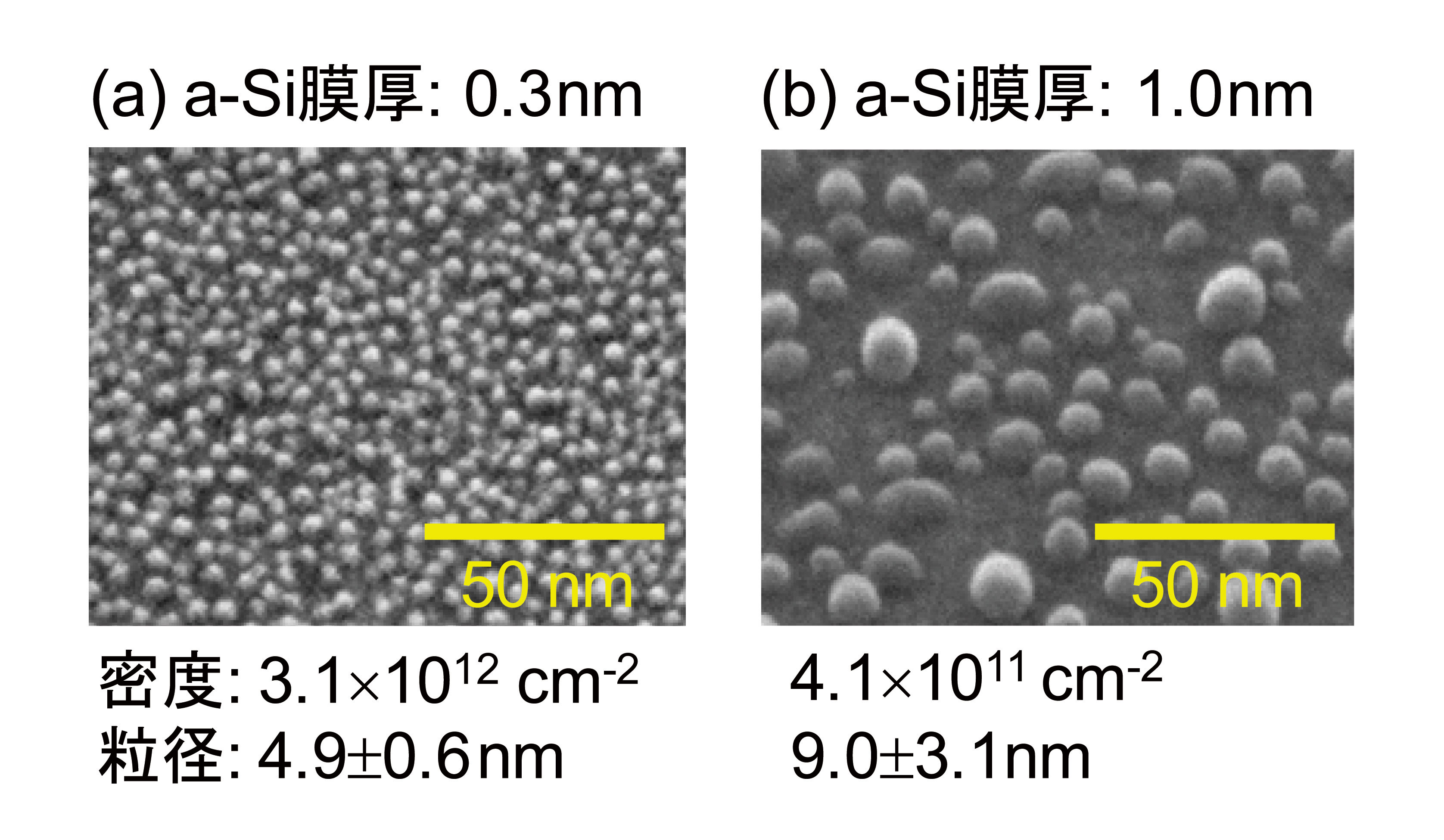
図7 SiO2/Si上に形成したSiナノドット構造の表面走査電子顕微鏡像。a-Si/SiO2/Si基板構造に熱処理を加えて形成した。(a) 初期a-Si膜厚0.3 nmおよび(b) 1.0 nm。
図8は、Siナノドット/SiO2/Si試料のSi1s内殻準位のHAXPES測定から評価した、Si-Si結合に起因するスペクトルの半値幅に関する光電子脱出角依存性である。スペクトルの半値幅が、初期a-Si膜厚の違いに依存して変化することがわかる。すなわち、初期a-Si膜厚0.3 nmの試料においては、表面敏感な低脱出角の測定において、半値幅が1.5 eV程度まで大きく増大する。これはa-Si特有の結合角、結合距離の分散の広がりに起因すると考えられ、本研究で形成されたナノドットが結晶とは異なりアモルファス状態を取っていることが示唆された。この結果より、極薄a-Si層の熱処理によって形成されるSiナノドット内部の化学結合状態は、初期a-Si膜厚の極薄化と共に、結晶状態からアモルファス状態へ大きく変化することが明らかになった。

図8 Siナノドット/SiO2/Si試料のSi1s内殻準位のHAXPES測定から評価した、Si-Si結合に起因するスペクトルの半値幅に関する光電子脱出角依存性。
6.まとめ
本長期利用課題においては、将来のポストスケーリング技術に活用可能なHAXPES分析技術の構築とこれを用いたSi系MOSFETを中心とするナノ多層構造の精密評価を目指して研究を推進し、次世代Siナノエレクトロニクス技術確立に向けた多数の成果が得られた。紙幅の都合で割愛したが、前述の成果以外にも、①HfSiONやHfGdOxなどの各種高誘電率絶縁膜と半導体との界面領域におけるエネルギーバンド構造と組成分布、結晶構造との関係を解明し、次世代ゲート絶縁膜応用に向けた材料プロセス技術への指針を示した。②NiシリサイドやTiSiN、TiAlNなどの金属ゲート材料と絶縁膜との界面反応がゲート電極の仕事関数変調に大きな影響を与えることを示し、次世代MOSFETにおける仕事関数制御技術構築に貢献した。③SiおよびAlの酸化物、窒化物、および界面遷移領域におけるケミカルシフトの詳細評価を行い、MOS構造設計に重要な絶縁膜材料の誘電率決定に関する指針を示した。④次世代の極端紫外露光用レジストや有機系低誘電率層間絶縁膜に向けて、有機系基材へのプラズマ照射による表面ナノ領域における深さ方向の損傷状態の解明、および最表面への官能基付与技術の可能性を解明した、等々、多数の成果が得られている。
本長期利用課題では、最新のMOSFETゲートスタックにおける埋もれた界面構造の評価にHAXPES法が極めて有効であり、本研究領域の様々な問題解決に対して分析技術の観点から多大な貢献ができることを実証した。今後は、さらに集光技術の向上による高輝度硬X線マイクロプローブを用いる等、ナノスケールデバイス内部の局所領域における3次元顕微分光評価技術などにも大きな期待がもたれる。
謝辞
本報告の主要な成果は長期利用課題(2005B0005〜2008A0005)の枠組内で得られました。また、本研究の一部は、文部科学省・科学研究費補助金・特定領域研究“ポストスケール”の支援により推進されました。本課題の推進に関して多数のご支援、ご協力をいただいた関係諸氏に厚く御礼申し上げます。また、課題期間にわたり様々な技術支援をいただいたJASRI職員の皆様に感謝致します。
参考文献
[1] T. Hattori, H. Nohira, K. Azuma, K. W. Sakai, K. Nakajima, M. Suzuki, K. Kimura, Y. Sugita, E. Ikenaga, K. Kobayashi, Y. Takata, H. Kondo and S. Zaima: Int. J. High Speed Electron. Sys. 16 (2006) p.353-364.
[2] M. Sakashita, N. Kito, A. Sakai, H. Kondo, O. Nakatsuka, M. Ogawa and S. Zaima: in Ext. Abstra. of 2007 International Conference on Solid State Devices and Materials, p.330-331, Tsukuba, Japan, Sept. 18-21, 2007.
[3] 鬼頭伸幸、坂下満男、酒井朗、中塚理、近藤博基、小川正毅、財満鎭明:ゲートスタック研究会−材料・プロセス・評価の物理−(第12回研究会)研究報告 p.251-256.
[4] A. Ohta, H. Nakagawa, H. Murakami, S. Higashiand S. Miyazaki: J. Surf. Sci. Nanotech. 4 (2006) p.174-179.
[5] H. Kondo, T. Ueyama, E. Ikenaga, K. Kobayashi, A. Sakai, M. Ogawa and S. Zaima: Thin Solid Films 517 (2008) p.297-299.
中塚 理 NAKATSUKA Osamu
名古屋大学大学院 工学研究科 結晶材料工学専攻
〒464-8603 名古屋市千種区不老町
TEL : 052-789-5963 FAX : 052-789-2760
e-mail: nakatuka@alice.xtal.nagoya-u.ac.jp
財満 鎭明 ZAIMA Shigeaki
名古屋大学大学院 工学研究科 結晶材料工学専攻
〒464-8603 名古屋市千種区不老町
TEL : 052-789-2762 FAX : 052-789-3818
e-mail : zaima@alice.xtal.nagoya-u.ac.jp








