Volume 18, No.4 Pages 290 - 295
1. 最近の研究から/FROM LATEST RESEARCH
長期利用課題報告2 次世代MISトランジスタ開発に向けた高輝度硬X 線光電子分光分析
Long-term Proposal Report 2: Hard X-ray Photoemission Study of Materials and Process Integration for Advanced MIS Transistors
名古屋大学 大学院工学研究科 Graduate School of Engineering, Nagoya University
- Abstract
- 高度情報化社会を支える半導体集積回路の基本素子であるMISトランジスタの開発において、物理寸法の微細化スケーリングに代わる技術開発、具体的には、新材料・新デバイス構造の導入による高性能化に強い期待が向けられている。ゲルマニウム(Ge)は、従来のシリコン(Si)に比べ、電子・正孔ともにバルク移動度が高く、歪み印加による移動度向上率も高いことから、次世代高移動度チャネル材料として有望視されている。その導入に当たっては、電気的特性と密接に関連するゲート絶縁膜等の材料および界面物性の理解が必須であり、実デバイス内の様々な材料で構成されるナノメートルスケールの多層構造や埋もれた界面を高感度に非破壊で分析可能な硬X線光電子分光(HAXPES)は極めて強力な分析技術である。本研究では、ビームラインBL46XUでのHAXPES分析を通して、Geチャネルを有効活用する上で不可欠となる金属/high-k絶縁膜スタックやコンタクト形成等の要素技術において、化学反応や電子状態の理解を深め、界面反応の精密制御に繋がる知見を得ることに成功した。
1. はじめに
情報化社会の発展によりパソコンやスマートフォン等のIT機器の普及が進み、ユビキタスネットワーク社会の実現に向けて、より一層の高度化が期待される。しかしながら、現在、IT機器の消費電力量は激増しており、2025年には現在の約9倍(世界の総発電量の15%超)に達することが予測されており[1][1] 経済産業省/グリーンIT推進協議会試算(2008)、これを抜本的に打開するには、IT機器の主要構成部品である大規模集積回路(LSI: Large Scale Integration)の消費電力および発熱量を低減する技術の確立が急務である。
とりわけ、LSIの基本素子である金属-絶縁膜-半導体電界効果トランジスタ(MISFET: Metal Insulator Semiconductor Field Effect Transistor)の開発において、低省電力化と高性能化の両立が強く求められている。従来Si-MISFETで進められてきた幾何学的な微細化スケーリングによる性能向上は極限に達しており、材料固有の物性が性能限界を決定する主要因となっている。そこで、更なる高集積化・高性能化を図るために、高誘電率(high-k)ゲート絶縁膜、金属ゲート電極、高移動度チャネル等の新たな電子材料を導入した等価的なスケーリングやFinFET(Fin-Field Effect Transistor)に代表される立体構造トランジスタの開発・実用化が進められている。高移動度チャネル材料候補の中でも、Geは、Siに比べて電子・正孔ともにバルク移動度が高く、圧縮歪を導入することで正孔の移動度が増大し、伸長歪では正孔のみならず電子の移動度向上も可能となる。Geの高い移動度を活かした高電流駆動力をデバイスレベルで引き出すためには、MISFETを構成する電子材料固有の物性の本質的な理解と、MIS界面の制御技術を確立する必要がある。特に、各種候補材料に対して、薄膜や界面の化学構造をそれぞれ独立に評価するだけでなく、最終的な微細MISFETを見据えた積層構造において、ナノメートルスケールで近接する界面で生じる相互作用(酸化・還元反応や原子拡散)を明らかにすることが重要となる。
そこで、本長期利用課題「次世代MISトランジスタ実現に向けた材料プロセスインテグレーション ~金属/高誘電率絶縁膜/Geチャネルゲートスタック構造の硬X線光電子分光~」では、実際のデバイス内の様々な材料で構成される多層構造や埋もれた界面における化学構造や電子状態の非破壊分析に有効な硬X線光電子分光(HAXPES: HArd X-ray Photoemission Spectroscopy)を活用して、低消費電力かつ高電流駆動が期待できるGe-MISFET実現に不可欠な界面反応制御やプロセス技術の指針を得ることを目標に分析を進めた。
2. 評価方法
HAXPES分析は、ビームラインBL46XUに設置された光電子脱出角度が可変な光電子分光ステーションを利用した。蓄積リングからアンジュレータを通して得られた放射光を、Si単結晶を用いたモノクロメータ、スリット、集光ミラーを通すことで、単色化された硬X線が分析試料上で~20 μmまで集光される。7939 eVの励起エネルギーを持つ硬X線をプローブとして使用した。この時Ge基板から励起されるGe 2p3/2内殻光電子の平均自由工程は~9.3 nmであり[2][2] S. Tanuma, C. J. Powell and D. R. Penn: Surf. Interface Anal., 43 (2011) 689-713.、深さ方向の分析限界は表面から~30 nmに相当する。これに対して、一般に市販されているX線光電子分光(XPS: X-ray Photoelectron Spectroscopy)装置で励起X線源に使用されているAl Kα特性X線(1486.6 eV)の場合では、同様のGe 2p3/2内殻光電子の平均自由工程は~0.8 nmであり[2][2] S. Tanuma, C. J. Powell and D. R. Penn: Surf. Interface Anal., 43 (2011) 689-713.、試料表面の分析が中心となる。両者の光電子分光装置を用いて、熱酸化GeO2/Ge構造を実測したGe 2p3/2内殻光電子スペクトルを図1に示す。HAXPESでは、表面に存在する厚さ21 nmのGeO2を通してGe基板からの光電子が検出されており、市販のXPS装置では分析不可能な試料表面より深い領域の化学結合状態が観察可能であることが分かる。このことに加えて、多元素から構成された試料では、結合エネルギー数百eVの測定領域で、内殻光電子信号同士が重畳し解析を困難にする場合があるが、HAXPESでは測定可能なエネルギー範囲が幅広いため、このような問題を回避し分析精度を向上できる。また、高輝度X線を使用することから、高いエネルギー分解能で極微量存在する構成元素が検出でき、かつ従来にない高いスループットで測定を進めることが可能となる。
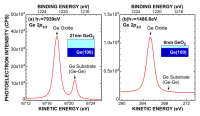
図1 HAXPESの特徴である深い分析深度を示す一例:(a)HAXPES(hν = 7939 eV)および(b)単色化Al Kα特性X線を用いたXPS(hν = 1486.6 eV)分析で評価したGeO2/Ge(100)構造のGe 2p3/2内殻光電子スペクトル GeO2層の厚みは分光エリプソメトリにより別途評価し、測定時の試料表面に対する光電子脱出角度はそれぞれ(a)80ºおよび(b)90ºである。
3. High-k絶縁膜/Ge界面における化学反応制御
Geチャネル上のゲート絶縁膜には、SiO2膜厚換算で1 nm以下が要求されており、極薄膜で生じる量子効果による直接トンネルゲートリーク電流を抑制するために、物理膜厚を厚く設定しても電気的等価膜厚は薄くできるhigh-k絶縁膜を組み合わせることが必須である。そのため、欠陥準位の形成や電気的等価膜厚の薄膜化を妨げる界面反応を抑制し、良好な界面特性を得るための制御技術構築が必要不可欠である。そこで、high-k絶縁膜/Ge界面へ極薄のGeON、Si、Al2O3、TiOx、TaOx制御層導入を検討し、その効果をHAXPESにより分析した。以下に成果の一部を示す。
HfO2/歪Ge層界面に分子線エピタキシー法(MBE: Molecular Beam Epitaxy)でSi層を形成し、O2雰囲気中熱処理が歪Ge層酸化の抑制効果について調べた[3][3] A. Komatsu, K. Nasu, Y. Hoshi, T. Kurebayashi, K. Sawano, M. Myronov, H. Nohira and Y. Shiraki: ECS Transactions, 33 (2010) 467-472.。図2には、熱処理前後においてSi 1sおよびGe 2p3/2内殻光電子信号で観測された酸化成分のSi層の膜厚依存性を示す。Si層の厚みが1 nm以下では、HfO2堆積時より歪Ge層の酸化が生じるのに対して、厚さ2 nm以上のSi層を用いた場合では、300ºCの熱処理前後で、歪Ge層の酸化は認められず、効果的に酸化反応を抑制できた。また、内殻光電子スペクトルの解析から、Si層が1 nm以下の場合では、酸化反応の進行と伴に元素の相互拡散が生じ、HfSiO:Ge混合層を形成することが分かった。さらに、光電子脱出角度依存性を利用して、HfO2/Si/歪Ge構造における化学組成の深さ方向分析を行った結果、厚さ5 nmのSi層形成が400ºC熱処理後においても積層構造の安定化・界面反応の抑制に効果的であることが示された。
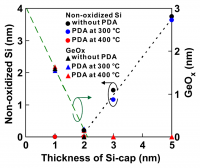
図2 内殻光電子信号より見積もったO2熱処理前後のHfO2(10 nm)/Si/歪Ge(20 nm)構造の未酸化Si層およびGe酸化物のSi層膜厚依存性
4. Ge-MIS構造における界面化学結合状態分析
MISFETの動作に重要なゲート電圧のしきい値は、電極/絶縁膜界面での電荷移動に伴う電気二重層の生成や絶縁膜中の荷電欠陥密度分布に強く影響を受けることが知られており、前述した絶縁膜/Ge界面だけでなく金属電極も含めた界面反応の理解とその制御が重要になる。熱酸化で形成したGeO2およびhigh-kゲート絶縁膜候補であるPrOx膜を用いたGe-MIS構造を作製し、化学反応制御に関する知見を得た。
真空蒸着によりTi、Al、Ni、もしくはAuの金属層を、厚さ1 nmの熱酸化GeO2上に形成した[4][4] A. Ohta, T. Fujioka, H. Murakami, S. Higashi and S. Miyazaki : Jpn. J. Appl. Phys., 50 (2011) 10PE01.。図3に示す各試料のGe 2p3/2内殻光電子スペクトルより、金属元素に依存しGe酸化成分の強度が変化し、Al >Ti >Ni >Auの順にGeO2の還元性が高いことを明らかにした。最も還元性の高いAlでは1 nm程度のGeO2と反応することが分かった。この金属層形成に伴うGeO2の還元性は、界面における金属の酸化反応と強く相関し、酸化還元反応に伴う自由エネルギー変化の大きさで説明できる(図4)。また、厚さ1 nm以上のGeO2膜上にAlを堆積した場合では、GeO2の減少だけでなく、Ge-Al結合成分の形成が認められた。
Al、W、Pt、もしくはAuを形成した金属/PrOx/Ge積層構造では[6][6] K. Kato, M. Sakashita, W. Takeuchi, N. Taoka, O. Nakatsuka and S. Zaima: Solid-State Electron., 83 (2013) 56-60.、Ge 2p3/2内殻光電子スペクトルの解析より、PrOx堆積後にGeOx(もしくはPrGeOx)形成し、還元性の高いAl堆積によりGeOx量は顕著に減少することが分かった(図5)。また、金属堆積することでPrOx膜中のPr4+成分が減少しPr3+成分の割合が増大する価数変化が認められ、金属の還元性が高いほどPrOx膜から金属へ酸素が移動したと考えられる。さらに、光電子脱出角度を変化させた深さ方向分析から(図6)、AlやWなど還元性が高い金属堆積後ではGeOxは主にPrOx表面に存在し、GeがPrOx中に容易に拡散することが示唆された。一方、還元性の低いPtやAu薄膜の場合は、金属膜形成に伴いGeOx量が増大することが分かった。同様の試料の電気的特性評価では、還元性の高いAl電極に用いた場合、高密度な欠陥形成が認められた。以上の結果から、ゲート金属の酸化・還元性は、high-k絶縁膜表面のみならず、high-k膜中およびGeとの界面反応にも大きく影響することが明らかになった。
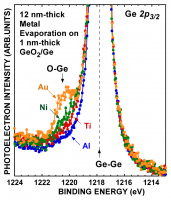
図3 厚さ1 nmの熱酸化GeO2/Ge上に異なる金属薄層(Au、Ni、Ti、およびAl:平均厚さ12 nm)を堆積した試料のGe 2p3/2内殻光電子スペクトル 各スペクトルは、光電子脱出角80ºで測定し、光電子強度はGe基板成分で一致させた。

図4 Gibbs自由エネルギー変化(ΔG)に基づく金属/GeO2界面反応の考察 金属とGeO2の反応により金属酸化物とGeが形成する場合の自由エネルギー変化(温度298 K圧力1 atm)を算出した。各酸化物の標準モルギブス自由エネルギーは文献値[5][5] 化学便覧基礎編 Ⅱ 改訂3版, 305を使用した。

図5 金属(Al、W、およびPt)/PrOx/Ge構造のGe 2p3/2内殻光電子スペクトルより見積もったGe酸化成分(Gex+)と基板成分(Ge0+)の面積強度比
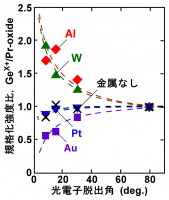
図6 金属(Al、W、Pt、およびAu)/PrOx/Ge構造において、観測されたPrOxに対するGeOx光電子強度の光電子脱出角依存性
5. 金属/Ge構造の界面反応評価
Geに金属を直接接触させたショットキー接合では、その接合障壁高さに金属の仕事関数がほとんど反映されず、フェルミ準位がGeの価電子帯上端近傍に固定されるフェルミレベルピニング(Femi Level Pinning: FLP)が生じる。金属/Ge直接接合の形成や低コンタクト抵抗を得るためには、FLPの理解とその制御手法の確立が必要となる。FLP解消の簡便な手法として、接合界面に極薄GeO2トンネル制御層を挿入することが報告されている。そこで、本研究では、その物理描像の理解を深めるため、金属層越しに界面遷移領域での化学構造分析を進めた[7][7] A. Ohta, M. Matsui, H. Murakami, S. Higashi and S. Miyazaki: ECS Transaction, 50 (2012) 449-457.。
真空仕事関数がGeの伝導帯下端近傍であるAl(4.10~4.28 eV)を用いたAl/GeO2(厚さ2.7 nm)/p型Ge(100)構造において、Ge 2p3/2内殻光電子スペクトルでは、堆積直後に観測されたGeO2成分は300ºC以上の熱処理により還元反応が促進し消失する(図7)。また、熱処理に伴いGe基板成分は低結合エネルギー側へ徐々にシフトする。HAXPES測定中は、AlおよびGe基板を接地電位にしており、Alに相当する信号は一定のエネルギー位置を示すことから、観測されたエネルギーシフトの主要因として、Ge基板表面のポテンシャル変化(バンドベンディング)が考えられる。すなわち、図8に示すように接合界面近傍でAlの実効的な仕事関数がGe価電子端近傍に固定されたと解釈できる。このことは別途測定した電流―電圧特性で認められた傾向とも一致し、熱処理による接合界面の化学構造変化がFLPを誘起することが分かった。これらの結果より、金属/Ge界面に極薄膜を導入して伝導特性を制御するには、熱的・化学的に安定な制御層が必須と言える。この結果を踏まえ、熱的に安定な界面制御層として極薄HfNを挿入した場合では、FLPの発現が抑制できた。極薄膜を用いた伝導特性制御において、熱的に安定な接合界面の形成には、N導入が効果的であることが示された。

図7 N2熱処理前後におけるAl/GeO2(2.7 nm)/p-Ge(100)構造のGe 2p3/2内殻光電子スペクトル 各スペクトルは光電子脱出角30ºで測定した。
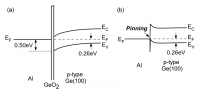
図8 (a)熱処理前および(b)450ºCのN2雰囲気中熱処理後のAl/GeO2(2.7 nm)/p-Ge(100)のエネルギーバンド構造
6. 高濃度As+イオン注入したGe層の化学分析
低抵抗ソース・ドレインの形成において、PやAsなどのn型ドーパントの活性化率を向上させることが課題であり、高濃度不純物導入領域における化学結合状態に関する理解とその知見に基づいた活性化手法が求められている。
図9には、As+イオン注入したGe層の活性化熱処理前後で測定したGe 2p3/2内殻光電子スペクトルを示す[8][8] T. Ono, A. Ohta, H. Murakami, S. Higashi and S. Miyazaki: Extend Abstract of 2012 International Conference of Solid State of Device and Materials, (2012) 38-39.。Ge基板成分はAs+イオンの注入により低結合エネルギー側へシフトする。このシフトは、イオン注入したGe層の価電子帯側へのフェルミ準位変化を示唆している。別途行ったラマン散乱分光法による結晶性評価結果を考慮すると、n型ドーパントであるにも関わらずフェルミ準位が価電子帯側へ移動したのは、イオン注入によるアモルファス化に伴うアクセプター型欠陥が生成に起因すると考えられる。また、活性化熱処理に伴うGe基板成分の高結合エネルギー側へのシフトは、As活性化とアクセプター型欠陥の低減による伝導帯側へのフェルミ準位のシフトと解釈できる。図10に示す活性化熱処理後のAs 2p3/2内殻光電子スペクトルにおいて、活性化したAs1+成分と不活性状態なAs0+成分に分離した結果、ドーズ量を5x1014 cm-2から5x1015 cm-2に増大させても、As1+の相対強度より算出した活性化量は約5x1019 cm-3で飽和することが分かった。As活性化の飽和には、3配位Asの増大、Asクラスタリングが関与している可能性が高く、低抵抗As注入層の形成のためには、それらの抑制が不可欠であることを明らかにした。最近の研究において、-50ºCに冷却したGe基板へイオン注入では、イオン注入時のアニール効果が抑制されてアモルファス化が助長することで、3配位As やAsクラスタ生成が効果的に阻害されて、熱処理による活性化率が顕著に向上することも見出している。
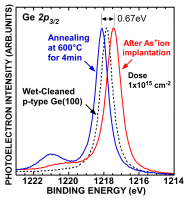
図9 As+イオン注入(10 keV, 1x1015 cm-2)したp型Ge(100)における活性化熱処理(N2雰囲気中、4分)前後のGe 2p3/2内殻光電子スペクトル 各スペクトルは光電子脱出角30ºで測定した。光電子分光分析では、フェルミ準位を基準として結合エネルギーを測定することを考慮すると、観測されたエネルギーシフトは、主として実効的なフェルミ準位の変化に相当する。
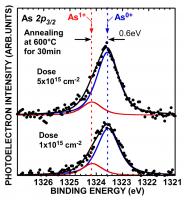
図10 高濃度As+イオン注入後に600ºCで活性化熱処理した試料のAs 2p3/2内殻光電子スペクトルの成分分離結果
7. まとめ
本長期利用課題で推進したHAXPES分析は、Ge-MIS構造や接合界面の化学構造・結合状態分析や微量不純物の電子状態評価に極めて有効であり、極薄制御層導入による界面反応抑制技術や、Geチャネルに適した金属電極の材料選択指針、不純物活性化等の新材料・プロセス制御の知見を得ることができ、Ge-MISFET基盤技術の構築に貢献できる成果が得られた。
紙幅の都合で、本報告では高移動度チャネル材料であるGeを中心とした成果を記述したが、課題期間中にはhigh-k材料探索としてPrOxへのAl添加効果や、Hf系多元素系high-k絶縁膜のエネルギーバンド構造、プラズマプロセスによるHfO2絶縁膜/半導体構造や有機材料へのイオン照射ダメ―ジの影響等の多数の成果を得ることができた。
今後は、HAXPESの特徴である分析深度や空間分解能の更なる向上を願うと伴に、その技術をCMOS形成後のpおよびnチャネルMISFETに相当する局所領域の分析、3次元構造のエッジや側壁領域の界面構造・反応分析、歪印加が拡散現象や電子物性へ与える影響の解明に活用することが期待される。
謝辞
本報告の成果は、長期利用課題(課題番号2009B0026~2012B0026)を通してビームラインBL46XUで得られました。本課題の推進において、分担・共同研究者としてご尽力頂いた村上 秀樹 助教、大田 晃生 研究員(広島大学)、財満 鎭明 教授、中塚 理 准教授、田岡 紀之 准教授、坂下 満男 助教、近藤 博基 准教授、竹内 和歌奈 助教、加藤 公彦 研究員(名古屋大学)、野平 博司 教授、澤野 憲太郎 准教授(東京都市大学)、角嶋 邦之 准教授(東京工業大学)、浜屋 宏平 准教授(九州大学)、節原 裕一 教授、竹中 弘祐 助教(大阪大学)、並びに各研究グループの関係諸氏、学生諸君に厚く御礼申し上げます。また、課題期間にわたり様々な技術支援を頂いた孫 珍永 博士、陰地 宏 博士、崔 芸涛 博士、町田 雅武 博士、JASRI職員の皆様に感謝致します。
参考文献
[1] 経済産業省/グリーンIT推進協議会試算(2008)
[2] S. Tanuma, C. J. Powell and D. R. Penn: Surf. Interface Anal., 43 (2011) 689-713.
[3] A. Komatsu, K. Nasu, Y. Hoshi, T. Kurebayashi, K. Sawano, M. Myronov, H. Nohira and Y. Shiraki: ECS Transactions, 33 (2010) 467-472.
[4] A. Ohta, T. Fujioka, H. Murakami, S. Higashi and S. Miyazaki : Jpn. J. Appl. Phys., 50 (2011) 10PE01.
[5] 化学便覧基礎編 Ⅱ 改訂3版, 305
[6] K. Kato, M. Sakashita, W. Takeuchi, N. Taoka, O. Nakatsuka and S. Zaima: Solid-State Electron., 83 (2013) 56-60.
[7] A. Ohta, M. Matsui, H. Murakami, S. Higashi and S. Miyazaki: ECS Transaction, 50 (2012) 449-457.
[8] T. Ono, A. Ohta, H. Murakami, S. Higashi and S. Miyazaki: Extend Abstract of 2012 International Conference of Solid State of Device and Materials, (2012) 38-39.
名古屋大学 大学院工学研究科 量子工学専攻
〒464-8603 愛知県名古屋市千種区不老町
TEL : 052-789-3588
e-mail : miyazaki@nuee.nagoya-u.ac.jp








