Volume 06, No.3 Pages 211 - 217
4. 最近の研究から/FROM LATEST RESEARCH
高分解能マイクロビームX線回折法によるInGaAsP選択成長層の評価
Characterization of InGaAsP Selective- growth Layers Using High Resolution Microbeam x-ray Diffraction
[1]NEC基礎研究所 Fundamental Research Laboratories, NEC Corporation、[2]NEC関西 化合物デバイス統括部 Compound Semiconductor Device Division, NEC Kansai Limited、[3]姫路工業大学 理学部 Faculty of Science, Himeji Institute of Technology
- Abstract
- We have succeeded in developing the high-resolution microbeam x-ray diffraction method to define optical devices. Using the method, the lattice constants of quaternary alloy (InGaAsP) compound semiconductors selectively grown in microscopic regions measuring 1.7 µm in width were accurately measured. As a result, it is possible to define the composition of the selectively grown InGaAsP layers with roughly 100 times more accuracy than when using traditional technologies.
1.はじめに
狭幅選択MOVPE(Metal-Organic Vapor Phase Epitaxy)法は、InP(100)基板上の[011]方向に成膜された一対のSiO2ストライプマスクに挟まれた2µm以下の狭い領域に選択的にMOVPE成長する方法で、NECオリジナルな技術である(Fig.1)[1,2]。この方法の長所は、SiO2ストライプマスク幅を変化させることにより、同一成長条件でも、選択成長層の膜厚、結晶組成を変化させることが可能であることと、(100)面と(111)B面に囲まれた理想的な光導波路がエッチングを行うことなく自動的に形成できることである(Fig.2)。この長所を活かして、各種の光集積素子[3,4]や高性能レーザーダイオード[5]等の作製が行われている。
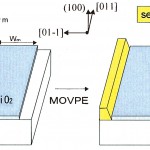
Fig. 1 Schematic figure of narrow-stripe selective-MOVPE growth.

Fig. 2 A cross-sectional SEM photograph of selectively grown InP/InGaAsP layers.
このような特長を持つ狭幅選択MOVPE法を成功させるためには、狭い領域のInGaAsP選択成長層の膜厚、結晶組成(バンドギャップ、格子歪量)をデバイス設計通りに制御する必要がある。そのためには、選択成長において、SiO2マスク幅によって変化するInGaAsP組成を定量的に把握することが必要である。基板全面にエピタキシャル成長されたInGaAsP層の場合には、フォトルミネッセンス(Photo-Luminescence:PL)と高分解能X線回折 (High-Resolution X-Ray Diffraction:HRXRD)法により、バンドギャップと格子歪量を求め、それらから組成を決定することが行われているが、選択成長層の場合、これまでは顕微フォトルミネッセンス(µ-PL)によるバンドギャップの測定しかできておらず、正確に組成を判断するのは困難な状況であった。これは、ミクロンオーダーの領域でHRXRD法を行えなかったためである。
最近、米国にある第三世代放射光施設APS(Adovanced Photon Source)のCaiらが高輝度放射光を利用して、小さなピンホールやフレネル・ゾーン・プレートと呼ばれる集光素子で形成したミクロンオーダーのX線ビームを使い選択成長されたInGaAsP多重量子井戸構造の超格子衛星反射が測定できることを示した[6]。しかし、上記のX線マイクロビームは、10−4ラジアン程度の角度広がりを持つため、超格子の衛星反射のように基板ピークから離れた位置に現れる反射を測定する場合には有効であるが、基板ピークの極めて近い位置に現れる歪の小さい選択成長層からの回折ピークを測定するのには使えないものであった。
そのため、我々は兵庫県ビームライン(BL24XU)を利用して、シリコンの非対称反射を利用した、角度広がり、および、エネルギー広がりの小さいX線マイクロビームを開発している。これまでに、エネルギー15keVの硬X線で、試料位置でのビームサイズ7.1µm(水平方向)×4.8µm(垂直方向)、発散角7.7µrad、エネルギー幅66meVのX線マイクロビームを作製することに成功し、Δd/d〜10−6の微小な歪を局所的に測定できることを示した[7]。このマイクロビームはHRXRD測定に十分な性能を持っているため、我々はInP基板上の幅1.7µmの狭いストライプ領域に選択成長されたInGaAsPのHRXRD測定を行った。その結果、ビームサイズは選択成長領域の幅より大きいものの、両端にSiO2マスクが存在するので、選択成長層のみからの回折ピークを明瞭に捕えることができ、格子歪量の定量に成功した[8]。その結果、InxGa1-xAsyP1-yのIn組成(x)とAs組成(y)を一義的に決定することが可能になり、これまでマスク幅によって変化しないと思われていたAsの組成が変化することが明らかになった。
2.実験
2−1.試料
今回測定した試料は、n型InP(100)基板上[011]方向に一対のSiO2ストライプマスク(マスク幅Wm=4〜40µm、開口幅Wo=1.7µm)が形成されたパターン基板を用いて選択成長したInGaAsP層である。基板上のストライプマスクが形成されていない領域に常圧MOVPE法によりInGaAsP層とInPキャップ層を選択成長した(Fig.3)。Ⅲ族ソースにはトリメチルインジュウム(TMIn)とトリメチルガリウム(TMGa)を、Ⅴ族ソースにはアルシン(AsH3)とフォスフィン(PH3)を使用した。非選択成長領域(Wm=0µm)に形成されたInxGa1-xAsyP1-yの組成は、x=0.56, y=0.61であった。また、非選択成長領域でのInGaAsP層とInPキャップ層の厚さは、両方とも約20nmであった。
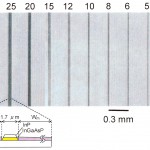
Fig. 3 An optical micrograph of the sample structure.
2−2.実験方法
今回の実験で使用したX線光学系の配置図をFig.4に示す。実験は兵庫県ビームライン(BL24XU)のCハッチで行った。このビームラインは8の字アンジュレータからの高輝度X線が利用できるビームラインである[9]。今回の実験では、アンジュレータ光からSi 111二結晶分光器により1.5次光である15keVのX線を取り出して利用した。そのX線を100µm(水平)×50µm(垂直)に4象限スリットで整形した後、水平方向と垂直方向にそれぞれ2回ずつFZ-Si(100)の511非対称反射を行うことにより、ビームサイズの圧縮を行った。非対称反射によるビームの圧縮は、非対称因子b=sin(θB+α)/sin(θB−α)の逆数倍になる。ここで、θBはブラッグ角、αは表面と回折面とのなす角であり、今回の場合、θB=23.29°、α=15.79°であるため、b=4.83となり、ビーム幅は水平方向、垂直方向ともに1/b2=1/23.3=0.043倍に圧縮される。ビームに発散角がなければ100×50µm2のビームを圧縮しているので、4.3×2.2µm2のビームが得られることになるが、511非対称反射によるビーム発散が水平方向では7.7µrad、垂直方向では5.3µradであるため、試料位置ではビーム発散による広がりが4〜5µm含まれる。試料位置でのビームサイズを測定するために、試料位置でナイフエッジを水平方向、及び垂直方向にステップ幅1µmで移動させ透過X線強度を測定した。その結果、試料に入射するX線のビームサイズの実測値は7.3µm(水平方向)×6.4µm(垂直方向)であった。また、ビームのフラックスは、この非対称反射光学系により約1/15000に減少したが、HRXRD測定には充分なものであった。
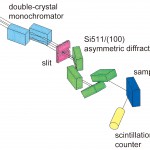
Fig. 4 The experimental arrangement setup at BL24XU.
このマイクロビームを入射X線として、サブミクロンの精度で試料の位置決めができるXYZ移動ステージを備えた垂直軸型高精度2軸回折計によりHRXRD測定を行った。試料は、[011]方向が水平線と平行になるようにセットした。試料の目的の微小領域にマイクロビームX線を入射させる方法は、以下の手順で行った。まず、試料を取り付けるゴニオヘッドに円錐形のピンを取りつけ、そのピンの先がマイクロビームの中心にくるように透過光強度をモニターしながら調整する。その後、焦点距離300mmで約200倍の拡大像が得られる望遠レンズを取り付けたCCDカメラ2台で2方向からピンの先端を観察し、モニター画面上に記録する。その後、ピンを外して、試料をゴニオヘッドに取り付け、目的とする微小領域が2台のモニター上のビームを記録した位置にくるように調整した。ロッキング曲線の測定は、InP 400回折ピーク周りを0.004°ステップで微小回転させながらシンチレーション検出器により回折強度を計測することにより行った。計測時間は1点10秒で行った。また、この測定に先立って、正確なInP 400のピーク角度位置と半値幅を求めるために、非選択成長領域においてInP 400基板ピークを0.0002°ステップで測定した。この時、シンチレーション検出器の数え落としを防ぐために検出器の前に1mm厚のAl吸収板を設置して測定した。
3. 結果と考察
Fig.5に非選択成長領域で測定したInP 400のロッキング曲線を示す。この曲線の半値幅は21.7µradであった。この値は、理想的なInP 400の半値幅18.8 µradと非常に近く、本測定光学系がHRXRD測定に有効であることを証明している。Fig.6には狭幅選択成長層と非選択成長領域で測定した一連のロッキング曲線を示す。Fig.6で、横軸は、Δq/q=Δθcot θBでプロットしている。ここで、ΔθはInGaAsP層ピーク位置とInP基板ピーク位置との差(単位はラジアン)、θBはInP基板のブラッグ角である。Wm=30µmを除くすべての曲線で、Δq/q=0に見られるInP基板ピークの他にInGaAsP選択成長層のピークが測定できていることが分かる。選択成長層からのピークは、Wmが増加するにつれて、強度が増加するとともに高角側から低角側にシフトしている。狭幅選択成長の成長速度増加現象と組成変動現象を反映している。これらの現象はFig.7に示すように、新たに2つの原料供給経路、「SiO2マスク上からの表面マイグレーション」と「横方向気相拡散」、が狭幅選択成長では加わることにより起こると考えられている[10]。
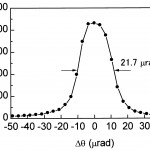
Fig. 5 A measured InP 400 peak profile at the non-selective growth region (Wm = 0 µm) of the sample.

Fig. 6 A series of the rocking curves from the narrow-stripe selective MOVPE grown regions of the sample. The log of the diffraction intensity was plotted against Δq/q.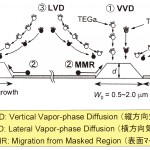
Fig. 7 Schematic drawing of the narrow-stripe selective MOVPE growth mechanism.
Δq/q=−Δd/dであることは、ブラッグの法則から導けるため、基板表面に垂直な方向のInGaAsP選択成長層の歪はFig.6のピーク位置から直接求めることができる。Fig.8には、マスク幅に対してプロットした基板表面に垂直方向の歪を示す。今回測定したInGaAsP選択成長層はInP基板にエピタキシャル成長しているため、ポアッソン変形が起こっている。InGaAsP層が完全にエピタキシャル成長している(ミスフィット転位の発生がない)場合、歪のない立方晶のInGaAsPの格子定数a0を求めるためには、以下の式が利用できる[11]。
![]() (1)
(1)
ここで、aInPはInP基板の格子定数で5.8686Åである。また、CijはInGaAsPの弾性定数であるが、C11/(C11+2C12)=0.502を使用した。この値は、InP, InAs, GaP, GaAsの弾性定数を使いIn0.5Ga0.5As0.5P0.5に対して内挿したものである[13]。(1)式により計算したa0も同時にFig.8の右縦軸に示している。a0に注目すると、マスク幅の増加に伴い、増加しながら飽和値に近づくように変化していることが分かる。InGaAsPの格子定数はベガード則に良く従うことが知られており、InP, InAs, GaP, GaAsの格子定数を使い次の式で表される[12]。
a0=0.4174x+0.2021y−0.0123xy+5.4512 (2)
(2)式から、In組成(x)、もしくは、As組成(y)が増加するとInGaAsPの格子定数が大きくなることが分かる。したがって、狭幅選択成長ではマスク幅の変化に伴い、In、もしくは、Asが選択成長層に取り込まれ易くなることを示している。また、(2)式から、InGaAsPのような4元混晶では、格子定数の測定のみからでは組成を決定できないことも分かる。
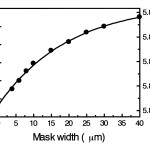
Fig. 8 Mask width dependence of the perpendicular strain Δd/d and the unstrained lattice parameter a0 for narrow-stripe selective MOVPE grown InGaAsP layers.
Fig.9にµ-PLにより測定されたPLピーク波長を示す。このPL波長データとFig.8の格子定数のデータから、InGaAsP組成を一義的に導出できる。その結果をFig.10に示す。●がⅢ族(In)組成を、○がⅤ族(As)組成を表している。この結果、これまでオージェ電子分光法による測定で観測されず変化しないとされていたⅤ族組成がマスク幅の増加とともに変化していることが初めて観測された。さらに、As組成yは単調に増加するのではなく、狭いマスク幅領域(Wm<10µm)では逆に減少する領域が見られる。このことは、Ⅴ族組成の変動要因に複数のメカニズムがあり、しかもそれらがAs原料とP原料で各々逆方向の効果をもたらしている可能性があると考えられる結果である。
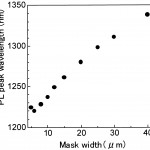
Fig. 9 Mask width dependence of photoluminescence peak wavelength for narrow-stripe selective MOVPE grown InGaAsP layers.
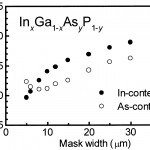
Fig. 10 Mask width dependence of the composition change for narrow-stripe selective MOVPE grown InGaAsP layers.
4.まとめ
SPring-8兵庫県ビームラインを利用した高分解能マイクロビームX線回折法により、狭幅選択MOVPE法でInP基板上の幅1.7µmの狭いストライプ領域に選択成長されたInGaAsP層からの回折ピークを測定することに成功した。その結果、選択成長されたInGaAsP層の格子歪量、および、格子定数を定量することが可能になった。InGaAsPのような4元混晶の組成を同定するためには、バンドギャップと格子歪量の両方を測定する必要があるが、これまでは、µ-PLによるバンドギャップの測定しかできていなかった。今回、SPring-8を利用したマイクロビームX線回折により初めて、格子歪量の定量に成功した。この結果、InxGa1-xAsyP1-yのIn組成(x)とAs組成(y)を一義的に決定することが可能になり、これまでマスク幅によって変化しないと仮定されていたAsの組成が変化することも明らかになった。これらの結果をソースガスの制御に生かすことで、設計通りの組成の結晶を成長することが可能となり、デバイス特性の大幅な向上が達成されている。
謝 辞
本研究の遂行に関して多くの関係者の方々にお世話になりましたが、特に、篭島 靖助教授(姫路工業大)、大平智章氏(NEC基礎研)、宮本直樹氏、山口竜也氏(以上 スプリングエイトサービス㈱)、岩崎英雄氏((財)ひょうご科学技術協会)、および、姫路工業大学理学部X線光学講座の皆様には大変ご尽力頂きました。ここに感謝致します。
参考文献
[1]T. Sasaki, M. Kitamura, and I. Mito:J. Cryst. Growth 132(1993)435.
[2]Y. Sakata, T. Nakamura, S. Ae, T. Terakado, Y. Inomoto, T. Torikai, and H. Hasumi:J. Electron. Mat. 25(1996)401.
[3]H.Yamazaki, Y. Sakata, M. Yamaguchi, Y. Inomoto, and K. Komatsu:Electron. Lett. 32(1996)109.
[4]T. Takeuchi, T. Sasaki, M. Hayashi, K. Hamamoto, K. Kakita, K. Taguchi, and K. Komatsu:IEEE Photon Tech. Lett. 8(1996)361.
[5]Y. Sakata, T. Hosoda, Y. Sasaki, S. Kitamura, M. Yamamoto, Y. Inomoto, and K. Komatsu:IEEE J. Quantum. Electron. 35(1999)368.
[6]Z. Cai, W. Rodrigues, P. Legnini, B. Lai, W. Yun, E. D. Isaacs, K. E. Lutterodt, J. Glew, S. Sputz, J. Vandenberg, R. People, M. A. Alam, M. Hybertsen, and L. J. P. Ketelsen:Appl. Phys. Lett. 75(1999)100.
[7]Y. Tsusaka, K. Yokoyama, S. Takeda, M. Urakawa, Y. Kagoshima, J. Matsui, S. Kimura, H. Kimura, K. Kobayashi, and K. Izumi:Jpn. J. Appl. Phys. 39(2000)L635.
[8]S. Kimura, H. Kimura, K. Kobayashi, T. Oohira, K. Izumi, Y. Sakata, Y. Tsusaka, K. Yokoyama, S. Takeda, M. Urakawa, Y. Kagoshima, and J. Matsui:Appl. Phys. Lett. 77(2000)1286.
[9]http://www.spring8.or.jp/JAPANESE/facility/bl/
[10]Y. Sakata, Y. Inomoto, and K. Komatsu:J. Cryst. Growth 208(2000)130.
[11]J. Honstra and W. J. Bartels:J. Cryst. Growth 44(1978)513.
[12]J. R. Flemish, H. Shen, K. A. Jones, M. Dutta, and V. S. Ban, J:Appl. Phys. 70(1991)2152.
木村 滋 KIMURA Shigeru
NEC 基礎研究所 主任
〒305-8501 茨城県つくば市御幸が丘34
TEL:0298-50-1189 FAX:0298-56-6137
e-mail:s-kimura@bl.jp.nec.com
木村 英和 KIMURA Hidekazu
NEC 基礎研究所 主任
〒305-8501 茨城県つくば市御幸が丘34
TEL:0298-50-1139 FAX:0298-56-6137
e-mail:h-kimura@dg.jp.nec.com
小林 憲司 KOBAYASHI Kenji
NEC 基礎研究所 主任
〒305-8501 茨城県つくば市御幸が丘34
TEL:0298-50-1152 FAX:0298-56-6137
e-mail:k-kobayashi@ef.jp.nec.com
泉 弘一 IZUMI Koichi
NEC 基礎研究所 主任研究員
〒305-8501 茨城県つくば市御幸が丘34
TEL:0298-50-1144 FAX:0298-56-6137
e-mail:k-izumi@cq.jp.nec.com
阪田 康隆 SAKATA Yasutaka
NEC関西 化合物デバイス統括部 主任
〒520-8555 滋賀県大津市晴嵐2-9-1
TEL:077-537-7544 FAX:077-533-0343
e-mail:sakata87@kansai.nec.co.jp
津坂 佳幸 TSUSAKA Yoshiyuki
姫路工業大学 理学部物質科学科 助手
〒678-1297 兵庫県赤穂郡上郡町光都3-2-1
TEL:0791-58-0231 FAX:0791-58-0236
e-mail:tsusaka@sci.himeji-tech.ac.jp
松井 純爾 MATSUI Junji
姫路工業大学 理学部物質科学科 教授
〒678-1297 兵庫県赤穂郡上郡町光都3-2-1
TEL:0791-58-0233 FAX:0791-58-0236
e-mail:matsui@sci.himeji-tech.ac.jp








