Volume 04, No.6 Pages 33 - 40
3. 共用ビームライン/PUBLIC BEAMLINE
チューナブルX線アンジュレータによる高輝度XAFS High-Brilliance
XAFS Using Tunable X-ray Undulator
1.はじめに
X線吸収分光(XAFS)注1 は光電子をプローブとして内殻励起の終状態効果から物質の電子状態や原子配列を調べるX線分光法である。手法の詳細と最近の10年間の成果については解説[1]を参照されたい。1019/cm3以下の濃度領域の固体試料や1014/cm2以下の表面原子を対象とするXAFSには蛍光検出法が用いられる。蛍光検出法では光源の輝度と検出器の効率がキーポイントである。そのため各国の放射光施設において挿入光源を半導体多素子検出器と組み合わせたXAFSの高感度化に関するR&Dが進められている。ESRF、APS、SPring-8等の第3世代蓄積リングでは低エミッタンス(<10nmrad)の恩恵で硬X線領域をカバーするアンジュレータが広く使われるようになった。アンジュレータはウイグラーに比べて格段に指向性が高くビームの平行性が高いので表面敏感な配置など高輝度ビームを必要とする実験には恩恵が大きい[2]。SPring-8では共同利用ビームラインの一部を全国の研究者がワーキンググループを組織して建設しているが、ここで紹介するBL10XUには本稿の共著者を中心に組織された高輝度XAFSグループが設計・製作を担当した蛍光XAFS測定装置が設置されている。立ち上げ作業は1997年12月から1998年10月までの約1年間をかけて行われた。標準型アンジュレータ(U32V)のギャップを分光器に同期して制御することにより、1次光および3次光を用いて5〜30keVのエネルギー範囲において高エネルギー分解能のX線吸収スペクトルを得ることができる。BL10XUステーションは高感度蛍光XAFSを目的として設計されたが、クライオスタットに単結晶試料をマウントしたままで任意の結晶軸に電場ベクトルを平行にすることができるため、偏光依存スペクトルの温度変化が容易に行える。検出器システムとしては高密度ピクセル検出器を開発したが、これについては現在、調整段階であるので別の機会に譲り、本稿ではアンジュレータのギャップ制御等のXAFS装置の基本性能について述べる。
![]()
注1 吸収端から約50eVの領域にみられる鋭い構造は、XANES(X-ray Absorption Near Edge Structure)と呼ばれ、広いエネルギー範囲にわたりゆっくりと振動するEXAFS(Extended X-ray Absorption Fine Structure)と区別される。
2.高輝度XAFS
2-1.アンジュレータの特徴
アンジュレータの特徴は、高輝度、平行性、コヒーレンスにすぐれていることの他、偏光性が容易に制御できることである。特に偏光制御は磁気円二色性(XMCD, X-ray magnetic circular dichroism)に有利な性質で、一足先にアンジュレータによる研究が開始されたESRFを中心に活発な研究が行われている。平行性のよいビームが得られることは高分解能光学系にはうってつけであるが、反面、エネルギーバンド巾が狭く、一般にはXAFS(特にEXAFS)では光源強度がピークを離れると強度が激減しそのままではスペクトル測定ができない。
EXAFSスペクトルを測定するには頻繁に1keV 程度の範囲に渡りエネルギー走査を行う。さらに吸収端を選ぶ際には、より広いエネルギー範囲で中心のエネルギーを変える必要がある。CaからInまでの元素のK吸収端をカバーするためには、最大で24keVもの範囲をカバーしなければならない。アンジュレータのエネルギーは磁場の強さと周期によって決まるため一定の周期の磁石列では磁石間隙(ギャップ)を変化させることによりピーク位置を移動することができる。これをアンジュレータのギャップチューニングと呼ぶ。これによりピーク位置を制御し基本波長(1次光)と高次光(3次光)を使って硬X線領域(5〜30keV)の領域を連続的につなげることができる[3]。
このアンジュレータの磁石列のギャップを変化させた場合のスペクトルをFig.1に示す[3]。この結果からギャップを制御してスペクトル中心を分光器と同期して走査すれば1次光と3次光を組み合わせることにより、目的のエネルギー領域(5〜30keV)を供給できることがわかる。K値 注2 は磁場の強さで決まる光源の性質を決める重要なパラメーターでギャップを小さくすればK値も減少しスペクトルは高エネルギー側へシフトする。この図には3つの異なるK値に対するスペクトルを重ねて示したが、連続的に変化させたときのピーク値の描くスペクトルを示したのがFig.2である。比較のためPhoton Factoryの放射光、ウイグラー光、および7GeVの第3世代リングであるAPSの標準的なアンジュレータの場合を示してある。輝度(brilliance)についてはPhoton Factoryのウイグラー光と比べて5桁、APSのアンジュレータと比べても1桁高い。このことは一方で熱負荷では逆に不利となる。ウイグラーに比べてパワー密度が実に200倍にも達している。
![]()
注2 K=γ Ψ0=eH0λu/2πmc2=0.934B0(T)λu(cm)、ここで、Ψ0、B0(T)、λuは電子軌道の最大曲げ角、最大磁束密度、磁場周期長である。γ={2(1/β−1)}−1/2は電子のローレンツ因子、H0は最強磁場である。
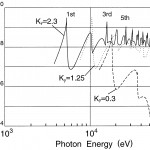
Fig.1 SPring-8アンジュレータ(U32V)の輝度分布のK値依存性
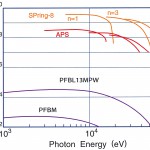
Fig.2 SPring-8アンジュレータ(U32V)のK値を変化させたときのピーク輝度の変化
2-2.アンジュレータビームラインの光学系
アンジュレータはビームの平行性が高いので高輝度ビームが簡単な平行ビーム光学系で実現できる。ビーム発散の大きい第2世代放射光では広がったビームを収束するのにミラーや湾曲結晶などの光学素子が用いられるが、平行ビームではその必要がなくしたがって光学系はいたって簡素である。SPring-8のアンジュレータビームラインBL10XUの光学系(Fig.3)は2結晶分光器と可変臨界角平行ミラー(2枚)からなる。1次光と3次光にSi(111)を用い2結晶分光器のブラッグ角走査と磁石列のギャップ調整の同期をとることにより、広いエネルギー領域で高輝度の単色ビームを得ることができる。この方法ではギャップを制御する速度をあまり大きくとれないので高速のエネルギースキャンには向かないが、最も基本的なアプローチである。
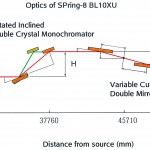
Fig. 3 SPring-8のBL10XUの光学系
光学素子の設計においてはアンジュレータの熱負荷(パワー密度)が最大の問題である。結晶表面の熱負荷を低減するため、ビームの縦横方向に照射面を広げる回転傾斜配置(Rotated inclined geometry)[4]が用いられる。この方法ではパワー密度を直入射の1/57にまで下げられるため、ピンポストクーリングなどシリコン結晶の直接水冷技術により最大パワーの1/5である20mAの運転条件では熱負荷の深刻な問題はない。光線追跡を行うと回転傾斜配置では、非対称反射の2結晶分光器(+,−配置)となるため結晶の回折曲線が従来の約2倍となる結果であったが、エネルギー分解能が悪くなる恐れがあったが実際にエネルギー分解能を見積もると9keV付近で1.5eVとなりPhoton Factoryの場合よりむしろ向上している。幾何学的な分解能は発散が小さいこともあり全体のエネルギー分解能にはあまり寄与しないが、結晶の回折曲線に左右される。したがって将来的にはシリコンの熱膨張係数が零となる温度で用いる低温冷却法やより熱交換効率のよい結晶冷却法の開発が必要である。
Fig.4には光線追跡により得られたアンジュレータ軸上放射に対する位相図(X方向)、位相図(Y方向)、スポットを示した。計算は8keVX線についてのものである。位相図からX方向は発散ビームになっていることがわかる。位相図の傾きから仮想物面の位置を計算するとX方向は光源上方へ8m地点であるが、Y方向はアンジュレータの中心位置で近似できる。Fig.5には光源から試料位置までの距離を52mから58mまで変化させた時のスポット図を比較したものであるが、この範囲でほとんど一定したビームサイズであることがわかる。

Fig.4 SPring-8のBL10XUの光線追跡による位相図(上)とスポット図(下)

Fig.5 SPring-8のBL10XUの光線追跡によるビームプロファイル
2-3.アンジュレータチューニングの実際
アンジュレータスキャンについてさらに考察してみる。周期長λu=3.2cm、磁極数140のSPring-8の標準的なアンジュレータを考える。Fig.6にアンジュレータスペクトルおよび分光器のアクセプタンスを模式的に示した。ギャップ値を固定して分光器を低エネルギー側へ走査すると強度はa-bのように徐々に減少する。一定の強度になったところでギャップ値を増やしてアンジュレータピークを低エネルギーへシフトさせると強度はb-cに沿って急激に増大する。この過程を繰り返し行うと鋸の歯状に強度の変動が周期的に起こる。このため入射ビーム強度はなめらかではないが一定の範囲内に変動を限定することができる。アンジュレータギャップの変更を自動的に分光器とギャップを設定する制御ソフトを開発した。
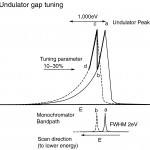
Fig.6 アンジュレータのギャップチューニングと分光器の制御
制御のタイミングおよび方向と移動量はこの曲線から割り出すことになる。ここでブラッグ角θB=4〜7度の高エネルギー領域をH-mode、7〜21.5度の低エネルギー領域をL-modeと呼びそれぞれ3次と1次光でカバーすることにした。これらの切り替えはブラッグ角で自動的に判断して切り替えるため、分光器を操作するユーザーは意識しなくてよい。ただし実際にはミラーのカットオフエネルギーを境にしてそれよりも高エネルギー領域に対してはミラーを光学系からはずす必要があるのでH-mode、L-modeの切り替えはミラーの出し入れにも対応するように選んである。
アンジュレータ制御でキーパラメーターは分光器のブラッグ角のみである。移動角度とモード切替の角度(7度)の大小関係を判断してギャップの移動量を計算する。この時の計算は多項式が使われるがそれらの係数をモードに対応して与える。次にギャップ移動量は移動する境界値と比べられて、その値より大きければギャップを制御するが、それ以下であればストアされて次回の分と足しあわせる。この操作によって細かい移動を繰り返し行った場合、ストアされた移動量の合計が境界値を越えた時にのみ移動を行う。ここで境界値を設定するためにはいくつか方法が考えられる。
例えば実際のビーム強度をモニターしていてある強度を下回ったらギャップ移動を行う方法やピークから離れた場合の強度変化をプロファイルから予測して、移動を行う方法である。我々は分光器の走査を特定のエネルギー領域で繰り返し行う分光実験においては、その都度、判定条件の変化する前者よりも常に一定のブラッグ角でギャップ制御がはいる後者が有利であると判断して後者を採用した。ただしプロファイルをギャップ値に対して計算を行うのは煩雑であるので、ギャップ値とピークの幅の関係を求め簡単な関数で近似して、エネルギー値で補間して用いることにした。実際には分光器やギャップ値の制御はビームラインのワークステーションにコマンドを送出することによって行うため、これらを制御した後にステータスの確認作業を行っている。
3.実験装置
ここでは実験装置について簡単に説明する。XAFS用ゴニオメーターの模式図と平面図をFig.7に示す。試料のオリエンテーションをクライオスタットに保ったまま高精度に制御できるように従来のXAFS装置とは異なり精密ゴニオメーターにクライオスタットをマウントした。各軸の名称と自由度を次に示す。
(1)ω軸:試料の回転(4軸回折計でいうところのø)
(2)2θ軸:透過ビーム用イオンチェンバー(定在波では反射ビームモニターとなる)
(3)χ軸:試料の傾き(偏光に対するふたつの配置(縦偏光、横偏光)以外も任意の角度に設定可能)
(4)X軸:架台の水平方向のトランスレーション
(5)Z軸:架台の垂直方向のトランスレーション

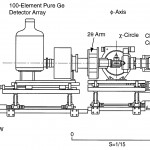
Fig.7 蛍光XAFS測定装置の模式図(左)および側面図(右)
これらはマニュアルでステップモーターコントローラから制御できる。
Fig.8に実験装置全体(a)およびχ軸にマウントされたクライオスタット(b)の写真を示した。(a)は実験ハッチの下流から向かって右側から装置を眺めた写真で左手にのびるビームパイプは下流側にビームを供給するためのものである。装置の左手にみえる液体窒素デュワーは蛍光X線計測のための半導体検出器のものである。(b)は上流側右手から撮影した装置の中心付近で、クライオスタット(偏光面が試料表面に垂直になるような配置をとっている)に入射するビームの強度は入射ビームモニター(イオンチェンバー)で計測される。計測システムの構成をFig.9に示す。制御ソフトはC言語により記述されており、Linux 2.0.30上で動作する。半導体検出器については説明を省くが、ゲルマニウム100ピクセルアレイ検出器[5]を用いて100チャネルデータの同時計測により高感度の蛍光XAFSが可能になる。検出器の開発は終了し基本的な性能(エネルギー分解能は5.9keVで212eV)を満足していることが確かめられたが、今回のアンジュレータスキャンの評価は透過法によって行われた[6]。
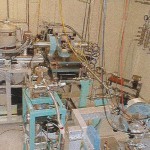
(a)
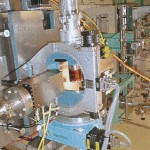
(b)
Fig.8 蛍光XAFS測定装置、装置全景(a)とクライオスタット付近(b)

Fig.9 蛍光XAFS測定装置のデータ収集システムのブロック図
4.結果
Fig.10aに各モードでの実測のピークエネルギーと公表されている計算値との差を示す。わずかながら実測のピーク値はずれており、計算値に対する多項式フィットでは正確なピークチューニングはできないことがわかる。実測値と計算値のずれをプロットしたのがFig. 10bである。この図からおおむね±0.2mmの範囲におさまるが1次光の高エネルギーの限界付近ではずれが大きい。このため実際の制御では実測値を多項式で近似して制御を行うことにした。

Fig.10a Si(111)を用いたときの分光器ブラッグ角に対するアンジュレータのギャップ値計算値および実測値
Fig.10b Si(111)を用いたときの分光器ブラッグ角に対するアンジュレータのギャップ値計算値と実測値の差
アンジュレータスキャンの評価は透過法で行い、標準試料である銅フォイル、粉末標準試料としてCu2O、CuOを用いCu K吸収端(9kev)で、高エネルギー領域での評価はPrRu4P12 粉末を用いRu K吸収端(22.1keV)で行った。透過法によるX線吸収スペクトル測定では入射ビーム強度i0、透過ビーム強度iをイオンチェンバーにより測定しln(i0/i)のエネルギー依存性を得る。今回の評価実験では入射ビームと透過ビームのイオンチェンバーには窒素ガス、アルゴンガスを使用した。通常は分光器の送り方向はエネルギーで高い方向すなわちブラッグ角で低角方向にとるのが普通である。しかし機械的な安定性は重力に逆らう高角送りの方が安定であるため、高角側を順方向として低角方向の場合にバックラッシュを除去している。このことはアンジュレータのピークチューニングに対しても都合がよい。すなわち分光器の高角側への送りでは非対称なピークの傾きがゆるやかな方向の変化となり、急激な強度変化をさけることができる。分光器の主軸送りにはタイムラグがあるが、停止後のビーム安定性は極めて良好であった。
Fig.11にNd2CuO3.85F0.15 のCu K-XANES領域のスキャン結果を示す。この領域ではi0のピークは一回だけはいりチューニングにより段差を生じるが、その他は滑らかな変化を示す。この図から明らかなようにXANES領域ではギャップ固定でも測定が充分可能である。透過スペクトルにはCuO2面のXANESの特徴的な構造(1s->4p遷移の鋭い吸収など)がよく現れておりエネルギー分解能の高いデータが得られていることを示す。エネルギー分解能はPhoton FactoryにおけるSi(111)のデータより高く、むしろ回折曲線の幅が少ないSi(311)を使用した場合に近い(9keV付近で1.5eV程度と見積もられる)。i0のピーク強度にはチューニングにより周期的に階段状の強度変化がみられる。階段状の強度変化はギャップ制御の境界値を変更することにより、必要ならスキャンにかかる時間を犠牲にすればさらに滑らかな変化にすることが容易にできる。

Fig.11 Nd2CuO3.85F0.15のCu K-XANESスペクトルおよび入射ビーム強度
Fig.12に60K付近に金属非金属転移を示すことで興味を持たれているPrRu4P12粉末のRu K-EXAFSおよびi0を示す[7]。チューニングによりi0には周期的に階段状の強度変化が観測されるが強度変化に対応する場所には異常はみられない。このことはチューニングによる入射ビーム強度の変動はビームモニターの規格化により完全にキャンセルされていることを意味する。

Fig.12 PrRu4P12のEXAFSスペクトルおよび入射ビーム強度
アンジュレータを光源としたXAFSの本領が発揮されるのは輝度が重要な場合であるが、典型的な応用分野は表面敏感XAFSのようにビーム幅が制限される分野である。実際に微少角入射条件では試料の寸法によって有効に利用できる幅は、全反射条件では50ミクロン程度であるから、収束しなければ数10分の1のしか利用できない。他にも微結晶、極端条件下での実験や粒界などを対象とする場合、高輝度ビームの必要性が高い。一方、試料の面積が充分とれる場合にはフラックスに依存することになりメリットはそれほど顕著ではない。
5.まとめ
今回のアンジュレータスキャンによるXAFS測定の結果は以下のとおりである。
(1)SPring-8 アンジュレータのギャップを制御してXAFSスペクトルを透過モードで測定し、Si(111)分光結晶を用いて高エネルギー分解能のX線吸収スペクトルを測定できることを確認した。これまでの放射光ではSi(311)分光結晶で可能であったエネルギー分解能をSi(111)で実現することができた。
(2)2結晶分光器およびアンジュレータの制御に成功し、ピークを適時チューニングしながら通常の放射光と同等の感覚で高輝度ビームによるX線吸収スペクトル測定が可能となった。
今回の実験でアンジュレータのピークを分光器の走査に対応してシフトさせることにより、最大輝度の約80%以内に保つことができた。そのような条件においては入射ビーム強度を正確にモニターして規格化すれば通常の放射光と感覚的には大差ない実験が可能である。一方、入射ビーム強度のさらに変化を小さくすることもギャップ制御のパラメーターをその場で容易に変更できる。アンジュレータ制御の手法が確立したことで、アンジュレータスキャンXAFSは今後、蛍光計測システムの整備を経て応用研究フェーズにはいる。
今後の予定としてはゲルマニウム100ピクセルアレイ検出器を設置して蛍光検出モードでのアンジュレータスキャンによるXAFS測定がある。計測システムの要であるデジタル信号処理システムの整備も終わり、各ピクセルからのデータを同時に計測するためのソフトウエアの完成をまって総合評価を行う。アンジュレータスキャン蛍光XAFSは感度、時間分解能、試料上の空間分解能、エネルギー分解能において質的な変革をもたらすであろう。これによってこれまで手の届かなかった新しい研究領域や測定技術が開拓されるものと期待される。
参考文献
[1]大柳宏之:X-Ray Absorption Fine Structure,Application of Synchrotron Radiation to Material Analysis ed.by H.Saisho and Y.Goshi, 1996 Elsevier Scioence B.V.
[2]大柳宏之:挿入光源と第三世代XAFS−高輝度光源による新しい展開−電子技術総合研究所彙報第8号(1997)別冊、p.385-394.
[3]北村英男:SPring-8光源パラメーター(1994)より抜粋
[4]Y.Kashihara,H.Yamazaki,K.Tamasaku and T.Ishikawa:Position of exit X-rays from rotated-inclined double-crystal monochromators,J.of Synchrotron Radiation, 5(1998)679-684.
[5]H.Oyanagi,M.Ishii,C.H.Lee,N.L.Saini,Y.Kuwahara,A.Saito, Y.Izumi and H.Hashimoto : Rapid & Sensitive XAFS Using Tunable X-Ray Undulator,J.of Synchrotron Radiation (1999)in press.
[6]李 哲虎、大柳宏之、関根ちひろ、城谷一民:PrRu4P12のXAFS、日本物理学会1998年秋
[7]電総研ニュース(第589号)ゲルマニウム100ピクセルアレイ検出器の開発に成功
大柳 宏之 OYANAGI Hiroyuki
工業技術院 電子技術総合研究所 電子基礎部
〒305-8568 茨城県つくば市梅園1-1-4
TEL:0298-54-5394 FAX:0298-54-5085
e-mail:oyanagi@etl.go.jp








