Volume 04, No.4 Pages 31 - 34
5. 最近の研究から/FROM LATEST RESEARCH
Capacitance-XAFS 不均一系のXAFSへの新しいアプローチ
Capacitance-XAFS: A New Approach to XAFS of Heterogeneous System
(財)高輝度光科学研究センター 放射光研究所 利用促進部門 JASRI Experimental Facilities Division
- Abstract
- In order to analyze the local structure of heterogeneous system, the 'capacitance-XAFS' by measuring the x-ray photon-energy dependence of the capacitance of a Schottky barrier diode is proposed. Since the capacitance is sensitive to the localized electron in the deep level, dropping of the electron into a core hole arising from X-ray absorption of the atom in the deep level, not the bulk atom, increases the capacitance. The site-selectivity of the capacitance XAFS is successfully applied to AlGaAs:Se system. Several applications of the capacitance-XAFS to heterogeneous system, such as the interface XAFS, are introduced.
1.はじめに
X線吸収分光(X-ray absorption fine structure; XAFS)が特定元素の動径分布を与える解析手法として注目され始めたのが1970年代初頭であるから、以来約30年の月日が流れたことになる。その間に実験技術・解析技術の発展や変遷はあったものの、非常に大雑把な言い方をすれば、単一あるいは平均構造の吸収量の測定という意味では本質的な変化はなかったように思われる。勿論二つ程度の構造の重ね合わせでスペクトルを近似する方法などはあるが、基本的には測定対象元素は試料中で一様であるという仮定がある。だが実際には材料中で一つの元素が場所によって違う形態を持っている例は多く、特に極少数派の局所構造が物性上重要な場合は、XAFSの解析によってミクロな構造とマクロな物性を結びつけることは極めて困難である。従来のXAFSの前提条件である系の一様性の仮定を取り払い、不均一な系のXAFSを開発するにはどうしたらよいだろうか? これがCapacitance−XAFSの出発点である。今回は「SPring-8利用者情報」での研究紹介ということもあり、Capacitance−XAFSのデータとともに、これからの展開を述べることで、基本的なアイディアの全体像を示すことにする。
2.Capacitance-XAFSの原理[1]
半導体に適当な金属を接触させた場合、両者の仕事関数の差から図1に示すように半導体中にバンドの曲がりが生じ、いわゆるショットキー障壁が形成される。この図ではn型半導体を仮定しているが、p型でも同じ議論が成立する。このバンドの曲がりの部分では電荷が掃き出される空乏層が形成される。その厚さdは
d=[2εrε0(Vd−Vb)/qNs]1/2 (1)
となる。この空乏層によって静電容量(Capacitance; C)ができ、その値は
C=[qεrε0A2Ns /2(Vd−Vb)]1/2 (2)
となる。ここで、qは基本電荷量、εrε0は半導体の誘電率、Aは電極面積、Nsはn型不純物のイオン化濃度、Vbは印可バイアス、Vdは拡散電位である。ここにX線が吸収され内殻励起が起こった場合を考える。n型不純物のエネルギー準位がフェルミエネルギーを下回るバンドの曲がりの端(λ領域と呼ぶ)では、この準位に捕らわれた電子が内殻に落ち込むか、オージェ過程などによって放出される。すると、Nsが増加することになり、式(2)に従ってCが増加する。この不純物準位が何らかの理由で非常に深い準位で、電子が束縛され局在しているとどうなるだろう? バンド図は固体内全体の電子状態を表したものであるが、不純物準位にとらえられた局在電子のX線によるイオン化は局所的な現象となる。従って、静電容量のX線フォトンエネルギー依存性を測定すれば、バルクを構成する元素ではなく、深い準位に関連した元素のみのSite−selectiveなXAFSスペクトルが得られることになる。

図1 Capacitance-XAFSのバンドダイアグラム
3.実験
具体的な例に移ろう。閃亜鉛鉱構造をもつ化合物半導体中へのn型不純物のドープによって作られる「DXセンター」は、永続光電流などの特異な現象に対する物理的興味も手伝って、局所構造がホットに議論された深い準位の代表例である。Chadi等によりDXセンターは不純物の周りの大きな格子歪みに起因するという有名な理論の論文が発表され[2]、これをめぐって多くの研究者から理論[3]・実験[4,5]の両面から論文が発表されてきた。当然の事ながら通常のXAFSを使ったDXセンターの機構解明の研究も行われてきた[6]。しかし、今回実験を行ったSeドープのAlGaAsのような場合、低濃度不純物であるSeの吸収を蛍光XAFSで見ようとすると、Seの特性X線がバルクのAsのそれにまぎれてしまうこと、またDXセンターの格子緩和は不純物自身ではなく不純物と隣り合うGaで起こることが理論的に予測されていることなどから、直接的な観測は困難であり、明確な結論は得られていない。Chadi等の理論が正しいならば、Gaに注目するとAlGaAs:Seは、バルク中の格子位置にいるGaと格子位置から外れている極めてわずかなDXセンター中のGaが混在している不均一系の例とみなせる。ここで物性上重要な局所構造は、DXセンター内のGaであることに注目していただきたい。Capacitance−XAFSによる不均一系の解析の最初の例として、このDXセンターを形成している極微量のGaの格子緩和を観測することを試みた。
実験は、SPring-8 BL10XU高輝度XAFS実験ステーションにて行った。BL10XUについては本誌Vol.3 No.2(1998)とVol.4 No.3(1999)を参照いただきたい。測定試料は分子線エピタキシー成長法によって成長した、Al0.33Ga0.67Asを用いた。Seのドープ量は5×1017/cm3である。この試料に直径500μmのAlドット電極を真空蒸着してショットキーダイオードを作製した。硬X線はこのAl電極を透過して空乏層に入射する。測定温度は60Kである。静電容量は1MHzの高周波測定で行い、Vbは−1.5Vとした。
4.実験結果と議論
図2(a)の実線に、作製したショットキーダイオードのCのGa吸収端付近の照射X線波長依存性を示す。Ga吸収端で明確なedge jumpとそれに続くXAFS振動が観測され、静電容量でも吸収スペクトルが測定できることが分かる。edge jumpは10pF程度であった。更に、従来のXAFSとの比較を行うため、固体素子検出器(Solid state detector; SSD)を用いた蛍光XAFSスペクトルを同じ図に破線で示す。蛍光XAFSの場合、観測しているGaの殆ど全てはバルクであるため、閃亜鉛鉱構造の局所構造を示すスペクトルが得られる。吸収端近傍をみるとCapacitance-XAFSの方が吸収端のピークが鋭く、かつ低エネルギー側にシフトしていることが分かる。この違いは、DXセンター内のGaとバルクのGaの局所構造の違いに起因していると考えられる。DXセンターを形成するGaの数は、ドープしてあるSeの数を超えることは無いであろうから、5×1017/ cm3より少ないであろう。一方で、Al0.33Ga0.67Asバルク中のGaの個数は約1×1022/cm3であるから、およそ五桁少ない特定サイトを占めるGaのみが、Capacitance-XAFSによって選択的に観測されたことを示唆している。図2(b)は同じ実験をAs吸収端で行ったものである。こちらも同じように静電容量によって吸収スペクトルが得られているが、SSDを使ったそれと殆ど一致した。
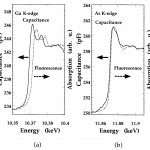
図2(a)Ga及び(b)AsのK吸収端のXAFSスペクトル。破線がCapacitance-XAFSによるもの、実線が従来の蛍光XAFSによるもの。
この結果を理解するために、Chadi等によるAlGaAs:SeのDXセンターのモデルを図3(a)と(b)に示す。これらは同じものであるが、(a)はGaの周りを(b)はAsの周辺をあらわし、中心となる元素に網掛けしてある。AlGaAs中のバルクのGaは通常の格子位置では四配位であるが、DXセンターを形成するGaは(a)に示すように不純物であるSeと結合を切り、大きな格子緩和により格子間位置に移り三配位変化していると、Capacitance−XAFSのエネルギーシフトを説明できる。一方(b)に示すようにAsはSeにとって第二近接原子であり、その格子歪み量は小さく、配位数の変化も少ない。従ってCapacitance−XAFSと従来のXAFSのスペクトルは殆ど一致するであろう。Capacitance-XAFSのSite−selectivityによって、構造上の大きな歪みに起因してDXセンターが形成されていることが初めて直接的に観測されたと言える。

図3 Chadi等によるDXセンターの格子緩和モデル。
(a)GaはSeと結合を切り配位数がバルクと異なる。
(b)Asは格子に歪みがあるものの、配位数に大きな変化はない。
5.今後の展開
今回はDXセンターの構成要素の選択的なXAFSのデータを示したが、Capacitance-XAFSの応用例をいくつか示し、今後の研究の展開の狙い所として紹介しておく。
[欠陥構造XAFS]まず深い準位に関しては、DXセンター以外の欠陥についてもCapacitance-XAFSの適用が可能であろう。イオンビームや電子ビーム照射など半導体プロセスには結晶欠陥を誘起するものが多数ある。バルク中の照射欠陥構造のような、従来のXAFSでは不可能であった同種元素で構造が異なるものの選択的XAFS観測は、不均一系を観るCapacitance-XAFSの狙いの一つである。
[ヘテロ界面XAFS]半導体ヘテロ界面にも深い準位が多く存在することが知られている。図4に示すように、DXセンターの場合と同様、この界面準位に捕らわれた局在電子を叩いてCapacitance-XAFSを測定すれば、界面XAFSができる。結晶構造が違うヘテロ界面でダングリングボンドなどはまさにこの局在電子の捕獲点であり、一番の興味の対象であるバルクと異なる界面の原子配置の情報が選択的に得られることを意味している。
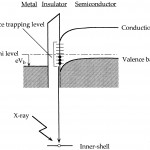
図4 Capacitance-XAFSの応用例の一つである界面XAFSの原理
[ナノメートル構造XAFS]今回は深い準位についてデータ紹介したが、浅い準位を持つ通常の半導体も同様の原理で観測可能であろう。この場合はデバイ長が長くなるために、観測領域は不純物を中心に数nm程度の範囲に及び、バルクの情報を拾うようになるだろう。空乏層幅は式(1)に示したようにVbによって変化するため、Capacitance-XAFSが実際に観測を行っているλ領域は深さ方向で任意に選ぶことが出来る。従ってバイアスを適当に選べば、量子細線や量子ドットの埋め込み構造などに含まれる元素のXAFSを選択的に非破壊で観ることが出来るようになる。
[低濃度XAFS]これは不均一系とは少し異なるが、Capacitance測定の高感度性はかなり低濃度の材料の観測にも威力を発揮するであろう。半導体材料の場合、例えばドーパント濃度は1016/cm3のような従来のSSDでは観測不可能な領域で使われる場合が多い。このような低濃度領域でも静電容量は材料の電気的特性を十分測定可能であり、Capacitance-XAFSによって極低濃度でも局所構造が解析可能であることを示している。
6.まとめ
新しいXAFSとして静電容量のX線フォトンエネルギー依存性を測定するCapacitance-XAFSを紹介した。不均一な構造中の物性上興味深い部分のみのXAFSを抽出するためのアイディアを示し、プリミティブながらAlGaAs:Seを試料にした測定で半導体中の欠陥構造の選択観測の例を示した。今後は、Capacitance-XAFSの特性を更に良く調べ、5.に示した不均一系のXAFSのアイディアの実証や、様々な材料やデバイスへの応用を通じて一般的手法への道を探査したい。
AlGaAs:SeのDXセンターの研究は、岡山理科大 吉野洋子氏、財部健一先生、日本原子力研究所 下村 理先生との共同研究(課題番号1999A0117-NX)によって行われた。
参考文献
[1]M.Ishii,Y.Yoshino,K.Takarabe and O.Shimomura : Appl. Phys.Lett.,74,2672(1999).
[2]D.J.Chadi and K.J.Chang : Phys.Rev.B39,10063(1989).
[3]E.Yamaguchi,K.Shiraishi and T.Ohno : J.Phys.Soc.Jpn. 60,3093(1991).
[4]H.Bemelmans,G.Langouche : Phys.Rev.Lett.72,856(1994).
[5]J.Ma¨kinen et al. : Phys.Rev.B 53,7851(1996).
[6]M.Mizuta and T.Kitano : Appl.Phys.Lett.52,126(1988).
石井 真史 ISHII Masashi
(財)高輝度光科学研究センター 放射光研究所
〒679-5198 兵庫県佐用郡三日月町光都1-1-1
TEL:0791-58-0918 FAX:0791-58-2752
e-mail:ishiim@spring8.or.jp








