Volume6 No.2
SPring-8 Section B: Industrial Application Report
X線吸収微細構造測定によるEuCppm2を用いて成長したEu,Si共添加GaNのEuイオン周辺局所構造の評価
Local Structure around Eu Ions in Eu,Si-codoped GaN Grown Using EuCppm2 by Organometallic Vapor Phase Epitaxy Studied by X-ray Absorption Fine Structure
a大阪大学,b(公財)高輝度光科学研究センター
aOsaka University, bJASRI
- Abstract
-
Eu添加GaNによる赤色発光ダイオードの高輝度化を目的として、高濃度Eu添加とEuイオン周辺局所構造の制御技術の確立を目指している。これまでに、酸素を共添加することで、Eu添加GaNの発光ピーク強度が増大し、X線吸収微細構造(XAFS)測定においてスペクトルの変化も観察された。ところが、二次イオン質量分析により酸素濃度とEu濃度を比較したところ、添加された酸素濃度はEuに対して数%程度であったことから、XAFS測定にて観察された構造変化をEuと酸素の複合体の形成だけでは説明できないことが分かった。新たなモデルとして、酸素がドナーとして働くことにより導入される欠陥の濃度が変化することで、励起されやすいEuイオン周辺局所構造が形成されることが考えられた。そこで、GaN中でドナーとなるSiを導入し、酸素共添加と同様な発光スペクトルの変化とEuイオン周辺局所構造の変化が生じるのかを調べた。X線吸収端近傍構造(XANES)測定の結果、これまでのEu原料(Eu(DPM)3)を用いて作製したEu添加GaNと似たスペクトルが現れた。Si原料であるモノメチルシラン(MMSi)流量を一定として、Eu濃度に対する依存性の評価においても、差はほとんど生じないことが分かった。
キーワード: ユウロピウム、窒化ガリウム、赤色発光デバイス、XAFS、Si共添加
背景と研究目的:
GaN系材料は、青色や緑色発光ダイオード(LED)を構成する半導体材料として実用化され、街頭で見かけるような大画面フルカラーLEDディスプレイなどに応用されている。これまで、赤色LEDには、GaN系材料ではなくGaAs基板上に成長されたAlGaInPが用いられてきた。一方、GaN系材料を用いて赤色LEDが実現すれば、同一材料による光の三原色発光が揃うため、半導体微細加工技術を生かしたモノリシック型高精細LEDディスプレイやLED照明などへの応用が可能となる。このため、GaN系材料を用いた赤色発光デバイスの実現は、産業的に極めて重要な研究課題となっている。
GaN系材料による赤色LEDの実現に向けた研究は、青色・緑色LEDにおいて活性層として用いられているInGaNの高In組成化を目指してきた。しかしながら、InGaN/GaN間の格子不整合に起因する結晶品質の劣化により発光効率が著しく低下するという問題に直面している。一方、ユウロピウム(Eu)イオンは、三価の状態で赤色領域に光学遷移を有するため、GaNを用いた赤色発光材料の発光中心として注目されている。我々の研究グループでは、Eu添加GaNを活性層としたGaN系LEDの室温動作を世界に先駆けて実現している[1,2]。現状では,GaN系赤色LEDの実現に向けて、数十 μW の光出力を mW 程度まで増大させることに課題が絞られてきている。
Eu発光は、添加されたEuイオンの価数やその周辺局所構造に起因する結晶場によって、発光波長や発光効率が変化する。そのため、発光効率の高い局所構造への制御が課題解決へ向けた鍵となっている。これまでに、Eu添加GaNにMgなどの不純物を意図的に添加することでEu発光強度が増大することを見いだしている[3]。その発光強度が増大するメカニズムについては明らかとなっていないものの、作製された試料におけるEuイオン周辺局所構造の作る結晶場が関係していると考えられる。
近年、酸素を共添加することで、Eu添加GaNの発光ピーク強度が増大し、X線吸収微細構造(XAFS)測定においてスペクトルの変化も観察された。ところが、二次イオン質量分析により酸素濃度とEu濃度を比較したところ、添加された酸素濃度はEuに対して数%程度であったことから、XAFS測定にて観察された構造変化をEuと酸素の複合体の形成だけでは説明できないことが分かった。新たなモデルとして、酸素がドナーとして働くことにより導入される欠陥の濃度が変化することで、励起されやすいEuイオン周辺局所構造が形成されることが考えられた。そこで、GaN中でドナーとなるSiを導入したEu,Si共添加GaNの発光スペクトルとEuイオン周辺局所構造に生じる変化をEu,O共添加GaNと比較することを目的とした。
実験:
Eu,Si添加GaN試料は、有機金属気相エピタキシャル法によりGaNを成長する際、新規に合成された酸素を含まないEu原料である EuCppm2 とモノメチルシラン(MMSi)を供給することによって作製した。試料構造は、サファイア基板上に低温GaNバッファ層を成長し、続いて無添加GaNバッファ層、さらにEu,Si添加GaN層を 500 nm 程度成長した。成長条件は、成長温度を 1080°C として、成長圧力は 100 kPa とした。SiとEuの添加条件は、MMSi供給量を一定として、EuCppm2キャリアガス流量を 0.2、0.3、0.5 l/min と変化させた。容量-電圧(CV)測定により求めたドナー密度は、どの試料もおよそ 3 × 1017 cm-3 程度であった。なお、Si濃度についても変化させる予定であったものの、試料作製が測定日程に間に合わなかった。成長直後のEu添加GaN試料は、課題番号2013B1579の実験により、Euを含む化合物が表面に析出することが分かっている。そこで、Eu,Si共添加GaN試料においても同様な析出物が考えられることから、150°C に加熱した熱リン酸によって1分間のエッチング処理を施すことで、表面に析出したEuを含む化合物を下地のEu,Si共添加GaN層の一部とともに除去した。エッチング処理後、蛍光X線強度を標準試料と比較して求めたEu濃度は、0.4 ~ 1.1 × 1019 cm-3 であった。XAFS測定は、BL14B2にてEu LIII吸収端に対して行い、19素子Ge半導体検出器(19SSD)を用いて蛍光法により入射X線と試料面の間の角度が 3° の条件にて測定した。XAFS解析には、XAFS解析ソフトDemeterを用いた
結果および考察:
Eu,Si共添加GaN試料のフォトルミネッセンス(PL)スペクトルは、MMSiの添加によりEu発光中心の一つであるOMVPE 7発光中心が支配的となった(図1)。このような特定の発光中心による発光強度の増大は、Eu,O共添加GaNにおけるOMVPE7発光中心が酸素供給量の増加とともに増大する様子とよく似ている。ただし、このOMVPE7は、母体からのエネルギー輸送効率の高い発光中心であるため、発光スペクトルでは支配的となるものの、含まれる発光中心の密度については、光直接励起による測定[4,5]から、Eu,O共添加GaN試料と同様にOMVPE4発光中心が最も多い。
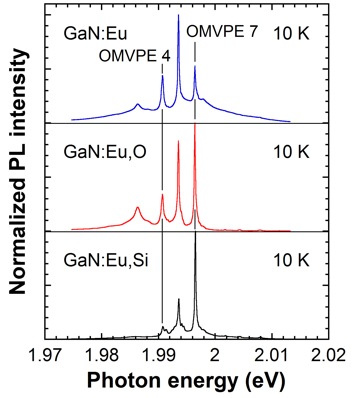
図1. 有機金属気相エピタキシャル法により作製したGaN:Eu、GaN:Eu,O、GaN:Eu,Si の PL スペクトル。酸素共添加と同様に、Si 共添加でも OMVPE7 の相対ピーク強度が増加している。
Eu,Si共添加GaN(10 ppm MMSi流量 0.17 ml/min)、Eu添加GaN、Eu(DPM)3 を用いて作製したEu添加GaNのXANESスペクトルを図2に示す。酸素を含むEu原料である Eu(DPM)3 を用いて作製したEu添加GaNと比較して、酸素を含まない原料である EuCppm2 を用いて作製したEu添加GaNとEu,Si共添加GaNは、Si共添加の有無に関係なく、ホワイトライン強度のわずかな増加が観察された。このことから、Si共添加によるEuイオン周辺構造の対称性に関する変化は小さいことがわかった。これらの試料のEXAFS振動関数を図3に、動径構造関数(フーリエ変換の波数範囲 k: 3.0 ~ 10.0 Å-1)を図4に示す。Eu,Si共添加GaN試料は、Eu添加GaN試料と比べて、第二近接のピーク強度が増加した。これまでの実験結果により、第二近接の強度はEuイオン周辺局所構造の乱れが生じることでピーク強度の減少が観察されている[6]。フィッティングにより求めたパラメータを表1に示す。減衰因子S0は、標準試料EuNから見積もった値をEu添加GaNのデータに適用した。Eu,Si添加GaNのDebye-Waller因子は、Eu添加GaNと比較して小さい。このことは、Euイオン周辺局所構造がSi添加によって揃う傾向にあることを示し、PL測定におけるOMVPE7の増加に関わっていると考えられる。
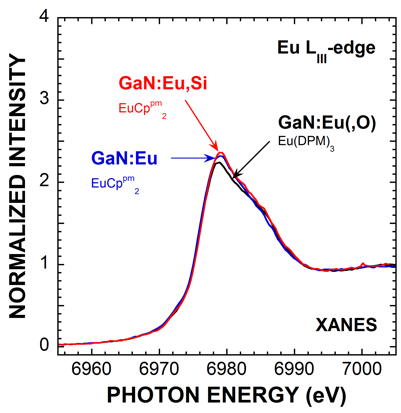
図2. Eu, Si 共添加 GaN、Eu添加 GaN、Eu(DPM)3 を用いて作製した GaN:Eu(,O) の XANES スペクトル。

図3. GaN:Eu,Si、GaN:Eu、GaN:Eu(,O) のEXAFS振動関数。
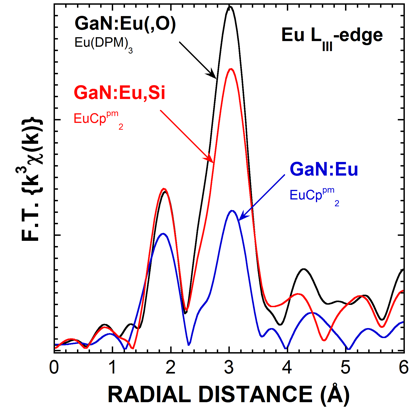
図4. GaN:Eu,Si、GaN:Eu、GaN:Eu(,O) の動径構造関数。
表1:フィッティングにより得られた各構造パラメータ(フィッティング範囲:1.4 〜 3.6 Å(GaN:Eu)、1.4 〜 4.0 Å(EuN)、R:原子間距離、N:配位数、σ:Debye-Waller因子、ΔE0:吸収端エネルギー、S0:減衰因子、下線パラメータはフィッティング時に固定)
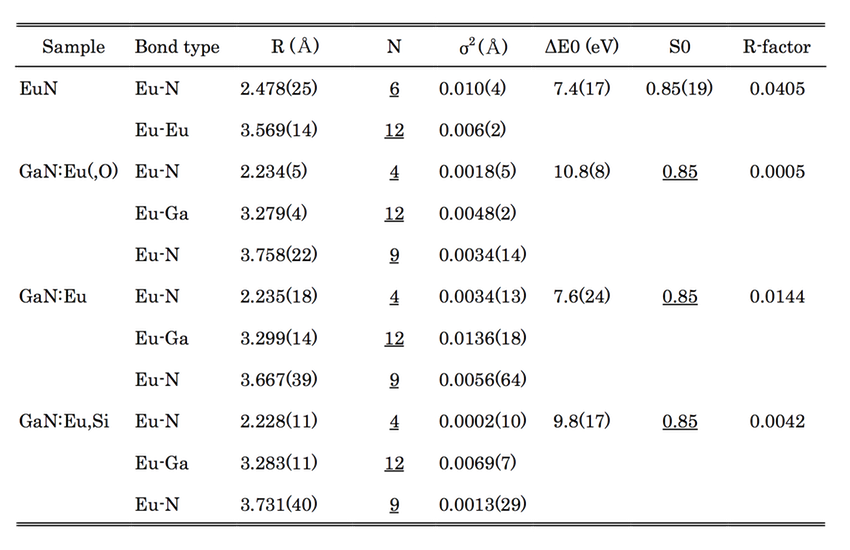
今後の課題:
熱リン酸によりEu,Si共添加GaN試料をエッチングすることにより、表面に偏析したEuを含む化合物の影響を取り除くことができたものの、GaNに添加されていたEu濃度が低すぎたため、今回のビームタイムでは、XAFS解析できるEu濃度依存性のデータを得ることができなかった。今後は、Eu濃度が 1019 cm-3 台かつSi濃度を変化させた試料を測定することで、Euイオン周辺局所構造の解析を行う。
謝辞:
本研究の一部は、日本学術振興会科学研究費補助金(基盤研究(S)No. 24226009)の援助によって行われた。
参考文献:
[1] A. Nishikawa et al., Appl. Phys. Exp., 2, 071004 (2009).
[2] A. Nishikawa et al., Appl. Phys. Lett., 97, 051113 (2010).
[3] D. Lee et al., Appl. Phys. Lett., 100, 171904 (2012).
[4] N. Woodward et al., Optical Materials, 33 , 1050 (2011).
[5] R. Wakamatsu et al., J. Appl. Phys., 114, 043501 (2013).
[6] H. Ofuchi et al., e-J. Surf. Sci. Nanotech., 9, 51 (2011).
ⒸJASRI
(Received: April 28, 2014; Accepted: December 18, 2017; Published: August 16, 2018)






