Volume4 No.2
SPring-8 Section B: Industrial Application Report
全反射蛍光XAFSによるa-InGaZnO薄膜の局所構造解析
Local Structural Analysis of Amorphous In-Ga-Zn-O Thin Films by Total Reflection Fluorescence X-ray Absorption Fine Structure Technique
㈱コベルコ科研
KOBELCO Research Institute,Inc.
- Abstract
-
アモルファスInGaZnO(以下、a-IGZO)における熱処理やArプラズマ処理に対する薄膜表面近傍の局所構造を調べるため全反射蛍光XAFS測定を実施した。Ga-K吸収端及びZn-K吸収端から導出した動径構造関数から、熱処理有無によるMetal (Ga, Zn) – Oの結合距離や第一隣接ピーク強度などに有意な差異、変化は認められなかった。一方、Arプラズマ処理によってMetal (Ga, Zn) – Oの結合距離が僅かに大きくなる傾向が認められた。
キーワード: 酸化物半導体、a-IGZO、X線吸収微細構造
背景と研究目的:
アモルファス酸化物半導体(a-IGZOなど)は、低温で大面積製膜が可能な事に加え、電子移動度が10 cm2 (Vs)-1を超えるTFT(薄膜トランジスタ)を作製できることから、次世代フラットパネルディスプレイ(FPD)への応用が期待される材料である[1,2]。一方で、バイアスストレスや光照射による閾値シフト、TFTプロセス(エッチングや保護膜形成など)の影響で特性が劣化することなど、実用化へ向け安定性、信頼性で改善していくべき課題がある[3,4]。特にa-IGZOでは、TFTプロセスで実施されるドライエッチングに対する耐性が極めて弱いことが知られている[5]。これまでに我々は、元素選択性のあるXAFS(EXAFS)により各金属元素の動径構造関数から酸素配位数や結合距離を比較することによって酸素欠損生成のメカニズムを明らかにすることを検討し、一定の成果を得てきた[6]。
本実験では、ドライエッチングの影響を受けやすいa-IGZOの表面近傍における局所構造を調べるため、全反射蛍光XAFSによる検討を行った。ダメージに関するa-IGZOの最表面の状態、配位数、結合距離などの情報を得てプロセス起因の劣化メカニズムを明らかにすることができれば、プロセスの改善やコストメリットの大きな工程(バックチャネルエッチ型)への転換、さらに材料開発における材料設計の方向性を明確にすることが可能であり、アモルファス酸化物半導体TFTの実用化を加速することができるものと思われる。
実験:
(1)試料作成
Si基板上にa-IGZO薄膜をDCスパッタリングにより200 nm成膜した。IGZOターゲットは組成比In:Ga:Zn=1:1:1のものを使用した。成膜後、大気中で熱処理(350°C、1時間)を実施した。また、ドライエッチングの影響を調べるため、一部の試料についてArプラズマ中に試料を1分間曝露したものを準備し、大気との接触をさけるため測定直前までArガスを封入した密閉容器にて保管を行った(但しXAFS測定は大気中で実施した)。全反射条件における入射ビームの試料上での広がり(フットプリント)を考慮して、試料サイズは110 mm × 20 mm程度の大きさの試料を準備した。
(2)全反射蛍光XAFS測定
SPring-8 BL14B2にて全反射蛍光XAFS測定を実施した。入射X線のビームサイズは0.08 mm (V) × 5 mm (H)である。a-IGZO薄膜の構成金属元素のIn-K, Ga-K, Zn-K吸収端について、19素子SSDによる蛍光法、複数回のクイックスキャンによるスペクトルの積算を実施した。分光器の結晶面は、Ga-K吸収端、Zn-K吸収端はSi(111)、In-K吸収端はSi(311)を使用した。また全反射蛍光XAFS測定前に試料の後方(X線入射方向に対して)に設置されたイオンチェンバーを用いてX線反射率測定を行った。X線反射率測定の結果から全反射臨界角を求め、全反射条件にて全反射蛍光XAFS測定を実施した。In-K, Ga-K, Zn-K吸収端の入射角条件はそれぞれ試料面に対して0.04°、0.11°、0.14°であった。
深部(バルク)との比較を行うため、入射角度を15°にした測定も実施したが、Si基板からの回折ピークが出現し全反射条件との比較が困難なデータであったため、本報告ではデータを示していない。
結果および考察:
図1に熱処理有無及びArプラズマ処理後におけるIn-K、Ga-K、Zn-K吸収端のXAFSスペクトルを示す。各金属元素において、熱処理有無やArプラズマ処理有無でのスペクトルの立ち上がりエッジ位置や吸収端近傍のスペクトル形状に大きな差異は認められない。熱処理やArプラズマ処理が価数や配位構造には大きく影響しないことが推定される。一方、In-K吸収端の高エネルギー側(28500 eV以降)においては、試料間で大きく強度(バックグラウンド)の振る舞いが異なることが確認される。この要因として、エネルギーに依存したX線の入射位置の変動が影響している可能性が考えられる。In-K吸収端は他の吸収端に比べて全反射測定時の入射角度が浅いため、垂直方向のX線の入射位置に変動が生じた場合、試料上でX線が照射される位置が変化しやすい。このため、エネルギーによって試料上での照射位置がずれるまたは外れることによって信号強度の増減を引き起こした可能性が考えられる。またこのためIn-K吸収端については吸収端後のバックグラウンドを上手く引くことができず、EXAFS振動の導出ができなかった。
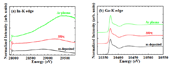
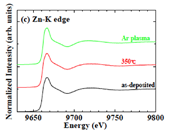
図1 (a)In-K吸収端、(b)Ga-K吸収端、(c)Zn-K吸収端のXAFSスペクトル
図2にGa-K、Zn-K吸収端から抽出したEXAFS振動を示す。各試料を比較すると、試料間でEXAFS振動の周期に大きな違いは認められない。
図3にEXAFS振動をフーリエ変換して得られた動径構造関数をそれぞれ示す(フーリエ変換の波数の範囲はそれぞれ2〜8 Å-1とした)。各金属原子周辺において酸素配位(Metal – O)に由来する第一隣接ピークが確認される。試料間において各第一隣接ピークの強度に大きな差異は認められない。各試料のパラメーターを詳細に比較するため図3の動径構造関数に対してFEFFプログラム[7,8]を使用したカーブフィッティングを行った。図4に一例として Zn-K及びGa-K吸収端のas-depositedのカーブフィッティング結果を示す。また表1、2に得られた各パラメーターの結果を示す(R:結合距離、N:配位数、σ2:Debye-Waller因子、S02:Intrinsic loss factor、R-factor)。この時、 配位数を固定し(Ga-K:Oの配位数5、Zn-K:Oの配位数5)、カーブフィッティングの範囲をそれぞれ1.0〜2.5 Åとして解析を行った。試料間で各パラメーターを比較すると、熱処理有無では、Debye-Waller因子やMetal (Ga, Zn) – O結合距離に有意な差異は認められない。一方、Arプラズマ処理をしたものについてはMetal (Ga, Zn) – Oの結合距離が僅かに大きくなる傾向が認められた。この結合距離の変化に関する物理的な解釈については現在のところはよく分かっていないが、Arプラズマ処理後のa-IGZO表面において価電子帯の裾準位が増加する傾向が確認されており[9]、今回得られた結果との相関について明らかにする必要があると考えている。
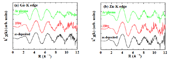
図2 (a)Ga-K吸収端、(b)Zn-K吸収端のEXAFS振動
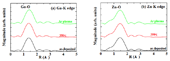
図3 (a)Ga-K吸収端、(b)Zn-K吸収端の動径構造関数

図4 (a)Ga-K edge as-deposited、(b)Zn-K edge as-depositedの動径構造関数のカーブフィッティング結果
表1 Ga-K吸収端の動径構造関数のカーブフィッティング結果
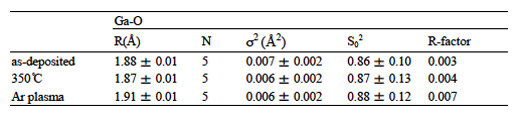
表2 Zn-K吸収端の動径構造関数のカーブフィッティング結果
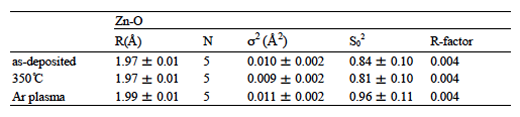
まとめと今後の課題:
全反射蛍光XAFSにより熱処理及びArプラズマ処理によるa-IGZO薄膜の最表面近傍における金属元素の局所構造への影響を評価した。この結果、Arプラズマ処理によってMetal (Ga, Zn) – Oの結合距離が僅かに変化する事が分かった。全反射蛍光XAFSが酸化物系アモルファス材料の表面近傍の評価に有効な手法となることを実証した。一方で、バルク領域(入射角度の大きい条件)の測定でSi基板の回折ピークが出現する事やIn-K吸収端XAFSスペクトルではビーム入射位置の変動によるエネルギーに依存したバックグラウンド強度の変化等の課題が有る事も分かった。サンプル構造や測定条件の最適化、ビーム位置変動の低減などの検討が必要と考えている。
また、今回はArプラズマ処理後の試料の測定を大気中にて実施したが、より正確な評価のためには、処理から測定までの一連の作業を大気非曝露で実施できるような検討も必要と考えている。
参考文献:
[1] K. Nomura, A. Takagi, T, Kamiya, H. Ohta, M. Hirano and H. Hosono, Jpn. J. Appl. Phys., 45, 4303 (2006)
[2] H. Yabuta, M. Sano, K. Abe, T. Aiba, T. Den, H. Kumoni, K. Nomura, T. Kamiya and H. Hosono, Appl.Phys. Lett., 89, 112123 (2006)
[3] A. Suresh and J. F. Muth, Appl. Phys. Lett., 92, 033502 (2008)
[4] Y.-K. Moon, S. Lee, D.-H. Kim, D.-H. Lee, C.-O. Jeong and J.-W. Park, Jpn. J. Appl. Phys., 48, 031301 (2009)
[5] 雲見日出也, 応用物理, 79, 981 (2010)
[6] S. Yasuno, M. Inaba, S. Kosaka, S. Morita, A. Hino, K. Hayashi, T. Kugimiya, Y. Taniguchi and I.Hirosawa, Proceedings of the 20th IDW (Society for Information Display), 617 (2013)
[7] B. Ravel, M. Newville, J. Synchrotron Rad. 12, 537 (2005)
[8] M. Newville, J. Synchrotron Rad. 8, 322 (2001)
[9] S. Yasuno, T. Kita, S. Morita, A. Hino, K. Hayashi, T. Kugimiya, and S. Sumie, IEICE Transactions on Electronics, E95-C, 1724-1 (2012)
ⒸJASRI
(Received: April 29, 2014; Early edition: February 25, 2016; Accepted: June 24, 2016; Published: July 25, 2016)






