Volume4 No.1
SPring-8 Section A: Scientific Research Report
軟X線光電子分光によるSi中にドープされた不純物のクラスター化の熱処理条件および濃度依存性
Study of Clustering of Impurities Doped in Si Crystals Depending on Annealing Conditions and Concentration by Using Soft X-ray Photoelectron Spectroscopy
a東京工業大学, b東京都市大学, c(公財)高輝度光科学研究センター
aTokyo Institute of Technology, bTokyo City University, cJASRI
- Abstract
-
Si中にドープされたBおよびAsの化学結合状態を軟X線光電子分光で観測し、電気的活性/不活性との対応づけ、構造の異なる不純物クラスターの存在を推測し、これらの濃度を求めた。Bドープについては、二種類のクラスター形成の濃度比のドーズおよび熱処理条件の依存性から、クラスター形成過程についてモデルを提案した。Asドープについては、電気的に活性なAs原子およびクラスター化したAsを検出し、それらの濃度プロファイルを明らかにした。
キーワード: 軟X線光電子分光、ナノデバイス、Si、不純物、クラスター
背景と研究目的:
集積回路に使われるシリコン(Si)の極微細トランジスタでは、Si結晶表面の浅い領域にホウ素(B)やヒ素(As)などの不純物を電気的に活性な状態で高濃度にドープしてできるだけ低抵抗の領域を形成することが要求されている。しかし、一般的に電気的に活性化する不純物の濃度には上限がある。これは、過剰な不純物原子が電気的に活性化する半導体結晶の格子サイトに入らず、不純物原子同士が集まるクラスター化を起こし不活性化してしまうことが原因と考えられている。より高濃度の不純物ドーピングを実現するには、このクラスター化を制御するプロセス技術が必要である。しかし、活性化熱処理の際に起こる不純物のクラスター化の基本的なメカニズムやそのモーティブフォースについては未解明の部分が多い。半導体プロセスの微細化追求の開発の中で、この重要でありながらその解決が困難である技術課題を克服するためには、このクラスター形成のメカニズムの解明に立ち戻った基礎研究の推進が必須であると考える。
そもそも、不純物のクラスター化を直接観測することが大変難しい。その第一歩として、我々はこれまで、軟X線光電子分光と、試料の表面をサブnmステップで段階的にエッチングする手法を組合せ、Si中のBに対して、B 1sの光電子スペクトルのケミカルシフトから活性なBと二種類の異なる構造を持つクラスターと推測されるBを分離観測し、それぞれの濃度の深さ方向プロファイルを測定することに成功している[1]。さらに陽電子消滅法を用いてこれらのクラスターの構造を推測する知見も得た[2]。
本研究課題では、この成果を元に、クラスターが形成される過程の熱処理温度、およびクラスター化の初期状態における不純物濃度の二つの条件を変えた場合のクラスター化を観測し、その過程について知見を得ることを目的とした。ナノレベルの微細化を追求するデバイスプロセス技術では、不純物の熱拡散の抑制も重要な要求であり、これと不純物の高い活性化率への要求を両立させるために、より高温で高速(短時間)の熱処理技術が開発されてきている。この領域でクラスターの形成過程を直接捉えるには高い時間分解能を有した観測が必要になるが、それは光電子分光ではかなり困難である。そこで、まずはクラスター形成の進行を時間軸の代わりに温度軸で捉える、すなわちクラスター形成の進みにくい低温から通常プロセスの高温になってゆく中での状態変化を追跡することにした。
また、Si中でアクセプタとなるBとともにドナーとなるAsも重要な不純物元素である。前課題でAsに対する予備実験を行い、Bと同様な手法で活性化とクラスター化を調べられる見通しを得ていた。本課題では、Asドープした試料に広範囲の深さのエッチングを行い、Asの化学結合状態の分離の精度を高めるとともに、電気的活性/不活性との対応づけを明らかにすることを目指した。
実験:
Si(100)基板表面に、プラズマドーピング法でBあるいはAsをドーピングし、活性化のための熱処理を続けて行った。この際、不純物のドーズ、および熱処理の温度および方法を変化させた。このうち、Bドープ試料に対しては、熱処理の方法は、比較的低温で10分間の電気炉(furnace)による熱処理と、赤外線ランプによる高温短時間(約1秒のオーダー)のspike-RTA(rapid thermal annealing)法を用いた。Spike-RTA法は、極微細トランジスタの高温短時間熱処理プロセス技術として現在広く使われている方法である。Asドープ試料では、spike-RTA法のみを用いた。熱処理はいずれも窒素雰囲気で行った。
これらのドーピングされた基板を、常温でオゾン雰囲気中での表面酸化と形成された酸化膜をフッ酸でエッチング除去する工程を繰り返すステップエッチング法により、表面から種々の深さまでエッチングし、測定用試料を作製した。個々の測定試料は、最後に希フッ酸処理で表面酸化層を除去し表面を水素終端した状態で直ちにイソプロピルアルコールに浸漬し、これを空気層が残らないよう容器に密閉してビームラインの実験場まで運搬した。ここで用いたイソプロピルアルコールは三昼夜ほど窒素ガスバブリングにより酸素の脱気処理を行ったものである。測定時には、試料を取り出し、大気中は通過するが直ちに測定チャンバーに導入し真空引きを行った。その後、真空中では特に熱処理などの表面処理は行わず、光電子分光測定を実施した。以上の方法により、測定時のSi 2pスペクトルから見積もられる表面の自然酸化膜の厚さは0.5 nm程度以下であり、測定には大きな影響を与えないことを確かめた。
試料は、BL27SUの分光システムを利用し、光電子の収率を上げるため試料表面から10°の小角の斜入射条件で光電子分光スペクトルを取得した。入射フォトンエネルギーは500 eVである。光源およびアナライザーのそれぞれのエネルギー分解能から測定のオーバーオールのエネルギー分解能は、0.22 eVである。また、光電子取り出し角(TOA)は、55°で行った。このときの、Si中のB 1sおよびAs 3dの光電子の平均自由行程から算出した検出深さ(probing depth)はそれぞれ0.87 nmおよび1.13 nmである。
結果および考察:
(1) Bのクラスター形成の過程
Bのドーズが1×1015 cm-2の低ドーズおよび 2×1015 cm-2の高ドーズの二種類の基板に対して、活性化のための熱処理を行わないas-doped試料、500℃および750℃の電気炉アニールを行った試料、975℃〜1075℃の spike-RTA処理を加えた試料を準備した。これらのうち、両ドーズ条件のas-dopedおよび最も高温のspike-RTA後の試料のBの深さ方向濃度プロファイルを二次イオン質量分析(SIMS)法で評価した結果をFig.1に示す。as-dopedでは表面から10 nm以内の極浅領域にBは局在しており、spike-RTA後にはBは20 nm以上の深さまで拡散するとともにそのプロファイル形状も変化している。
それぞれの試料に対し、熱処理条件毎に観測されたB 1sのスペクトルをFig.2にまとめて示す。なお、ここでは全ての試料は、表面から約1 nmの浅いエッチングをしてあり、Fig.1からわかるように表面近傍の高濃度の領域を測定している。まず、熱処理後の試料においては、結合エネルギーが、187.1 eV、188.3 eV、189.6 eVの位置にそれぞれBEL, BEM, BEHとラベル付けした三つのピークが認められる。これらのピークは、これまでの我々の研究から、BELが電気的に活性なBのピーク、BEMとBEHはいずれも電気的に不活性なBのピークであり、結合エネルギーの違いはそれぞれ構造の異なるBのクラスターが形成された状態と推測されている[1]。一方、as-dopedのピークも類似であるが、熱処理後でBELに相当する最も低い結合エネルギーに大きなピークが現れている。熱処理前には電気的に活性なBは殆ど存在しないことが別途電気的特性の評価からわかっているため、このピークは結合エネルギーが近いものの、電気的に活性なBでは無いと考えられるため、ラベルとしてはBEL2と異なる表記にしてある。また、全ての試料に共通で、結合エネルギーが191〜193 eV付近のBは試料の表面の自然酸化膜中に取り込まれた酸化したBであることも確かめられている。この酸化されたBについてはここでは特に議論せず、Si中に存在するBの状態について各条件の依存性を見てゆく。
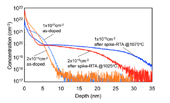
Fig.1 Bの深さ方向濃度プロファイル。高ドーズ(2×1015cm-2)および低ドーズ(1×1015cm-2)においてそれぞれ熱処理前(as-doped)およびspike-RTA後。

Fig.2 ドーズおよびアニール条件に依存したB 1sスペクトル。
熱処理温度依存性を見ると、as-doped状態から電気炉による熱処理の温度を上げてゆく(Fig.2では上方から下方へ)に従い、as-dopedで支配的であったBEL2の成分が減少し、相対的にBEMおよびBEHの成分が増加してゆくことがわかる。この結果は、BEL2の状態であったBがBEMやBEHの状態をもつクラスター構造を形成してゆくことを示している。そして、二種類のクラスター構造の比較では、ドーズが同じ試料では温度が高い方がBEMに対しBEHの相対強度が大きくなる傾向が認められた。この傾向は、spike-RTAの場合でも同様である。
次に、ドーズの違いによる比較(Fig.2では左右の比較)をする。as-doped状態では三つの結合エネルギーを持つBの成分比率は殆ど同じであるのに対し、熱処理後には顕著なドーズ依存性が現れ、高ドーズ試料では同一温度において相対的にBEMに対しBEHの占める割合が大きくなった。spike-RTAの試料では両ドーズで同一温度のデータは無いが、高ドーズの1025℃は低ドーズの975℃と1075℃の二つの温度の間にあることを考慮してスペクトルを比較すると同じことが言える。ところで、ドーズは単位面積当たりに注入されるB原子の数であるので、注入エネルギーが同一であれば、高いドーズはすなわちSi中でのB濃度が高いことになる。しかし、このドーズ依存性を単純に濃度依存性とは考えられない。それは、Fig.1で示されているように表面に浅く高濃度に注入されたBは熱処理の過程で奥深くに拡散しながら表面付近の濃度は下がってゆく。Fig.2で観測しているのはこの拡散後の状態である。クラスター形成のモーティブフォースを考えるとき、熱処理前の濃度と熱処理により拡散を起こした後の濃度は分けて考える必要がある。
そこで、1025℃でspike-RTA後の高ドーズ試料と1075℃でspike-RTA後の低ドーズ試料の二種類について、表面からのエッチングの深さを変えた測定試料を作製し、同様のB 1sスペクトルを測定して比較検討した。いずれの試料もエッチングが深くなるとその表面のB濃度は低下する。従ってこの方法により、同一基板内で広範囲に変化した濃度での状態を観測することができる。Fig.3に、各試料の表面で観測された全種類のBの総濃度(All Boron Concentrationと表記)に対するBEMおよびBEHの相対濃度をプロットした図を示す。ここで、横軸のB濃度は、光電子分光で得られたB 1sのスペクトル強度と同時に測定されたSi 2pのスペクトル強度から算出するが、種々の誤差が含まれるので、Fig.1に示したSIMSによるB濃度の深さ方向プロファイルと比較し、一定の補正係数をかける校正を行っている。補正の詳細は、後述のAsの測定結果(Fig.7)でも述べる。この横軸のB濃度は熱処理で拡散した後の濃度である。この結果は、特にBEHのピークに対応するBの相対濃度は横軸の熱処理後の濃度では一意に決まらないことを示している。むしろ、ドーズの違いに依存してBEHの相対濃度が変わる傾向が顕著である。
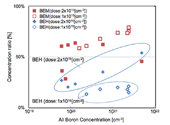
Fig.3 BEMとBEHに対応するBの相対濃度と熱処理後の全B濃度との関係。
以上より、クラスター形成過程においては、温度が高いほど、また、ドーズが高いほどBEHに対応したBクラスターの形成が促進されることが明らかになった。このことから、クラスター形成過程について、次のようなモデルを考えることができる。まず、高温ではB原子はより長い拡散距離を持ち、一方、高ドーズでは熱処理前のB濃度は高くなるので、これらの条件下で形成率の高くなるBEHのクラスターはより多くのB原子が集合したサイズの大きなクラスターと推測される。Fig.4に、低ドーズと高ドーズのそれぞれに対して熱処理前後の状況を模式的に示す。熱処理前ではB原子は単独でランダムに存在しているものが多い。これはBEL2に対応する状態と考えられる。これらに熱処理を加えると、B原子の移動と凝集によるクラスター形成が起こるが、ドーズの高い場合は初期濃度が高いので、サイズの大きなクラスターがより形成されやすい。さらに、この図には示していないが、熱処理温度が高い場合にはB原子の移動性は高まるのでBEHのクラスター形成はより促進されることになる。

Fig.4 熱処理によりBクラスターが形成される際のドーズ(初期のB濃度)に依存するクラスター形成の相対濃度の違いのモデル。(a):低ドーズ、(b):高ドーズの状況。図中のB 1sスペクトルはFig.2に既出のas-dopedおよび最も高温の熱処理後のもの。
(2) Si中にドープされたAsの化学結合状態と電気的活性/不活性との対応
Si(100)基板にAsをプラズマドーピング法で3×1015 cm-2ドープした後、1025℃のspike-RTAで活性化した試料を測定した。BL27SUのシステムを用いて、フォトンエネルギー500 eVでAs 3dのスペクトルを測定した。As 3dは、前課題の予備実験で、光電子強度は必ずしも強く無いがスペクトル幅が狭い点でケミカルシフトの計測には有利であることを確かめていたことから、今回これを選択した。これらの試料はいずれもBドープ試料の場合と同様のステップエッチング法で種々の深さにエッチングして深さ方向プロファイルを求めた。また、合わせて、エッチング深さごとに別途ホール効果測定を行い、各試料のシートキャリア濃度(伝導電子濃度)を測定した。
Fig.5に、もとの表面から1.1 nmの浅い領域および16.3 nmの深い領域におけるAs 3dスペクトルの観測例を示す。なお、ここで、もとの表面からの観測深さはステップエッチングの深さに光電子の脱出深さの約1/4に相当する0.3 nmを加えた値とした。また、As 3d5/2とAs 3d3/2は、その積分強度比が 1.5:1.0、両者の結合エネルギー差が0.69 eVであることを固定し、この条件のもの とに観測されたAs 3dスペクトルのピーク分離を行った。その結果、Fig.5に示すようにいずれも三種類の異なる結合エネルギーをもつAs 3d5/2およびAs 3d3/2のセット、すなわち全6ピークに分離できた。ここでも、Bの場合と同様に結合エネルギーの低い方から順にBEL, BEM, BEHのラベルを付けている。なお、酸化したAsの結合エネルギーは44 eV以上の領域なので、ここではSi中の酸化されていないAsのみを観測していることになる。
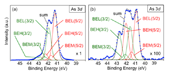
Fig.5 Asドープ試料の深さの異なるエッチング後の表面で観測されたAs 3dスペクトル(バックグラウンド除去後)とそのピーク分離のフィッティング。As 3d5/2成分を赤、As 3d3/2成分を緑で表示。もとの表面からの観測領域の深さは、(a) 1.1 nm、(b) 16.3 nm。
Fig.6に、エッチング深さの異なる六種類の試料について、同様のピーク分離を行い、その結果得られたAs 3d5/2のみのピーク成分を抜き出して示した。BEL(41.0 eV), BEM(41.4 eV), BEH(42.1 eV)の3ピークが異なる三種類のAsの化学結合状態に対応している。
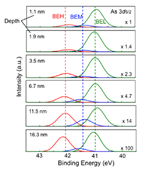
Fig.6 異なるエッチング深さの試料におけるAs 3d5/2のピーク成分。結合エネルギーの異なる(BEH, BEM, BEH)三種類のAsの化学結合状態が存在し、それぞれの状態に対応するAs濃度が異なる深さ方向分布を持っている。
これらのAs 3d5/2ピーク成分に対して積分強度をとり、同時に測定したSi 2pスペクトルの積分強度を基準にしてAs濃度を算出した。Fig.7に、これらのピークに対応したAs成分の濃度をエッチング深さに対応したもとの表面からの深さの関数としてプロットした深さ方向プロファイルを示す。ここには、全ての種類のAsの濃度の合計の総濃度(All Asと表記)および SIMS法で別途測定したAs濃度プロファイルも重ねて示してある。Fig.3のBの濃度評価でも述べたように、ここでも光電子スペクトルから算出したAll As濃度をSIMSの測定濃度に合わせ込む調整をした。
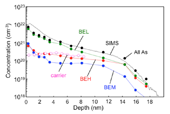
Fig.7 異なる化学結合状態のAsの濃度およびそれらを合わせたAsの総濃度(All As)の深さ方向プロファイル。SIMSで計測したAs濃度プロファイルおよびホール測定で求めたキャリア(伝導電子)濃度のプロファイルも重ねて示す。
すなわち、Fig.7で、光電子スペクトルから求めたAll As濃度とSIMSによるAs濃度のそれぞれのプロファイルが同じ高さ(濃度)になる補正係数を決めた。このとき、全深さ領域で完全に合わせることはできなかったため、およそ5〜10 nmの深さ領域で両者を合わせた。これは、ごく表面近くではSIMSの測定精度が低化すること、また深い領域ではAs濃度が低くなることによる光電子スペクトル強度の誤差が大きくなることを考慮して決めたものである。
さらにFig.7上には、ホール効果測定から得られたキャリア濃度の深さ方向プロファイルを重ねてプロットした。その結果、BEHに対応するAs濃度プロファイルとキャリア濃度プロファイルが良い一致を示した。これより、異なる化学結合状態のAsのうち、BEHに対応するAsが電気的に活性なAsであり、BEMおよびBELはそれぞれ構造の異なるAsクラスターに対応すると推測された。その特徴をBの場合と比較すると、Bの場合では二種類のクラスターは同じオーダーの濃度で観測されることが多く、大小関係が逆転することもあるのに対し、Asの場合、ここに示すように、広い領域に渡ってBEMの成分はBELの成分の10%程度かそれ以下と顕著に低いことがわかった。このような違いの原因はまだ不明であるが、クラスター形成過程において不純物に依存した形成機構の違いがある可能性を示唆している。
まとめと今後の課題:
Si中にドープされたBのクラスター化に関し、これまで二種類の異なる構造のクラスターの存在が観測されてきたが、本課題において、活性化熱処理の条件、および熱処理前のBの濃度に依存してそれらの形成の濃度比が変化する現象を明らかにした。この結果を基に、クラスター形成過程のひとつとして、高温および高濃度でよりサイズの大きなクラスターの形成が促進されるというひとつのモデルを議論した。
また、Si中のAsに関しても、Bの場合と同様の手法を用いて、電気的に活性なAs、および二種類の異なる構造のクラスターと推測される状態のAsを検出し、その深さ方向プロファイルを明らかにすることができた。
今後の課題として、今回議論したモデルはまだ単純で推測の部分が多く、特定のパラメータ依存性に絞った詳細な実験により裏付けを取ってゆく必要がある。そしてそれを通して、クラスター化を抑制する活性化プロセスの可能性を探索しなければいけない。Si中のBで先行している本研究をAsなど他の不純物系にも展開することが、学術的理解の深化にも工業技術上の貢献にも有用であると考える。また、最近、光電子ホログラフィーの手法を用いて、クラスターの三次元的構造をより直接把握する試みを始めている。これらを合わせて、さらに知見を進めることを目指している。
参考文献:
[1] K. Tsutsui et al., J. Appl. Phys., 104, 093709 (2008).
[2] A. Uedono et al., Jpn. J. Appl. Phys., 49, 051301 (2010).
ⒸJASRI
(Received: February 3, 2015; Early edition: September 25, 2015; Accepted: December 11, 2015; Published: January 25, 2016)






