Volume3 No.2
SPring-8 Section A: Scientific Research Report
結晶表面層のすれすれ入射単結晶X線構造解析法の開発
Development of Grazing Incidence X-ray Single Crystal Structure Analysis of a Surface-Shallow Layer
a兵庫県立大学, b(公財)高輝度光科学研究センター, c(独)物質・材料研究機構
aUniversity of Hyogo, bJASRI, cNIMS/SPring-8
- Abstract
-
表面が広く平坦な基板結晶と別の基板結晶上に薄膜単結晶をエピタキシャル成長させた試料について、放射光X線マイクロビームを用いたすれすれ入射X線回折実験を行い、基板結晶表面および薄膜単結晶からの回折X線強度を測定した。基板結晶は表面サイズ1.10×0.99 mm2、表面の凹凸0.15 μmであり、エピタキシャル結晶は表面サイズ0.64×0.45 mm2、表面の凹凸1.0 μm、膜厚は1.4 μmであった。測定した積分反射強度についてLp補正と吸収補正を行い|Fo|2を求め、結晶構造から計算した|Fc|2と比較してR(F2)を求めた。基板結晶ではR(F2)=0.04~0.10、薄膜結晶ではR(F2)>0.53であった。しかし、薄膜結晶について適切に測定された反射のみではR(F2)=0.03~0.10であり、広く平坦な結晶では表面層の単結晶構造解析が可能であることが示された。
キーワード: 単結晶X線構造解析、薄膜結晶、結晶表面、金属錯体、エピタキシャル結晶
背景と研究目的:
結晶表面で起こる現象、例えば光化学反応をその反応経路を含めて構造化学的に明らかにすることは基礎・応用の観点から興味深い。しかし、分子が希釈されている溶液と違って、結晶では吸収が大きい励起光は表面から数μmまでしか透過せず、単結晶や粉末結晶を用いたX線結晶構造解析では構造解析は困難である。これまでは、吸収帯のすそので吸収の小さい波長の光を照射して、結晶内部まで光を透過させ、X線結晶構造解析により光反応生成物やその中間体の構造が決定されてきた[1]。しかし、これでは励起光の波長依存性や照射強度の影響を研究することは困難である。他方、薄膜結晶の機能性材料への応用や、MOF(Metal-Organic Framework)等の多孔性材料への小分子の吸蔵や活性化などの研究が盛んに行われており[2]、結晶表面・界面での小分子の移動や反応に着目した構造化学的研究を可能とする新たな構造解析手段が必要と考えられる。
本研究では、結晶表面・界面から数百nmから数μmまでの領域の結晶構造を三次元的に解析する結晶表面層の単結晶X線構造解析法を実用化することを目的とした。この実験手法を用いることにより、光誘起結晶相反応では、光化学反応の波長依存性、強度依存性の解析が可能となることが期待される。また、MOFによる小分子の取り込み等の研究では、界面近傍での結晶構造変化を直接観測できることが期待される。さらに、薄膜結晶およびその界面を利用した機能性材料開発においても重要な役割を果たすことが期待される。
実験:
結晶表面にすれすれにX線マイクロビームを入射すると、入射X線は吸収効果により結晶内部まで侵入せず、表面部分のみからの回折X線強度を選択的に測定でき、結晶表面層の三次元構造解析が可能である。結晶表面層の単結晶X線構造解析では、平坦な試料表面に対してX線マイクロビームを0.5°程度で入射させ、入射角を一定に保持しながら結晶表面を回転させ、表面部分のみによって回折された多くの反射強度を精度良く測定する必要がある。このため、試料表面の十分な大きさと平坦さが重要である。このような理由から、大きく平坦な結晶面が得られ、また薄膜単結晶をエピタキシャル成長させることに成功しているハロゲン架橋一次元白金(II,IV)混合原子価錯体を測定試料に用いた[3]。基板結晶上に薄膜単結晶が成長した試料を用いることにより、薄膜単結晶からの回折X線強度を選択的に測定できること、さらに結晶表面層の結晶構造を選択的に解析できることを示すことができる。
測定に用いた金属錯体試料は、R,R-シクロヘキサンジアミンを配位子とした臭素架橋一次元白金(II,IV)混合原子価錯体[4]の単結晶試料と、その単結晶を基板結晶として類似の格子定数を持つ同形の塩素架橋一次元白金(II,IV)混合原子価錯体[4,5]をエピタキシャル成長させた試料を用いた。エピタキシャル結晶は、薄膜結晶の飽和水溶液に基板結晶を沈め、濃塩酸を加えて薄膜結晶をすばやく結晶化させることにより作製した。エピタキシャル結晶の作製では、基板結晶表面の平坦さを予め共焦点顕微鏡を用いて測定して行った。また、薄膜結晶の厚さや表面の凹凸も共焦点顕微鏡を用いて測定した。X線回折像の測定に用いた試料は、基板結晶のみの試料1(試料表面の大きさ1.10×0.99 mm2、表面の凹凸0.15 μm)と別の基板結晶上に薄膜結晶をエピタキシャル成長させた試料2(図1、試料表面の大きさ0.64×0.45 mm2、表面の凹凸1.0 μm、薄膜結晶の厚さ1.4 μm、基板結晶表面の凹凸0.5 μm)である。試料は、ガラス製平面基板上に試料表面がガラス面に平行となるように接着剤で固定して測定に用いた。
図1.試料2のエピタキシャル結晶表面の顕微鏡写真。緑色の部分がエピタキシャル成長した薄膜結晶、金色の部分は基板結晶。
結晶表面層のX線回折強度の測定は、SPring-8 BL13XUの多軸回折計により、PILATUS二次元X線検出器を用いて行った。入射X線は、8.0 keVの単色X線を用い、二次元X線レンズを用いて半値幅約1.5×2.0 μmに集光して試料に照射した。試料表面の高さと傾きは、入射X線を用いて調整した。X線回折像の測定は、X線マイクロビームを試料表面に対して入射角0.3°, 0.5°, 0.7°で照射し、入射角を一定に保ちながら試料を表面に垂直な軸の周りで5°ずつ回転するごとに行い、試料を180°回転させて36枚の回折像を得た。各反射の積分強度は、ImageJ[6]を用いて反射点とそのまわりのバックグラウンド領域を反射点ごとに設定して積分し、バックグラウンド強度を差し引いて求めた。得られた反射強度に対して吸収補正およびLp補正[7]を行い、等価反射の値を平均して、構造因子の2乗(|Fo|2)を求めた。
結果および考察:
基板結晶のみの試料1について、結晶表面からの回折X線を測定した(図2)。測定された回折点は、単結晶からの回折点と同様な点状であった。測定した回折点に対して、既知の格子定数[4]を用いて各反射点の回折角と方向を計算し、これと実測された回折角と方向を対比させて各反射に対して指数付け行った。
図2.試料1の基板結晶のみのX線回折像。結晶を5°ずつ回転させて撮影した36枚の回折像を重ね合わせたもの。左上の挿入図は緑線で囲んだ部分の拡大図。青色の円は既知の格子定数から計算された回折点の位置、その上に反射指数を示した。
実測値の|Fo|2を、基板結晶の結晶構造から計算された|Fc|2と比較して、R(F2) = Σ(|Fo|2-|Fc|2)/Σ|Fo|2の値を求めた(表1)。この結果、入射角0.3°, 0.5°, 0.7°の各38個の|Fo|2に対して、それぞれR(F2) = 0.036,0.069, 0.103が得られた。また、測定された等価反射の強度の一致度は、それぞれRint(F2) = 0.089, 0.064, 0.061であった。これらの値は、通常の単結晶構造解析の値と比べると良い値ではないが、結晶表面の単結晶構造解析の可能性を示唆するものとして十分であると考えられる。
表1.試料1の構造因子の実測値(|Fo|2)と計算値(|Fc|2)の比較。|Fo|2はLp補正と吸収補正を行い等価反射について平均した値であり、|Fc|2は既知の結晶構造を用いて計算した。Rint(F2)は等価反射間の強度の一致度であり、信頼度因子R(F2)は実測した38反射の|Fo|2を使って計算した。
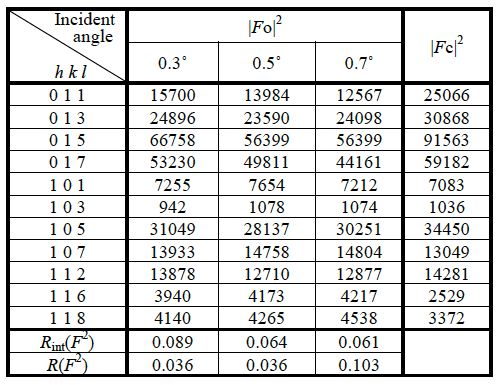
エピタキシャル結晶の試料2について、入射角0.3°, 0.5°, 0.7°で試料表面からの回折X線を測定した(図3)。測定された回折点について、基板結晶と薄膜結晶のそれぞれの既知の格子定数[4]を用いて指数付けを行った。基板結晶と薄膜結晶の回折点の多くは、図3のように、分離して観測された。また、基板結晶の回折点の形状は単結晶と同じ点状であったが、薄膜結晶の回折点には広がりが見られ、両者は明瞭に区別できた。この結果、基板結晶と薄膜結晶のほとんどの回折点について分離して指数付けすることに成功し、積分強度を分離して求めることができた。
図3.試料2のエピタキシャル結晶のX線回折像。結晶を5°ずつ回転させて撮影した36枚の回折像を重ね合わせたもの。左上の挿入図は橙色の線で囲んだ部分の拡大図。青円と赤円は基板結晶と薄膜結晶のそれぞれの回折点の計算位置。
薄膜結晶の回折点には粉末化に対応した円弧状の広がりと、回折角方向の広がりが観測された。回折点の粉末化に対応した広がりは、薄膜結晶の結晶粒の方向の乱れに対応し、回折角方向の広がりは、薄膜結晶の結晶性が基板結晶に比べて良くないことに対応していると考えられる。
試料2の回折像(図3)では、基板結晶と薄膜結晶の両方の回折点について、同じ指数の回折点が上下2カ所に分かれている。図3は、結晶を5°回転するごとに撮影された36枚の回折画像を重ね合わせたものであり、重ね合わせる前の回折画像では、薄膜結晶の回折点は円弧状に広がっているが2つに分かれていない。一方、等価なhkl反射と-hkl反射は、回折方向が異なるため別々の回折画像上に見られた。これより、試料の回転軸と基板結晶および薄膜結晶のc軸との間のずれの角度を求めたところ、2.1°であった。
実測した|Fo|2と既知の結晶構造から計算された|Fc|2について、基板結晶と薄膜結晶のそれぞれについてR(F2)値を計算して比較した(表2)。基板結晶については、基板結晶のみの試料1のR(F2)値に比べて悪いが、ほぼ全ての反射強度を使って計算したときR(F2) = 0.11~0.14である。一方、薄膜結晶について測定できた全ての反射強度を用いて計算したときR(F2) = 0.53~0.62ときわめて悪い。
表2.試料2の構造因子の実測値(|Fo|2)と計算値(|Fc|2)の比較。それぞれの入射角で測定された|Fo|2について、|Fc|2との比較から得られたR(F2)値と計算に用いた反射数を示す。薄膜結晶については測定した反射強度が系統的に弱い反射を除いてR(F2)値を再計算し、下段に示している。

薄膜結晶の|Fo|2と|Fc|2の大きな差について詳細に検討したところ、測定された結晶の方位(回転角)によって反射強度がきわめて弱くなることが分かった。一方、X線回折像の測定前に試料表面の高さ調整を行った時、入射X線ビームに対して試料表面の高さが約6 μm低い方向があった。両者の方位(回転角)を比較したところ一致することが分かった。X線マイクロビームの幅が約2 μmであることを考えると、入射X線が試料表面に適切に照射されていなかったことが考えられる。このため、回折強度の実測値が系統的に小さくなっている逆格子領域の反射を除いて再計算したところR(F2) = 0.03~0.10と妥当な結果が得られた。試料1に比べて試料2の結晶表面のサイズが小さく平坦さも悪かったため、入射X線ビームに対して試料表面の高さを適切に調整できなかったことが十分な精度で回折X線強度を測定できなかった主な原因と考えられる。これらの結果から、広く平坦な結晶表面を持つ試料については、十分な精度で結晶表面層の構造解析ができることが明らかになったと考えられる。
エピタキシャル結晶について測定されたX線回折画像から、薄膜結晶と基板結晶の結晶方位はほぼ一致していることが分かった。また、エピタキシャル成長面は基板結晶の(001)面であった。基板結晶と薄膜結晶の結晶構造を見ると、a軸方向はハロゲン架橋一次元鎖方向···Br–Pt(IV)–Br···Pt(II)···であり、b軸方向は一次元鎖間のN–H···X···H–Nの水素結合ネットワークの方向、c軸方向は白金錯体の有機配位子同士がファンデルワールス接触する方向である。エピタキシャル成長において基板結晶と薄膜結晶の(001)面が共有されていることから、エピタキシャル成長は白金錯体がファンデルワールス接触して積層する方向で起こっていることが分かった。基板結晶と薄膜結晶は同形の結晶構造をとり、格子定数の違いはa, b, c軸方向ではそれぞれ3.9%, 2.6%, 1.6%である。格子定数の違いは比較的小さいが、エピタキシャル成長面に対応するa軸の長さの違いは3%を超えていた。
我々は、同じ基板結晶と薄膜結晶の組み合わせのエピタキシャル結晶について、これまでに複数の試料を作製し、X線回折実験を行ってきた。これらの結果、薄膜結晶の回折点について、円弧状の広がりが顕著なものからほとんど見られないものまであり、薄膜結晶表面の形状観察の結果と対応していた。すなわち、薄膜結晶表面が平滑である試料では回折点の円弧状の広がりが小さく、表面の凹凸が大きい試料では円弧状の広がりが顕著に見られた。これらの結果から、すれすれ入射X線回折実験から薄膜結晶の結晶性について容易に判断できることが分かった。
今後の課題:
結晶表面層からの多くの回折X線強度を精度良く測定するためには、試料表面に垂直な軸の周りで試料を回転させたとき、試料表面の一定位置に入射X線を照射させる必要がある。このためには、回折X線強度の測定前に、試料表面の傾きと高さを入射X線に対して平行になるように精密に調整することが重要である。そして、このためには試料表面のサイズが大きく、十分に平滑であることが要求される。本研究から、金属錯体の結晶試料については試料表面のサイズが1.0 mm2程度で凹凸が0.15 μm以下であれば、結晶表面層の単結晶構造解析が可能な精度で回折X線強度を測定できることが分かった。しかし、このような大きく平坦な自然面を持つ金属錯体の単結晶が得られることは多くはなく、結晶表面を平坦に成形する方法又は結晶表面が小さな試料でも入射X線に対して試料面を平行にする方法等の技術開発が期待される。
謝辞:
本研究はJSPS科研費23350012と25620064の助成を受けたものである。また、SPring-8 BL13XUビームライン担当者の支援に感謝する。
参考文献:
[1] H. Nakai, T. Nonaka, Y. Miyano, M. Mizuno, Y. Ozawa, K. Toriumi, N. Koga, T. Nishioka, M. Irie,and K. Isobe, J. Am. Chem. Soc., 130, 17836-17845 (2008).
[2] H. Sato, W. Kosaka, R. Matsuda, A. Hori, Y. Hijikata, R. V. Belosludov, S. Sakaki, M. Takata, S.Kitagawa, Science, 343, 167-170 (2014).
[3] H. Tanino, K, Takahashi, and T. Yao, Jpn. J. Appl. Phys., 1987, 26, 983-986.
[4] Crystallographic data: [Pt(R,R-chxn)2][PtCl2(R,R-chxn)2]Cl4, green lustrous, orthorhombic, I222, Z=2,a=5.1710(3), b=6.8430(4), c=24.271(2) Å; [Pt(R,R-chxn)2][PtBr2(R,R-chxn)2]Br4, yellow lustrous,orthorhombic, I222, Z=2, a=5.3746(5), b=7.0221(7), c=23.876(2) Å.
[5] K. P. Larsen and H. Toftlund, Acta Chem. Scand., 31a, 182-186 (1977).
[6] W. S. Rasband, ImageJ, U. S. National Institutes of Health, Bethesda, Maryland, USA, http://rsbweb.nih.gov/ij/, 1997-2012.
[7] Lorentz factor: M. J. Buerger, "Crystal-Structure Analysis," John Wiley & Sons, New York, 1969, pp.158-163. Polarization factor: O. Sakata, P. F. Lyman, B. P. Tinkham, D. A. Walko, D. L. Marasco,T.-L. Lee, and M. J. Bedzyk, Phys. Rev. B, 61, 16692 (2000).
ⒸJASRI
(Received: November 29, 2014; Early edition: April 28, 2015; Accepted: June 29, 2015; Published: July 21, 2015)