Volume3 No.2
SPring-8 Section A: Scientific Research Report
微量O2添加アニール法によるSi(111)及びSi(100)基板上エピタキシャルグラフェン
Epitaxial Graphene on Si(111) and Si(100) by the Oxygen-Induced Annealing Method
a東北大学電気通信研究所, b独立行政法人日本原子力研究開発機構
aResearch Institute of Electrical Communications of the Tohoku University, bJapan Atomic Energy Agency
- Abstract
-
酸素雰囲気下におけるSi基板上3C-SiC薄膜のグラフェン化過程の時間発展を明らかにするために、極微量酸素雰囲気下におけるSi(111)基板上3C-SiC(111)薄膜表面上グラフェン化過程をリアルタイムX線光電子分光(XPS)により測定した。その結果、微量酸素添加による3C-SiC薄膜上グラフェン化は、SiC結合の解離過程に律速されている可能性が高いことが明らかになった。また、酸素添加アニールが3C-SiC(111)基板以外でも有効かを明らかにするためにSi(100)基板上3C-SiC(100)薄膜に対しても同じく酸素微量添加下でグラフェン形成を試み、グラフェン形成を確認すると共に、形成薄膜の角度分解XPS評価を行った。
キーワード: グラフェン、SiC、角度分解X線光電子分光
背景と研究目的:
SiテクノロジーはCMOSデバイスの微細化による高集積化と高速化の同時実現という、いわゆるスケーリング戦略によって今日までIT技術を牽引してきた。しかしこのSiテクノロジーも、Siの物性的限界と極微細化プロセスコストの高騰から、スケーリング戦略の維持が困難になりつつある。この問題を解決する方策の一つにSi以外の新材料の採用がある。Siより何桁も大きな移動度を有する材料をチャネルに用いることにより、これ以上の微細化を行うことなく飛躍的にデバイス性能を向上させることができるようになるからである。
グラフェンは直線的なバンド構造に由来するきわめて大きな移動度(<2,000,000 cm/V/s)を有しており、こうした次世代MOS-FETチャネル材料として有望視されている。グラフェンの作製法としては多くの方法が報告されているが、その中で最も工業的とされる製法の一つにエピタキシャルグラフェン(EG)法がある。これは炭化珪素(SiC)結晶を超高真空中で加熱することでSi原子を昇華させ、残留するC原子によって基板の結晶情報を引き継いだグラフェンを得る方法である。基板の熱処理のみによって安定した基板界面を有するグラフェンを形成できるため、EG法は半導体プロセスに親和性が高く、デバイス化に適しているといえる。しかしSiプロセスとの親和性を考えるとき、もしSi基板上にグラフェンを形成することができれば、その方がはるかに望ましいことは論を待たない。
Suemitsuら[1]はSi基板上に3C-SiC単結晶薄膜を作製し、この薄膜を超高真空過熱することでSi基板上にEGを得るグラフェンオンシリコン(GOS)技術を提案した。GOS技術は現在の半導体技術を用いてグラフェンFETをSi基板上に構築できる可能性を持ち、工業的に高いポテンシャルを持つ技術である。しかし現状GOS技術のグラフェン化温度は約1250℃とSiプロセスに組み入れるにはまだ高温であり、グラフェン化温度の低温化が強く望まれていた。こうした中にあってImaizumiら[2]は、Si(111)基板上に形成した3C-SiC(111)薄膜を圧力1.0×10-5 Paの極微量酸素雰囲気下でアニールすることにより、グラフェン化温度を1000℃へと約250℃低温化できることを報告している。彼らはSong, Smith[3]らによるSiC-O反応相図に基づき、高温・低圧領域において(2+x)SiC + O2 → (2+x)Si↑ + 2CO↑ + xC↓なる反応が支配的となった結果、SiCが分解して生じるC原子がEG生成に関与したと解釈している。しかし酸素雰囲気下におけるグラフェン化過程がどのような時間発展を示すか、あるいは、同法が3C-SiC(111)基板以外の面方位でも有効かについてはこれまで不明であった。今回我々はSPring-8 BL23SU表面化学エンドステーションを用い、極微量酸素雰囲気下における3C-SiC(111)薄膜表面上グラフェン化過程をリアルタイムX線光電子分光(XPS)により測定し、グラフェン化活性化エネルギーがSiC結合解離エネルギーにほぼ等しいことを見出した。また、Si(100)基板上3C-SiC(100)薄膜上に対しても微量酸素雰囲気下でGOS形成を試み、同面においても微量酸素添加によるグラフェン低温形成が可能であることを見出した。
実験:
Si(111)基板上及びSi(100)基板上にモノメチルシラン(MMS)をSiC源とするガスソース分子線エピタキシー(GSMBE)法を適用し、それぞれ3C-SiC(111)薄膜及び3C-SiC(100)薄膜を成膜した。典型的な膜厚は100 nmである。これら3C-SiC薄膜をSPring-8 BL23SUの解析槽に装着した後、1100℃,数秒のフラッシュアニールを行って清浄表面を得た。その後、酸素分圧1.0×10-5 Pa,基板温度1000℃でグラフェン化アニール処理を行い、励起光エネルギー650 eVを用いてXPS評価を行った。3C-SiC(111)上GOSについてはリアルタイムXPS測定によるグラフェン膜厚の時間発展を、また3C-SiC(100)上GOSについては角度分解XPSを用いて膜厚評価を行った。リアルタイムXPS測定における光電子の取り出し角度は60°である。また角度分解XPSの光電子取り出し角度は20°から85°まで、5°おきに変化させた。
結果および考察:
1. 3C-SiC(100)薄膜上GOSの角度分解XPSによる評価
図1に3C-SiC(100)/Si(100)薄膜における酸素添加下グラフェン化処理210分後の光電子取り出し角θ = 20°におけるC 1sの光電子スペクトルを示す。グラフェンに由来するsp2ピーク[4]が明瞭に見えており、3C-SiC(111)表面のみならず3C-SiC(100)表面においても酸素添加効果によって約1000℃の低温でグラフェンが作製されることがわかる。同図におけるIG/ISiC比(= 0.7521)から、次式を用いて膜厚を求めることができる。

ここにσG、σSiCはそれぞれグラフェン及びSiC(100)の表面原子密度であり、σG = 3.82×1015 cm-2 [4]、σSiC = 5.19×1014 cm-2である。またλGは光電子の平均自由行程であり、

より求められる[5]。同式にグラフェンの格子定数aA = 0.246 nm、放射光エネルギーhν = 650 eV、EA = hν- EB – φ ≅ 365.5 eV(φ:仕事関数)、C 1s内殻準位の束縛エネルギーEB = 284.5 eVを代入すると、グラフェン中の平均自由行程としてλG = 0.957 nmを得た。これらの値を(1)式に代入し、グラフェン膜厚としてd = 0.031 nm (0.095 ML, 1 ML = 0.335 nm)を得た。
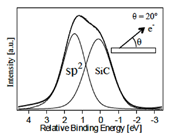
図1. 3C-SiC(100)/Si(100)、微量酸素添加熱処理後のC 1s光電子スペクトル

図2. 3C-SiC(100)/Si(100)、微量酸素添加熱処理後のC 1sグラフェンピークとSiCピークの強度比の角度依存性
膜厚を求めるもう一つの方法に角度分解光電子分光法がある。図2にC 1s光電子スペクトルのグラフェンとSiC の強度比の角度依存性を示す。光電子取り出し角θの低い表面敏感測定においてグラフェン由来のピーク強度が増大することから、3C-SiC薄膜表面にグラフェンが形成されていることがわかる。この角度依存性を(1)式を用いてフィッティングし(図中実線)、膜厚としてd = 0.038 nm(0.112 ML)を得た。これは図1におけるIG/ISiC比から求めた膜厚d = 0.031 nm(0.095 ML)とよく一致している。以上の結果から、微量酸素添加によるGOSグラフェンの低温形成は、3C-SiC(111)表面のみならず3C-SiC(100)表面でも有効であることが立証された。
2. 3C-SiC(111)薄膜上GOSの時間発展
図3に、3C-SiC(111)薄膜表面に対して微量酸素添加下で1000℃,3時間の熱処理を行った時のC 1sの光電子スペクトルを示す。sp2結合に起因するピークが明瞭に出現しており、1000℃という低温アニールでグラフェンが成長していることがわかる。1000℃,3時間の真空アニールでは全くグラフェンが形成されないから、微量酸素添加の効果は明白である。
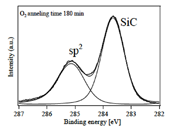
図3. 3C-SiC(111)/Si(111)薄膜の微量酸素添加熱処理後のC 1sの光電子スペクトル
図3のグラフェン(sp2)ピークとSiCピークの強度比IG/ISiC比から、3C-SiC(100)表面と同様に(1)式を用いてグラフェン層数を見積ることが出来る。ただしσSiCはSiC(111)の表面原子密度であり、σSiC = 1.21×1015 cm-2を用いた。こうして求めたグラフェン層数の、微量酸素雰囲気下アニール処理時間に対する時間発展を図4に示す。酸素添加アニール処理を始める前にグラフェンが形成されているのは、清浄表面を得るためのフラッシュアニール時にすでに一部グラフェン化が起こっているためと考えられる。図中実線はラングミュア型時間発展であり、

の形を取る。フィッティングの結果、d0 = 0.2 ML、dsat = 0.749 ML、t0 = 27.8 s, τ = 76.7 sを得た。d0は酸素添加アニール開始時におけるグラフェン層数である。得られた飽和層数dsat = 0.749 MLは同一アニール条件におけるグラフェン膜厚0.63 ML [2]とよく一致している。
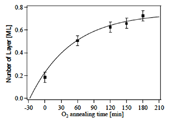
図4. 微量酸素雰囲気下における1000℃での熱処理時における3C-SiC(111)/Si(111)薄膜上グラフェン層数の時間発展
こうして得られたグラフェン化の時定数τ = 76.7 s及びアニール温度T = 1273 Kをアレニウスの活性化式
に当てはめ、頻度因子νとして典型的な値である1012-1013 s-1を用いると、活性化エネルギーEa = 3.51-3.76 eVを得た。この値はSiC結晶のSi-C結合解離エネルギー3.66±0.09 eV[6]に近く、SiC結晶からのグラフェン形成過程がSi-C結合の解離によって律速されることを示唆する。得られた活性化エネルギーを用いて1100℃フラッシュアニール時のグラフェン形成時定数を求めるとτ = 6.89 sを得る。これより1100℃フラッシュアニールで図4の初期グラフェン膜厚(d0〜0.2 ML)を得る時間を求めると2.14 sとなるが、この値は、フラッシュアニールの延べ時間が数秒である事実と矛盾しない。
結論:
微量酸素添加がグラフェンの低温形成に有効であることが、これまで報告のある3C-SiC(111)面のみならず 3C-SiC(100)面においても示された。また酸素添加によってGOSグラフェン形成温度が低温化されることにより、グラフェン形成のkineticsをリアルタイムXPSで評価することに成功した。しかし酸素添加GOSグラフェンの品質は剥離グラフェンやSiC基板を用いたエピタキシャルグラフェン、あるいは酸素無添加の通常GOSグラフェンのそれと比べ今だ劣っており、今後、品質向上のためのグラフェン形成パラメータの最適化が必要である。
参考文献:
[1] M. Suemitsu, et al., e-J. Surf. Sci. Nanotech. 7 311 (2009).
[2] K. Imaizumi, et al., Jpn. J. Apll. Phys. 50 070105 (2011).
[3] Y. Song and F. Smith, J. Am. Ceram. Soc. 88 1864 (2005).
[4] K. V. Emtsev, et al., Phys.Rev.B 77,155303 (2008).
[5] J. F. Watts and J. Wolstenhole “An introduction to SURFACE ANALYSIS by XPS and AES” WILEY (2003).
[6] R. R. Reddy, T. V. R. Rao, R. Viswanath, Astrophysics and Space Science, 189 29 (1992).
謝辞:
The synchrotron radiation experiments were performed at the BL23SU of SPring-8 with the approval of the Japan Synchrotron Radiation Research Institute (JASRI) (Proposal No.2010B3878, No.2011B3876).
ⒸJASRI
(Received: May 13, 2015; Early edition: June 22, 2015; Accepted: June 29, 2015; Published: July 21, 2015)






