Volume3 No.2
SPring-8 Section B: Industrial Application Report
窒化処理を行った酸化膜/4H-SiC界面の軟X線光電子分光による解析
Soft X-ray Photoelectron Spectroscopy of the SiO2/4H-SiC Interface after Nitridation Process
a技術研究組合 次世代パワーエレクトロニクス研究開発機構, b(独)産業技術総合研究所
aR&D Partnership for Future Power Electronics Technology, bNational Institute of Advanced Industrial Science and Technology.
- Abstract
-
窒化処理を行った後のSiO2/SiC界面に取り込まれた窒素原子の化学状態を軟X線光電子分光法により解析した。窒化処理を行った試料においては、HFエッチングにより酸化膜を完全に除去した状態においても窒素原子はSiC表面に残存しており、Si 2pスペクトルのショルダー部分の形状が変化していることが見出された。これはSiC表面においてSi-C3N結合が形成されていることに起因すると考えられる。SiC基板の最表面には窒化処理により導入された多くの窒素原子が結合していることが示唆される。
キーワード: SXPES、SiC、酸化膜、窒化処理
背景と研究目的:
SiCはハイパワーデバイス用材料として多くの優れた物性を有しているとともに、熱酸化プロセスより安定なSiO2膜を表面に形成可能であるというデバイス作製上の利点を有している。しかしながら、熱酸化プロセスにより形成したSiO2膜を用いたSiC-MOSFETのチャネル移動度は、バルクの電子移動度から予想される値よりも著しく低下している。その原因のひとつにSiO2/SiC界面の準位密度の高さがあり、これを低減するために酸化膜形成後の界面窒化処理が広く採用されている。したがって、SiO2/SiC界面の窒素原子の化学状態を把握し、それを制御していくことがSiC-MOSFETの特性向上のために重要である。
最近になって複数の研究機関から、窒化処理後のSiO2/SiC界面での窒素の挙動に着目した研究結果が報告されている[1-4]。それらの結果から比較的多量の窒素原子がSiC基板の表面付近に取り込まれていることが明らかになってきている。しかしながらその化学結合状態についてはまだ解明されているとは言い難い。本研究では、工業的に多用されている一般的な窒化プロセスにより界面窒化処理を施した試料に対して軟X線光電子分光(Soft X-ray Photoelectron Spectroscopy, SXPES)を行い、その界面状態の解析を試みた。
実験:
実験にはn型4H-SiCエピタキシャルウェーハ(4°オフ基板)を使用した。エピタキシャル層のキャリア濃度は約1E16 cm-3である。はじめにH2SO4/H2O2洗浄後、標準的なRCA洗浄を行い、その後1200°Cで酸素雰囲気でのドライ酸化により表面に熱酸化膜を形成した。さらに1200°C、8時間の一酸化窒素(NO)雰囲気下での窒化処理を実施した。最終的な熱酸化膜の膜厚は約70 nmであった。
SXPES測定には、ドライ酸化のみを行った試料(窒化なし試料)と、ドライ酸化後窒化処理を行った試料を使用し、これら2水準の試料に対してSXPES測定を実施した。測定の前に、表面に存在する熱酸化膜は、HFエッチングにより完全に除去した。これは、SiC基板と窒素原子の結合状態をより直接的に観測するためである。HFエッチングを行った試料は速やかにBL27SUに設置された超高真空チェンバーに導入された。SXPES測定におけるフォトンエネルギーは700 eVとし、生じた光電子をSPECS社製PHOIBOS 150により検出した。光電子の取り出し角度は 90°、パスエネルギーは12 eVに設定した。また、Au 4f 7/2結合エネルギーのピーク位置を84.0 eVとして光電子エネルギーを較正した。
なお、課題申請時に予定していた欠陥密度の異なる試料に対する測定については、窒化なしの試料についてのみ比較測定を行ったが、スペクトル形状にほとんど差異が見られなかったため、窒化処理を行った試料に対する比較測定は実施しなかった。
結果および考察:
各試料に対して観測されたSi 2pスペクトルを図1に示す。両試料ともに、メインピークの結合エネルギーは101.7 eVに観測され、この結合エネルギーはこれまで報告されているSi-Cバルク成分の結合エネルギー[1]とほぼ一致している。また、このメインピークから2.2 eV程度高エネル ギー側のSi酸化物に対応する成分[5]は観測されておらず、熱酸化により表面に形成されたSiO2膜はその後のHFエッチングにより完全に除去されていることが確認された。さらにバルク成分よりも0.5 eV程度高エネルギー側に存在するショルダー部分の形状が試料間で異なっており、窒化処理を行った試料の方がなだらかな形状になっていることが見出された。このスペクトル変化の原因を議論するために、最小二乗法を用いたスペクトルフィッティングを行った結果を同図中に示している。フィッティングにおいては、Shirley法によるバックグラウンド除去を行い、ガウス型のスペクトル形状を仮定した。また、Si 2p1/2ピークとSi 2p3/2ピークのスピンスプリットは0.6 eV、強度比は2:1としている。両試料のスペクトルに対し、バルク成分(Si-0)と2つの表面成分(Si-1とSi-2)により全体のフィッティングが可能であった。カーブフィッティングにより得られたそれぞれのピークの結合エネルギーとその半値幅、および表面成分のバルク成分に対するピーク強度比を表1にまとめた。
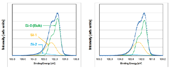
図1. Si 2pスペクトル、およびカーブフィッティングの結果
測定点はclosed circle、フィッティングデータは実線で示している。
左図は窒化なし試料、右図は窒化した試料のスペクトル
表1. ピーク分離により得られた3つのピーク成分の比較
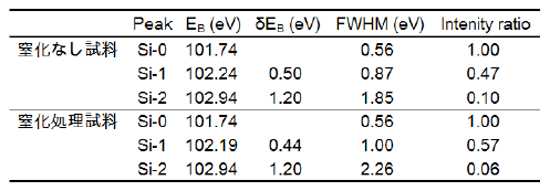
窒化処理を行った試料については、Si-1成分のピーク位置がわずかに(0.05 eV)低結合エネルギー側、すなわちバルク成分側にシフトしているとともに、その半値幅が0.1 eV程度広くなっているという結果が得られ、これにより前述のショルダー部分の形状がなめらかになっていると判断した。このピーク位置のシフトと半値幅の増加はSiC基板表面に取り込まれた窒素原子によって、新たな結合準位が形成されたことによるものだと考えられる。栃原、白澤は単純な電荷移動モデル[1]を用いて、SiC表面に形成されたSi-C3N構造のケミカルシフトは0.4 eVと見積もられることを報告している。さらに、このモデルによりSi-C3O構造を考えた場合には、そのケミカルシフトは0.6 eVとなる。今回の測定結果(窒化なし試料の0.50 eV、窒化した試料の0.44 eV)は両者の中間に位置しており、窒化なし試料の最表面ではSi-C3O構造がメインであるのに対し、窒化した試料では新たにSi-C3N構造が形成されたものと推察される。
表面酸化膜エッチングを行った窒化処理試料において、窒素原子が表面に結合していることを確認するために、N 1sスペクトルの測定を行った。図2に示すように、スペクトル形状は非対称なものとなり、3つのガウス型のピークに分離が可能であった。メインピークの結合エネルギーは398.7 eVとなり、この値は6H-SiC(0001)面上にSiON原子層をエピタキシャル成長させた場合に得られた結果[1]と一致している。さきに述べたように、SiC基板最表面のSiに対してN原子が結合し、これに対して2個のSiが結合することでN-Si3配置が形成されるというモデルを考えることが可能である。また、これと同時に観察された399.3 eVと400.7 eVの信号は、N-Si3配置における窒素原子の一部を酸素で置き換えたO-N-Si2あるいはO2-N-Siが混在しているものと推察される。

図2. 窒化処理を行った試料のN 1sスペクトル
今後の課題:
以上みてきたように、熱酸化後の窒化処理を経たSiO2/SiC界面ではSi 2pスペクトルに変化が見られることが確認できた。しかしながら、窒化処理の有無によるスペクトル形状の差異が少なく、ピークフィッティングの結果には曖昧さが残っている。今後は、試料最表面に形成されているSi-C3N、あるいはSi-C3O構造に対する検出感度を向上させるため角度分解測定を行う等、スペクトル形状の変化をより顕著に検出するための対策が必要である。
謝辞:
本研究は、NEDO委託事業「低炭素社会を実現する新材料パワー半導体プロジェクト」の成果である。
参考文献:
[1] H. Tochihara, T. Shirasawa, Progress in Surf. Sci. 86, 295 (2011).
[2] R. Kosugi, T. Umeda and Y. Sakuma, Appl. Phys. Lett. 99, 182111 (2011).
[3] J. Rozen, M. Nagano and H. Tsuchida, J. Mater. Res. 28, 28 (2013).
[4] Y. Xu, X. Zhu, H. D. Lee, C. Xu, S. M. Shubeita, A. C. Ahyi, Y. Sharma, J. R. Williams, W. Lu, S. Ceesay, B. R. Tuttle, A. Wan, S. T. Pantelides, T. Gustafsson, E. L. Garfunkel and L. C. Feldman, J. Appl. Phys. 115, 033502 (2014).
[5] C. Virojanadara, L.I. Johansson, Surf. Sci. Lett. 472, L145 (2001).
ⒸJASRI
(Received: January 29, 2015; Early edition: April 28, 2015; Accepted: June 29, 2015; Published: July 21, 2015)






