Volume3 No.2
SPring-8 Section B: Industrial Application Report
マイクロビームXAFSによる窒化ガリウム系電子デバイスの界面状態解析
Analysis of Interface Condition on GaN Based Electron Devices by Micro Beam XAFS
a住友電気工業(株), b(公財)高輝度光科学研究センター
aSumitomo Electric Industries, Ltd., bJASRI
- Abstract
-
窒化ガリウム系電子デバイス(GaN-HEMT)において、表面保護膜とGaNとの界面状態の評価を目的として、マイクロビームX線を入射した斜出射XAFS法による評価を実施した。GaN表面をO2プラズマ処理し、その表面に窒化膜(SiN)を堆積したサンプルで、SiN堆積直後のものと、それを高温アニール処理したものを比較したところ、SiN堆積直後にはGaN表面にGa2O3が存在するが、高温アニール処理によってこの酸化物層が金属状Gaに変化していることが確認できた。これは、過去に同じサンプルで行った硬X線光電子分光(HAXPES)評価と同じ結果である。
また、GaN-HEMTのエピ構造において、周辺に何もない状態と比べ、金属電極に挟まれた領域ではGaN表面状態が変化しているらしいことが確認できた。この表面状態の変化は、SiNがGaNに及ぼす応力による結晶歪みの違いによるものと推定している。
キーワード: 窒化ガリウム系電子デバイス、GaN-HEMT、斜出射XAFS、表面状態
背景と研究目的:
マイクロ波帯通信用の高出力デバイスでは、これまで砒化ガリウム系材料を用いたトランジスタ(GaAs-FETやGaAs-HEMT)が使用されることが多かったが、近年では、窒化ガリウム系電子デバイス(GaN-HEMT)の開発・製品化が活発に進められている。比較的周波数の低いL帯~S帯(0.5~4 GHz)ではGaN-HEMTはすでに高出力デバイスの主流の座を占めており、より周波数の高いC帯(4~8 GHz)以上でもGaN-HEMTの開発が盛んになっている。GaN-HEMTでは、従来から、電流コラプスと呼ばれるドレイン電流の時間変動現象があることが分かっている。この電流コラプスは、高出力トランジスタの出力電力や効率を劣化させるため[1, 2]、その解決が必須の課題であるが、その原因は、表面保護膜とGaNとの界面状態に起因するらしいと推測されてはいるものの、詳細なメカニズムはよく分かっていない。我々は、このメカニズムの解析を目的として、SPring-8のBL46XUを利用したHAXPES評価を実施し、SiN/GaN界面のGa酸化層(Ga2O3)が電流コラプス現象に関係しているらしいこと、そのGa酸化層が高温アニール処理によって金属状Gaに変化し、電流コラプスが改善されることを突き止めた[3]。
HAXPESでは実際のデバイスでの評価は不可能であったが、本実験では、マイクロビームを利用することにより、デバイスの電極間の微小領域を狙った評価を試みた。
実験:
表面保護膜とGaNとの界面に着目した評価を実施するため、浅い出射角度の蛍光X線を検出する斜出射蛍光XAFS法を用いた評価を行った。出射発散角と垂直方向の検出効率を稼ぐ必要があるため2次元検出器(PILATUS)を使用した。ビームラインはBL39XUを用い、GaのK吸収端(主にXANES領域)を評価した。図1に測定系の写真と概略図を示す。試料面に垂直にX線を入射し、X線入射軸と垂直に検出器を配置し、試料表面すれすれに射出した蛍光X線を検出している。X線入射点から検出器までの距離は50 cmとした。また、バックグラウンド信号を除去するため、パスの入射部に鉛板を利用したスリットを設けている。
最終目的はGaN-HEMTの評価であるが、測定手法の妥当性を検証するため、構造と状態が既知のサンプルもいくつか準備した。具体的には(A) GaAsウェーハ表面に自然酸化膜(Ga2O3)が生成されたもの、(B) GaNエピウェーハ表面にSiN膜を80 nm堆積したもの、(C) GaNエピウェーハ表面をO2プラズマ処理し、SiN膜を4 nm堆積したもの、および、(D) 同じ構造で、SiN堆積後に還元雰囲気中、600℃で15分間、高温アニール処理を行ったものである。また、最終目的である(E) GaN-HEMTデバイス、および、比較のために、(F) GaN-HEMTデバイスと同一ウェーハ上に設けた被測定領域周辺の200 μm四方に電極が存在しないものも準備した。このうち、(C)と(D)は、過去にBL46XUにて硬X線光電子分光(HAXPES)による評価を実施したものである[3]。

図1.測定系写真と、真上から見た測定系の概略図
結果および考察:
(1)測定方法の妥当性検証
(A) 図2にGaAs表面に自然酸化膜(Ga2O3)が堆積したサンプルのXAFSスペクトルを示す。挿入図の横軸は検出器のチャネルを示し、これは出射角度に対応しており、小さいほど高角度、すなわち界面近傍の情報となっている。PILATUSの1ピクセルは172 μmであり、サンプルからPILATUSまでの距離が50 cmであるから、1チャネルあたり約0.02°の角度に対応している。
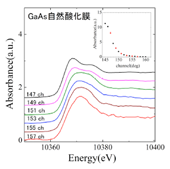
図2.Ga2O3/GaAsのGa-K吸収端スペクトル
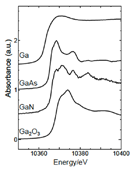
図3.標準試料のGa-K吸収端スペクトル
図2のスペクトルを、事前に取得した標準試料のスペクトル(図3)と比較すると、バルク(147 ch)では、10,368 eVと10,376 eVに明瞭なピークを持つことから、GaAs状態であることが分かる。これに対して、界面近傍(157 ch)では10,374 eVのみにピークをもつことからGa2O3状態になっていることが分かる。バルクから界面にかけて上記のスペクトル変化が徐々に起こっており、Ga2O3が増加する様子が明瞭に捉えられていることが分かった。この結果から、今回の測定手法に問題が無いことが確認できた。
なお、上記測定において、大気中に被測定サンプルをおいた状態で実施したところ、X線照射中にスペクトルが変化してしまう現象が観察された。これは、X線強度が強いために大気中酸素がオゾン化し、試料表面の破壊(エッチングや酸化)をもたらすものと考えられた。そこで、X線の入射部・出射部をポリイミド系フィルムの窓としたカバーで測定試料を覆い、内部にHeガスを充填させて測定を行ったところ、試料の破壊・変質が大幅に抑制されることを確認した。
(B) GaNエピウェーハ表面に80 nmと、厚いSiN膜を堆積したものを評価した。このサンプルは、GaN表面に自然酸化物(Ga2O3)が存在しているが、XAFSスペクトルからは、Ga2O3の存在が確認できなかった。これは、SiN層の膜厚が80 nmと厚すぎるためと考えられる。
(C、D) 図4と図5にO2プラズマ処理を行ったSiN/GaN試料のXAFSスペクトルを示す。図4はSiNを堆積したままのもの、図5はSiN堆積後に高温アニール処理を施したものである。いずれも、出射角大(バルク側)から出射角小(界面側)にかけて、図中に赤丸で囲った10,366 eV近傍のピークが低下していることが分かった。これらは、図3の標準試料のスペクトルと比較すると、界面に近づくにつれ、GaN信号に、金属状GaもしくはGa2O3の信号が重なっていくことによるものと考えられる。これらのどちらの状態になっているか、標準試料スペクトルとの比較だけでは判断できないが、過去に実施したHAXPES分析の結果から、図4のアニールなし試料は界面にGa2O3が存在し、図5のアニールあり試料は界面に金属状Gaが生成しているものと推測できる[3]。

図4.O2プラズマ処理を行ったSiN/GaN品(アニールなし)のXAFSスペクトル

図5.O2プラズマ処理を行ったSiN/GaN品(アニールあり)のXAFSスペクトル
そこで、GaNおよび、金属状Ga、Ga2O3標準試料のスペクトルを用いたプロファイルフィッティングを行ったところ、上記推測を裏付ける結果が得られ、図4のアニールなしでは、界面近傍でGa2O3の存在比が約50%であった。
結局、HAXPESの結果と同様、アニールによって界面状態が酸化物(Ga2O3)から金属状Gaへの変化することが確認できた。
なお、低出射角で出る蛍光X線は、SiN膜表面と、SiN/GaN界面での反射と屈折に伴う緩衝効果が生じ得る。この干渉効果は出射角によって異なる事から、今回観測された出射角依存性が干渉効果による可能性も考えられるが、HAXPESでの解析結果と合わせて考察することによって、今回の結果は干渉効果ではないと考えている。ただし、出射角依存性の詳細な解析を進めるには干渉効果の定量的把握が不可欠であるため、今後の検討課題としたい。
(2) GaN-HEMT デバイスのSiN/GaN 界面状態評価
図6に、GaN-HEMTのGate電極とDrain電極間(図7参照)の微小領域を狙ったスペクトル(赤線)と周辺200 μm四方の領域に電極がない状態(大面積部:黒線)の評価結果を示す。また、図7においてGate-Drain間隔は5 μmで、今回は、その中央(Gate電極端から2.5 μmの点)を評価している。入射X線のビームサイズは700 nm程度である。
図6より、バルク側では電極間と大面積部のデータが重なっており、状態の違いは見られなかった。これに対して、表面側では、第3ピーク付近のスペクトル(図中で赤丸で囲った領域)にわずかな違いが得られた。この違いの原因として、GaNにかかるストレス(応力)の違いが想定される。半導体表面に堆積されたSiN膜が半導体にストレスを及ぼすことはよく知られており、今回の実験構造においても、GaNに圧縮側のストレスを及ぼしている。周辺に何もない大面積部に比べ、近傍に電極がある場合、SiNからGaNにかかるストレスが変化し、GaN結晶が歪むことによりGa-K吸収端のスペクトルに違いが生じたという説明が可能である。ただし、スペクトル差がわずかであるため、蛍光X線の干渉効果の影響も含めた解析は今後の課題である。
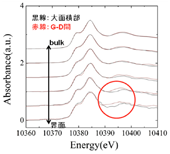
図6.GaN-HEMTのGate-Drain電極間(赤線)と、周辺200 μm四方に電極がない部分(黒線)との比較
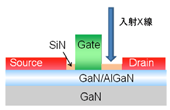
図7.GaN-HEMTの断面模式図
今後の課題:
今回の測定では、電極間の場合、特に界面近傍でのS/N比低下が顕著であった。これは、出射蛍光X線の多くが近傍の電極に阻まれ、電極長手方向に並行に出射した蛍光X線しか検出されないため、信号検出効率が低下するためである。今後、データの蓄積時間やスキャン回数を増やす以外にも何らかの手段によって検出効率を改善する手法を検討したい。また、今回は時間の制限のために十分な評価ができなかった、実デバイスにパルス状に電圧ストレスを印加し、ストレスOFF直後からの表面状態の時間変化を測定することも今後の検討課題としたい。
また、電極間と大面積部のスペクトルの違いの原因について、GaN結晶の歪みによるものと推定しているが、他の手法(回折法を使った逆格子マッピングなど)による検証も行いたい。
参考文献:
[1] S. C. Binari, et al., IEEE Trans. Electron Devices, 48, 465 (2001)
[2] D. J. Meyer, et al., Appl. Phys. Lett., 92, 193505 (2008)
[3] 舘野泰範、他, SPring-8重点産業利用課題成果報告書 2010B1847
ⒸJASRI
(Received: October 4, 2012; Early edition: April 28, 2015; Accepted: June 29, 2015; Published: July 21, 2015)






