Volume3 No.2
SPring-8 Section B: Industrial Application Report
X線反射率測定法を用いたシリコン酸化膜の評価
Evaluation of the SiO2 Film by X-ray Reflectivity
明治大学
Meiji Univ.
- Abstract
-
本課題では、プラズマ酸化膜のプロセス条件の最適化のため、BL46XUのビームラインでX線反射率測定法を実施し、膜密度や界面ラフネスといった物理的特性の評価を行った。測定結果より、RF電圧や成膜時のO2流量を大きくすることで、膜密度は低くなり、界面は粗くなるということが明らかとなった。今回の測定により、プラズマ酸化条件の最適化に一歩前進したと考えられる。
キーワード: プラズマ酸化、X線反射率測定、膜密度、界面ラフネス
背景と研究目的:
従来、ゲート絶縁膜の酸化膜の酸化手法には熱酸化法が用いられてきた。熱酸化法の利点は、酸素雰囲気中で熱処理するだけで簡単に得られる、優れた絶縁特性と界面特性を有していることが挙げられる。しかし、欠点もいくつかある。微細化によりナノスケールまで薄くなった極薄膜状態では、トンネル電流が増大し、リーク電流も大きくなってしまう。また、熱酸化法は、高温のもとで製造するために熱応力が加わり、欠陥を作ってしまったり、不純物の拡散が大きくなったりする。そこで、低温酸化プロセスに着目したのが、プラズマ励起を用いたラジカル酸化法である。この酸化手法では、化学的に活性な酸素ラジカルを用いることで、熱酸化法よりも低温で酸化させることが可能である。しかし、ラジカル酸化法ではプロセス条件が複雑であり、プラズマ条件、酸化雰囲気条件などを最適化しなければならない[1]。よって本研究では、X線反射率測定により、膜の物理的特性、特に深さ方向の密度分布、界面ラフネスを比較することで、プロセス条件の最適化について検討した。
実験:
我々はBL46XUにおいて、10 keVのX線を用いてX線反射率測定を行った。試料はプラズマ酸化手法により(100)シリコン基板上に作製した酸化膜を用いた。試料形状、酸化膜厚は4.5~7 nm、試料の長手寸法は10 cmである。成膜温度は750°Cとし、Radio Frequency (RF)や成膜圧力などプラズマ酸化条件を変えた試料を6水準用意した。プラズマ酸化の具体的な条件については表1に示す。試料1と試料2および、試料4と試料6でRFの効果を比較する。試料1と試料3ではO2流量の影響を、試料1と試料4で成膜時の圧力の影響を、試料4と試料5でH2流量の影響をそれぞれ比較する。
表1. 試料概要

装置は多軸X線回折装置を用い、検出器にはシンチレーションカウンタを使用した。測定散乱角2θの範囲は0~8°として実施した。
結果および考察:
X線反射率測定法(XRR:X-ray Reflection)により、プラズマ酸化膜密度および界面ラフネスがプラズマ条件によりどのように変化するかを評価した。図1にプラズマ酸化膜(試料2)より得られた代表的なXRRプロファイルおよびフィッティング曲線を示す。また、表2に多層膜仮定での解析におけるモデル図を、図2に解析結果例(試料2)を示す。材料はすべてSiO2膜だと仮定し、基板側から順に界面層、バルク層、表面層を仮定し解析を行った。このとき、密度は各層の膜厚と密度で加重平均によって求めた値とし、界面ラフネスはSi基板のラフネスを値とする(表2より試料2の界面ラフネスの値は約0.74 nmとなる)。図3よりRF電圧を大きくすると酸化膜の密度は低くなり、界面が粗くなる結果となった。この原因としては、RFにより発生したプラズマからの酸化膜へのダメージが寄与していると考えられる。同様に、O2の流量を大きくすることで密度は低くなり、界面は粗くなった(図4)。一方で、圧力を下げることで界面は平坦になった(図5)。今回の測定結果より、RF電圧、O2流量を下げることで、プラズマ酸化膜の密度が高くなり、界面が平坦になることが明らかとなった。また、圧力条件を最適化することにより、界面の平坦性向上の可能性が示唆された。
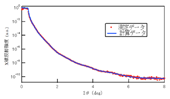
図1. プラズマ酸化膜(750°C RF)より得られた代表的なXRRプロファイルおよび理論曲線によるフィッティング結果
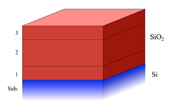
図2. 酸化膜モデル
表2. 解析例(試料2)
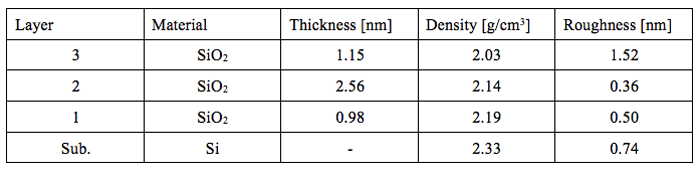
表3. 各試料の密度、界面ラフネスおよび膜厚
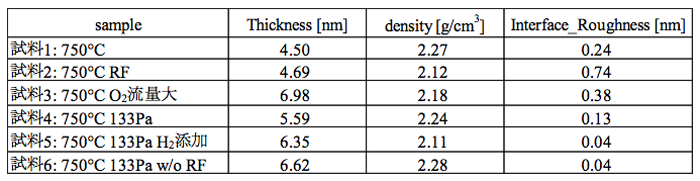

図3. プラズマ酸化膜の膜密度(左)および界面ラフネス(右)のRF依存性

図4. プラズマ酸化膜の膜密度(左)および界面ラフネス(右)のO2流量依存性

図5. プラズマ酸化膜の膜密度(左)および界面ラフネス(右)の圧力依存性
今後の課題:
今回の実験では、シリコン酸化膜の膜密度および界面ラフネスの評価といった物理的特性の検討を行ったが、デバイス性能の直接的な評価である電気的特性にどう影響するか議論するため、リーク電流や誘電率といった電気特性の検討を行う必要がある。
参考文献:
[1] T.Yamaguchi, K.Nagata, A.Ogura, T.Koganezawa, I.Hirosawa, Y.Kabe, Y.Sato, S.Ishizuka and Y.Hirota “Evaluation of Properties of SiO2 Films Fabricated by Plasma Oxidation”, ECS Trans. 41(3), 169 (2011).
ⒸJASRI
(Received: October 31, 2014; Early edition: May 28, 2015; Accepted: June 29, 2015; Published: July 21, 2015)






