Volume3 No.1
Section B : Industrial Application Report
走査型X線顕微鏡による樹脂内の導電性粒子の分散状態と電気抵抗の相関に関する研究
Scanning X-ray Microscope Study of Relationship between Dispersion State of Conductive Particles in a Resin and Electrical Resistance
キヤノン株式会社
Canon Inc.
- Abstract
-
走査型X線位相顕微CTにより電気抵抗が異なるフィラー分散樹脂中のフィラー分散状態の可視化について検討を行った。その結果、X線の位相情報を用いた断層像の再構成によりフィラーの分布の可視化を実現することができた。更に三次元再構成像から粗大凝集体の分布および量を抽出した結果、電気抵抗の高い試料ほど粗大凝集体の割合が高くなっていることを確認することができた。しかしながら今回検討した試料において、より詳細な情報抽出を実施するためには、試料のX線によるダメージを軽減させる方法を考える、もしくは更なる解析方法の工夫等の必要があることが分かった。
キーワード: ナノコンポジット材料、走査型X線位相顕微CT
背景と研究目的:
ナノ粒子などを基材中に分散させたナノコンポジット材料は機能材料としてタイヤ、電極材料、面状発熱体や電磁波シールド材など非常に幅広い分野で様々な製品や部品として極めて重要な役割を果たしている。フレキシブル配線などナノコンポジット材料の導電性を利用した部品は絶縁体の基材中に導電性ナノフィラーを分散させることにより導電性を発現させている。そしてこれら材料の電気的そして力学的な特性は、導電性ナノフィラーの分散状態に大きく依存することが知られている[1]。
基材中のフィラーは一次粒子とそれらが集まった凝集体からなる階層構造で存在し、このようなフィラーの分散状態を分析する手法の一つとして超小角X線散乱を挙げることができる。これらの材料に対する超小角X線散乱プロファイルは階層構造由来の情報により形成され、例えばUnified model等によるプロファイルフィッティングから各階層構造の大きさやフラクタル次元等の情報を抽出することが可能である[2]。我々もこれまで超小角X線散乱の測定をフィラー分散樹脂に対して実施してきた。しかしながら小角散乱のような逆空間情報から得られた情報だけでは例えば具体的な実空間におけるフィラーの分散モデルを構築し、材料特性との相関についてより詳細に考察することが難しく、更に通常の超小角X線散乱では数 µmを超える様な大きな凝集構造についてはデータを取得することが難しいといった問題点がある。
そこで今回は基材中のフィラーの分布についての実空間情報を取得するため、まずは走査型X線位相顕微CTを用いることにより直接、フィラーの分布を可視化できるかについて検討を行うと共に電気抵抗の異なる材料についてフィラーの分散状態を可視化し、特に超小角X線散乱では得ることができない数 µmを超える大きな凝集体にも着目し、電気抵抗との相関を明らかにすることを目的とした。
実験:
実験はBL47XUで走査型X線位相顕微CT装置[3]を用いて実施した。アンジュレータ光源からのX線は二結晶モノクロメータによって8 keVのX線に単色化され、一次元フレネルゾーンプレートにより、水平方向におよそ150 nm程度の幅のライン状ビームに集光し試料に入射した。試料を透過したX線は受光光学系を介して試料からおよそ6.2 m後方の位置にある検出器に入射した。検出器にはビームモニタ(浜松ホトニクス社製)を使用した。ビームモニタのシンチレータにはP43を用い、カメラはORCA flash 4.0(浜松ホトニクス社製)を用いて2×2のビニング設定で測定した。検出器上に投影されたX線ラインビームの縦方向の一画素のサイズは約220 nmに相当する。
試料は樹脂に導電性フィラーとしてカーボンブラックを導入したものを用いた。電気抵抗との相関について検証するため試料作成プロセスの条件を変化させることにより電気抵抗が異なる試料を作成した。フィラーの導入量は一定である。用いたフィラーの一次粒径はおよそ100 nm程度である。測定試料はシート状に成型した樹脂をもとに最終的にミクロトームで測定部が100 µm×100 µm×100 µm以下になるように加工したものを使用した。
まず仮測定においてX線による試料のダメージ等の確認を試料毎に実施し、測定条件を決定した。測定は試料をX線に対して水平方向に走査しながらX線ダイレクトビームを撮像し、水平方向の走査を終えた後に垂直軸の周りに試料を一定角度幅(主に0.8°)ごと回転させ、これを繰り返すことにより各角度での投影像の取得を0°〜180°の範囲で実施した。
測定データから試料によるX線の位相変化を抽出するためライン状X線の縦方向各位置での水平方向の重心変化を算出し、試料―検出器間距離を用いて計算されたX線の屈折角から縦方向各位置における水平方向の位相勾配のsinogramを作成した。この位相勾配のsinogramに対してFiltered back projection (FBP)法[4]によって各レイヤーの断層像を再構成した。一方、X線の吸収情報による再構成は縦方向各位置におけるX線透過率からsinogramを作成しConvolution back projection (CBP)法によって実施した。また、各試料について得られた再構成像の比較を実施して電気特性との相関について検討を実施した。
結果および考察:
まずX線の吸収情報を用いて再構成した像に関しては、全ての試料においてフィラー凝集体を十分に可視化することはできなかった。一方、X線の位相情報から再構成することによりフィラー凝集体を可視化することができた。しかしながら、位相情報を用いてもおよそ半分の試料に関しては、十分にアーチファクトを除去できず再構成がうまくいかないものがあった。具体的には試料の外形は問題なく再構成されるが、内部のフィラー形状が不自然な形状に再構成されてしまう現象である。これはX線照射によって測定中にフィラーが動いてしまっている可能性が高いと考えられる。この仮説を基に、対策としてスキャンスピードの高速化や測定の角度ステップを粗くする等を実施し、測定時間の短縮によってフィラー形状の不自然さが軽減され再構成画像が改善されるものもあった。ただし、全体的に原因が分からない長周期のアーチファクトが見られる傾向があり、今後原因の究明および対策の必要があると考えている。
図1に試料のX線の位相情報から再構成した断層像の例を示す。図中で黒い領域がフィラー凝集体である。図が示すように再構成した断層像においてフィラー凝集体と樹脂との間に明瞭なコントラストを得ることができた。フィラー凝集体は数百 nmの小さいものから数 µmを超える大きな凝集体まで存在していることを確認した。図中の試料Bは試料Aに対して体積抵抗率が3桁程度高い試料となっている。また、体積抵抗率の高い試料に関して大きさが数 µmを超えるフィラーの大きな凝集体が多数存在していることが分かった。試料の各断層像をスタックして三次元再構成像を作成し、粗大凝集体の抽出に適当なコントラストレベルの2値化処理を実施した後に、抽出された領域においてその大きさが約1 µm3以上の領域を粗大凝集体と定義し、位置および大きさに関する情報を抽出し比較を行った。その結果、再構成できた全ての試料にこの様な粗大凝集体が存在していることが分かった。また、試料Aおよび試料Bについて全粗大凝集体の体積が試料体積に占める割合を計算したところ、試料Aに対して試料Bのこの割合がおよそ2倍程度大きな値を示していることが分かった。このことは試料Bが粗大凝集体が無い部分のフィラーの割合が低下した結果、導電パスとなるフィラーが十分なネットワーク構造を形成できていない可能性を示唆しており、その結果、試料Aに対して試料Bは3桁程度高い抵抗化を示していることが考えられる。
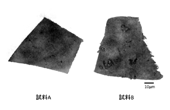
図1 試料Aおよび試料Bの再構成断層像
今後の課題:
今回、フィラー分散樹脂についてその分散状態の可視化を実現するため走査型X線位相顕微CT装置を用いた測定を実施した。再構成画像を精査すると、試料によってX線のダメージの度合いが大きく変化することが分かった。より詳細なフィラーの凝集状態の解析を実施するには、例えば冷却しながらの測定やより試料サイズを小さくする等といったダメージに対する対策が必要となると考えられる。今後、解析的に小さな凝集体の情報を抽出する方法を検討し、試料Aおよび試料B以外の試料におけるより詳細なフィラーの分散状態と電気特性との相関について検証していく予定である。
参考文献:
[1] K. Wongtimnoi, Composites Science and Technology, 71 (2011) 885.
[2] G. Beaucage, J. Appl. Cryst., 29 (1996) 134-146.
[3] A. Takeuchi, K. Uesugi and Y. Suzuki, J. Synchrotron Rad., 20 (2013) 793.
[4] F. Pfeiffer, C. Kottler, O. Bunk and C. David, PRL, 98 (2007) 108105.
ⒸJASRI
(Received: May 1, 2014; Early edition: July 30, 2014; Accepted: January 16, 2015; Published: February 10, 2015)






