Volume3 No.1
Section B : Industrial Application Report
X線励起可視発光検出によるEu付活蛍光体のXAFS測定
XAFS Measurement of Eu-activated Phosphor Using X-ray Excited Optical Luminescence (XEOL) Detection
a徳島文理大学, b(公財)高輝度光科学研究センター
aTokushima Bunri University, bJASRI
- Abstract
-
Eu付活蛍光体について、X線励起可視発光(XEOL)検出によるXAFS測定を試みた。可視蛍光の測定系を立ち上げて、Eu-LIII端近傍でのX線励起によりXEOLスペクトルが測定できることを確認した。XEOLスペクトルとX線吸収との関係について試料形態(厚み)依存性を調べ、10 μmオーダーの薄い試料であればX線吸収を反映するスペクトルが得られることを確認した。
キーワード: 蛍光体、Eu2+、XAFS、XEOL
背景と研究目的:
Eu2+イオンを付活した蛍光体は、ディスプレイや照明などに広く利用されている実用材料である。Eu2+イオンは準安定状態であり、所望の価数ではないEu3+イオンが蛍光体中にしばしば共存する。また熱などの負荷により、2価でサイト置換していたイオンが3価に戻って蛍光体の輝度が低下する。この混合価数状態は、それぞれのイオンの局所構造を調べることを妨げており、蛍光体の開発上重要な「結晶中のどこにそれぞれのイオンが存在しているのか?」という発光特性を左右している構造の情報が得られてこなかった。我々がこれまで蛍光法などで測定してきたEu2+付活蛍光体(例えばCaMgSi2O6:Eu)のEu-LIII端XAFSスペクトルにも、2本のホワイトライン(Eu2+:6972 eV, Eu3+: 6980 eV)が共存しており[1]、EXAFS振動抽出には至っていない。
このような問題を解決する一つの可能性として、発光イオンごとのX線励起可視発光(XEOL)スペクトルをモニタし、励起X線波長を変えて測定したXEOLスペクトルをX線吸収の代わりとするXEOL-XAFSがある。Euイオンは価数状態によりスペクトル形状(Eu2+:バンドスペクトル・線幅50 nm程度、Eu3+:線スペクトル・線幅3 nm程度)と発光波長域(Eu2+:ピーク波長380〜660 nm程度、Eu3+:580〜700 nmに数本)が異なることから、価数の異なるイオンが混在する場合にも、それぞれの発光を切り出してXEOL-XAFSを測定することで、各イオンの局所情報が得られることが期待される。またEu2+イオンでは周辺構造で発光色が異なるため、複数サイトが存在する場合、それぞれの発光を切り出すことで配位状態に合わせて局所情報を切り分けて得ることも期待できる。Eu2+イオンを付活した蛍光体でEuイオンを対象にしたXEOL-XAFSの実験例はこれまで報告されていないが、最近発光イオン選択XAFSとしてTiO2:Sm3+薄膜試料において光学活性なSm3+イオンのみのSm-LIII端XANESスペクトルを測定し、光学活性なSmO6八面体の局所ひずみを議論した報告がなされている[2]。
一方、XEOL-XAFSでは、X線吸収を反映しない構造のXEOLスペクトルがしばしば観測され[3-5]、XAFSスペクトルを取得するには試料形態に制約があることが指摘されている[3]。本研究では試料形態を変えた複数のEu付活粉末蛍光体を用意し、異なる発光波長域のXEOLスペクトルを用いた発光イオン選択XAFS測定系を立ち上げることを目標に実験を行った。
実験:
蛍光体には市販のランプおよびプラズマディスプレイ用蛍光体BaMgAl10O17:Eu(BAM)、CaMgSi2O6:Eu (CMS)、Y2O3:Eu (YO)、YBO3:Eu (YBO)を用いた。それぞれ2 g程度の粉末をポリエチレンバッグにパッケージしたもの、また粉末をエチルセルロースと混練してペースト化し、ガラス基板上に塗布した膜を測定用の試料とした。厚さは粉末パッケージ試料が5 mm程度、膜試料が10 μm程度である。
XEOL-XAFS測定は、産業利用ⅡビームラインBL14B2にて行った。付活イオンであるEuのLIII端を用い、XANES領域(6700-7400 eV)で測定を行った。XEOLスペクトルは単色X線を試料に45°入射して測定した。励起X線のスポットサイズはおよそ5×1 mm2である。この領域から発した可視蛍光を、大口径ファイバーを試料に近接させて取り込み、マルチチャンネル分光器(大塚電子社製MCPD-7000)を用いて可視発光スペクトルを測定した(図1(a))。XEOLスペクトル(XEOL検出XAFSスペクトル)は、図1(b)のセッティングで測定した。試料からの可視蛍光を石英レンズで集光し光ファイバーに入射し、回折格子分光器(日本分光社製CT-25)に導入した。目的のスペクトル領域で切り出した蛍光を光電子増倍管(浜松ホトニクス社製R580)で検出し電圧信号として取り出した。蛍光は微弱であるためチョッパーコントローラーで変調してロックインアンプで検出し、その出力を既設のXAFS測定系のI1としてPCに取り込んだ。ロックインアンプの時定数の都合から、2結晶分光器はステップスキャンで角度を変えてX線エネルギーをスイープした。なおI0は通常測定と同様に電離箱で測定している。図1(c)と1(d)に測定系の写真を示す。XEOLスペクトルに対するリファレンスXANESスペクトルは19素子SSDによる蛍光法で測定した。
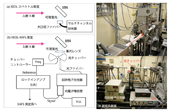
図1.XEOLおよびXEOL-XAFS測定系のブロック図((a)および(b))とブロック図(b)による
実験ハッチ内セッティング(XEOL-XAFS)の写真((c), (d))
結果および考察:
図2にX線エネルギーをホワイトライン(Eu2+: 6972 eV, Eu3+: 6980 eV)に合わせて励起した各蛍光体の可視発光スペクトルを示す。紫外線励起時と同様な発光スペクトルが得られており、XEOL検出でのXAFS測定の可能性は示された。図2のインセットに示すとおり実験ハッチ内に設置したカメラによる可視発光の目視は可能であるが強度は十分ではなく、現状の集光系では実用蛍光体程度の発光強度が要求されることが明らかになった。今後は集光系を含め、検出系の改善が必要である。

図2. 各蛍光体の可視発光スペクトル.(a)青色蛍光体BAM, CMS.(b)赤色蛍光体YO, YBO.
各図のインセットは実験ハッチ内に設置したカメラによるBAMおよびYOの可視発光像.
XEOL検出では励起X線に対して厚すぎる試料では吸収端でネガティブジャンプを呈することが多く報告されていることから[3-5]、強いXEOLスペクトルを示したYOと、一桁程度XEOL強度が弱いBAMでmm以上の厚さの粉末パッケージ試料を用いて確認を行った。図3にYOとBAMのXEOLスペクトルを示す。YOではネガティブジャンプが、BAMではわずかなポジティブジャンプが通常ホワイトラインが観測されるエネルギー近傍で観測された。透過法および蛍光法で測定されたスペクトル構造が観測されないことから、厚い試料ではXAFS測定が困難であることが今回の試料においても確認された。
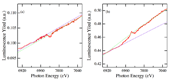
図3.粉末パッケージ試料のXEOLスペクトル.(a)YO, (b)BAM.点線は解析ソフトAthenaで
引いたプリエッジおよびポストエッジのバックグラウンドライン.
以上を踏まえて、XEOL強度は更に低下してしまうが、膜試料を用いてXAFS測定を試みた。図4に粉末パッケージ試料と厚み10 μm程度の膜試料でEu2+による青色領域のXEOLスペクトルをモニタしてXAFS測定を行い、蛍光法で測定したスペクトルと比較した結果を示す。X線吸収と比例したXEOLスペクトルが測定できるかどうか検討したところ、粉末パッケージ試料では、規格化スペクトルが蛍光法のXANESスペクトルと比較して著しく異なる構造を示している(図4(a))。
一方、膜試料では、ホワイトラインの強度に若干の差が見られるが、ほぼ蛍光法と同様のスペクトルを示しており、膜にすることでX線吸収を反映したXEOLスペクトルが得られることがわかった。なお、繰り返し測定を行っていないためS/N比が低く、概形の比較のみに留まっており、特に6980 eVのEu3+によるX線吸収の有無、イオン化後の振動構造に関する議論は困難になっている。

図4.XANES領域のBAMの規格化XEOLスペクトル.(a)粉末パッケージ試料, (b)膜試料.
蛍光法で測定したXANESスペクトル(FY:赤線)をリファレンスとして示す.
まとめと今後の課題:
X線励起可視発光(XEOL)検出によるXAFS測定を試みた。実験ハッチ内に可視蛍光の測定系を組み、Eu-LIII端近傍でのX線励起により可視発光スペクトルが測定できることを確認した。10 μmオーダーの薄い試料であればX線吸収を反映したXEOLスペクトルが得られることを確認し、XANES領域のスペクトルが測定できた。しかしながら、得られたスペクトルのS/N比は低く、EXAFS測定には一試料当たり24時間以上を必要とするため現実的ではない。斜入射照射により発光面積を増やすことで発光量を増加させることができる。その場合発光面積が広くなるためレンズ集光系ではファイバー開口とのカップリングが悪くなり、十分なXEOLスペクトルが取り込めなくなることも考えられるが、集光系に楕円面鏡を用いて改良すること、光電子増倍管にプリアンプを導入し信号電圧を上げることが可能である。以上のようにS/N比を一桁以上向上させて対象とできる試料を広げ、EXAFS測定にチャレンジしたい。
参考文献:
[1] T. Kunimoto, T. Honma, K. Ohmi, S. Okubo and H. Ohta, Jpn. J. Appl. Phys. 52 (2012) 042402.
[2] M. Ishii, I. F. Crowe, M. P. Halsall, B. Hamilton, Y. Hu, T-K. Sham, S. Harako, X-W. Zhao and S.Komuro, J. Appl. Phys. 114 (2013) 133505.
[3] S. Emura, T. Moriga, J. Takizawa, M. Nomura, K. R. Bauchspiess, T. Murata, K. Harada and H. Maeba,Phys. Rev. B 47 (1993) 6918.
[4] G. Martinez-Criado, B. Alen, A. Homs, A. Somogyi, C. Miskys, J. Susini, J. Pereira- Lachataignerais, J.Martinez-Pastor, Appl. Phys. Lett., 89 (2006) 221913.
[5] M. Murphy, X-T. Zhou, F. Heigl, T. Regier and T-K. Sham, AIP Conf. Proc., 882 (2007) 764.
ⒸJASRI
(Received: February 14, 2014; Early edition: July 30, 2014; Accepted: January 16, 2015; Published: February 10, 2015)






