Volume1 No.3
Section B : Industrial Application Report
深紫外光源用Gd添加AlN薄膜の高エネルギー光電子分光法による深さ方向解析 (3)
Depth Analysis of the Gd Doped AlN Thin Film for Deep Ultraviolet Light by Hard X-ray Photoelectron Spectroscopy (3)
a(株)ユメックス, b兵庫県立工業技術センター, c神戸大学
aYUMEX INC., bHyogo Prefectural Institute of Technology, cKobe University
- Abstract
-
我々は、水銀ランプの代替光源としてGd添加AlN薄膜の開発を進めている。今回、高エネルギー光電子分光(HAXPES)によりアニール前後の試料と電子線照射により劣化した試料の化学結合状態を分析し、発光強度と化学組成の関係を調べた。アニールにより発光強度が増大した試料は、酸化によりAl-O結合状態の領域が増え、窒素流量が大きいほど酸化物成分の割合が増加する傾向が得られているが、今回の結果より窒素流量、及びアニールによるCL強度増加の原因の究明に至る結果は得られなかった。また、電子線照射により劣化した試料は結晶が破壊されており、組成変化が発光強度の低下に繋がったと推測される。
キーワード: Gd添加AlN、深紫外光源、HAXPES
背景と研究目的:
近年、地球規模で水銀を削減するために国連環境委員会や環境省が進める「水銀規制条約」の策定作業が本格化している。水銀ランプを製造してきたメーカーにとって、水銀ランプに替わる新技術を確立することは速やかに解決すべき最重要課題である。我々は水銀ランプの代替利用を目的に、電子線照射により深紫外発光をする窒化アルミニウム(AlN)に希土類元素ガドリニウム(Gd)を添加した薄膜を用いて、電子線励起型深紫外光源の開発を進めている[1,2]。この深紫外光源の実用化には、薄膜の高輝度化と電子線照射による試料ダメージの低減が重要な課題である。図1に典型的なGd添加AlN薄膜のカソードルミネッセンス(Cathode Luminescence :CL)スペクトルを示す。希土類元素の内殻f-f電子遷移によるシャープな発光を示しており、この特長は医療や環境衛生用の紫外光源として利用が期待できる。これまでの研究結果から薄膜は、アニール処理することにより発光強度が約7倍に向上することを発見した。
本課題では、アニール前後の薄膜試料について化学結合状態を分析し、発光強度と化学結合状態の関係を調べることと、試作フィールドエミッションランプ(Field Emission Lamp : FEL電子線励起型の冷陰極発光デバイス)のランプ寿命評価を実施した試料について電子線照射による劣化原因を解明することを目的とした。
実験:
図2に試料構造の模式図を示す。試料は、反応性高周波マグネトロンスパッタリング法により基板温度200°Cの設定で石英ガラス基板上にAlNを100分間成膜した後、AlNにGdを添加した発光層を100分間成膜した。成膜時のガス圧力は5 Paに設定し、Ar:N2のガス流量比をAr:N2 = 9:X(X = 3,4,5) [sccm]と制御して、窒素流量依存性について調べた。蛍光X線分析(XRF)で膜厚を測定した結果、バッファー層と発光層を合わせた試料の膜厚は、Ar:N2 = 9:3〜9:5で約1600〜1800 nmであった。アニール処理は窒素ガス雰囲気下1100°C、30分の条件で行った。図3にアニール前後の試料について、窒素流量とCL強度の関係を示す。Ar:N2 = 9:5においてアニール前後を比較するとCL強度が7倍以上に向上していることが分かる。図4に試作FELのランプ寿命評価結果を示す。電子線照射による劣化状態の分析は、加速電圧5 kV、加速電流50 μAの条件で試料を電子線励起して得られる紫外線照度の時間変化を測定し、点灯1000時間後に初期照度の約70%まで低下した試料を測定に用いた。加速電圧5 kVで入射した電子は、薄膜の約150 nmの深さまで進入すると考えられる。試料は、図2に示すようにランプ寿命評価の際はAlメタルバック膜を施してチャージアップを抑制した試料を用い、HAXPES測定の際にはAlメタルバック膜を研磨除去した試料を用いた。
HAXPES測定はSPring-8ビームラインBL46XUにおいて、励起光エネルギーが7940 eVのX線を入射させ、生じた光電子を半球型アナライザー(VG-SCIENTA製R4000)により室温で測定した。アナライザー入射スリットはcurved 0.5 mm、パスエネルギーは200 eVにそれぞれ設定した。Au 4f7/2結合エネルギーのピーク位置を84 eVとし、光電子エネルギーを補正した。測定試料にはHAXPES測定時のチャージアップを防止するために、金薄膜を1〜4 nmコーティングした。
図1.典型的なCLスペクトル 図2.試料構造の模式図


図3.アニール前後のCL強度と窒素流量の関係 図4.試作FELのランプ寿命評価結果
結果および考察:
図5に光電子検出角(TOA)80°で測定したアニール前後のAl 1s HAXPESスペクトル測定結果、表1にピーク分離より得た解析結果を示す。スペクトルは縦軸のピーク強度を揃えて規格化し、ピーク分離の際はAl-Alのピーク位置を1559 eV、Al-Nのピーク位置を1560.5 eV、Al-Oのピーク位置を1562 eV、Al-O系酸化物のピーク位置を1566 eVに固定した。アニール前では窒素流量比をX = 3からX = 5へ上げるにつれてAl 1sのピークが1560.5 eVから1560.85 eVに高結合エネルギー側へシフトした。X = 3では窒素供給量が少ないため、AlNが十分に形成されずにメタリックな領域が増えるが、X = 5では窒素供給量がAlNを形成するために十分存在していると考えられる。アニール後はX = 3からX = 5において結合エネルギーのピーク値が1560.8 eVと同じ数値になり、高結合エネルギー側の裾が大きくなる傾向が現れた。これは、アニールにより結晶欠陥が減少して安定な構造の結晶を形成すると同時に、酸化反応によりAl-O結合状態(1562 eV)の領域が増えている事を示している[3,4]。X = 5において1565〜1567 eV付近に小さなピークが現れたが、これはAl-O結合を含むAlO系酸化物{AlO, AlO(OH), Al(OH)3等}が形成された可能性が考えられる[5,6]。X = 5の試料においてアニール前の場合、Al-O成分のエリア面積の割合が11.0%であり、Al-O系酸化物成分のエリア面積の割合が2.4%であったのが、アニール後になるとAl-Oが41.3%、Al-O系酸化物が10.2%と増大しており、酸化の影響が大きいことが分かる。図6に光電子検出角80°で測定したアニール前後におけるN 1s HAXPESスペクトル測定結果を示す。N 1sもアニール前は窒素流量比がX = 3からX = 5へ上がるにつれて397.1 eVから397.4 eVに高結合エネルギー側へシフトしたが、アニール後は何れの試料も397.2 eV付近にピークを持つようになった。これはアニールにより結晶化が進み、何れの試料も安定な状態になったためと考えられる。図7に光電子検出角80°で測定したアニール前後におけるO 1s HAXPESスペクトル測定結果を示す。文献[3]よりO-Alのピーク位置は532 eV、O-Hのピーク位置は533 eVと考えられる。アニール後は低結合エネルギー側へシフトしたが、これは水酸基(OH: 533 eV)が除去されたことによると考えられる。

図5.Ar:N2 = 9:X(X = 3,4,5)で作製した試料のアニール前後におけるAl 1s測定結果
表1.図5のAl 1sピーク分離により得た解析結果
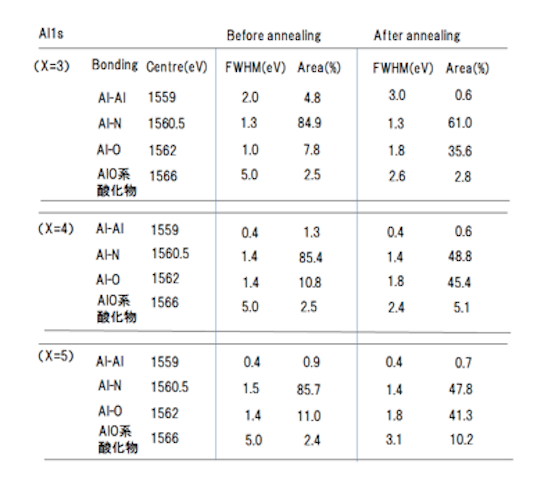

図6.Ar:N2 = 9:X(X = 3,4,5)で作製した試料のアニール前後におけるN 1s測定結果
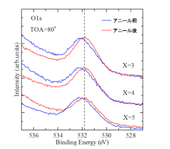
図7.Ar:N2 = 9:X(X = 3,4,5)で作製した試料のアニール前後におけるO 1s測定結果
図8に電子線照射により試料がダメージを受ける前後でのAl 1sの光電子検出角度(TOA)依存性、及び表2にピーク分離結果を示す。電子線照射によりダメージ受ける前の試料は、検出角度を変えてもAl 1sのスペクトル形状が変わらず、厚さ方向で均一になっている。電子線照射によりダメージ受けた後の試料は、TOA = 80°から40°へ小さくなるにつれてAl 1sのピークが1560.97 eVから1560.75 eVへ低結合エネルギー側にシフトした。TOA = 80°において1559 eV付近に小さなピークが現れたが、これはAl-Al結合の形成によると考えている。また、TOA = 60°の条件において1566-1567 eV、TOA = 40°の条件において1565 eV付近に新しいピークが現れた。これはAl-O結合を含むAlO系酸化物{AlO, AlO(OH), Al(OH)3等}によるものだと考えられる。電子線照射によりダメージを受けた後の試料において、検出角80°の場合はAlO系酸化物のエリア面積の割合が1.3%であったのが、検出角40°になると44.1%と増大しており、表面近傍でAlO系酸化物の影響が大きいと考えられる[6]。
アニールにより発光強度が増大した試料は、酸化によりAl-O結合状態の領域が増え、窒素流量が大きいほど酸化物成分の割合が増加する傾向が得られているが、今回の結果より窒素流量、及びアニールによるCL強度増加の原因の究明に至る結果は得られなかった。今後、更にGd添加AlN薄膜の結晶性、及び酸化が発光強度に与える影響について調べていく予定である。
また、電子線照射によりダメージを受けたGd添加AlN薄膜の表面は、酸化によりAlO系酸化物の領域が増大しており、内部はAl-Alの結合が形成されたと考えられる。
これらの結果より、試料は電子線によるダメージを受けて結晶が破壊されており、組成変化が発光強度の低下に繋がったと推測される。FELを長寿命化させるには、電子線の影響による組成変化を抑制する必要があると考えられる。

図8.電子線ダメージ前後のAl 1sの光電子検出角度依存性(TOA = 80〜40°)
表2.図8のAl 1sについて、ピーク分離により得た解析結果
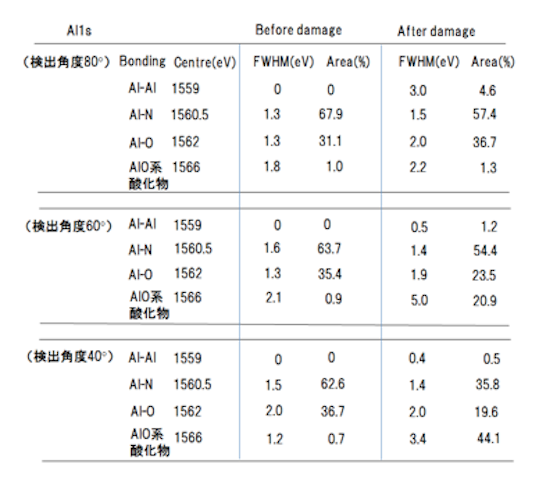
参考文献:
[1] S. Kitayama, et. al., J. Appl. Phys., 110, 093108 (2011).
[2] 小林幹弘他、SPring-8重点産業利用課題実施報告書 (2011B1961).
[3] D. Chen, et. al., J. Phys. D: Appl. Phys., 41, 235303 (2008).
[4] A. Mahmood, et al., Diamond and Related Materials, 12, 1315 (2003).
[5] J. T. Kloprogge et al., Journal of Colloid and Interface Science, 296, 572 (2006).
[6] T. F. Landaluce, et. al., XPS characterization of Al2O3 films deposited by ALD., (2012).
(http://www.vub.ac.be/SURF/files/file003.pdf)
ⒸJASRI
(Received: October 4, 2012; Accepted: November 1, 2013; Published: December 10, 2013)