Volume2 No.1
Section B : Industrial Application Report
油-水-鉱物3相界面における芳香族界面活性剤の吸着現象の解明と石油増進回収技術への応用
Structure Analysis of Aromatic Surfactant on Oil-Water-Mineral Interface for Application to Enhanced Oil Recovery Technique
a京都大学, b(独)石油天然ガス・金属鉱物資源機構, c早稲田大学/JAXA, d(公財)高輝度光科学研究センター
aKyoto University, bJOGMEC, cWaseda University/JAXA, dJASRI
- Abstract
-
石油増進回収技術の開発には、油-鉱物、水-鉱物の界面における水分子および油分子の集積、吸着現象の解明が必要である。本研究では、鉱物として自然酸化膜付Si基板を、油相としてシクロヘキサンを、水相として超純水を採用し、X線反射率法を用いて固液界面に垂直な方向の電子密度分布を推定した。その結果、分子動力学法で見られたO-bridgeのシリカと水の界面の疎水性gapの存在は確認されなかった。このことから、この自然酸化膜はOH端を有しているか、疎水性gapが小さいため表面粗さに埋もれて確認できなかったことが示唆された。
キーワード: 油-鉱物界面、石油増進回収、X線反射率法
背景と研究目的:
発展途上国の急速な経済成長にともなう石油・天然ガスの需要の増加に応えるため、メタンハイドレートやシェールガスなど新規資源の開発に加えて、効率的な石油増進回収(EOR)技術の開発が求められている。効率的なEOR技術の開発には、µmスケール以下の微小孔隙内における高温高圧下での水-鉱物および油-鉱物の2相界面現象、さらには、油-水-鉱物の3相界面現象の解明が必要である。これに関して、我々は分子動力学を利用し O-bridgeのシリカと水の界面について調べたところ、図1に示すような疎水性gapがあることがわかった[1]。また、シリカとトルエン、ヘプタンそれぞれの界面を比較すると、トルエンの方がシリカ表面に集積しやすいことも分かっている[2]。このように、シリカの表面構造だけでなく、油の種類によっても界面現象が異なってくることが分かった。
そこで、本研究では、分子動力学による解析結果の検証を行うとともにX線反射率法により鉱物と油、鉱物と水の2相界面における吸着構造を解明することを目的に、シリコンウエハーのHfOx/Si基板および自然酸化膜付Si基板を固相とし、それぞれに対して超純水およびシクロヘキサンを液相とした場合の固液界面に対してX線反射率測定を行った。また、参照データとするため液相がない基板表面に対しても同様の測定を行った。今回の測定では、HfOx/Si基板は測定条件の最適化のために使用し、自然酸化膜付Si基板は鉱物中に最も多く含まれているSiO2の基礎データ取得のために使用した。なお、鉱物基板として白雲母の劈開面に対しても測定する計画であったが、準備した白雲母の劈開面が粗く有意なX線反射率データが得られなかったため、その測定を取り止めた。また、トルエン、ヘプタン、ヘキサンについては毛細管圧力により測定セルの隅角部を這い上がりセル上部においてシールが十分に確保できなかった。このため、これらを液相とした計測も取り止め、前回の結果との比較が可能なシクロヘキサンを有機溶媒の代表として用いた。
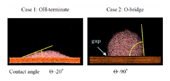
図1 シリカと水の界面に見られる疎水性gap
実験:
測定はBL19B2で行い、入射X線エネルギーは20 keVとした。1回目のHfOx/Si基板のみの測定では、入射光形状5 mm×0.09 mmのX線を用い、受光側は、0.5 mm×8.0 mmのスリットでコリメーションを行った。その他の測定については、入射光形状4 mm×0.09 mmのX線を用い、受光側は、0.5 mm×6.0 mmのスリットでコリメーションを行った。測定セルは幅11 mmのアルミ製でX線入射側と検出側にはKaptonフィルムの窓があり、X線が透過できる構造になっている。また、液中の基板は測定中に浮力で傾いたり移動したりしやすく、さらに有機溶媒中では接着剤が使えないため、図2に示すように、セルの底面に埋め込んだ磁石と微小な鉄板で基板を挟むことで固定した。これにより、液中でも高角度まで安定した測定が行えるようになった。基板を固定した後、液相をセルに入れ、揮発と漏えいを防ぐための蓋を取り付けて密閉した。これを多軸回折計のステージに設置し、X線の入射を行った。測定範囲は、バックグラウンドが少なく有効なデータが得られる範囲であると考えられる散乱角2θ = 0°から2θ = 4°までとした。なお、HfOx/Si基板のみの場合は液相によるバックグラウンドがなくなるため、2θ = 5°までの測定を行った。また、今後の測定につなげるため、計画を変更したことで発生したビームタイムを活用して、白雲母の劈開面に対するCTR法の有効性を確認した。
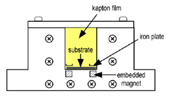
図2 測定セル
結果および考察:
図3(a)左に、HfOx/Si基板に対するX線反射率測定結果および多層膜構造モデルを用いたカーブフィッティングによって得られた反射率曲線(黒実線)を重ねて示す。また、図3(a)右にHfOx/Si基板に対するX線反射率解析により得られた電子密度分布を示す。図3(b)に、自然酸化膜付Si基板(SiO2/Si基板)に対する結果を図3(a)と同様に示す。この解析で得られたモデルパラメータを表1に示す。本実験では、水およびシクロヘキサンのバックグラウンドを測定し、基板と水との界面の反射率からバックグラウンドを差し引いて解析している。
なお、図4に示すように、計測データにはノイズと見られる周波数が高く小さな振動が含まれているため、ここではX線反射率が図中の赤線で示すバックグラウンドの10点区間の最大値以上となる範囲で解析した。具体的な解析範囲は、SiO2/Si基板と水の場合は2θ = 2.60°まで、SiO2/Si基板とシクロヘキサンの場合は2θ = 2.84°まで、HfOx/Si基板と水の1回目の場合は2θ = 3.96°まで、HfOx/Si基板と水の2回目の場合は2θ = 3.86°まで、HfOx/Si基板とシクロヘキサンの場合は2θ = 3.90°までである。解析にはX線反射率法解析用のフリーソフトMotofit[3]を用いた。HfOx/Si基板の解析モデルにおいて、液相の電子密度およびSi層の電子密度は理論値を用いた。最適化計算の結果、基板上のHfOx層の層厚、電子密度はどの場合もほぼ同じとなり、それぞれの結果に矛盾は見られなかった。液相が存在している場合でもKissingフリンジが見られ、基板の表面のナノレベルの層厚が測定できることが分かった。SiO2/Si基板の解析モデルについても液相の電子密度およびSi層の電子密度は理論値を用いた。初めに基板のみの測定結果の解析を行い、その結果を用いて液相が存在する場合の解析を行った。その際SiO2層の層厚は固定し、SiO2層の電子密度を理論値周辺で変化させ、実験結果に最も近づく膜構造と電子密度分布を得た。これより推定された液相が存在する場合のSiO2層の電子密度は、液相が無い基板のみのSiO2層の電子密度と比べ大きな差が見られなかった。また、このモデルで実験結果とよいフィッティングが得られていることから、d = πq-1から計算される本測定のz方向の空間分解能6.82 Åより大きい疎水性gapは存在しないと考えられる。
表1 解析で得られたモデルパラメータ (ρeは電子密度,dは層厚,σは界面粗さ,χ2は対数残差の2乗平均を表し、数字の0が空気または液体、1がHfOxまたはSiO2、2がSiを表す)
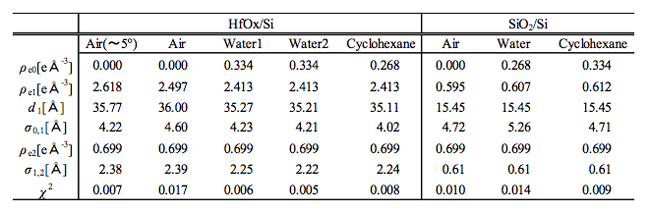
基板のみの測定結果では、自然酸化膜は電子密度0.595e Å-3、密度1.98 g/cm3と推定され、石英ガラスの密度よりも低く推定された。この自然酸化膜の表面粗さ、電子密度、層厚のパラメータがフィッティングに与える影響を考察するため、表面粗さと電子密度または層厚に対するχ2の変化について計算した結果を図5に示す。なお、χ2はA. Uysal et al.[4]にしたがい次式により計算した。

ここで、Nは反射率データ数、Rcalcはモデルから計算された反射率、Rdataは反射率データ、qiは散乱ベクトルである。Awaji et al.[5]の研究では、シリコン基板の表面粗さは 3.4 Å~3.6 Åと推定されている。図5に示すようにこの表面粗さ付近でχ2が最小になる点があり、その点のモデルパラメータを本研究での推定値とした。また、同研究では、自然酸化膜の密度は2.07 g/cm3~2.25 g/cm3と推定されている。HCl処理後の自然酸化膜の密度は低く、UV/O3やH2SO4処理後の自然酸化膜の密度はSiの密度に近いこと、FTIRおよびXPSによる評価ではHCl処理後の自然酸化膜にはSi-HやSi-OH結合が見られ、UV/O3やH2SO4処理後の自然酸化膜にはそれらが見られないことが示されている。今回推定された自然酸化膜の密度は、HCl処理後の自然酸化膜の密度に近いことからSi-HやSi-OH結合を有していることが考えられ、このためにO-bridgeによる疎水性gapが見られなかった可能性がある。また、分子動力学法による研究では、表面粗さが0 Åの理想的な構造の基板を仮定しているが、本研究で推定された表面粗さは4.72 Åであり、理論的に考えられる疎水性gapが表面粗さに埋もれて見えなかった可能性も考えられる。

(a) HfOx/Si基板

(b) SiO2/Si基板
図3 (a) HfOx/Si基板と(b) SiO2/Si基板のX線反射率測定結果および電子密度分布
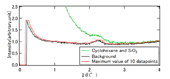
図4 X線反射率データとバックグラウンドデータおよびその10点区間最大値

(a)空気の場合の電子密度と表面粗さ(左)、層厚と表面粗さ(右)に対するχ2map

(b)水の場合(左)とシクロヘキサンの場合(右)の電子密度と表面粗さに対するχ2map
図5 SiO2/Si基板の各実験における表面粗さ、電子密度、自然酸化膜の膜厚に対するχ2map
今後の課題:
今回使用したシリコンウエハーのHfOx層およびSi自然酸化膜層の表面粗さや分子構造に関するデータを確認することができなかったため、ここで採用した測定手法については十分に検証できていない。しかし、原油増進回収技術におけるEOR手法の基礎としてSiO2基板表面の3相界面の有機分子吸着構造の評価を行うという本来の目的から判断して、当該計測手法に関する限り、ほぼ合理的な計測結果が得られたと考える。今後、SiO2基板の表面粗さについてはAFM計測を行い、電子密度については分子動力学法を用いて基板の表面粗さと液相の有無の影響について検討する。また、これらと合わせて追試測定を実施して評価結果の検証を行う。さらに、天然鉱物の結晶表面に対する油や水分子の吸着構造については、今回適用性が確認されたX線CTR散乱法による評価を実施する。
謝辞:
本研究は、JSPS科研費基盤研究(A)24246148の助成を受けたものです。
参考文献:
[1] M. Kunieda, Y. Liang, A. Ueda, T. Matsuoka, S. Takahashi and H. Okabe, 11th International symposium on reservoir wettability, University of Calgary, 6-9th September (2010).
[2] M. Ledyastuti, Y. Liang, M. Kunieda and T. Matsuoka, J. Chem. Phys. 137, 064703 (2012).
[3] A. Nelson, J. Appl. Cryst., 39, 273-276 (2006).
[4] A. Uysal, M. Chu, B. Stripe, A. Timalsina, S. Chattopadhyay, C. M. Schlep¨utz, T. J. Marks and P. Dutta, Phys. Rev. B, 88, 035431 (2013).
[5] N. Awaji, Y. Sugita, T. Nakanishi, S. Ohkubo, K. Takasaki and S. Komiya, J. Vac. Sci. Technol. A, 14, 971 (1996).
ⒸJASRI
(Received: April 24, 2014; Accepted: July 3, 2014; Published: July 10, 2014)






