Volume1 No.3
Section B : Industrial Application Report
X線光電子顕微鏡を用いたポリマーの化学状態解析の検討
Estimation of Chemical State Analysis of Polymers with X-ray Photoemission Electron Microscopy
a住友ゴム工業株式会社, b(公財)高輝度光科学研究センター
aSUMITOMO RUBBER INDUSTRIES, LTD., bJASRI
- Abstract
-
高分子材料の微小領域の化学状態やその変化を精密に解析するために、XPEEM(X-ray Photoemission Electron Microscopy)を用いた顕微XAFS(X-ray Absorption Fine Structure)測定に着目し、SPring-8 BL17SUにて検討を行っている。これまでの実験から、炭素K殻吸収端領域の測定において、光学系における炭素汚染の影響により入射X線強度を正確に測定できていないためXAFSスペクトルが歪むなどの問題が明らかとなっている。今回、入射X線強度の計測方法の検討を目的とし実験した結果、炭素K殻吸収端におけるスペクトルの歪みを低減することができた。
キーワード: XPEEM、ポリマー
背景と研究目的:
高分子材料は様々な環境下で使用されることで、材料表面から複雑に化学状態が変化するため、その変化を精度良く解析し機能向上させることは重要なテーマである。従来、FT-IR(Fourier Transform Infrared Spectroscopy)、NMR(Nuclear Magnetic Resonance)やXPS(X-ray photoelectron spectroscopy)などの分光学的手法を用いて化学状態変化が調べられてきた。しかしFT-IRやNMRは比較的バルク情報を捉えるため、表面から進行する化学状態変化を精密に捉えることが難しかった。また、XPSは表面敏感な手法であるが、遷移の始状態を検出しているためにC-H結合やC=C結合などのピーク分離が困難であった。それに対し、NEXAFS(Near Edge X-ray Absorption Fine Structure)は、遷移の終状態を捉えるため、精密な化学状態が解析できると期待される。これまでNEXAFSを用いて研究を進めてきた結果、高分子材料の化学状態変化を精度よく解析することができることがわかってきた[1]。一方、通常の高分子材料は機能や特性を向上させるために2種類以上のポリマーや薬品をブレンドされ使用されており、高分子材料の化学状態変化を精密に解析するためには、微小領域における各種材料の化学状態の解析が必要となる。
そこで我々は、XPEEMを用いた微小領域のXAFS測定(顕微XAFS)[2]に着目し、ポリマーをブレンドした系での化学状態の観察をSPring-8 BL17SUにて行ってきた。その結果、各ポリマーの海島構造の観察に成功した。しかし、炭素K殻吸収端付近のNEXAFSスペクトルが歪むという課題にも直面している。その原因は、光学系の炭素汚染の影響により、試料上流ミラーのドレイン電流測定では、試料に入射されるX線強度を正確に測定することができていないためと考えられた。そこで、試料をマウントしたシリコンウェハ表面で入射X線強度測定を試みたが、同じくシリコンウェハ表面も炭素により僅かに汚染されているため、正確な強度を測定することができなかった。
今回、これらの問題を解決すべく、完全に試料表面の炭素汚染を取り除いた金属板を作成し、それを用いて入射X線強度を計測することで炭素K殻吸収端におけるNEXAFS測定ができるのか検討を行った。
実験:
実験はSPring-8 BL17SUのSPELEEM装置を用いて行った。試料は、イソプレンゴム(IR)とブタジエンゴム(BR)を7: 3の比率で混合したものをシリコンウェハ基板上にスピンコートした。通常、XPEEMのアライメントを行う場合、UVランプが使用されるが、これまでの実験においてゴム表面にUVを照射すると損傷を起こすことが分かっている。また、XPEEMに付属している低エネルギー電子線を用いても損傷を起こすことが分かってきている。そこで、最も相互作用の小さいX線(放射光)を用いてXPEEMのアライメントを行うことにした。具体的には、あらかじめシリコン基板上でXPEEMの光学系の収差調整及びフォーカス調整を行い、次に目的とする試料表面上で微調整することで、できるだけX線損傷を防いだ。
一方、XPEEMによるNEXAFS測定を行う場合、エネルギースキャンを行っている間に試料が損傷を受ける可能性がある。そこで、ビームライン上流のスリットを絞ることで試料に入射されるX線強度を下げ、XPEEM装置の静電アナライザー直後のエネルギースリットを最大に広げることで、検出器に入る二次電子量を増やす工夫を行った。目的の視野径は20 µmとした。この時のピクセル分解能は約40 nmである。また測定時に試料に掛かっているバイアス電圧は−20 kVである。入射X線強度測定は、別途イオンスパッタにより作成した清浄な銅板(LEEDで表面汚染が無いことを確認)を用いて行った。
結果および考察:
Fig. 1に285 eVにおけるXPEEM画像を示す。得られた画像を二値化し解析した結果、IRとBRの面積比率がブレンド比7: 3とほぼ一致しており、さらに別途AFM(Atomic Force Microscope)観察にて得られたモルフォロジーと一致することから、XPEEM測定においてIR/BRのモルフォロジーが観察できていると考えられた。次にFig. 2(a)にXPEEM測定から得た炭素K殻吸収端付近におけるXAFSスペクトル、(b)に別途測定した炭素K殻吸収端付近におけるIR単体及びBR単体のNEXAFSスペクトルを示す。今回、清浄な銅表面を用いて入射X線強度測定することで、Fig. 2(a)のように各ポリマーのスペクトルが歪むことなく得ることができ、NEXAFS結果と同様にIRとBRのスペクトルの違いが検出できた。
しかしNEXAFSスペクトルと比較すると、XPEEM測定から得られたスペクトルの半値幅が広くなっていた。これは、試料表面の帯電を十分防ぐ事ができていないため、試料表面に帯電分布が生じたためと考えられた。今後、試料表面の帯電除去方法などの検討が必要と思われる。
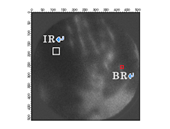
Fig. 1.285 eVにおけるXPEEM画像
(黒部分: IR, 白部分: BR)

Fig. 2.(a) XPEEM測定から得た炭素K殻吸収端付近におけるNEXAFSスペクトル
(b) 炭素K殻吸収端付近におけるIR単体、BR単体のNEXAFSスペクトル
今後の課題:
今回、入射X線強度(I0)の測定を種々検討したが、課題が残る結果となった。今後、検出器感度のエネルギー依存性や効率性を検討し、最適な検出方法を検討する予定である。
参考文献:
[1] O. Dhez et al., Journal of Electron Spectroscopy and Related Phenomena, 128, 85–96 (2003).
[2] C. Morin et al., Journal of Electron Spectroscopy and Related Phenomena, 121, 203–224 (2001).
ⒸJASRI
(Received: November 16, 2012; Accepted: November 1, 2013; Published: December 10, 2013)






